知识星球里的学员问:Au bump是怎样制作的?有哪些应用场景?需要检测的技术指标有哪些?
什么是Au bump工艺?
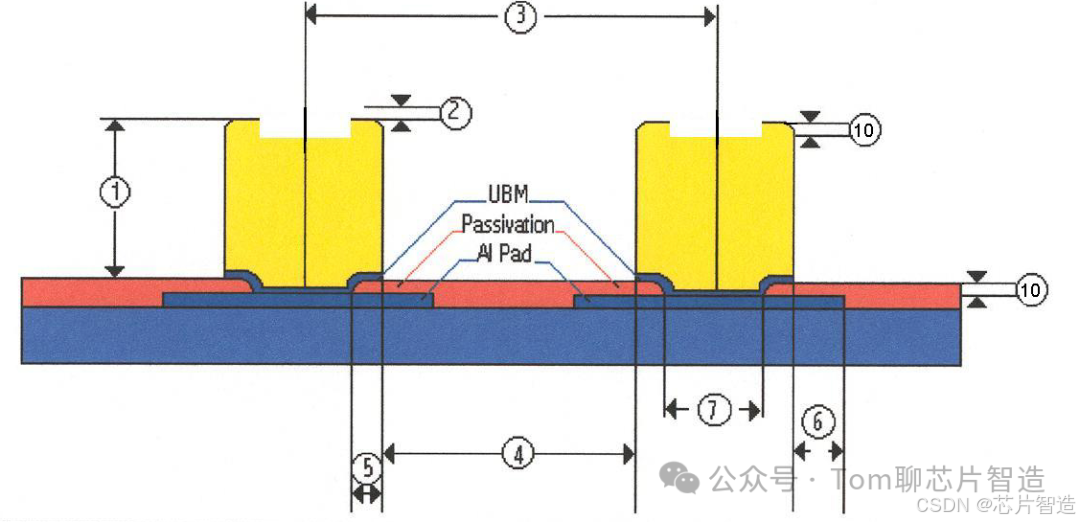
如上图,
在芯片的铝焊盘上电镀金(Au)形成微小的金属凸点,这些凸点用于导通芯片与封装基板之间的电路。与Solder Bump不同的是,Au bump具有更好的导电性,更小的尺寸更高的密度,抗氧化能力更强。
Au bump主要用于哪方面的?
一般用于倒装工序(flip chip),最常见的是COG(chip on Glass)封装中。
Au bump的电镀工艺流程?
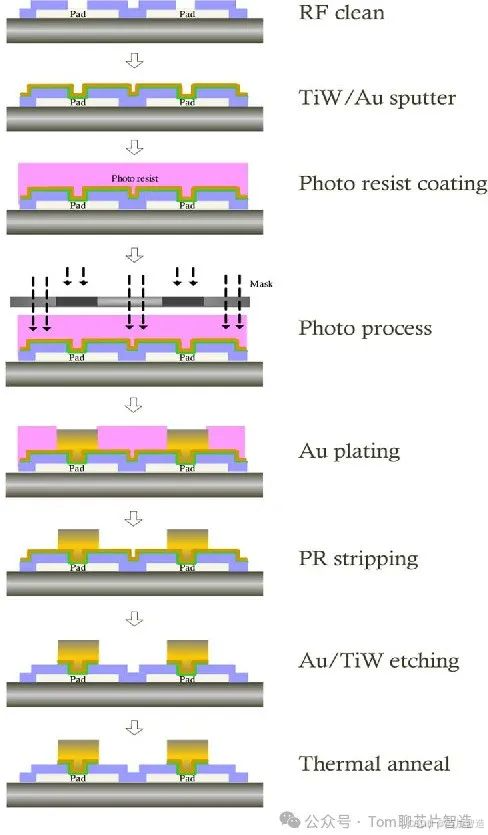
如上图,
RF清洗(RF Clean):在这一步,使用等离子体清洗晶圆表面,去除可能影响后续沉积的有机物和氧化物。这对于提高金属层与衬底的附着力至关重要。
钛钨/金溅射(TiW/Au Sputtering):在清洗后的焊盘上沉积一层钛钨(TiW)作为粘附层,随后再沉积一层金作为种子层,用于晶圆表面电路的导通,使后续的电镀工序能够进行。
光刻胶涂布(Photo Resist Coating):涂布一层光刻胶,通常厚度较厚,光刻胶的厚度是要高于金凸点的高度。
Photo Process:曝光,显影等,露出要电镀的部分,不需电镀的部分用光刻胶遮挡住。
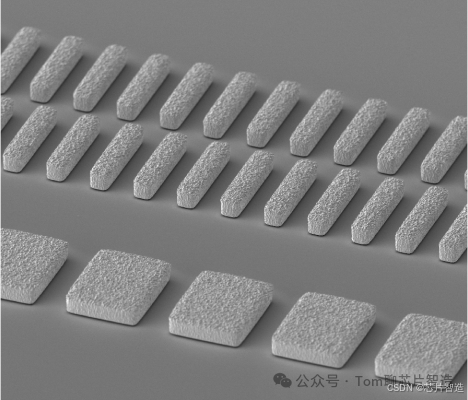
金电镀(Au Plating):在已暴露的金属区域进行金电镀,一般凸点的高度在15-18um,bump之间的空隙也在10um左右。
光刻胶剥离(PR Stripping):在电镀完成后,去除光刻胶,暴露出底层的TiW/Au层。
Au/TiW刻蚀(Au/TiW Etching):使用湿法刻蚀工艺去除未覆盖电镀层的多余TiW和Au层,保留已经形成的金凸点。
热退火(Thermal Anneal):最后,通过退火使电镀的金凸点结构更加坚硬,便于后续的倒装工序。
Au bump的要求?
1,退火后硬度足够高
2,镀层表面粗糙度足够小























 3141
3141

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








