近年来,芯片半导体国产化率提升,国内晶圆厂持续扩产,核心设备和零部件陆续突破,半导体国产替代是大势所趋。国内成熟制程半导体制造产业链的自主可控将加速,同时保持对先进制程的追赶,半导体的自主可控更加乐观,国产化率将持续提升。
半导体芯片上元器件分布密集,元器件之间空间非常小,当温度过高时,元器件体积发生膨胀、挤压,半导体芯片可能因为挤压产生裂纹报废。
若温度太高,集成电路工作时过热,会增大晶体管被击穿短路的概率;晶体管性能随温度会发生变化,使部分电路因为性能变化无法正常工作;高温提高电迁移导致导线工作寿命下降。如果温度过低,往往会造成芯片无法打开其内部的半导体开关,导致其不能正常工作。

在芯片研发设计和制造过程中,需要对其进行冷热冲击试验。电子芯片和微型设备的异质性和尺寸不断缩小,导致对冷热冲击过程全场变形数据的测量要求越来越高。然而扫描电镜系统图像会出现非线性漂移和失真,对变形测量产生较大的误差。
新拓三维XTDIC-MICRO显微应变测量系统,基于自主研发的专利算法,可进行2D和3D高低温变形测量,可对显微成像系统采集的图像进行漂移和失真校正,获取高倍数显微镜下芯片半导体试样变形的准确测量值。

下面分别展示了采用XTDIC-MICRO显微应变测量系统,通过高放大倍数显微镜进行图像采集,经过漂移校正后,芯片热膨胀表面位移场数据,达到分析其相关热膨胀性能的目的。
另外,通过对电子芯片的高低温冲击分析,直观地展示出电子芯片金属与聚合物层由于温度引起的变形梯度,XTDIC-MICRO系统可得到准确的测量值。
芯片热膨胀系数测试
芯片半导体结构材料在高温环境下的热膨胀系数,测试方法将XTDIC-MICRO显微应变测量系统和温控箱加热技术相结合,建立高温热变形测量系统。
XTDIC-MICRO系统搭配高放大倍数显微镜采集不同温度下试样的表面图像,经DIC方法分析处理得到芯片材料随温度升高产生的变形和应变,进一步计算得到相应温度下的热膨胀系数。
针对于工程实验的特殊性,本次实验采用XTDIC-MICRO显微应变测量系统,可配合显微镜加载系统,通过显微镜、放大镜头、显微镜头对微小尺寸芯片样件试验进行位移场测量和热膨胀系数分析。

在光学显微镜下材料的热膨胀测试中,挑战在于使用高放大倍数显微镜,意味着景深很小,几微米的离面位移就会造成显微镜失焦。XTDIC-MICRO系统通过自主算法和特殊设计,可有效控制离面位移对实验结果影响。
芯片热膨胀-DIC数据分析
芯片试件1类-位移场分析
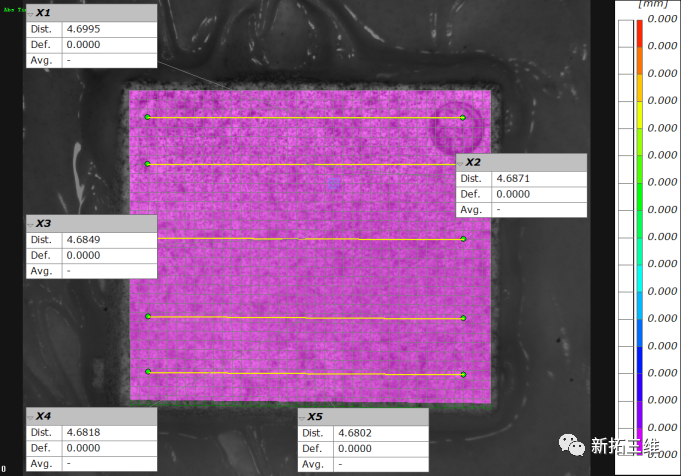
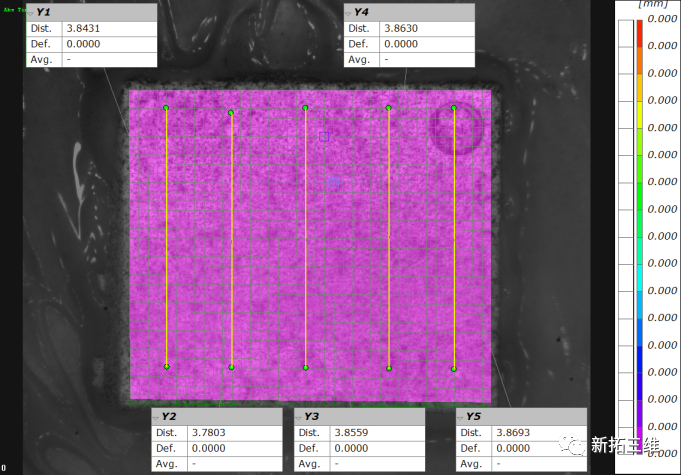
芯片试件2类--位移场分析
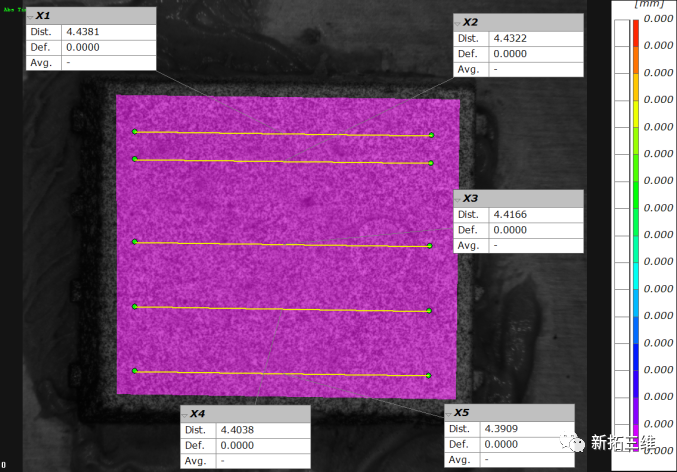
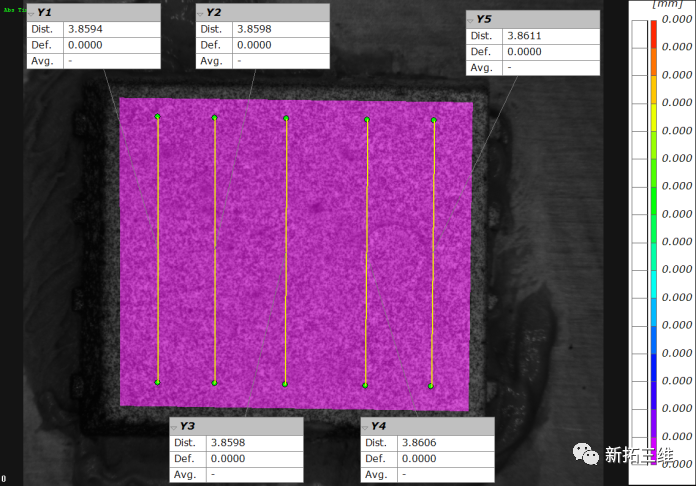
芯片热膨胀结果分析
选取2个芯片测试试件,结果选取到达125摄氏度后稳定区域内数据平均和初始值进行对比,推算试件的膨胀系数:


芯片高低温变形测试
高低温冲击几乎对所有的基本材料都有不利的影响,对于暴露于异常温度下的手机电子设备,由于温度会改变其组成材料的物理特性,因此可能会改变其工作性能,对手机功能造成暂时或永久的损害。
❖材料的软化、硬化和脆化
❖不同材料的收缩不一致
❖电子器件(芯片、电阻、电容)性能改变
❖破裂、开裂和脆裂,冲击强度改变,强度降低
❖芯片和PCB板性能改变
采用新拓三维XTDIC三维全场应变测量系统,测试在不同温度下芯片以及PCB板表面应变情况,分析其对于手机性能的影响。
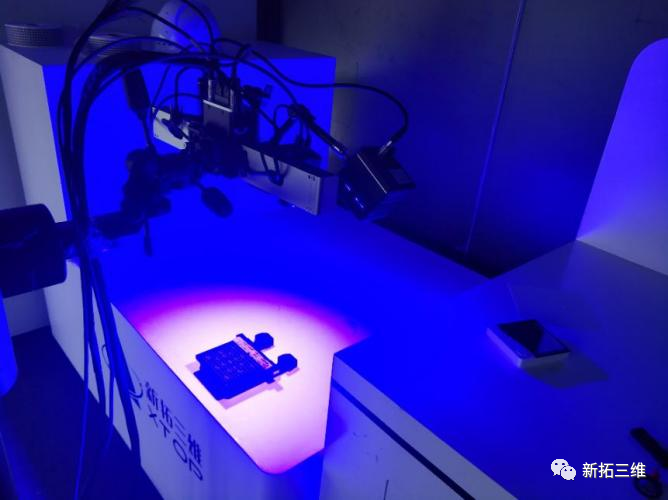
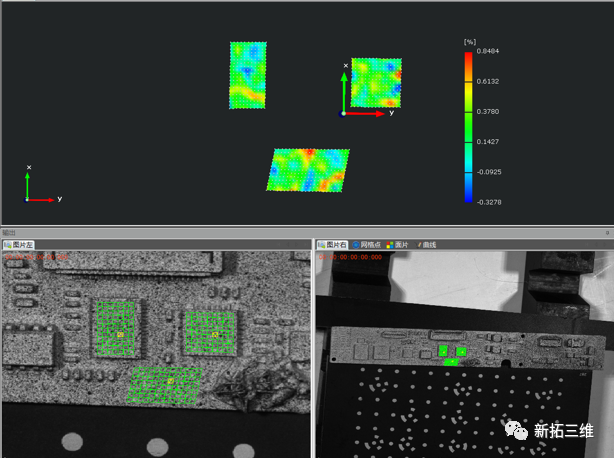

温度变化全过程关键点应变曲线
新拓三维XTDIC-MICRO显微应变测量系统,可用于测试芯片热膨胀系数,高低温等特有温度梯度下的变形测试,为测试精度提供精确保证。XTDIC系统适用于芯片微变形、硅片、封装、基板及材料等热变形效应测试,测量芯片在不同温度下的力学特性,如高温、低温测试,变形应变分布和应变集中位置。

























 7369
7369











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








