说在开头:关于海森堡和泡利(3)
索末菲每周都要和学生们谈话,跟每个学生都保持了密切联系,他推荐泡利和海森堡去哥廷根大学找玻恩学习,玻恩很赏识这两个年轻人。玻恩也有一个研讨班,搞了一班优秀的学生在深造,研讨班的气氛相当自由开放:愚蠢的问题不仅被允许,而且很受欢迎。大家无拘无束,热热闹闹的。下课后,海森堡站起来一回头看见希尔伯特大师就坐在教室后面,原来他跑到这个班上听课来了。他在物理学方面的功底也深不可测,当年就听了爱因斯坦关于广义相对论的报告,就抢在爱因斯坦之前把广义相对论方程式给推了出来,因为广义相对论基于黎曼几何,这对于他来说简直就是小菜一碟,希尔伯特当年说了一句意味深长的话:哥廷根的每个人都比爱因斯坦更懂黎曼几何,但是提出广义相对论的只能是爱因斯坦。所以希尔伯特经常听物理系的孩子们讨论,但越听眉头皱的越深:看来物理学对于物理学家来说,实在是太困难了点啊。
但后来有一个后生小子在英国大放厥词,物理学家根本不需要学那么多数学;如果有需要,自己就能发明数学工具;他的意思就是说还是物理学家更厉害,这小伙子叫狄拉克。到了20世纪20年代中期开始,量子物理就进入了一个男孩物理学的时代,因为提出创新理论的人都是20岁出头的毛头小伙子,这个狄拉克正是其中之一。
哥廷根大学的学术氛围非常浓厚,每年都会邀请著名的科学家来哥廷根做讲座:庞加莱,洛伦兹,索末菲,普朗克都来过。1922年来的正是玻尔,大家一听是玻尔这小子要来,德国物理学界一通忙碌,玻恩、普朗克、索末菲等领着一百多号人全来了,玻尔做了7场演讲,全都是关于原子模型和光谱线的。泡利和海森堡显然是不能缺席的,玻尔的演讲他们都听了。有这么好的机会,泡利岂能放过玻尔,当然是火力全开,海森堡也不甘示弱,一大堆问题炮轰过去。玻尔当时就觉得这俩娃前途不可限量啊,还跟他俩一起去爬山。玻尔说,我刚得了洛克菲勒基金会的一笔赞助;然后对着海森堡和泡利勾勾手指继续说,你们要是想来哥本哈根,我可以提供经费哦。后来,海森堡和泡利就经常去哥本哈根跟玻尔一起工作了。
转眼来到了1923年,海森堡要博士毕业了,他回到了慕尼黑大学,一大堆教授来答辩,海森堡的论文是《关于流体流动的稳定和湍流》,答辩委员会主席是维恩,老师索末菲也在。维恩问完了有关论文内容的问题,顺嘴问了一句有关光学仪器分辨率的问题,海森堡居然答不上来。维恩觉得,这么简单的问题你怎么能不知道呢?于是又问了几个其它关于光学仪器的问题,结果海森堡一问三不知。于是维恩当场便给海森堡打了不及格,索末菲打了满分,结果平均下来海森堡刚好及格过关。海森堡心里不服气,当天就买了火车票去了哥廷根大学,玻恩好好安慰了他,说你要是在慕尼黑待不下去了,就来我们哥廷根吧。
海森堡和泡利都是从恩师索末菲那里学到了原子模型的相关理论,都了解玻尔-索末菲理论是如何计算光谱的。海森堡和泡利来到哥廷根大学后,接受了非常严谨的数学观点,强调数学论证:那些你没有亲眼看到的东西,不能想当然地认为它存在!他们还跑去哥本哈根工作了一段时间,也跟玻尔深入地交流了。他们也努力想把索末菲的理论进一步修补完善,但发现这样做根本就解决不了问题。(参考自:吴京平-无中生有的世界)
三,MOS管原理
1, MOS管电容模型原理
MOS管的核心是:金属-氧化物-半导体电容;G极导电金属(多晶硅)与衬底(半导体)之间有一层氧化物绝缘层,这个结构很熟悉,两个导体中间夹着一层绝缘材料,这就是一个妥妥的平板电容。该电容对于MOS管来说起着非常重要的作用,是区别与BJT,提升性能的关键。
接下来,我们分别对金属-氧化物-半导体电容外加不同电压,来看MOS管的变化:
1. 如下图为P型衬底MOS电容,MOS结构的电容接近于平行板电容器:G极(栅极)与B(衬底)之间有一层绝缘材料(氧化物),加上负偏电压后G极出现负电荷,衬底则出现正电荷,电场穿入半导体,作为多子的“空穴”就会被推向氧化物-半导体的表面;单位面积电容C= ε/d,其中ε为介电常数,d为两板间距。
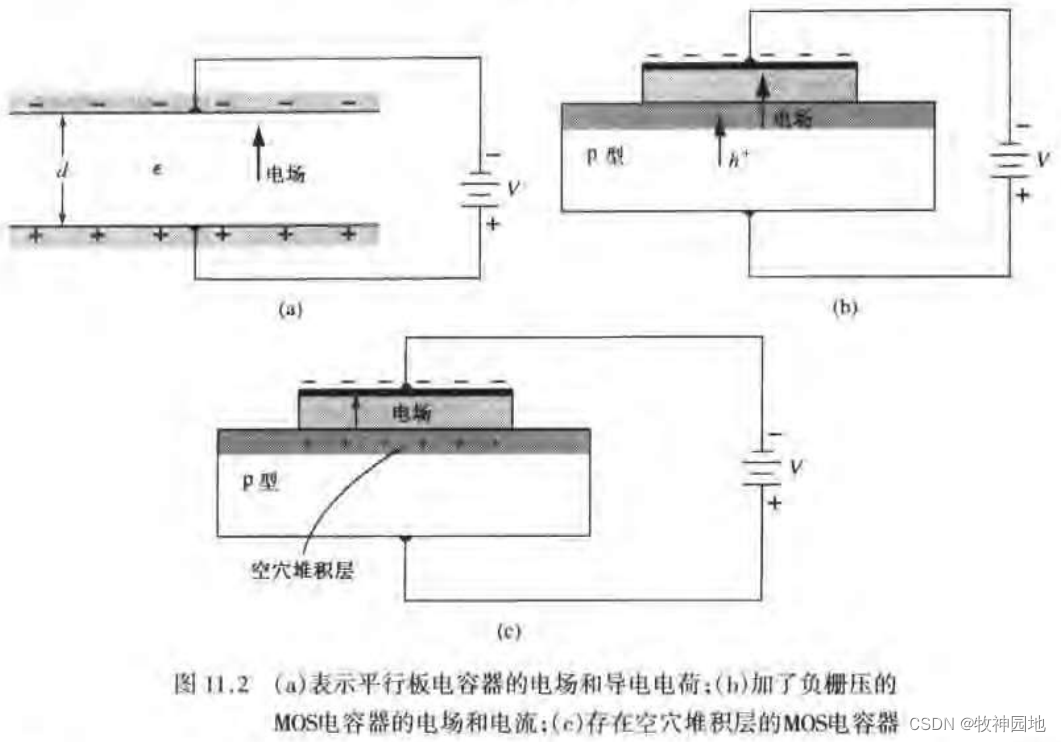
2. 如下图在G极与衬底B之间加正偏电压:此时正电荷出现在金属板上,随之产生的电场方向与前面讨论的相反,这种情况下“空穴”会被退离氧化物-半导体界面,由于固定不动被离化了的受主原子的存在,一个带负电的空间电荷区(没有“自由电子”和“空穴”)就形成了,该空间电荷区负电荷与G极上的正电荷相互对应。
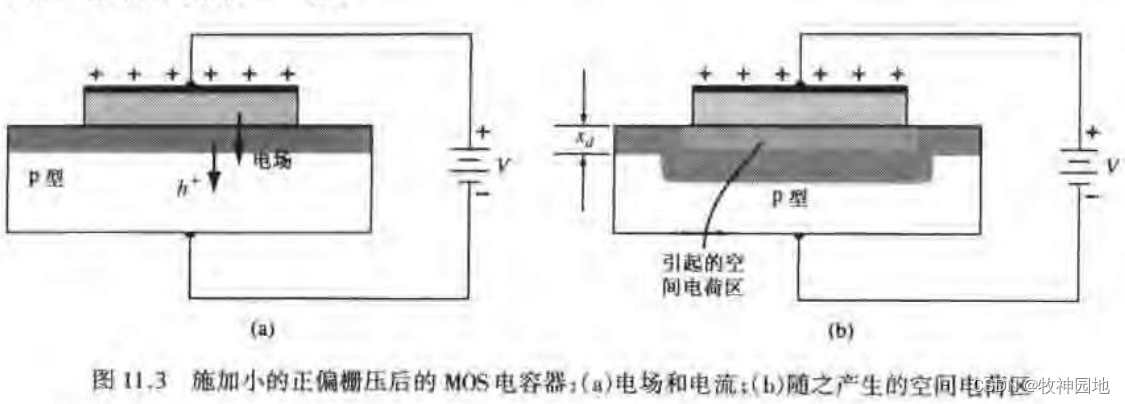
3. 如下图所示为施加不同极性电压时的MOS电容能带图,其中,Efi:本征费米能级;Ef:费米能级;
1, 在零偏电压(a)时:半导体能带图是平的,意味着半导体中没有净电荷存在(平带);
2, 在栅极加负偏电压(b)时:与P型半导体内部相比,氧化物-半导体界面处的价带更加靠近费米能级,表明界面处有“空穴”堆积;
3, 在栅极加正偏电压(c)时:其导带和价带边缘如图所示,空间电荷区与PN结类似,导带和本征费米能级均向费米能级靠近,产生的空间电荷区宽度为Xd;
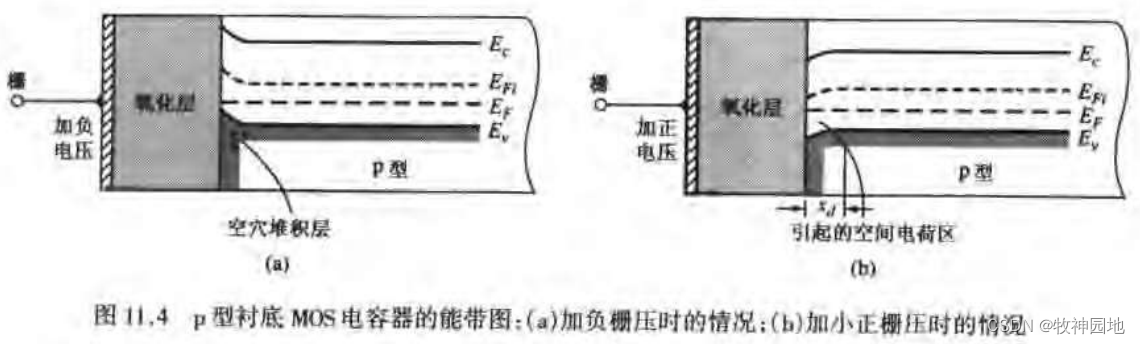
4. 我们继续对MOS电容器施加更大的正偏电压(更大的电场):MOS电容中更多的负电荷表明了更大的空间电荷区以及更弯曲的能带;如下图所示,氧化物-半导体表面的本征费米能级低于费米能级,导带比价带更靠近费米能级,此时从费米能级的角度可以看成N型半导体;表明通过施加足够大的正偏栅电压,半导体表面已经从P型转化成了N型半导体,从而产生了氧化物-半导体界面处的电子反型层。同理,N型衬底同样可通过能带理论推理得到“空穴”反型层。
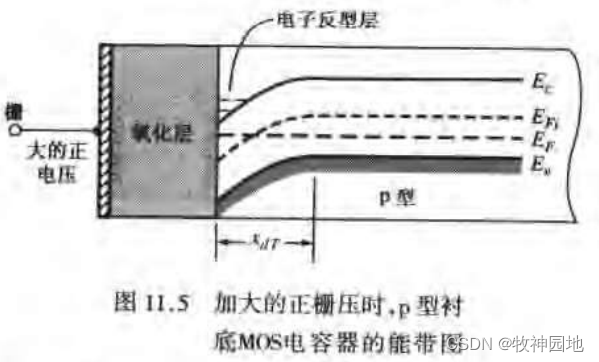
通过对MOS电容的能带理论分析,我们知道在G极和S极之间加不同的电压,衬底半导体的不同状态:VGS<0时,靠近G极的衬底产生空穴;VGS>0且比较小时,靠近G极的衬底产生一个空间电荷区(耗尽层,无“自由电子”);当VGS>0且较大时,靠近G极的衬底产生电子反型层(存在“自由电子”),此时MOS管导通。那VGS具体加多大的正偏电压,才能使MOS管导通呢?这个电压值,称之为MOS管的阈值电压。
2, MOS管阈值电压
阈值电压,从对MOS管应用的直观理解是:MOS管临界导通状态所需加在栅极(G极)与源极(S极)上的电压。我们通过对上一节的分析,知道MOS管与BJT不同,MOS管需要在栅极(G极)和源极(S极)加上大于某个偏置电压,氧化物-半导体界面才能有“自由电子”;那这个偏置电压点是多少呢?
对于能带理论来说,MOS管的阈值电压就是:达到阈值反型点时所需要的栅压。对于P型衬底来说与阈值反型点是:当表面势Φs = 2*Φfp时的器件状态,如下图所示,该状态下氧化物-半导体界面的“自由电子”浓度等于“空穴”浓度,如果大于该阈值电压,导带就会向费米能级轻微弯曲;同时表面“自由电子”的浓度是表面电势的指数函数(以10的幂次方增加);此时空间电荷的宽度(Xd)的改变却是微小的(再增加VGS电压,氧化物-半导体界面处会增加“自由电子”电荷密度,而不是增加空间电荷区的宽度)。
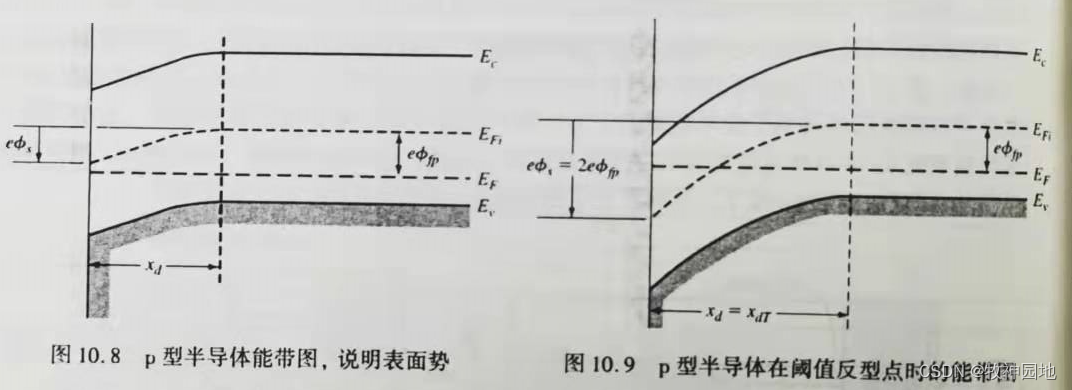
如下图所示为P型衬底MOS管G、S极加正偏电压,使处于阈值反型点时的电荷分布情况:
1. 此时半导体中空间电荷宽度已经达到最大值;
2. 氧化层在氧化物-半导体界面相邻处存在正值的净固定电荷Qss(与制造工艺中SiO2的氧化过程相关),根据电荷守恒原则:QmT+Qss=QSD(MAX);这是耗尽层单位面积空间电荷的最大值;
3. 增加的栅压能够改变穿过栅极氧化层的电压,从而改变表面势Φs;对于给定的半导体、栅氧化层和金属的材料,阈值电压是半导体掺杂、栅氧化层电荷Qss和栅氧化层厚度的函数。

3, MOS管电容-电压特性
我们前面说了,MOS电容结构是MOSFET的核心,MOS管的大量信息可以从器件的电容-电压特性曲线中得到。我们从电容定义:C=dQ/dV出发来看MOS电容的三个工作状态:堆积,耗尽和反型。
1. 堆积模式:如下图所示为P型衬底MOS管,在栅极加负偏电压下MOS电容的能带图;在氧化层-半导体界面处产生了“空穴”堆积层;电压的变化(dV)将会导致堆积电荷(dQ)发生变化,此时电荷密度的变化发生在栅氧化层的边缘,类似平行板电容器,其电容就是栅氧化层电容;电容大小不变。

2. 耗尽模式:如下图所示,为栅极加小的正偏电压下,MOS电容的能带图;此时氧化层-半导体相邻处产生了空间电荷区,氧化层电容与耗尽层电容是串联的,电压的增加将改变空间电荷区宽度和电荷密度的改变;经过公式计算,总电容C(耗尽层)随着空间电荷宽度的增加而减少;阈值反型点是当达到最大耗尽层宽度且反型层电荷密度为0时的情况,此时将得到最小电容:Cmin。

3. 反型模式:如下图所示为栅极加大的正偏电压下,MOS电容的能带图;此时MOS电容电压改变将导致和反型层电荷密度发生变化,而空间电荷宽度不变;如果反型层电荷能跟的上电容电压的变化,此时总电容就是栅氧化层电容(同堆积模式)。
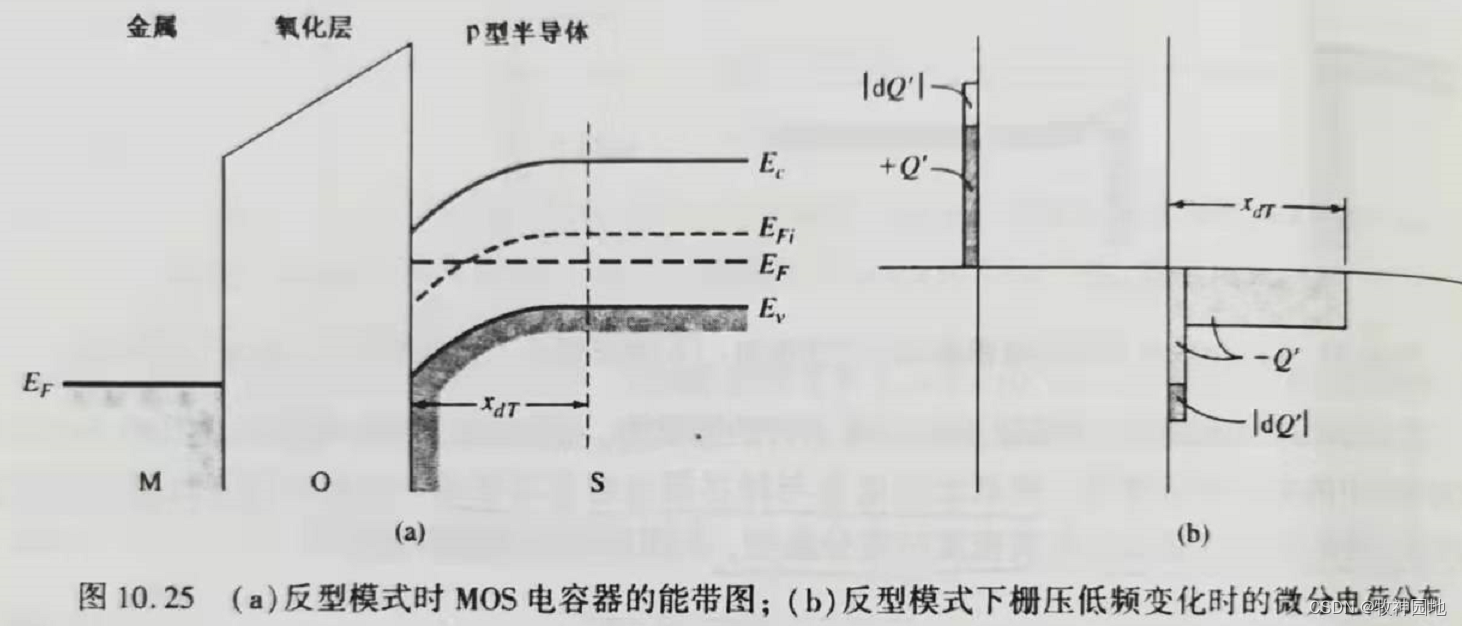
4. 我们将整个过程连贯起来,下图为理想电容和栅压的函数曲线,即P型衬底MOS电容的电容-电压特性;其中弱反型区是:栅压仅改变空间电荷区密度和当栅压仅改变反型层电荷时的过渡区;

我们可以看到MOS管在VGS加反压以及打开MOS管后继续增加的正偏电压,这两种情况下电容值是比较大的,其值等于MOS管G极与衬底平板电容的容值;但是MOS管打开过程的寄生电容容值是较小的。
对于高频信号来说,由于反型层的“自由电子”并不能瞬间增加或减少(反型层“自由电子”来源于P型衬底的少子扩散以及空间电荷区热运动产生的电子-空穴对),在高频时反型层“自由电子”并不会响应电容电压的微小改变,只有G极和空间电荷区处的电荷发生变化,所以MOS电容的容值大小就是Cmin。
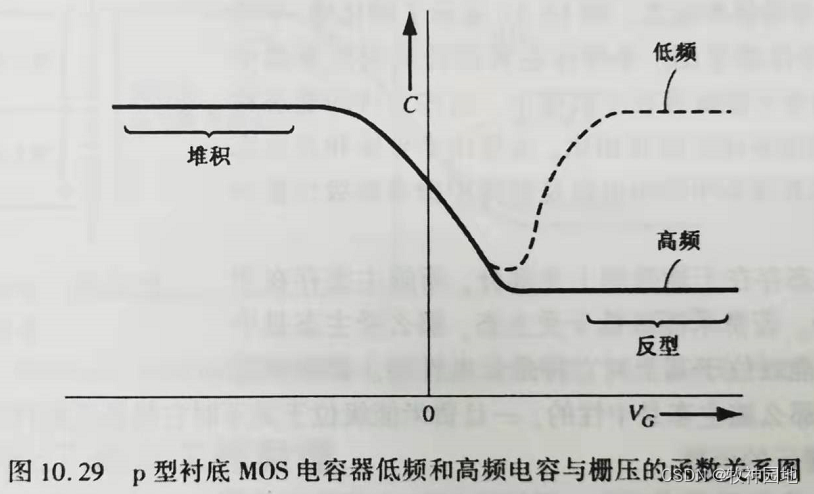
4, MOS管基本工作原理
我们通过前几节对MOS管电容的分析,理解了MOS管的简单工作过程:当Vgs>VT(阈值电压,Vgs(th))时氧化物-半导体界面会产生电子反型层,此时如果在漏极(D极)和源极(S极)之间加一个较小漏电压,反型层中的“自由电子”将从源端流向漏端,理想情况下并没有电流从氧化层向栅极流过。当然电流也可以是S->D的方向,一般我们习惯于打开NMOS管后电流导通方向是D->S,而S->D方向无需打开MOS管即可导通。
反型层电荷数量是栅压Vgs的指数函数(10的幂次),因此MOS管的工作机理为栅极电压对沟道电导的调制作用;而沟道电导决定了漏电流的大小。
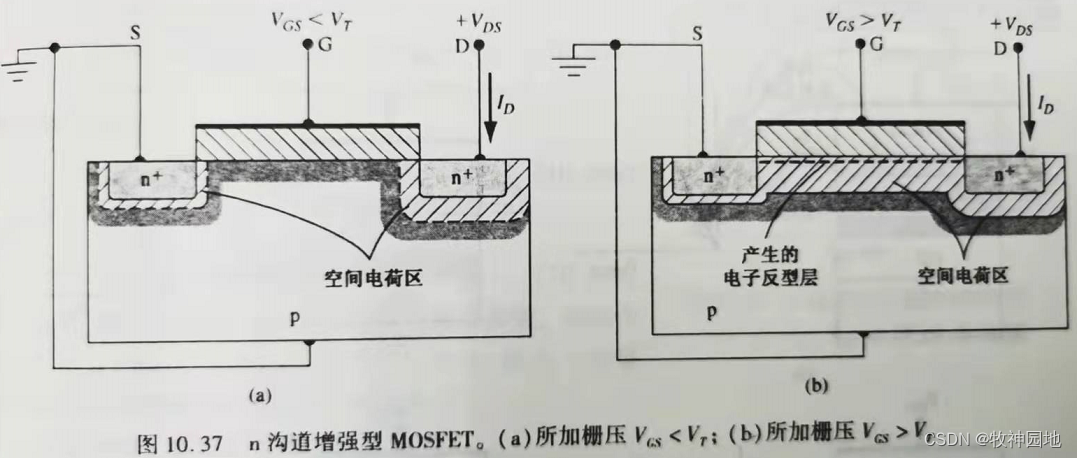
接下来,我们分析下Vgs>VT条件下,随着VDS电压的不断增加,ID-VDS特性曲线以及反型层电荷密度的变化,来深入理解MOS管的工作原理:
1. 当Vgs>VT且VDS较小时,如下图(a)所示;图中的反型沟道层的厚度表明了其相对电荷密度,此时相对电荷密度在沟道长度方向上为常数(固定值),其ID-VDS特性曲线为ID随VDS线性增加,其MOS管导通电阻为一固定值;
2. 当VDS继续增大,如下图(b)所示;由于漏极电压VD增大,VDB电压增加,导致衬底空间电荷区增加;又由于漏端附近的氧化层的压降减小(VGD减小),所以沟道反型电荷密度减小,从而漏端沟道电导减小,ID-VDS特性曲线斜率减小;
3. 当VDS增大到漏端的氧化层压降等于VT(阈值电压)时,如下图(c)所示;根据之前章节分析此时漏极处的反型层电荷密度为0,漏极电导为0,这意味着ID-VDS特性曲线斜率为0;此处的条件是: VDS(sat) = VGS-VT,这个点也称为预夹断点。那么大家肯定会产生一个疑问,这里没有“自由电子”了,那么ID=0么?这显然跟实际应用的经验不符,也跟ID-VDS特性曲线不符,这里只是ID不在增加。那既然“自由电子”已经被夹断,那ID电流从哪里来?
1, 首先,我们看到VS一直都是GND,那么在VGS不变的情况下,S端的沟道反型电荷密度就不会变,而且只要VDS之间有电场,“自由电子”就会向D端移动;说明“自由电子”从S端发出来是没有变化的;
2, 其次,我们再看D端,VDS增加即VD相对GND的电压增大,当VD=VDS(sat)时,氧化层压降等于VT不足以吸引到“自由电子”形成反型层,所以D端附近是一个空间电荷区;
3, 我们再来回顾下NPN三极管的B-C结:当B-C结反偏时(B-E结正偏),此时B区大量的少子-“自由电子”跨越B-C结到C区(反偏时,是少子的运动);所以此时MOS管D端与反型层的情况与三极管B-C结反偏一样:“自由电子”从S端发出,其浓度按梯度递减,到达D端的PN结时浓度为0,然后被空间电荷区电场“瞬时”推到D端;
4, 所以这些“消失”的、被“夹断”的“自由电子”去哪了?我猜是被漏极提前“拉”走了吧。
4. 当VDS >VDS(sat) 时,沟道中的反型电荷为0的点移向S端,如下图(d)所示;随着D端电压的继续增加,其空间电荷区的范围增大,所以反型电荷为0的点也不断被向左推,但此时漏电流不会再增加(ID是常数),MOS管进入饱和区。
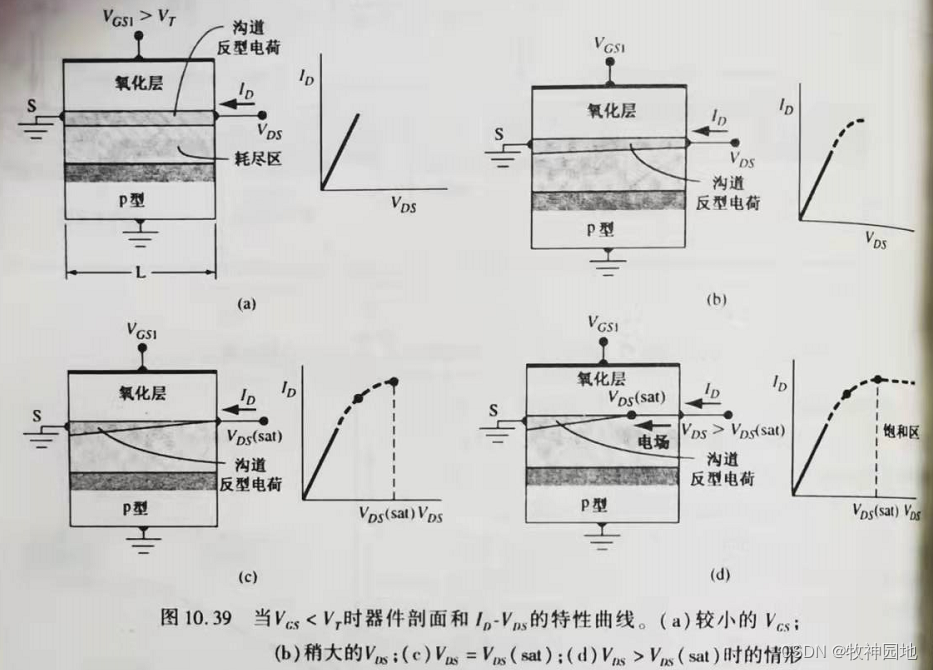
当VGS改变时,ID-VDS特性曲线也将有所变化,我们看到若VGS的增大,那么ID-VDS特性曲线的斜率也增大;如下图所示为N沟道增强型MOSFET的曲线簇图。
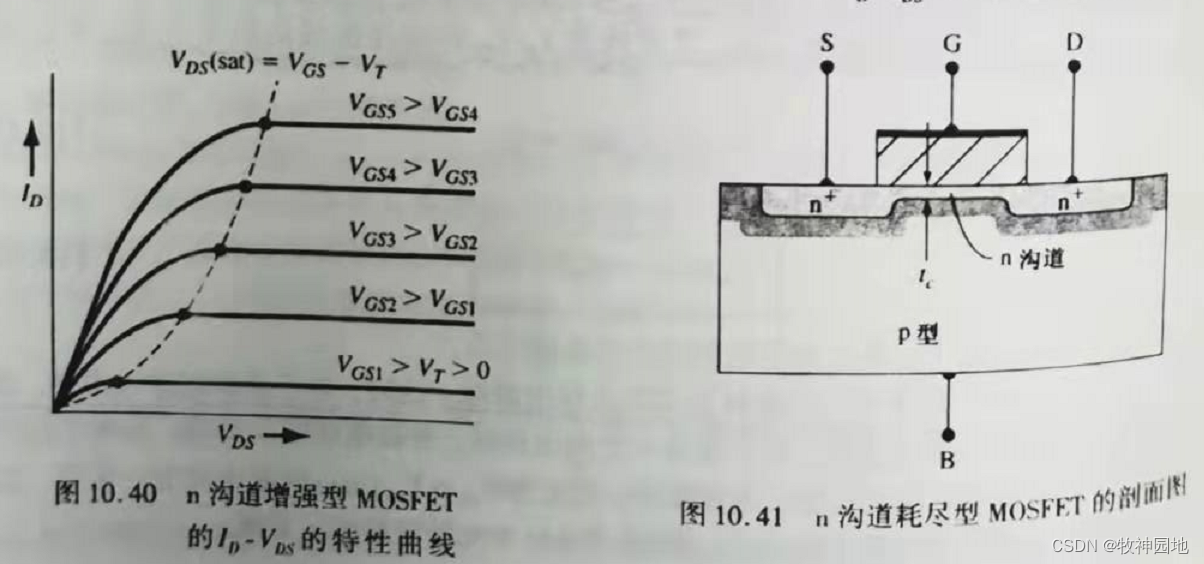
写在最后
MOS管与三极管有很大的不同,首先MOS管是单极性器件——只有多数载流子参与导电,其电流由漂移运动而非扩散运动产生,所以放大区导电特性更接近于金属材料,可以看成有固定阻抗;其次,MOS管通过电压而非电流控制的开关,控制电路设计更简单;最后,MOS管无PN结扩散电容,相对寄生电容更小,开关速度更快。所有这些特点都让它成为一个更理想的数字开关,更易于实现大规模集成电路。
上面说MOS管只有多数载流子参与导电,那么N沟道MOS和P沟道MOS哪个通流更大呢?
大家看过《PN结那些事》章节内容,就知道“自由电子”的迁移率要远大于“空穴”,所以相同半导体材料的NMOS电流要远大于PMOS;如果相同半导体材料的NMOS和PMOS器件要实现同样通流能力,那么PMOS的成本和体积应该会更大;同理对NPN和PNP三极管也会有一些影响,大家可以思考下。
在数字电路硬件设计中,MOS管的使用比三极管更加广范一些,开关电源,电源/逻辑开关,缓启动电路等等都用MOS管而非三极管来实现。
本章部分相关内容和图片参考自:唐纳德.A.尼曼-《半导体物理与器件》。下一章《MOS管特性和应用》。








 文章讲述了海森堡和泡利两位物理学家的学习经历,他们在哥廷根大学和哥本哈根的研究对量子物理发展作出贡献。同时,介绍了MOS管的核心——金属-氧化物-半导体电容模型,包括电容原理、能带理论、阈值电压概念以及电容-电压特性,展示了MOS管在半导体物理中的重要角色。
文章讲述了海森堡和泡利两位物理学家的学习经历,他们在哥廷根大学和哥本哈根的研究对量子物理发展作出贡献。同时,介绍了MOS管的核心——金属-氧化物-半导体电容模型,包括电容原理、能带理论、阈值电压概念以及电容-电压特性,展示了MOS管在半导体物理中的重要角色。
















 1695
1695

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








