
这篇文章的标题是《Characterization of Single Defects in Ultrascaled MoS2 Field-Effect Transistors》,作者是Bernhard Stampfer等人,发表在《ACS Nano》期刊上。文章主要研究了在超小尺寸的二硫化钼(MoS2)场效应晶体管(FET)中单个缺陷的特性。
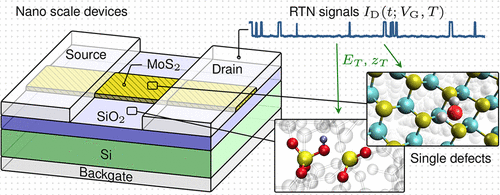
以下是对该研究内容的详细阐述:
摘要 (ABSTRACT)
- 研究背景: 二硫化钼(MoS2)作为一种半导体通道材料,因其与其他二维材料相比较大的能隙而受到关注。然而,这些器件的性能和可靠性受到缺陷的严重影响,这些缺陷作为电荷载流子的陷阱,导致迁移率严重降低、迟滞现象和长期漂移。
- 研究目的: 为了克服由于大量缺陷浓度导致的只能测量平均响应的局限性,本文通过在超小尺寸晶体管中进行测量来表征单个缺陷。
- 研究方法: 通过在不同栅压和温度下对MoS2器件上的单个缺陷进行电学表征,使用隐藏马尔可夫模型进行统计分析,提取了多个缺陷的电荷捕获和发射时间。
- 研究结果: 通过比较实验数据和理论模型的预测,提供了区分氧化物陷阱和吸附物的简单规则,并给出了估计缺陷垂直和能量位置的表达式。
引言 (INTRODUCTION)
- MoS2的重要性: MoS2是一种有前途的过渡金属二硫化物半导体,适用于超越CMOS的电子器件应用。
- 性能限制: 器件性能的主要限制之一是由于缺陷导致的电荷捕获,这些缺陷可以与通道交换电荷,从而严重影响器件的性能和可靠性。
结果与讨论 (RESULTS AND DISCUSSION)
- 器件制备和测量: 制备了约30个超小尺寸的MoS2 Schottky势垒(SB)-FETs,并对其进行了详细的电学特性测量。
- 随机电报噪声 (RTN): 观察到的随机电报噪声是由于单个缺陷的充电和放电引起的,这在小尺寸器件中尤为明显。
- 时间常数提取: 使用隐藏马尔可夫模型和Baum-Welch算法从测量的RTN迹线中提取时间常数。
- 理论考虑: 通过数值器件模拟和提取的时间常数,使用非辐射多声子(NMP)缺陷模型提取了缺陷参数集。
结论 (CONCLUSIONS)
- 研究发现: 研究了纳米尺度MoS2器件中的单个缺陷,并展示了单个缺陷对漏电流的影响。
- 模型比较: 比较了SRH和NMP陷阱模型,发现SRH模型无法解释测量数据的温度和偏置依赖性,而NMP模型更为适用。
- 缺陷属性: 通过详细的TCAD模拟提取了测量缺陷的物理参数集,并根据获得的缺陷参数对其物理性质进行了讨论。
方法 (METHODS)
- 制备: 描述了MoS2片层的转移、电子束光刻、干法蚀刻和镍电极的沉积等制备过程。
- 测量: 介绍了在室温下进行的基本电学特性测量和在真空中的RTN测量。
- 参数提取: 介绍了使用HMMs和Baum-Welch算法从记录的数据中提取捕获和发射时间的方法。
- 模拟: 描述了使用NMP陷阱模型和校准的器件结构来模拟单个陷阱的捕获和发射时间的过程。
相关内容 (ASSOCIATED CONTENT)
- 提供了支持信息,包括不同2D技术的单缺陷极限、器件的扫描电子显微镜图像、捕获和发射时间与陷阱位置的依赖性、器件建模、MoS2表面的吸附物、缺陷位置和能量的估计以及单个缺陷的详细结果。

图 1
- 图 1a: 展示了器件的示意图,包括源、漏和栅极的布局,以及MoS2层和SiO2绝缘层的结构。
- 图 1b: 显示了ID-VG(漏电流-栅压)特性曲线,其中包括了拟合的亚阈值斜率。这些曲线表明器件的行为符合预期的nMOS晶体管特性。
- 图 1c: 展示了ID-VD(漏电流-漏极电压)输出特性曲线,记录了在RTN测量期间使用的低漏极偏压下的输出特性。这些曲线显示了器件的小信号输出特性,表现出较为线性的行为。
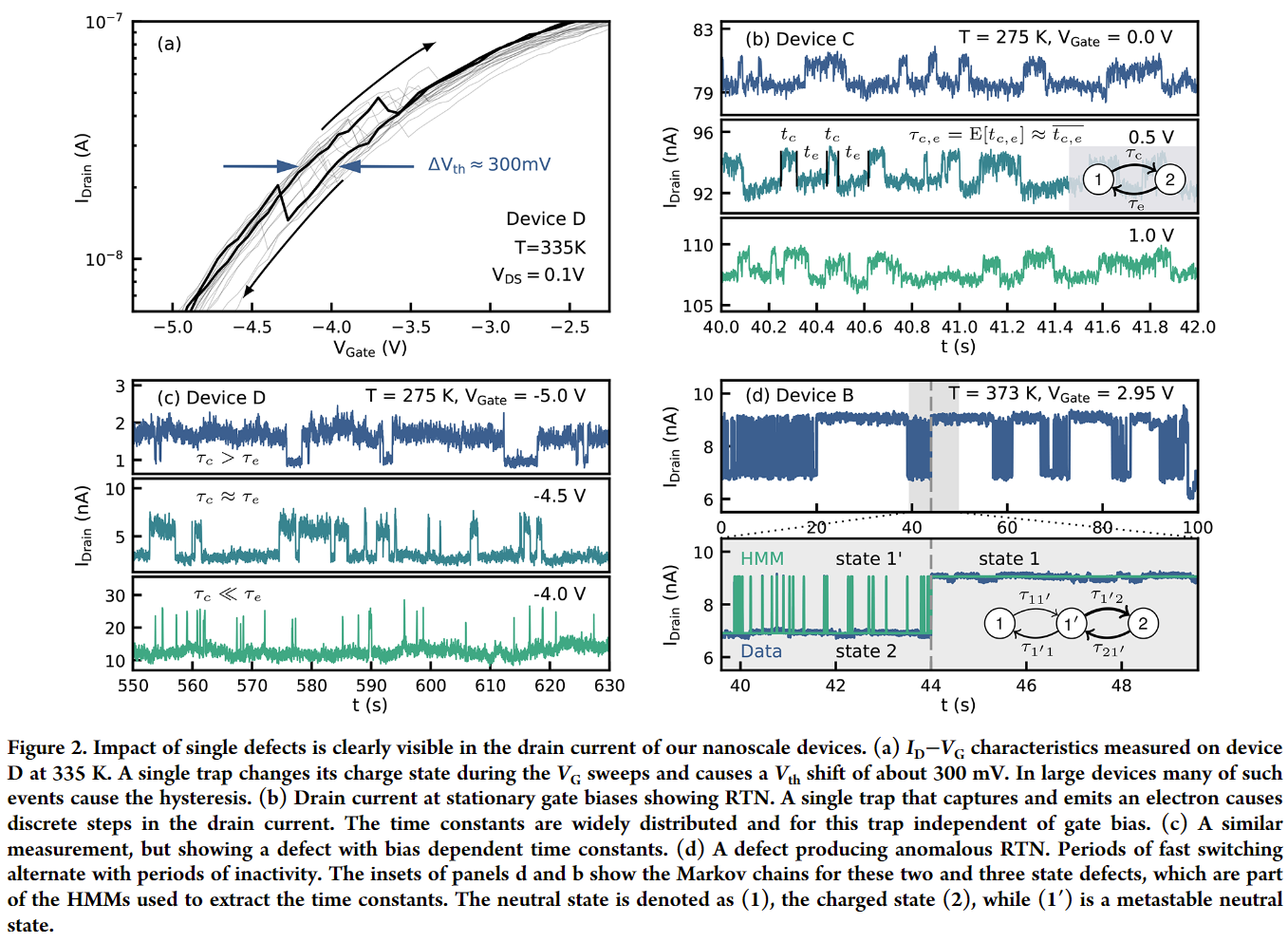
图 2
- 图 2a: 展示了在335 K温度下对器件D进行的ID-VG特性测量,其中一个单一的陷阱在VG扫描过程中改变其电荷状态,导致大约300 mV的Vth(阈值电压)偏移。
- 图 2b: 展示了在固定栅压下漏电流的RTN行为,其中一个单一的陷阱捕获和发射电子导致漏电流出现离散的步进变化。时间常数广泛分布,对于这个陷阱而言,与栅压无关。
- 图 2c: 类似于图2b,但展示了一个具有强烈栅压依赖性的缺陷。在-5V的栅压下,缺陷大部分时间处于未占据状态,而在-4V时,漏电流大部分时间处于低状态。
- 图 2d: 展示了一个产生异常RTN的缺陷,其中正常的RTN行为被随机的不活跃周期所打断。图中的插图展示了这些缺陷的马尔可夫链模型,这些模型是用于提取时间常数的HMMs的一部分。

图 3:
展示了在四个不同器件中发现的四个缺陷(标记为A至D)的提取捕获和发射时间。每个点对(对于陷阱B是四重)代表了在特定偏压和温度下测量的ID迹线。缺陷A和D显示出较大的栅压依赖性,而缺陷B和C则没有明显的栅压依赖性。缺陷B还有一个额外的亚稳态,具有较大的时间常数(aRTN)。

图 4
- 图 4a: 比较了Shockley-Read-Hall (SRH)和非辐射多声子(NMP)陷阱模型,展示了两种模型中电荷转移反应的能垒计算方式。
- 图 4b: 展示了在通道下方和上方不同温度下,缺陷的捕获和发射时间与SRH和NMP缺陷模型的关系。SRH模型无法解释实验数据中观察到的电压和温度依赖性。

图 5: 展示了在两个偏压点下的一个器件的模拟能带图,标记了四个缺陷的提取位置。偏压依赖性陷阱A和D位于MoS2层下方,而偏压独立性陷阱B和C位于其上方。灰色条标记了众所周知的SiO2缺陷带。









 研究人员通过电学表征和统计分析揭示了超小尺寸MoS2FET中单个缺陷的特性,提出区分氧化物陷阱和吸附物的规则,并验证了非辐射多声子模型在描述缺陷行为上的优势。
研究人员通过电学表征和统计分析揭示了超小尺寸MoS2FET中单个缺陷的特性,提出区分氧化物陷阱和吸附物的规则,并验证了非辐射多声子模型在描述缺陷行为上的优势。















 883
883











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








