文章目录
-
- 概要
- 是否执行
- 失效机理
- 和THB关系
- 怎么执行(及硬件制备)
概要
Bhast:高温高湿偏压实验,采用严格的温度,湿度和偏压条件,加速湿气穿过塑封料金属导体间的界面,从而评估在潮湿环境中非气密性封装芯片的可靠性

1)最小化功耗【Note:单纯上电 不下载位流 不跑pattern】
2)尽可能选择交替引脚偏置
3)尽可能分布芯片金属化的电位差
4)在可承受的工作范围内最大化电压
是否执行
①芯片设计公司要求
消规:一些芯片设计公司没有明确定义,他们的产品质量手册也都是可选,这个其实大部分看客户的需求; 重点大客户会有要求,因为他们董可靠性及用的产品多了,所以会有要求
工规:其实场景相比于消费恶劣,一般会安排
车规:AECQ100明确定义,毋庸置疑要做!
②看友商来决定:
ASIC芯片看大厂如展锐 海思,那就做吧 做起来全面客户才认,花点钱
FPGA芯片:看Xilinx和国内AL,都是做的,那就做吧!!
③标准:
JEDEC47:对于非气密性封装 如FCBGA类,建议做
AECQ100:车规就做吧!!
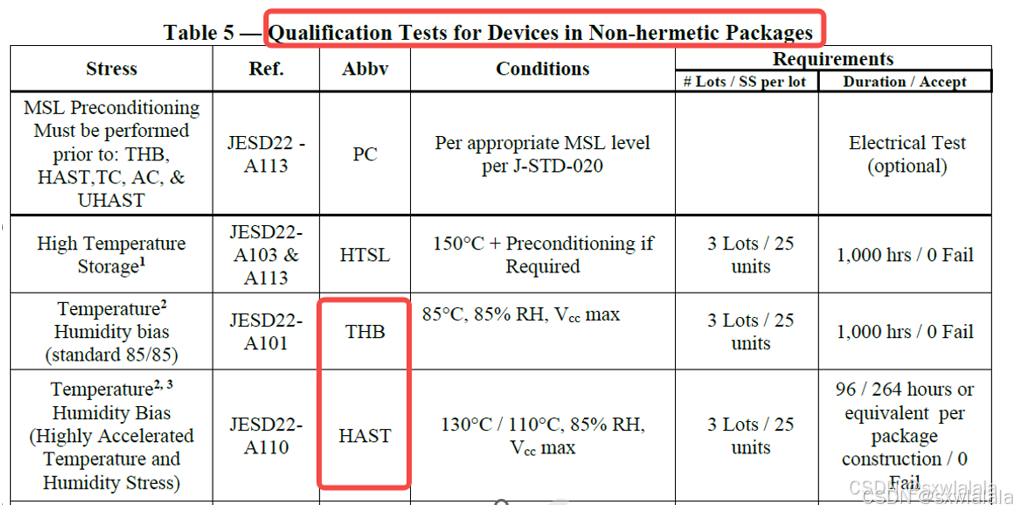
④:封装形式
FCBGA FCCSP WL之类就做吧!
WLCSP就没啥必要了,具体看失效机理,得有湿气呀 内部得有反应呀,这个风险低可以不做
但要做当然也没问题
失效机理
高中知识(还是说初中 忘了):就湿气进入,有电势差发生电化学腐蚀
对于湿气:封装材料underfil molding都是有一定吸湿性的!!
和THB关系
常规大家都说双85 那就是THB 就是温度湿度都是85
两者可以说基本等效,条件不同 但机理 加速因子都一样的,就Bhast条件更严苛
标准里面也提到两者选择一种即可,目前封装材料Tg都满足,风险小
Bhast的情况恶劣,更能说明封装可靠性问题;目前芯片业内都执行Bhast
没啥特殊情况 无脑选择Bhast就行,客户认可 及 做的时间还短 一般来说成熟封装没啥问题的!!

怎么执行(及硬件制备)
环境:机台提供所需湿度 温度的环境
PCB:将芯片pin脚引出提供偏置电压
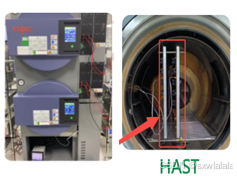
数量:3*25 3个lot
①首先需要进行precon
②对于BHast,做板子,power端接Vmax,VSS接地
IO管脚交替接高低电平,常规接4.7K电阻限流
差分信号业内接法如下图
Note:其实要看的是bump,所以严格来说是要对照bumplist来走而不是pinlist来走,要让内部bump有电势差!
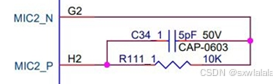
③硬件完成,芯片放入后在上图所示环境里面进行测试,需要看测试的时候电流多少,要让芯片处于最小工号,最一开始摘要里面明确提到【目的是 功耗大 湿气进入不了 实验目的无法达到】
④实验条件不放心的话直接选110℃ 85湿度即可























 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








