知识星球的学员问:晶圆的激光划片中,一般听的比较多的是激光隐切,有没有激光全切呢?这两种方式有什么差别?各有哪些应用场景?
什么是激光全切与隐切?
激光全切(下图),Laser full cut,也可叫Ablation,短脉冲激光照射晶圆表面,激光将材料从固态直接转变为气态,从而去除材料。
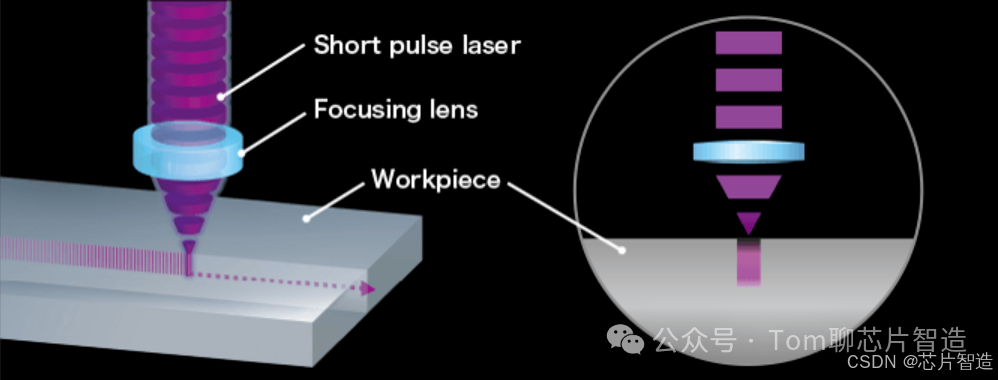
激光隐切(下图),Stealth Dicing,将激光聚焦在晶圆内部,在不破坏表面形貌的情况下,在晶圆内部形成一个改质层,改质层中的材质由于受到激光的照射,性质发生了变化。之后会在外力作用下,沿着SD layer将晶圆分割为一粒粒的芯片。

激光全切与隐切的各自特点?
激光全切优点:切割速度快;适用于各种厚度的晶圆;无需后续机械分割
激光全切缺点:晶圆表面会被损伤;颗粒污染严重;热应力与机械应力大
激光隐切优点:表面无损伤;切割应力小,适合较薄或脆的材质。
激光隐切缺点:切割速度慢;后续还需扩膜工艺使晶圆裂解。
激光隐切与全切的应用场景?
1. 激光全切
常用于以下材料:硅,锗,金属衬底,碳化硅(SiC),砷化镓(GaAs),DAF 膜
芯片产品:太阳能电池,LED,功率器件,射频器件,NAND Flash
2,激光隐切
常用于以下材料:硅,蓝宝石,碳化硅
芯片产品:MEMS,RFID,LED,功率器件























 2298
2298

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








