目录
一、加载和运行Athena的标准示例
Main Control→Examples
“Section”菜单中列出了deckbuild示例组,并根据示例演示的模拟器或模拟主题进行分组。Sub-section菜单中列出了单独的示例输入文件。要运行示例,在“Section”菜单中选择其中一个例子(例如,ATHENA_IMPLANT)。这将打开一个输入文件名的列表。对示例的简短描述将出现在示例窗口中。
使用Sub-section菜单或双击输入文件名选择其中一个输入文件,将会显示所选输入文件的说明。
按“Load Example”按钮将选定的输入文件加载到deckbuild窗口(窗口的底部面板)。输入文件以及与输入文件相关联的其他文件(结构文件、TonyPlot的设置文件和maskview的布局文件)将被复制到当前目录中。
要访问PC中的示例,请选择“Help→Examples”。
二、访问Athena
每个Athena运行在deckbuild的内部中应该从以下命令行开始:
#运行Athena
go athena
#运行具体版本的Athena(比如:5.8.0.R版本)
go athena simflags="-V 5.8.0.R"
#设置在Athena并行运行中使用的处理器的数量
go athena simflags="-V 5.16.0.R -P 4"
##或
go athena simflags="-P 4"Athena被设计为一个过程仿真框架。该框架包括模拟器独立的操作和模拟器特定的功能,模拟不同的过程步骤(例如,implant, RIE, or photoresist exposure)。Athena的输入/输出和创建输入文件的以下基本操作:
开发一个良好的模拟网格
执行共形沉积(淀积)
执行几何蚀刻
结构操作
保存和加载结构信息
与设备模拟器接口
使用不同的交互工具
这些操作与所有单独的Athena过程模拟器相关。教程的三个部分:SSuprem4, Elite和 OPTOLITH 专门用于各个模拟器。
三、定义初始矩形网格
当deckbuild运行或者当前的模拟器被设置为Athena,打开Commands菜单,如图所示。然后,选择Mesh Define....,然后将出现Athena网格定义菜单。固定这个弹出窗口,因为它将经常被用于设计一个初始网格。右边的网格图可以通过点击右下角的ViewGrid显示。
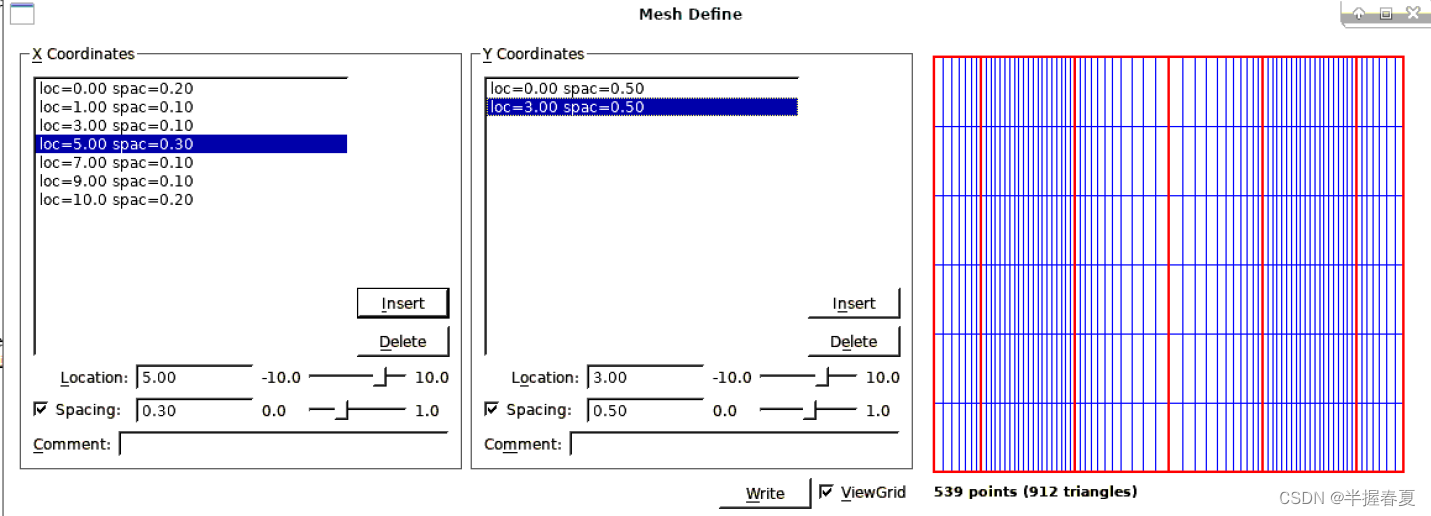
由上图可知,X方向的网格时非均匀的,Y方向的网格是均匀的。点击write自动输出以下代码(所有图形化设置的都需要点击write输出代码)。
loc(location)表示轴上的一点,spac(spacing)表示该点处的间距。
line x loc=0.00 spac=0.20
line x loc=1.00 spac=0.10
line x loc=3.00 spac=0.10
line x loc=5.00 spac=0.30
line x loc=7.00 spac=0.10
line x loc=9.00 spac=0.10
line x loc=10.0 spac=0.20
line y loc=0.00 spac=0.50
line y loc=3.00 spac=0.50注:1)Athena模拟的最大网格节点数是20,000个
2)确保在掩模边缘下指定了良好的二维轮廓分辨率
3)在关键位置(如PN结,反型层的位置)的网格要细密
四、定义初始衬底(init)
上面的line语句为Athena模拟结构设置矩形基础。下一步是初始化衬底。确定是衬底P\N型,掺杂浓度,面积,晶向等参数。ATHENA Command Menu→Mesh Initialize...

硅材料,晶向100,掺杂杂质为boron,掺杂浓度为1e18,二维仿真
init silicon c.boron=1.0e18 orientation=100 two.d五、离子注入(implant)
离子注入是将掺杂杂质引入半导体器件结构的主要方法。充分的模拟离子注入过程是非常重要的,因为现代技术采用了小的临界尺寸(CDs)和浅的掺杂轮廓、高剂量、倾斜的注入物和其他先进的方法。
ATHENA Command Menu→Process →Implant...

以下内容给出了应指定的最小参数集:
impurity表示注入如杂质名称(e.g., boron)
dose表示注入剂量,单位为ions/cm2,指数前值(如1.0)和Exp(如11)的注入剂量
energy表示注入能量,单位为KeV(如100KeV)
title表示倾斜角度(例如,7°)
rotation表示旋转角度(例如30°)
所有其他参数都可以使用其默认值。
除了晶体性参数外,上述声明中的所有参数都是自己设置的。晶体参数表明,对于所有的分析模型,将应用为单个硅晶体提取的范围统计数据(如果有)。如果选择了非晶硅,则将使用在预非晶硅中测量的范围参数(如果可用)。晶体参数对蒙特卡罗或BCA注入模型也有另一个意义。它调用了考虑到通道作用的晶体材料模型。请注意,后一种模型比非定形材料模型要慢得多(5 - 10倍)。晶体材料模型是BCA或蒙特卡罗模拟的默认模型。
可以指定离子光束的倾斜角度和旋转角度。正的倾斜角对应于来自左上角的离子束。指定旋转角度仅对非零倾斜角度有效。零旋转表示离子束矢量位于平行于二维模拟平面的平面上。90°旋转表示离子束矢量位于垂直于模拟平面的平面上。
选择连续旋转使服务器4旋转晶片,即以24个不同的旋转角度进行植入,以15°为增量。
六、沉积 / 淀积(deposit)
共形沉积可以用来生成多层结构。共形沉积是最简单的沉积模型,当沉积层的确切形状不是关键时,可以用于所有情况。当氧化过程中的掺杂再分配可以忽略不计时,共形沉积也可以用来代替平面或准平面半导体区域的氧化。
ATHENA Command Menu→Process→Deposit→Deposit...




从material菜单中可以选择需要淀积的材料,thickness表示淀积的厚度(1um=10000埃),沉积物层中的网格由grid参数控制。若要淀积掺杂的多晶硅层,在impurities中选择掺杂物和掺杂浓度。
七、扩散(diffusion)
热过程步骤的模拟是SSuprem4的一个重点。扩散和氧化模型的层次结构在“扩散模型”和“氧化模型”中被描述。本节演示如何设置扩散、氧化和硅化的不同参数和模型。只有当结构中至少存在一种耐火金属或硅化物层时,才会进行最后一种工艺。
扩散/氧化步骤的参数和模型可以从Athena扩散菜单中准备出来。ATHENA Command Menu→Process→diffusion...。Diffuse菜单有四个部分。最初只显示Time/Temperature和Ambient字段。只有在选中相应的复选框时,才会出现“Impurities”和“Models”字段。
扩散步长参数的最小集合如下:
(1)时间(例如,60分钟)
(2)温度(例如,1100°摄氏度)
(3)气体压力(默认为1个大气压)
如果选择“Ramped”项和“End Temperature”或“Temperature rate”,将模拟斜坡温度热步骤。默认情况下,温度速率是一个变量,但可以通过在Rate框中选择“Constant”来将其设置为特定的恒温速率。
快速热退火(RTA)
在工艺流程中使用快速热退火(RTA)的通常原因是为了退火消除基底中由先前的工艺步骤造成的损伤,通常是注入物,同时最大限度地减少掺杂剂的扩散。掺杂剂的激活也发生在这个过程中。由于声音器件的物理原因,这些退火通常温度高,持续时间低。
同样,精确模拟RTA的关键在于对基板损伤行为的精确模拟。间隙在增强掺杂剂扩散中的作用已经在第2.4节“在监督4中选择模型”中解释过,以熟悉间隙在过程模拟中的作用。
RTA通常使用高温和短时间的原因是,对于给定的高剂量注入物,如果选择退火时间,以便使固定的损伤百分比退火,退火温度越低,掺杂剂扩散就越多。上面的陈述需要一个解释,因为直觉上,相反的情况似乎更有可能。如果考虑到退火温度的两个极端,对正在发生的事情的描述性解释可以提供信息。对于最低退火温度,损伤退火速率几乎为零,因此在消除损伤所需的长时间内,掺杂剂的扩散速率提高了1000°C或更多。这导致了较高的总掺杂剂扩散。对于最高温度退火,大量的损伤去除发生在一秒内。在这种情况下,几乎没有损伤增强扩散或总扩散,并且消除损伤的退火时间非常短。在这两个极端之间的外推提供了中间温度退火发生的定性解释。
现在已经确定了两个重要的要点:
(1)由于声器件的物理原因,大多数RTA过程由高温、短时间退火组成。
(2)在典型的RTA温度下,损伤增强的扩散只会发生几秒钟。
对于RTA的精确模拟,第二点是最重要的,而且经常被错误地忽视。假设一个RTA包括一个10秒的斜坡到1000°C,然后是一个20秒的退火和10秒的冷却。从第二点开始,很明显,大部分的总掺杂剂扩散可能发生在RTA的上升阶段。因此,在模拟RTA过程时,总是能准确地模拟温度上升。在大多数情况下,斜坡下降是可以忽略的,因为所有的扩散都已经发生在一开始,那时硅仍然受损。
氧化(Oxidation)
模拟氧化的下拉菜单与“六、扩散(diffusion)”中描述的模拟惰性扩散的下拉菜单相同。本节讲述了有关从deckbuild中选择适当的下拉菜单的建议。
默认的氧化方法是“Compress”。在SSuprem4的例子中,有许多例子说明了对不同的过程和结构使用不同的模型。
在我们之前的例子中描述的“模拟扩散”61,如果下一步在含有3%HCL的干燥氧气中,温度恒定温度1000°C的环境,选择“Dry O2”框,并在“Ambient”部分中将HCL%设置为等于3。将出现以下输入文件片段:
DIFFUSE TIME=60 TEMP=1000 DRYO2 PRESS=1.00 HCL.PC=3

如果环境中是由一种以上的氧化剂组成的混合物,则总氧化速率将取决于环境中所有物质的综合效应。要指定环境混合物的含量,在“Ambient”部分中选择“Gas Flow”按钮,此时将显示其他“Athena Gas Flow Properties ”菜单(上图右侧部分)。
在环境中可能存在一种或几种杂质。要在“Athena Diffuse”菜单的“Impurity Concentration”部分设置环境设置。

diffuse语句中的还有菜单中未包含的其他几个参数,详情会在另一个文章介绍。
(1)IMPURITY, INTERSTITIAL和其他杂质和点缺陷声明,它们指定了这些物种的模型参数(例如,扩散系数或偏析)。
(2)OXIDE声明,它指定了不同的氧化模型的参数
(3)MATERIAL语句,它指定了所有材料的一些基本参数。
(4)SILICIDE声明,它指定了硅化系数。
表2-3显示了基本的扩散和氧化模型

八、刻蚀(etch)
要使用刻蚀工艺,ATHENA Command Menu→Process→Etch→Etch...

Geometrical刻蚀法是默认的方法。其他方法将在后续文章中讨论。从material菜单中选择需要刻蚀的材料。Geometrical type选择刻蚀类型(all、left、right、above、below、dry thickness(指定厚度的干式刻蚀)、any shape(任意形状))。
九、外延(epitaxy)
Athena/SSuprem4可以模拟高温硅的外延过程。外延过程被认为是沉积过程和扩散过程的结合。因此,可以模拟从高掺杂的埋地层自掺杂到轻掺杂的外延层等过程。然而,外延硅的扩散参数被认为与单晶硅是相同的。
使用外延层工艺,ATHENA Command Menu→Process→Epitaxy...
(1)Time/temperature部分以与扩散语句中相同的方式选择温度步长参数。
(2)Thickness/rate部分选择外延层的总厚度,或以微米/分钟为单位的沉积速率。在后一种情况下,总厚度将由速率和时间来决定。
(3)Grid Specification部分指定了生长的外延层内的垂直网格结构。所有网格参数与Athena的沉积菜单相同(见图2-12)。
(4)Impurity Concentrations部分以与扩散声明中相同的方式指定了生长的外延层。


后两组中的所有参数都是可选的。如果外延步骤的参数设置完全如图所示,则输入文件中将显示以下语句:
#外延层厚度设置为20um
epitaxy time=30 minutes temp=1000 thickness=20 c.boron=1e14






















 7740
7740











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








