1、写在前面的话
这个专题主要讲讲CMOS模拟集成学习中的一些事情,大多数内容涉及到一个芯片是如何设计和制作出来的,属于特别底层的东西,这些东西往往是核心技术,国内的软件行业发展已经特别领先了,但在底层方面,潜力十分的大,本身也是学这个的,就当复习了。这篇博客主要讲讲CMOS的工艺技术,涉及到了IC是如何制作出来的,实践中,如果懂这些,其实也就明白了来源,结合使用CPU的技能,这两样东西会越来越熟。
2、简述
现代CMOS工艺包括了200多道工序,不可能一道道的解释,这里只把这些工艺归为以下类别:
01 生产适当类型的衬底的晶圆制造工艺。
02 精确定位每个区域的光刻工艺。
03 向晶圆中添加材料的氧化、沉淀和离子的注入工艺。
04 从晶圆上去除材料的刻蚀工艺
备注:在集成电路中,工艺层的电阻率和厚度由其制作材料和工艺决定,在版图设计中是无法改变的,可以通过公式计算。
3、晶圆工艺
晶圆是用来制作衬底的,CMOS开始时的工艺所使用的晶圆必须是高质量制造的,是含有极少杂志的单晶硅体,并且必须加入一些适当的浓度杂质来满足电阻率的要求。
数据:Silicon Wafer
单晶生长柱状晶体:直径75~300mm,长度1m。
在晶体生长时参杂:~ 10的15次方/cm3
切割成硅晶圆片0.5~0.7 mm厚

制作:切克劳斯基法(Czochralski method)。
4、光刻工艺
光刻是把电路版图信息转移到晶圆上的第一步,处于制造的目的,分了很多层,比如:n阱层、有源区、多晶、接触孔、金属1等等。
概念:
01 掩模–和版图数据相对应,使光刻胶部分区域曝光。
02 光刻胶–在紫外光下会改变性能的有机聚合体。
正胶—暴露在紫外光下的区域将会去除。
负胶—未暴露在紫外光下的区域将会去除。
步骤:如下图所示(n阱为例)
01 精确控制电子束将版图图形“写”在透明玻璃的“掩模版”上。
02 在晶圆衬底上涂上一薄层光照后刻蚀特性会发生变化的“光刻胶”(涂光刻胶之前其实还要生长一层很薄的氧化层来保护晶圆表面)。
03 将掩模版放在晶圆上方,利用紫外线将图形投影到晶圆上,使得曝光区域的光刻胶“变硬”,不透光区域的光刻胶保持“松软”。
04 将晶圆衬底放到腐蚀剂中,去除“松软”的光刻胶,从而暴露出下方的硅表面。
05 这样就可以在暴露出其下方的硅表面区域制作n阱了,这一系列的流程称为一次光刻流程。
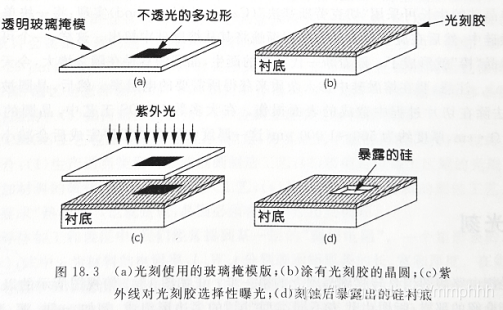
备注:
01 每一层光刻相关的流程都需要一块掩模版和三道工序,也即是:在晶圆上涂光刻胶、对准掩模版并进行曝光、刻蚀曝光后的光刻胶。
02 在一个生产中所用到的掩模版的数目严重影响了整体的造价,并最终影响了芯片的单价。因为一块掩模版价值数千美元,同时必要的精确度使光刻是一个缓慢而昂贵的作业。
03 实际上,CMOS技术最初的吸引力就是因为其相对较少的掩模版数目(7块左右),虽然现代的CMOS工艺掩模版数目约30块左右,但是,每块IC的价格依然不高,因为晶圆上每单位面积中晶体管的数目和晶圆的尺寸始终都在增加。
5、氧化工艺
在硅表面形成二氧化硅的工艺,这是利用硅的一个特性:可以在硅的表面生成非常均匀的氧化层,并且几乎不会在晶格中产生应力,使得制作的氧化层薄到几十埃(埃是0.1纳米)。
用途:
01 栅介质–层与层之间的隔离。
02 保护层–阻挡杂质对氧化层下材料的粘污。
03 互连线–在器件之间的区域,生成一种“场氧”的SiO2层,为后面工序制作互连线提供基础。
方式::
干法(薄氧100~1000 Å)
湿法(厚氧) 生长的温度:700~1100 ℃
备注:制作栅氧化层是一道非常重要的工序,因为氧化层的厚度tox直接决定了晶体管的电流驱动能力和可靠性(之后说到MOSFET器件特性的时候说),所以其精度必须控制在几个百分点之内。例如在晶圆上相差20cm的两个晶体管(晶圆大小一般12寸,就是30cm),它们的氧化层厚度差必须小于几个埃,这就要求整个晶圆的氧化层厚度要有极高的均匀性,并因此要求氧化层缓慢生长。此外,氧化层下面的硅表面的“清洁程度”也会影响电荷载流子的迁移率,从而影响晶体管的电流驱动能力、跨导和噪声。
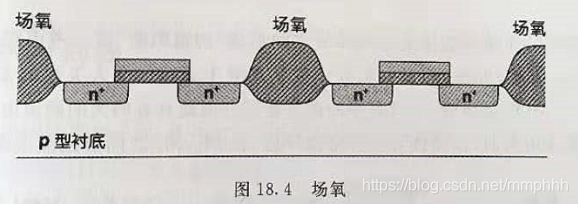
6、离子注入
通过将杂质原子加速变为高能离子束,再轰击晶圆表面而使杂质注入无掩模区域实现的,如下图所示。
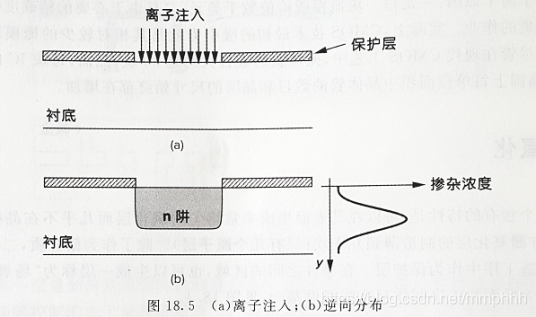
说明:掺杂浓度由注入密度和注入时间决定的,掺杂区域的深度是由离子束的能量决定的。
备注:
01 离子注入的另一个作用是:沟道阻断注入(可以查找资料看下)。
02 离子注入会严重的破坏硅的晶格,因此,注入后通常将硅片在大约1000摄氏度下加入15~30min,以使晶格键再次形成。这道工序被称为退火,它同时会引起杂质扩散,使杂质分布在各个方向展宽。比如:退火后会导致源/漏区横向扩散,形成与栅覆盖区域的交叠,故一般在所有的注入都完成以后,对晶圆仅退火一次。
03 另外,还有一个“沟道效应”的问题需要注意,大概就是要倾斜7度~9度进行注入,达到预期的掺杂浓度分布曲线。
7、淀积与刻蚀
概念:
01 淀积–把多种不同材料的薄膜层沉积到材料表面,包括生长氧化物,多晶硅等各种物质。常使用“化学气相淀法”实现。
02 刻蚀–去除被暴露材料(未保护),主要是为了去除光刻胶,多晶硅,氧化物等。常用有三种方法:湿法刻蚀、等离子刻蚀和反应离子刻蚀。







 本文深入探讨CMOS模拟集成电路的学习与制作过程,涵盖晶圆制造、光刻、氧化、离子注入及淀积与刻蚀等核心工艺。理解这些底层技术对于掌握芯片设计与生产至关重要。
本文深入探讨CMOS模拟集成电路的学习与制作过程,涵盖晶圆制造、光刻、氧化、离子注入及淀积与刻蚀等核心工艺。理解这些底层技术对于掌握芯片设计与生产至关重要。

















 1060
1060

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










