那一日,城外蟒雀齐鸣,霞光万丈,借势蜕变。
那一日,城内圣龙哀鸣,化作青烟,袅袅而散。
此为,蟒雀吞龙。
目录
-
1绪论
1.1研究背景
光刻是集成电路制造的核心工艺,光刻(photolithography)是将掩膜板(光刻板)上的几何图形转移到覆盖在半导体衬底表面的对光辐射敏感的薄膜材料(光刻胶)上去的工艺过程。光刻是通过光刻机来完成的。
1.2研究现状
目前光刻机市场主要厂商为ASML、Nikon、Canon三家企业,而这三家企业也占据了
全球光刻机市场的主要份额,市场呈现垄断格局。 数据显示,在2022年ASML市场份
额占比为82.1%,Canon市场份额占比10.2%,Nikon市场份额占比为7.7%。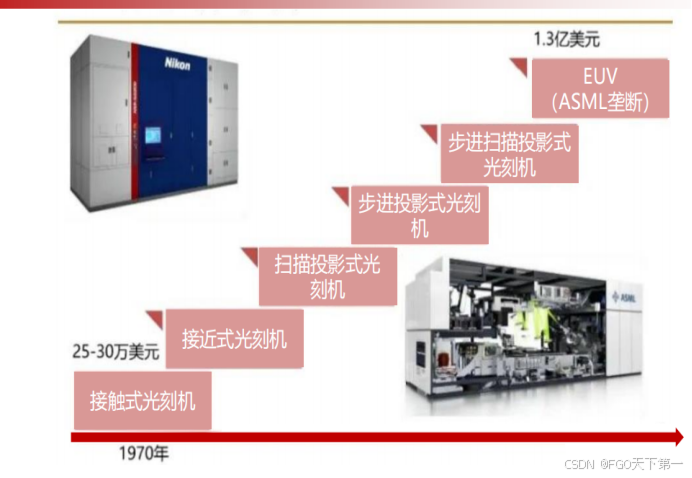
1.3 研究目的和内容
研究光刻机的发展历程,对于研究光刻技术的发展,乃至光电融合集成电路路技术的发展,具有重要意义。作为光刻工艺中最重要设备之一,光刻机一次次革命性的突破,使大模集成电路制造技术飞速向前发展。 了解提高光刻机性能的关键技术以及了解下一代光刻技术的发展情况是十分重要的。
-
2光刻机的组成和光刻原理
2.1光刻机的构成
光刻机(Mask Aligner) 又名:掩模对准曝光机,曝光系统,光刻系统等。
光刻(Photolithography) 意思是用光来制作一个图形(工艺);在硅片表面匀胶,然后将掩模版上的图形转移光刻胶上的过程将器件或电路结构临时“复制”到硅片上的过程。
一般的光刻工艺要经历硅片表面清洗烘干、涂底、旋涂光刻胶、软烘、对准曝光、后烘、显影、硬烘、刻蚀等工序。
光刻机是集成电路芯片制造的关键核心设备。光刻机是微电子装备的龙头,技术难度最高,单台成本最大。
光刻机的构造一般分为:照明系统(光源+产生均匀光的光路),Stage系统(包括Reticle Stage和Wafer Stage),镜头组(这个是光刻机的核心),搬送系统(Wafer Handler+ Reticle Handler),Alignment系统(WGA,LSA, FIA)。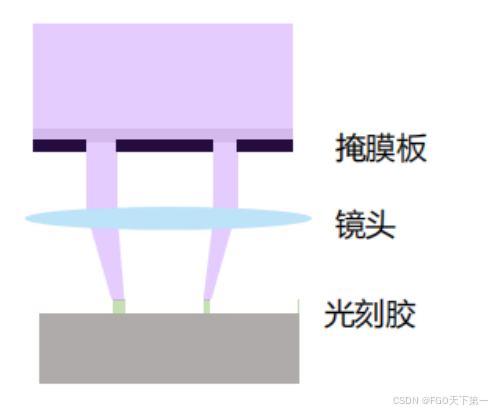
2.2光刻技术的涂胶工艺
光刻工艺通过曝光的方法将掩模上的图形转移到涂覆于硅片表面的光刻胶上,然后通过显影、刻蚀等工艺将图形转移到硅片上。
1、涂胶
要制备光刻图形,首先就得在芯片表面制备一层均匀的光刻胶。 在涂胶之前,对芯片表面进行清洗和干燥是必不可少的。
目前涂胶的主要方法有:甩胶、喷胶和气相沉积 ,但应用最广泛的还是甩胶。甩胶是利用芯片的高速旋转,将多余的胶甩出去,而在芯片上留下一层均匀的胶层,通常这种方法可以获得优于+2%的均匀性(边缘除外)。胶层厚度和转速、时间、胶的特性都有关系,此外旋转时产生的气流也会有一定的影响。
甩胶的主要缺陷有:气泡、彗星(胶层上存在的一些颗粒)、条纹、边缘效应等,其中边缘效应对于小片和不规则片尤为明显。

3.光刻机的发展历程
3.1光刻机发展路线图
分辨率 R 是指一个光学系统精确区分目标的能力。分辨率是决定光刻系统最重要的指标,能分辨的线宽越小,分辨率越高。

其中k1 是分辨率系数(或工艺系数),根据光刻水平,取值在0.3~0.8之间,目前一般取值0.4;λ 是光源的波长;NA 是光学系统的数值孔径。提升分辨率有效方法就是减小波长。通过光刻机的最小工艺节点及波长的区分,可以将光刻机发展分为5个阶段,现在已经发展到了第五代光刻机。下面我们将分别进行讲解。

3.2第一代光刻机
第一代光刻机是以接触式光刻机和接近式光刻机为代表的UV光刻机(波长436nm),用汞线作为光源可产生436nm的光,特点是易受污染,掩模版寿命短,成像精度不高。接触/接近式光刻是发展最早,也是最常见的曝光方式。它采用1:1方式复印掩膜版上的图形,这类光刻机结构简单,价格便宜,发展也较成熟,缺点是分辨率不高,通常最高可达1um 左右。此外由于掩膜版直接和光刻胶接触,会造成掩膜版的沾污。
3.2.1 接触式光刻机
接触式光刻机是1970年代以前的主要光刻手段,其掩膜板和光刻胶直接接触。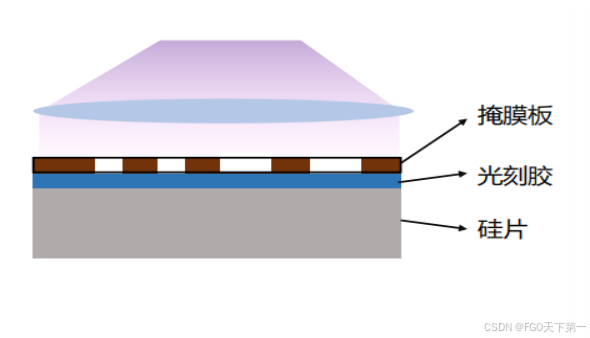
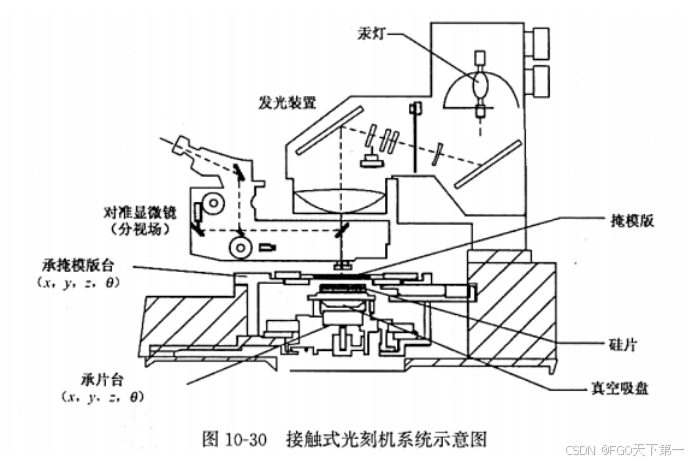
优点:
• 结构简单,成本低
• 减少了光的衍射效应,分辨率较高
缺点:
• 容易产生划痕和污染,降低了晶圆的良率
以及掩膜板的使用寿命
• 依赖人工操作,效率低,容易出错
3.2.2接近式光刻机
在1970年代普遍使用,其掩膜板与光刻胶不直接接触,而与光刻胶表面接近,约有2.5~25μm的间隙。
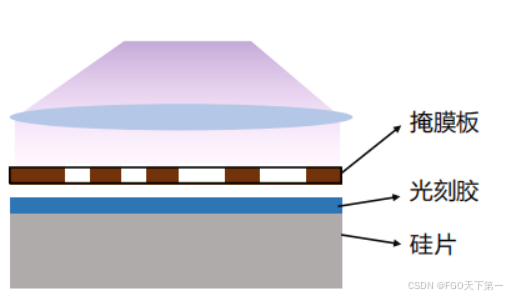
优点:
• 缓解了玷污问题
• 掩膜板使用寿命提升
缺点:
• 边缘衍射效应,使得系统分辨率减小
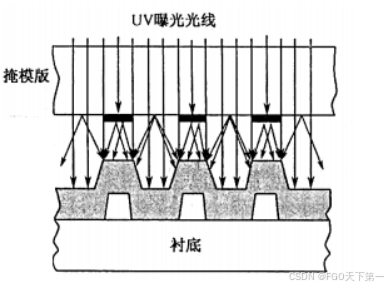
3.3第二代光刻机
第二代光刻机是以接触式光刻机和接近式光刻机为代表的UV光刻机(波长365nm),用I射线作为光源可产生365nm的光,特点是易受污染,掩模版寿命短,成像精度不高。与第一代光刻机原理相同,不同在于光源从汞射线变成了I射线,缩小了光源波长。在下面不再赘述。
3.4第三代光刻机
第三代光刻机是以扫描投影式光刻机为代表的DUV光刻机(波长248nm),用KrF射线作为光源可产生248nm的射线,特点是采用了投影式光刻法,大幅增加了掩模版的寿命。 投影式光刻机在现代光刻中占主要地位,据调查显示,投影式光刻机约占整个光刻设备市场份额的 70%以上。
3.4.1扫描投影式光刻机
为了解决接触式和接近式光刻机存在的玷污、边缘散射等问题,1970年代末和1980年代初,扫描投影式光刻机占据了主导地位。其主要优点是分辨率高,不沾污掩膜版,重复性好,但结构复杂,价格昂贵。 投影式光刻机又分为扫描式和步进式,扫描式采用 1:1 光学镜头,由于扫描投影分辨率不高, 因此 80 年代中期后就逐步被步进投影光刻机所取代。步进投影光刻机采用缩小投影镜头,一般有 4:1.5,1.10:1 等。
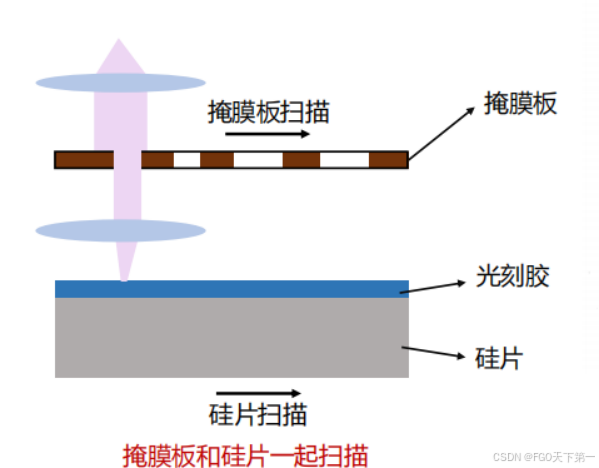

3.5 第四代光刻机
第四代DUV光刻机(波长193nm) ,大约5亿人民币,ArF准分子激光器作为光源可产生193nm的深紫外(Deep Ultraviolet)光。是最具有代表性的光刻机。采用了步进式投影技术,解决了曝光尺寸和镜头尺寸之间的矛盾。
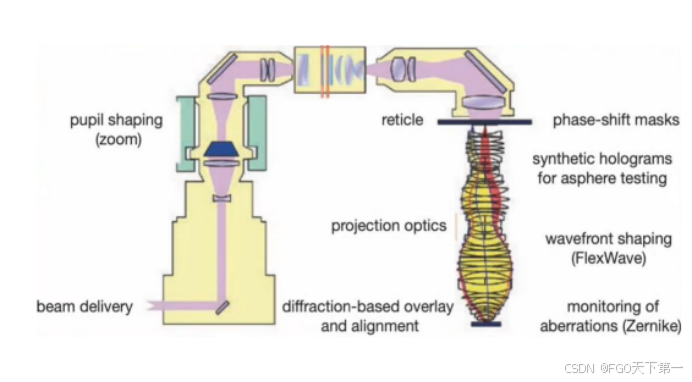
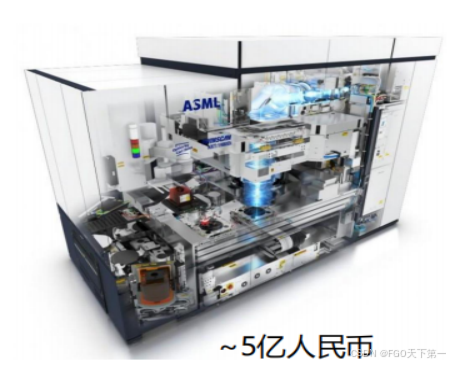
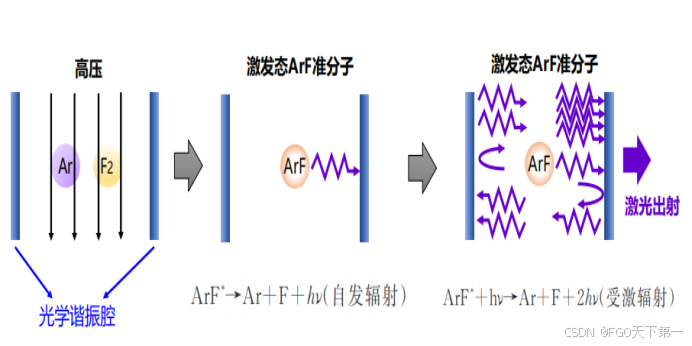
3.5.1步进投影式光刻机(分步重复投影式光刻机)
20世纪90年代用于集成电路制造的主流精细光刻设备,通过一次曝光结合硅片的步进,以提高生产效率。随着加工规模的增加,曝光视场尺寸也要相应增加,但镜头成本随之增加。
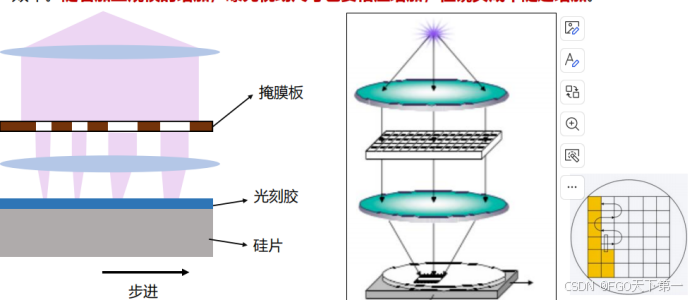
为了解决曝光视场尺寸和镜头尺寸的矛盾,发展了步进扫描式光刻技术。
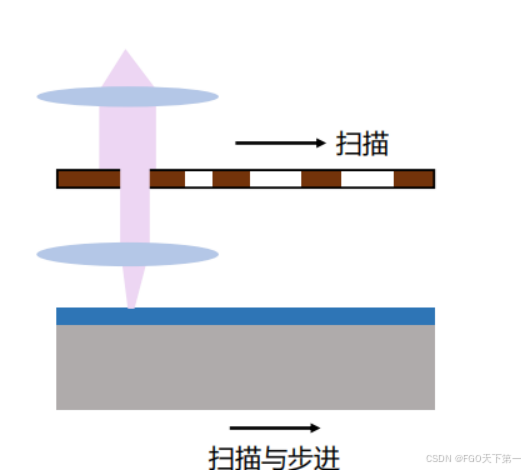
扫描:在小区域被光刻出特定图案,步进:步进到下一个大区域,进行重复扫描光刻
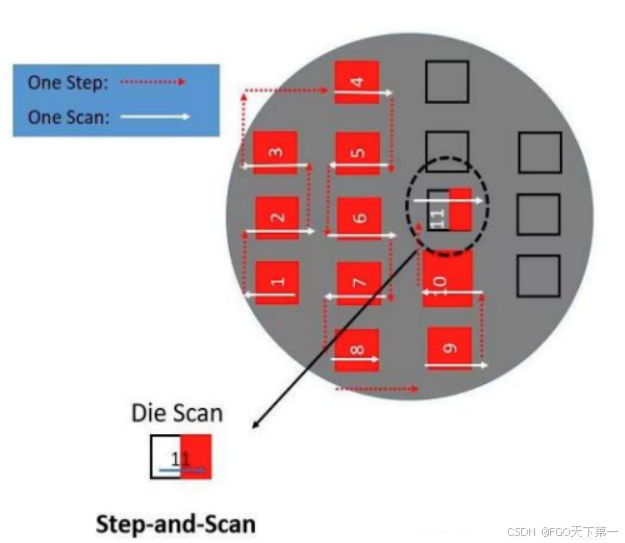
3.6 第五代光刻机
第五代光刻机是EUV 光刻机(波长13.5nm),价格: 大约14亿人民币。利用极紫外(Extreme Ultraviolet,EUV)产生原理来产生波长为13.5nm的射线,是世界上最先进的光刻机。但成本过高,技术突破困难。目前由ASML一家垄断。
3.6.1 极紫外光刻技术

利用高能脉冲激光激发锡液滴产生等离子体,等离子体进一步发光产生EUV光子
极紫外光刻技术一直是最受关注且最有可能达到量产化要求的光刻技术。极紫外光刻技术使用波长为13.5 nm的极紫外光,几乎所有的材料对这个波段的光都是强吸收的,因此极紫外光刻技术只能采用反射投影光学系统。
极紫外光线经过由80层Mo—Si结构多层膜反射镜组成的聚光系统聚光后,照明反射式掩模,经缩小反射投影光学系统,将反射掩模上的图形投影成像在硅片表面的光刻胶上。
目前,极紫外光刻技术研究面临的主要难题包括低缺陷密度掩模的制备,高输出功率、长寿命极紫外光源的研发,反射式投影光学系统中污染的有效控制,适用于量产的反射式投影光学系统的制造,低线条粗糙度和低曝光剂量极紫外光刻胶的研发,保护反射式掩模免受微粒污染等。
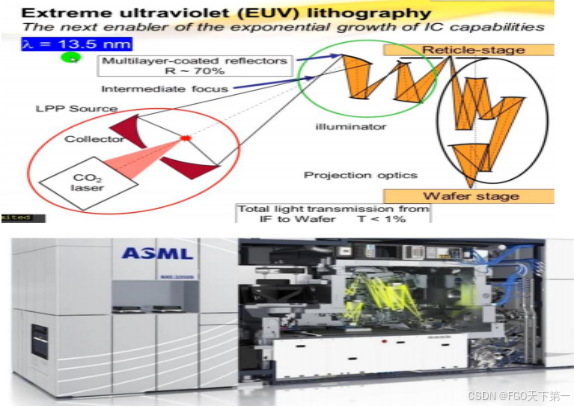
4.总结与展望
4.1 报告总结
综上所述,我们可以知道光刻技术的主要技术原理以及光刻技术的可能发展趋势。科技发展瞬息万变,只有技术的不断发展,才能满足现实社会的生产需求。我们由以上介绍可以知道,提高光刻机的性能要从减小特征尺寸入手。我们也通过光刻机的发展历程了解了这一前沿技术的发展趋势。科技的发展归于技术的突破。
4.2报告展望
极紫外光刻、纳米压印光刻、无掩模光刻等下一代光刻技术的研究也取得了较大的进步。在193nm浸没式光刻技术达到极限后,极紫外光刻将最有可能成为主流的光刻技术,纳米压印光刻和无掩模光刻也将是极有竞争力的下一代光刻技术。
关注作者了解更多
我的其他CSDN专栏
关注作者了解更多
资料来源于网络,如有侵权请联系编者

























 1897
1897

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










