关于BGA芯片布局时要注意的要点
随着芯片封装技术的发展,BGA(球栅阵列)已被视为标准封装形式。就具有数百个引脚的芯片而言,BGA封装的应用带来了巨大的优势。
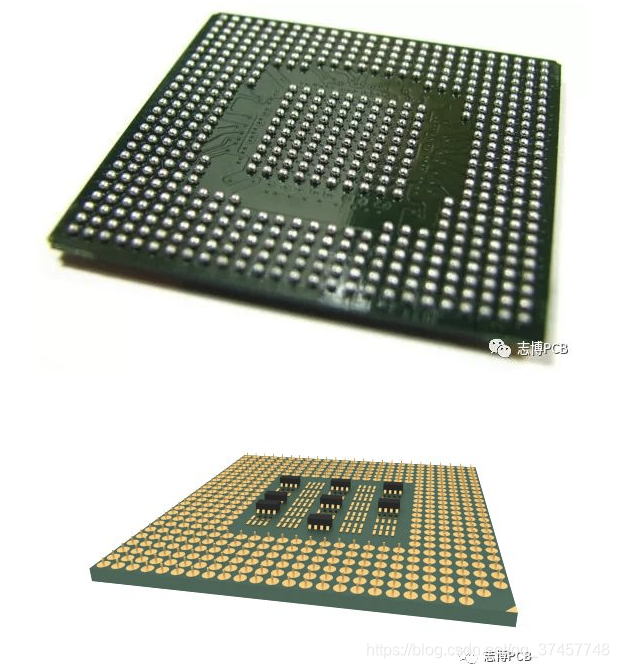
就BGA封装的形状而言,BGA芯片比QFP(四方扁平封装)芯片更有优势、功性能及实用性更强。BGA封装使芯片的物理尺寸大大减小,BGA芯片的管脚可以直接取代了QFP芯片的外围引线,这在多个I/O引脚的应用时尤其明显。随着I/O引脚数的改变,BGA的面积随着I/O引脚数的增加而线性增加,而QFP的面积随着I/O引脚数的增加而增加。因此,BGA封装为具有多个引脚的器件提供了比QFP更高的可制造性。一般来说,I/O管脚范围为250到1089,具体取决于封装类型和尺寸。就可制造性而言,BGA芯片的性能也优于QFP芯片。BGA封装芯片的引脚为球形,分布在2D阵列中。此外,I/O管脚比QFP具有更大的间距,并且可以作为由于接触而不会变形的硬球。对于芯片制造商而言,BGA芯片的另一个优点在于其产量高。还有一点要说的是,BGA芯片的封装缺陷率通常为每引脚0.3ppm至5ppm,可视为等效无缺陷。
基于以上优点,BGA封装芯片被电子组装商广泛应用。但是,我们需要在设计阶段使用一些重要的布局技巧来进行高速设计,否则BGA封装的特殊形状会导致焊接短路的风险增加。因此,我们下面注意讲解BGA芯片的一些重要布局规范,以便在SMT(表面贴装技术)器件中达到最佳焊接效果,避免出现短路的现象,提高良率。
•间距和间距
BGA封装的焊球间距通常保持在50mil。为了满足PCB(印刷电路板)制造工艺中使用的技术要求,通孔和焊盘边缘之间的间距应至少为8mil,走线与焊盘边缘之间的间距可以减小到5mil至6mil。因此,将BGA芯片的焊盘尺寸定义在18mil至25mil之间是合理的,并且BGA焊球之间的布线宽度应该在6mil至8mil的范围内。
•基准标记设置
由于BGA封装很难用肉眼检查,甚至肉眼也看不到焊点,为了满足装配等检查,需要要准确确定基准标记的位置,这样可以满足手工装配和返工后更换的要求。
通常的做法是在BGA组件的两个角或两个角标处放置两个基准标记,如下图所示。

基准标记和角标记都放置在BGA封装的同一层上,即器件层。基准标记通常具有三种形状:正方形,圆形和三角形,其尺寸范围为20mil至80mil,没有焊接保护区域为60mil的尺寸。角标本身的宽度控制在8mil到10mil的范围内,这样做是为了给BGA焊盘图形提供最精确的对准。
•焊盘中间的导电通孔
一般来说,通孔不要打在盲孔和更换埋孔的焊盘之间。因为这样会导致PCB生产成本增加。如果必须在焊盘之间打通孔,则应使用阻焊油来阻止焊锡流出或填充或覆盖通孔以阻止焊接中的短路。

•焊盘
在BGA芯片的所有引脚中,有很多是电源或地网络。如果将焊盘设计为通孔,则将节省大量空间用于走线。但是,这种设计仅适用于回流焊接技术。由于采用通孔组装方法,通孔数量应与焊膏量相适应。只要应用该技术,锡膏就会通过进行填充过孔。但是如果不考虑这个因素,锡球将沉入焊点,这样导电性就会下降。

除此之外,BGA芯片布局还有很多需要注意的,本文所写的只是其中一些BGA芯片的布局设计指南。除上所述外,BGA器件布局还与PCB板厂或装配商的能力和设备参数相关。例如,PCB生产机器能够处理的最大和最小电路板尺寸可能彼此不同,还要求相应的设计修改与不同的设计要求兼容。因此,对BGA芯片布局的所有内容进行全面确认以获得组装PCB和其他最终产品的最佳性能具有重要意义。
























 1142
1142

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








