在这里开个新专题,主要详细描述半导体制造整个流程中所用到的设备工艺步骤。
在集成电路制造工艺中,光刻是决定集成器件集成度的核心工序,该工序的作用是将图形信息从掩模版(也称掩膜版)上保真传输、转印到半导体材料衬底上。光刻工艺的基本原理是利用涂敷在衬底表面的光刻胶的光化学反应作用,记录掩模版上的器件图形,从而实现将集成器件图形从设计转印到衬底的目的。
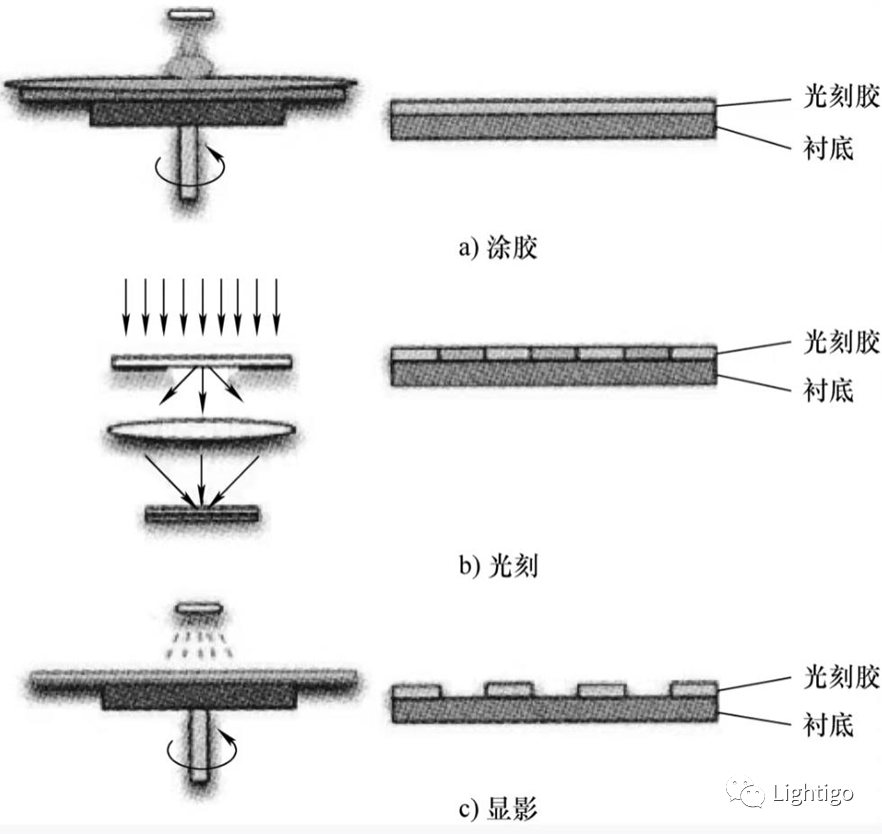
光刻工艺的关键指标包括分辨率、灵敏度、套准精度、缺陷率等。光刻工艺中最关键的材料是作为感光材料的光刻胶。光刻胶按极性可分为正光刻胶(简称正胶)和负光刻胶(简称负胶)两种,其性能差别在于:负光刻胶曝光区域在曝光显影后变硬而留在晶圆片表面,未曝光部分被显影剂溶解;正光刻胶经过曝光后,曝光区域的胶连状聚合物会因为光溶解作用而断裂变软,最后被显影剂溶解,而未曝光的部分则保留在晶圆片表面。先进芯片的制造大都使用正光刻胶,这是因为正光刻胶能达到纳米图形尺寸所要求的高分辨率。16nm/14nm及以下技术代在通孔和金属层又发展出正胶负显影技术,将未经曝光的正光刻胶使用负显影液清洗掉,留下曝光的光刻胶,这种方法可提高小尺寸沟槽的成像对比度。
典型的光刻工艺的主要过程包括5个步骤:底膜准备→涂光刻胶和软烘→对准、曝光和曝光后烘→显影坚膜→显影检测。
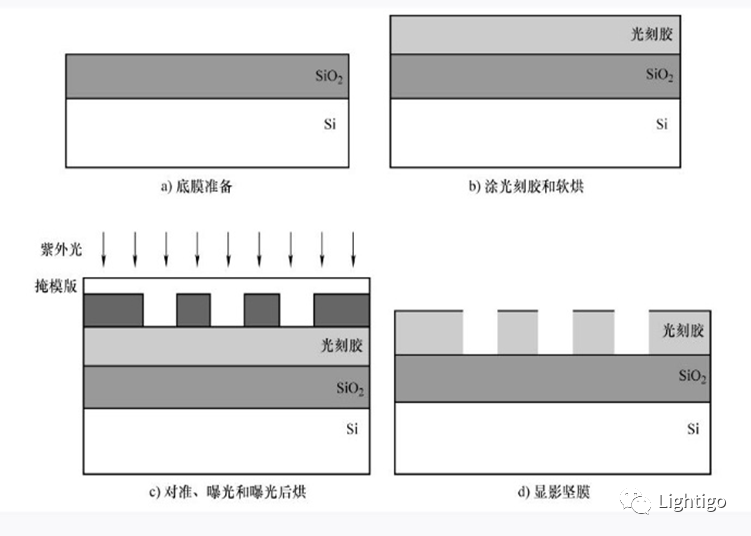
1)底膜准备:主要是清洗和脱水。因为任何污染物都会减弱光刻胶与晶圆片之间的附着力,所以彻底的清洗可以提升晶圆片与光刻胶之间的黏附性。
2)涂光刻胶和软烘:通过旋转硅片的方式实现。对于不同的光刻胶要求不同的涂胶工艺参数,包括旋转速度、胶厚度和温度等。软烘:通过烘烤可以提高光刻胶与硅片的黏附性,以及光刻胶厚度的均匀性,以利于后续刻蚀工艺的几何尺寸的精密控制。
3)对准、曝光和曝光后烘:对准和曝光是光刻工艺中最重要的环节,是指将掩模版图形与晶圆片已有图形(或称前层图形)对准,然后用特定的光照射,光能激活光刻胶中的光敏成分,从而将掩模版的图形转移到光刻胶上。对准和曝光所用的设备为光刻机,它是整个集成电路制造工艺中单台价格最高的工艺设备。光刻机的技术水平代表了整条生产线的先进程度。曝光后烘指的是曝光后进行短时间的烘焙处理,其作用与在深紫外光刻胶和常规i线光刻胶中的作用有所不同。对于深紫外光刻胶,曝光后烘去除了光刻胶中的保护成分,使得光刻胶能溶解于显影液,因此曝光后烘是必须进行的;对于常规i线光刻胶,曝光后烘可提高光刻胶的黏附性并减少驻波(驻波对光刻胶边缘形貌会有不良影响)。
4)显影坚膜:即用显影液溶解曝光后的光刻胶可溶解部分(正光刻胶),将掩模版图形用光刻胶图形准确地显现出来。显影工艺的关键参数包括显影温度和时间、显影液用量和浓度、清洗等,通过调整显影中的相关参数可提高曝光与未曝光部分光刻胶的溶解速率差,从而获得所需的显影效果。坚膜又称为坚膜烘焙,是将显影后的光刻胶中剩余的溶剂、显影液、水及其他不必要的残留成分通过加热蒸发去除,以提高光刻胶与硅衬底的黏附性及光刻胶的抗刻蚀能力。坚膜过程的温度根据光刻胶的不同及坚膜方法的不同而有所不同,以光刻胶图形不发生形变为前提,并应使光刻胶变得足够坚硬。
5)显影检测:即检查显影后光刻胶图形的缺陷。通常利用图像识别技术,自动扫描显影后的芯片图形,与预存的无缺陷标准图形进行比对,若发现有不同之处,就视为存在缺陷。如果缺陷超过一定的数量,则该硅片被判定未通过显影检测,视情况可对该硅片进行报废或返工处理。在集成电路制造过程中,绝大多数工艺都是不可逆的,而光刻是极少数可进行返工的一道工序。























 1786
1786

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








