首先刻蚀工艺在整个半导体工艺中也是至关重要的一个步骤。即光刻工艺之后真正将集成电路结构在所需晶圆上的实现。所以刻蚀与光刻是相关联的,曝光显影的图形质量也是决定刻蚀后的图形质量,这点对于尺寸以及线宽要求极为严格的图形来说非常重要。
1、刻蚀工艺分类:
在半导体制造中刻蚀工艺主要有两种:干法刻蚀和湿法刻蚀。干法刻蚀又分为三种:等离子体刻蚀、离子束溅射刻蚀和反应离子体刻蚀(RIE)。当然刻蚀也可以分为有图形刻蚀和无图形刻蚀。有图形刻蚀采用光刻胶或其他材料作为掩膜,只刻蚀掉裸露的部分,而无图形刻蚀是在没有掩膜的情况下进行。
2、刻蚀的目的和问题:
在图形转移或者复制的精度依靠几个工艺参数:不完全刻蚀、过刻蚀(overetch)、钻蚀、选择比和侧边的各项异性/各项同性刻蚀。
不完全刻蚀:原因可能是第一刻蚀时间过短,第二需要刻蚀的薄膜厚度不均匀等。
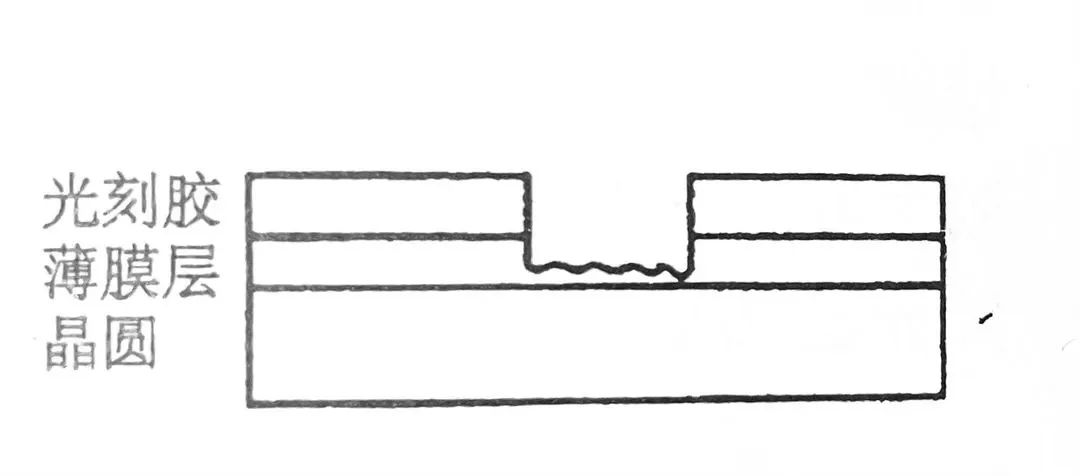
过刻蚀:在任何的刻蚀工艺中,总会有一定程度的、计划的过刻蚀,以便允许表层厚度变化,再或者是为了下一步工艺的要求等等。
各向同性和异性:各向同性是指刻蚀会向各个方向进行;各向异性与之相反,所以各向异性相比于同性会得到一个较为理想的刻蚀图形(垂直的侧边)
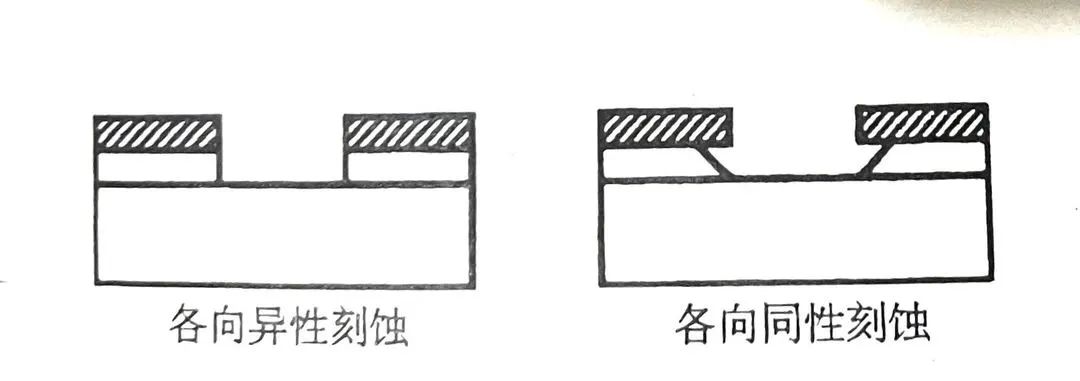
钻蚀:从最外的表面开始到底部的过程中刻蚀同样也会在最外表面进行,结果会在侧面形成一个斜面。当这种作用在光刻胶边缘下被刻蚀,可称为钻蚀。
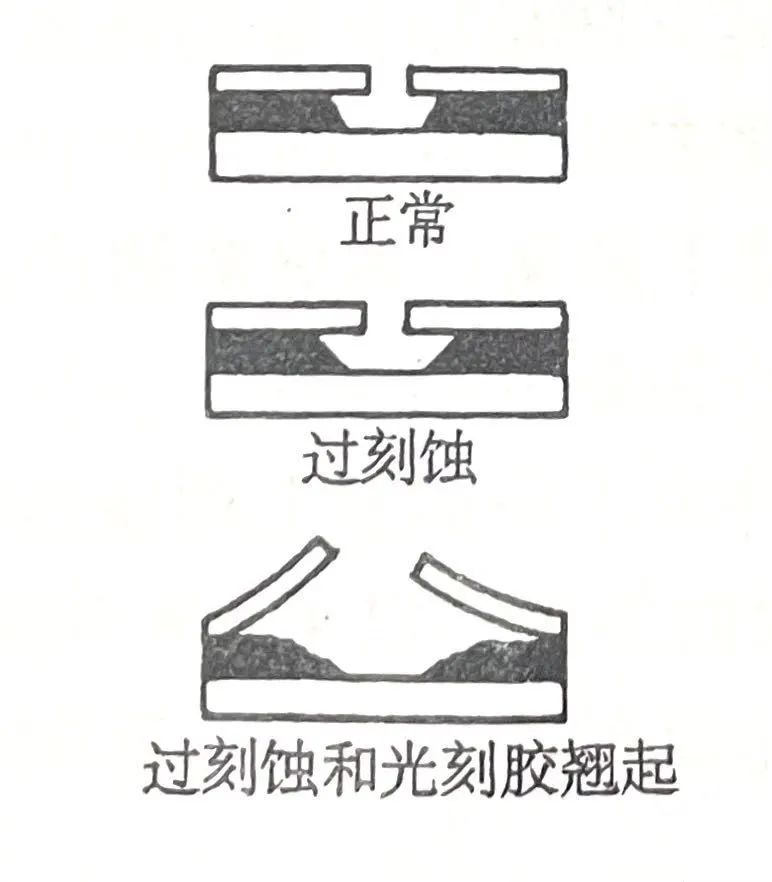
选择比:是指在同一刻蚀条件下两种不同材料刻蚀速率快慢之比。举个例子:当光刻胶作为掩膜需要去刻蚀SIO2,用干法刻蚀,这时就需要考虑刻蚀时在同等的时间,光刻胶和SIO2的刻蚀比。否则会出现光刻胶作为掩膜已经被刻蚀完了,SIO2还没刻蚀到所需要的要求。
均匀性:是衡量刻蚀工艺在整个硅片上,或整个一批,或批与批之间刻蚀能力的参数。均匀性与选择比有着密切的关系,因为非均匀性刻蚀会产生额外的过刻蚀。均匀性的一些问题是由于刻蚀速率和刻蚀剖面与图形尺寸和密度有关而产生的。刻蚀速率在小窗口图形中较慢,甚至在具有高深宽比的小尺寸图形上刻蚀能停止,这一现象被称为深宽比相关刻蚀(ARDE),也被称为微负载效应。为了提高均匀性,必须把硅片表面的ARDE效应减至最小。
除上述参数外,残留物、聚合物、等离子体诱导损伤以及颗粒沾污也是实际生产中刻蚀技术的参数。
3、小结:
湿法刻蚀:湿法喷雾刻蚀、浸没刻蚀。
优点:成本较低、可以批量等。
缺点:1、局限于2um以上的图形尺寸;2、各向同性,会侧向腐蚀导致侧边形成一定的斜坡;3、在湿法刻蚀后必须要求冲洗和干燥的步骤;4、各种腐蚀剂是具有毒害以及潜在的污染;5、光刻胶黏附能力的失效从而导致钻蚀。
干法刻蚀:等离子体、离子铣和反应离子刻蚀(RIE)
优点:选择比好,能实现更小的图形尺寸,能精准控制精度等等。
缺点:就俩字慢和贵。
























 2747
2747

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








