半导体封装的分类

引线框架封装中分为表面贴装型(引线贴装在表面),如QFP/TQFP、TSOP、SOJ;通孔型(将引线插入印刷电路板安装孔中),如DIP、ZIP。
基板封装中分为球栅阵列封装(锡球固定在封装基板上),如BGA;平面网格阵列疯转(基板上没有锡球焊盘阵列),如LGA。
陶瓷封装采用陶瓷体,具有良好的散热性和可靠性,但是制造工艺成本高。
半导体封装分为0级到3级等四个不同等级。0级封装——将晶圆切割出来;1级封装——芯片级封装;2级封装——将芯片安装到模块或者电路卡上;3级封装——将附带芯片和模块的电路卡安装到系统板上。
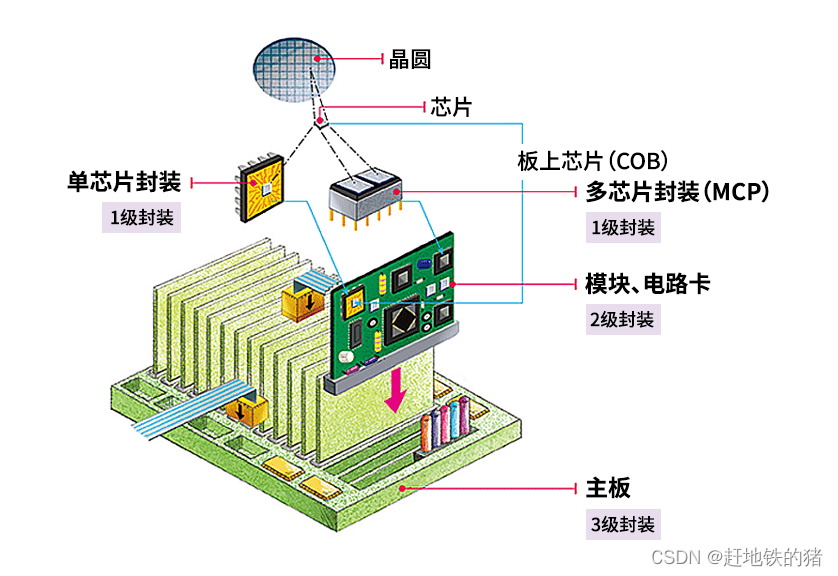
半导体封装的作用主要有四个,机械保护、电气连接、机械连接、散热。
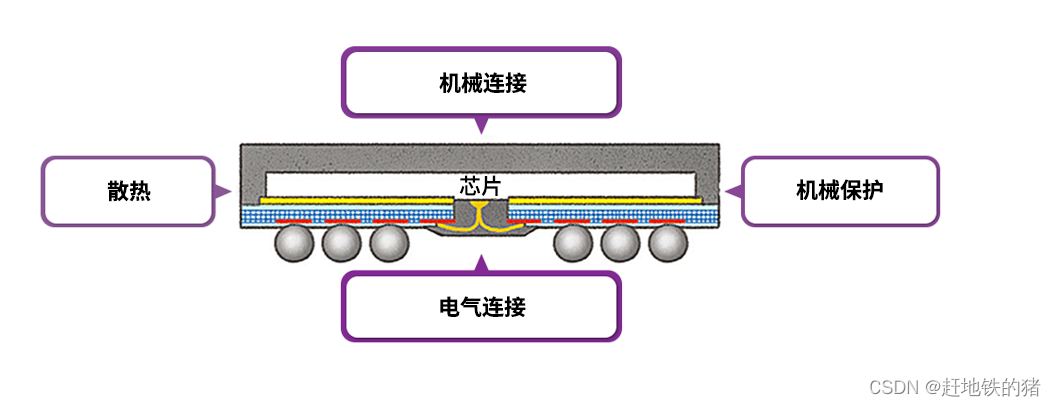








 本文详细介绍了半导体封装的分类,包括表面贴装、通孔型、球栅阵列和平面网格阵列,以及陶瓷封装。同时阐述了封装的四个主要等级和其在机械保护、电气连接、机械连接和散热方面的作用。
本文详细介绍了半导体封装的分类,包括表面贴装、通孔型、球栅阵列和平面网格阵列,以及陶瓷封装。同时阐述了封装的四个主要等级和其在机械保护、电气连接、机械连接和散热方面的作用。
















 3035
3035

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








