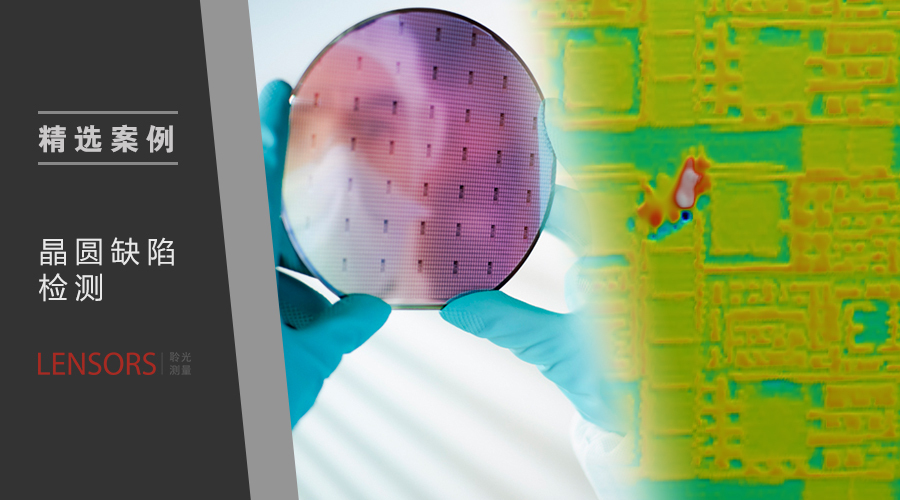
日常生活中常见的各类电子设备,如手机、电脑、电视和空调等,都依赖于各种芯片所提供的逻辑计算、存储和传感能力。每一颗芯片的核心都是晶片,由多种规格的晶圆切割而成。晶圆本身存在良率问题,晶圆表面也可能存在各类缺陷,为了防止存在缺陷的晶片流入后道封装工序,需借助光学检测设备识别晶圆表面缺陷并分类、标记,辅助晶片分拣。
晶圆经先进的半导体工艺制作而成,一片典型的8寸晶圆表面排布着数十万单独的晶片,晶片的关键尺寸小,要求极高的测量分辨率。同时,晶圆表面呈现镜面效果,对普通的测量光信号的干扰较大。FocalStation三维表面形貌系统提供的光谱共焦测量技术,不仅拥有纳米级的测量分辨率,还能够利用镜面反射光进行测量,从而可以获得高质量的晶圆三维表面形貌数据,最终识别分布在晶圆表面的缺陷。

一、测量需求
1.晶圆三维表面形貌
2.晶圆表面缺陷
二、测量步骤
1.固定晶圆样品至FocalStation测量台,并进行机械原点归位;
2.在FS软件中设置扫描参数,开始扫描并等待任务完成;
3.数据预处理,包含校平、光学降噪等;
4.分析与报告;
三、晶圆形貌和缺陷
调整3D视图可对晶圆表面数据快速可视化,方便查看晶圆表面整体形貌和存在的缺陷。
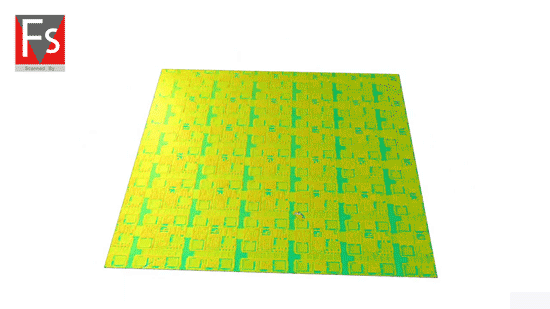
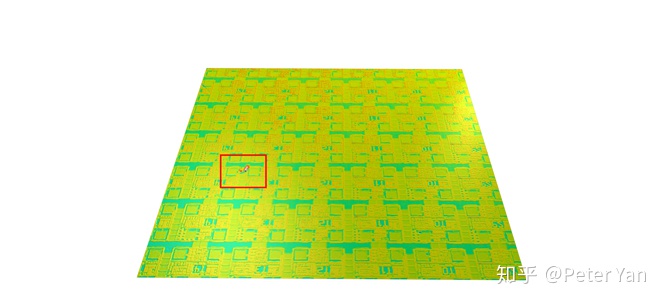























 891
891

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








