来源:A Compact Model of High-Voltage MOSFET Based on Electric Field Continuity for Accurate Characterization of Capacitance(TED 24年)
摘要
本文提出了一种新的高压MOSFET(HV MOS)紧凑模型,以消除现有模型中过高电容峰值的问题。与现有的改进电容模型方法相比,所提出的模型不再基于内部MOS和漂移区模型之间的电流连续性,而是基于电场连续性,并考虑了由于屏蔽栅(SG)和接触场板(CFP)引起的漂移区的二维效应。引入了一个新的远离SiO2/Si界面的点Ki,并使用点Ki处的静电势ψKi来替代内部漏极电压VK作为内部MOS的漏极电压,用于计算电流和电荷。此外,我们不再使用大多数现有模型中用于获取栅-漏极重叠(GDO)区域表面静电势ψK的一维高斯方程,而是提出了一个考虑P-区/ N-漂移结影响的新ψK模型。所提出的模型利用MM11模型来描述内部MOS的电流和电荷,并结合了作为ψK函数的GDO区域电荷模型,可以有效消除过高的电容峰值,并准确捕捉HV MOS的直流和电容特性。
关键词:2D效应、紧凑模型、电场连续性、栅-漏极重叠(GDO)区域电荷、高压MOSFET(HV MOS)
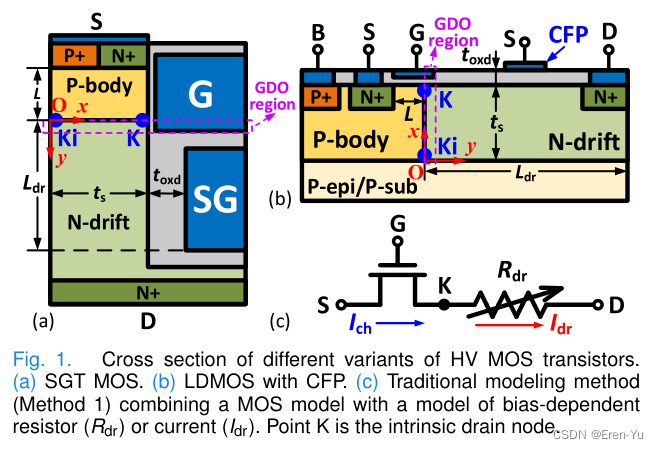
文章的研究内容
文章的研究内容是提出了一种新的高压MOSFET(HV MOS)紧凑模型,该模型基于电场连续性来精确表征电容特性。与现有改进的电容模型方法相比,此模型不再依赖于内在MOS与漂移区模型之间的电流连续性,而是考虑了由屏蔽栅(SG)和接触场板(CFP)引起的漂移区的二维效应。研究中引入了一个远离SiO2/Si界面的新点Ki,并使用Ki点处的静电势ψKi来替代内在MOS的漏极电压VK,进而计算电流和电荷。此外,研究没有采用多数现有模型中使用的基于一维高斯方程来获取栅-漏重叠(GDO)区域的表面静电势ψK,而是提出了一种新的ψK模型,该模型考虑了P体/N-漂移结界面对ψK的影响。
文章所提出的模型利用MM11模型来描述内在MOS的电流和电荷,并结合考虑ψK影响的GDO区域电荷模型,能够有效消除过高的电容尖峰,精确捕捉HV MOS的直流和电容特性。研究还通过使用二维泊松方程来求解ψKi,并提出了一种非迭代方法来计算ψKi,从而提高了计算速度和鲁棒性。通过与技术计算机辅助设计(TCAD)模拟结果以及15伏LDMOS的实际测量数据对比,验证了模型的有效性和准确性。模型还纳入了热网络以考虑自热效应,尽管实验条件限制使得无法获取所有VDS下的CGG曲线,但模型能准确捕捉CGD-VDS曲线的尖峰。
文章的核心贡献是开发了一个新的紧凑模型,它通过创新的电场连续性概念和对漂移区二维效应的考虑,显著改善了高压MOSFET电容特性的模拟精度。
文章的研究方法
文章采用的研究方法主要集中在理论建模、数值分析和实验验证几个方面,具体包括:
-
理论建模与创新:研究团队提出了一种新型的高压MOSFET(HV MOS)紧凑模型,该模型基于电场连续性而非传统电流连续性原理,这是理论创新之处。模型设计时考虑了二维(2-D)效应,特别是由屏蔽栅(SG)和接触场板(CFP)结构引起的漂移区效应。模型中引入了一个新的变量点Ki,用Ki点处的静电势ψKi代替传统的漏极电压VK来计算内在MOS的电流和电荷,这有助于更精确地表征高压MOS器件的电容特性。
-
数值求解与参数优化:研究中利用二维泊松方程求解ψKi,并通过数学推导与近似方法,如泰勒级数展开,得到了一系列方程来描述不同工作区间的电压和电荷关系。同时,提出了一个非迭代方法来快速且稳定地计算ψKi,以提高计算效率。模型中涉及的参数(如θch、θc、θd、kvg0、kvg1等)通过理论分析和拟合确定,以确保模型的精确度和实用性。
-
与现有方法对比:通过与现有的几种方法(称为方法1至3)进行对比,文章展示了新模型在消除过高电容尖峰方面的优势,特别是在精确捕获高压MOS器件的直流和电容特性方面。这种对比分析是通过理论推导和数值仿真完成的。
-
技术计算机辅助设计(TCAD)仿真验证:研究团队利用成熟的TCAD软件进行了仿真,验证了所提模型在18伏LDMOS器件上的适用性和准确性,包括直流特性和电容特性。仿真结果表明,新模型能够准确预测并消除电容尖峰现象。
-
实验数据验证:除了仿真验证,文章还利用了15伏LDMOS的实际测量数据进一步验证模型的准确性,证明模型不仅能有效应用于仿真环境,也能很好地反映真实器件的行为。
-
模型参数调整与优化:通过对模型参数的细致调整,确保模型能够适应不同条件下的器件特性,体现了模型的灵活性和普适性。
研究结合了理论分析、数值模拟与实验验证等多种研究方法,旨在开发并验证一种能够准确表征高压MOSFET电容特性的创新紧凑模型。
文章的创新点
文章的创新点在于提出了一种新的高压MOSFET(HV MOS)紧凑模型,旨在解决现有模型中电容尖峰过高的问题。以下是几个关键创新点:
-
基于电场连续性的新方法:不同于以往基于电流连续性的模型,新模型侧重于电场连续性,更准确地处理了高压MOS器件中漂移区的二维效应。这得益于考虑了屏蔽栅(SG)和接触场板(CFP)对漂移区的二维影响,使用了二维泊松方程来描述漂移区的电场分布。
-
引入Ki点和ψKi参数:模型创新性地引入了远离SiO2/Si界面的新点Ki,并使用该点的电势ψKi替代传统的内在漏极电压VK,来计算电流和电荷。ψKi的使用不仅避免了复杂的Maxwell-Boltzmann统计结合,而且简化了模型复杂度,提高了计算速度和模型的稳健性。
-
非迭代计算ψKi:为提升计算效率,文章提出了一个非迭代计算ψKi的方法,这在处理复杂物理现象时特别有益,因为通常迭代计算过程可能较为缓慢且稳定性不佳。
-
改进的ψK模型:针对栅-漏重叠(GDO)区域的电荷模型,文章提出了一种新的ψK模型,该模型考虑了P体/N-漂移结界面对ψK的影响,从而克服了传统模型仅使用一维高斯方程忽略二维效应的局限性。
-
综合MM11模型应用:模型综合运用了MM11模型来描述内在MOS的电流和电荷特性,并将GDO区域的电荷模型与之结合,实现了对HV MOS器件的直流特性和电容特性准确的描述,有效消除了电容尖峰问题。
-
理论与实践结合验证:研究不仅在理论上构建了模型,还通过技术计算机辅助设计(TCAD)仿真和实际15伏LDMOS器件的测量数据进行了验证,证明了模型的有效性和准确性,体现了理论与实践的紧密结合。
这些创新点共同构成了一个更为精准、高效且实用的高压MOSFET电容特性描述模型,对高压集成电路的设计与优化具有重要意义。
文章的结论
文章的结论是,为了消除高压MOSFET(HV MOS)中现存模型表现出的过度电容尖峰问题,本文提出了一种基于电场连续性的新型紧凑模型。该模型创新性地考虑了由屏蔽栅(SG)和接触场板(CFP)引起的漂移区二维效应,并引入了一个远离SiO2/Si界面的点Ki,利用该点的电势ψKi代替传统的内在MOS漏极电压VK来计算电流和电荷。此外,模型摒弃了常用的沿通道方向的一维高斯方程来获取GDO区域的表面电势ψK,而是提出了一个新的ψK模型,该模型考虑了P体/N-漂移结界面对ψK的影响。
模型的核心组成部分包括MM11模型来模拟内在MOS的电流和电荷,以及基于ψK的GDO区域电荷模型。这些组件的整合有效地去除了电容尖峰现象,并精确地捕捉了HV MOS的直流特性和电容特性。TCAD仿真结果和15V LDMOS的实际测量数据均被用来验证模型的准确性,表明模型在预测和表征高压MOS器件的电容特性方面具有显著的优势。
为了提高计算速度和模型的稳健性,文中还提出了一种非迭代方法来计算ψKi。最后,模型中加入了热网络以实现自热效应的模拟,尽管受限于实验条件,无法获取不同VDS下的CGG曲线,但模型能精确捕捉CGD-VDS曲线的尖峰。
总之,本文提出的基于电场连续性的高压MOSFET紧凑模型成功解决了电容尖峰问题,提高了电容特性的预测精度,并通过理论分析、仿真验证和实测数据的综合评估,验证了其在HV MOS器件建模中的有效性和实用性。























 1万+
1万+











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










