本文来自“走进芯时代:HBM迭代,3D混合键合成设备材料发力点”。
报告概述
HBM突破“内存墙”,实现高带宽高容量,成为Al芯片最强辅助,我们认为HBM将持续迭代,1/0口数量以及单1/0口速率将逐渐提升,HBM3以及HBM3e逐渐成为Al服务器主流配置,且产品周期相对较长,单颗容量及配置颗数逐步增加,预计HBM4于2026年发布。2024年全球HBM市场有望超百亿美元,市场空间足,国产供应链加速配套。
当前HBM采用“TSV+Bumping”+TCB键合方式堆叠,但随着堆叠层数的增加散热效率很差,TCB不再满足需求,海力士率先引入MR-MUF回归大规模回流焊工艺,芯片之间用液态环氧模塑料作为填充材料,导热率比TC-NCF中的非导电薄膜高很多,但海力士也预计HBM4会引入混合键合Hybrid Bonding方案,取消互连凸块。
混合键合与TSV是3D封装的核心,HBM“连接”与“堆叠”带来设备材料端发展新机遇:混合键合分为晶圆对晶圆W2W和芯片对晶圆D2W,3D NAND使用W2W,典型案例为长鑫存储的Xstacking,CMOS层+存储层采用W2W混合键合方案,预计HBM未来亦会采用W2W方案,W2W与D2W方案相比一般应用于良率非常高的晶圆,避免损失。
报告节选

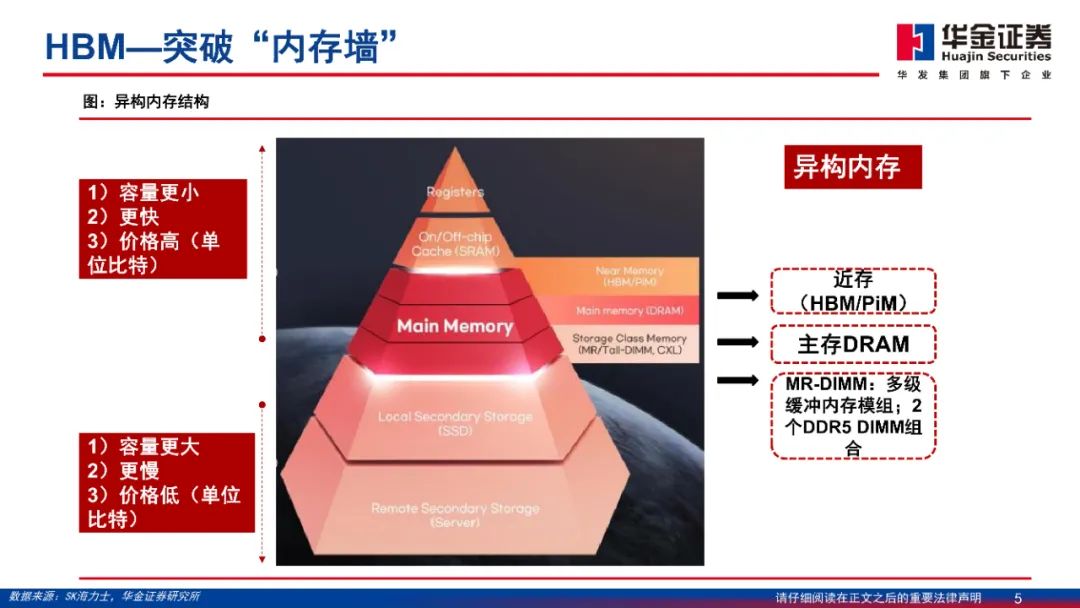
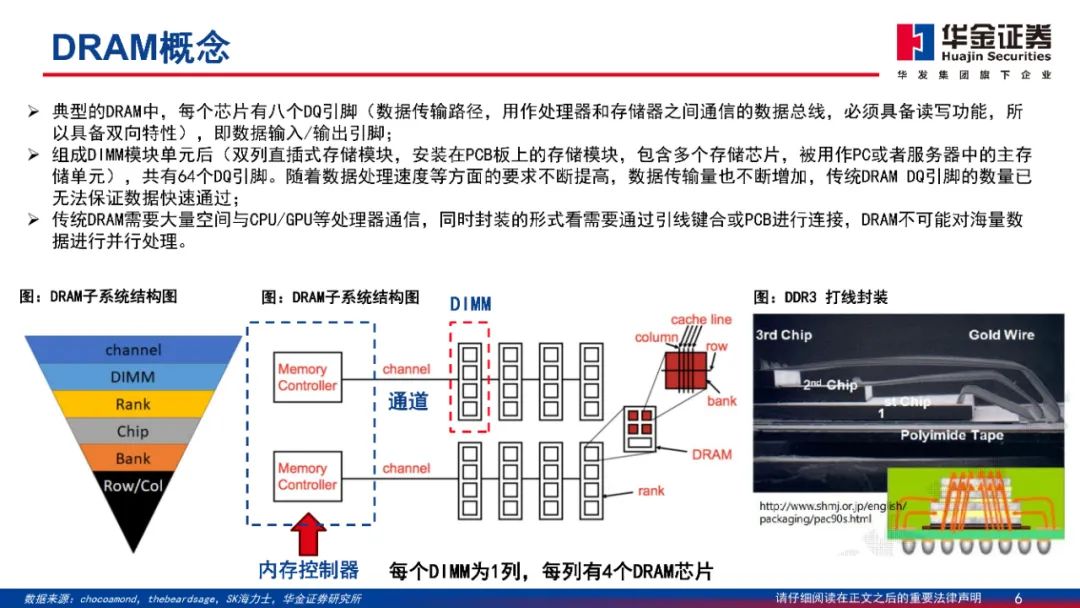
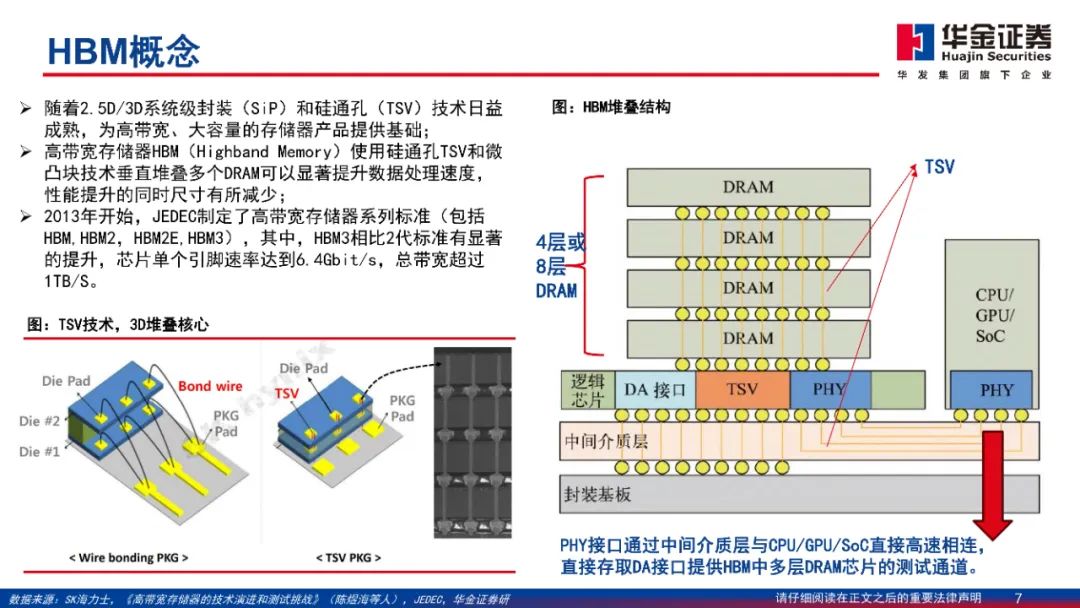

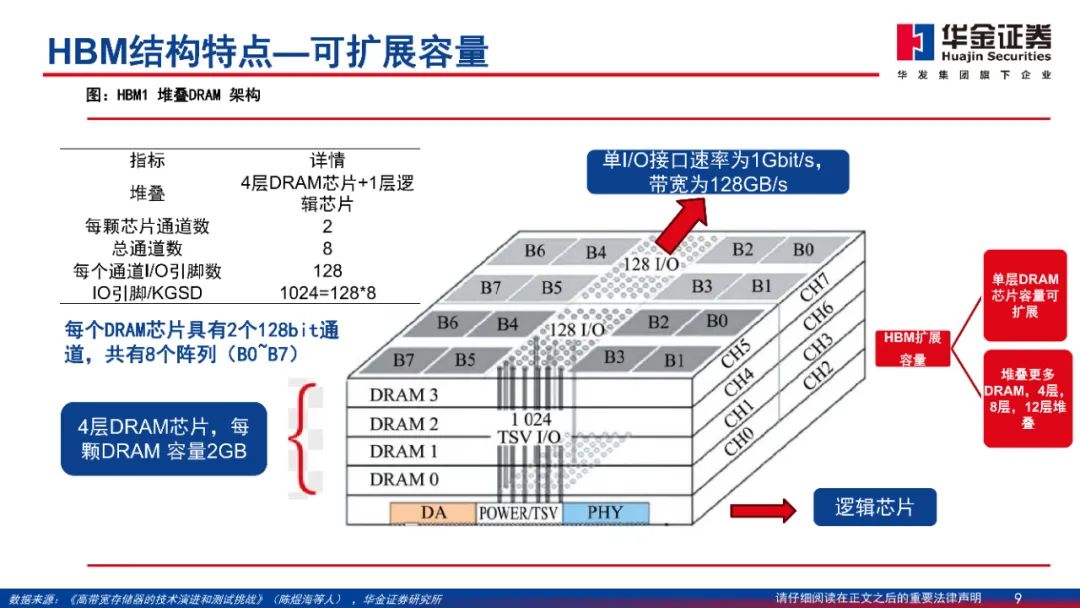
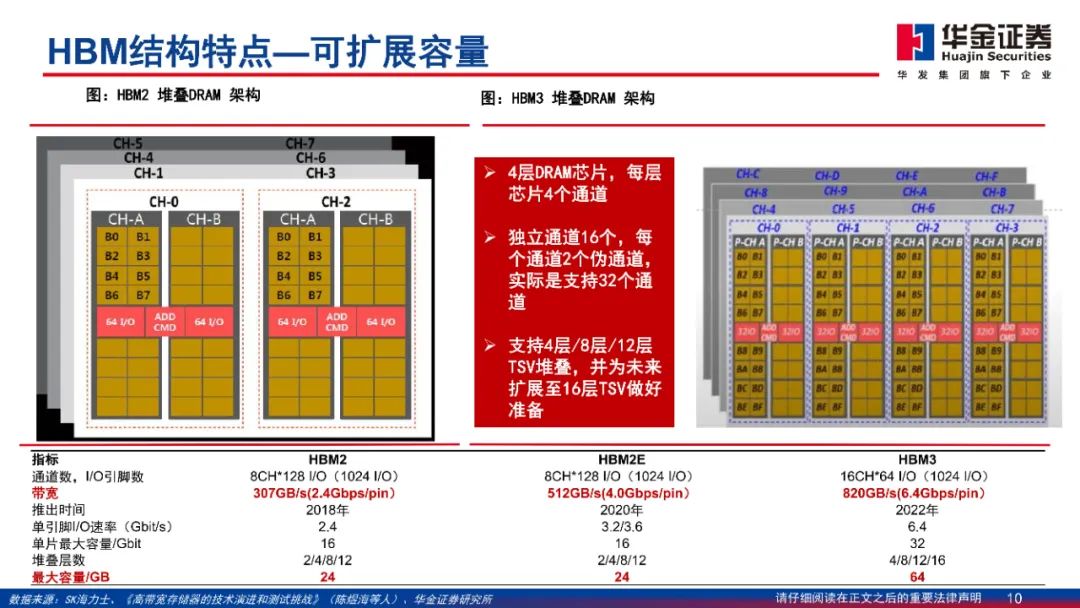

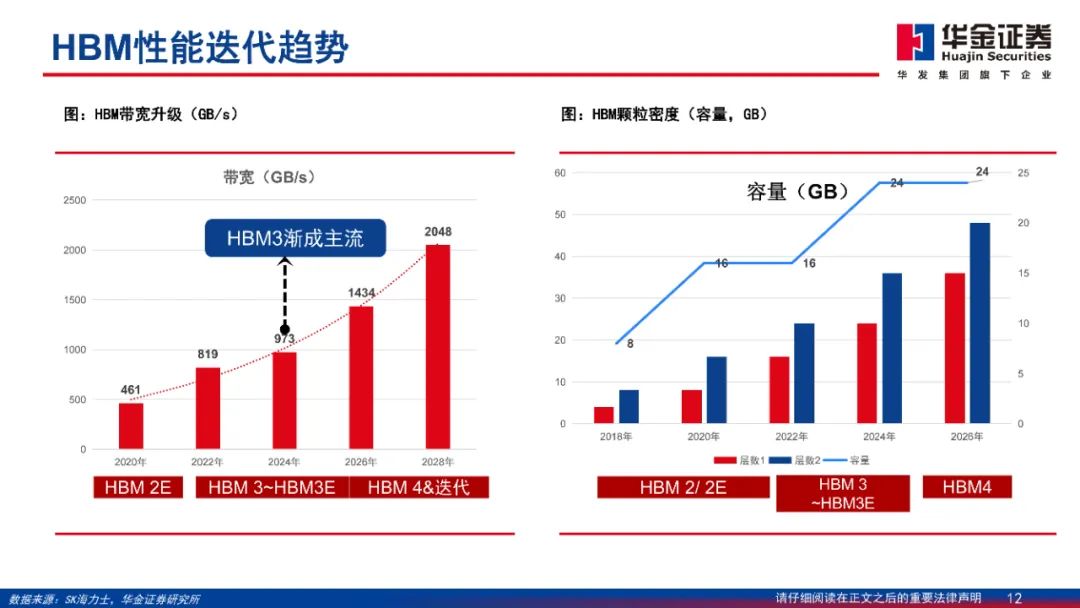
2、Al算力快速迭代,HBM为最强辅助


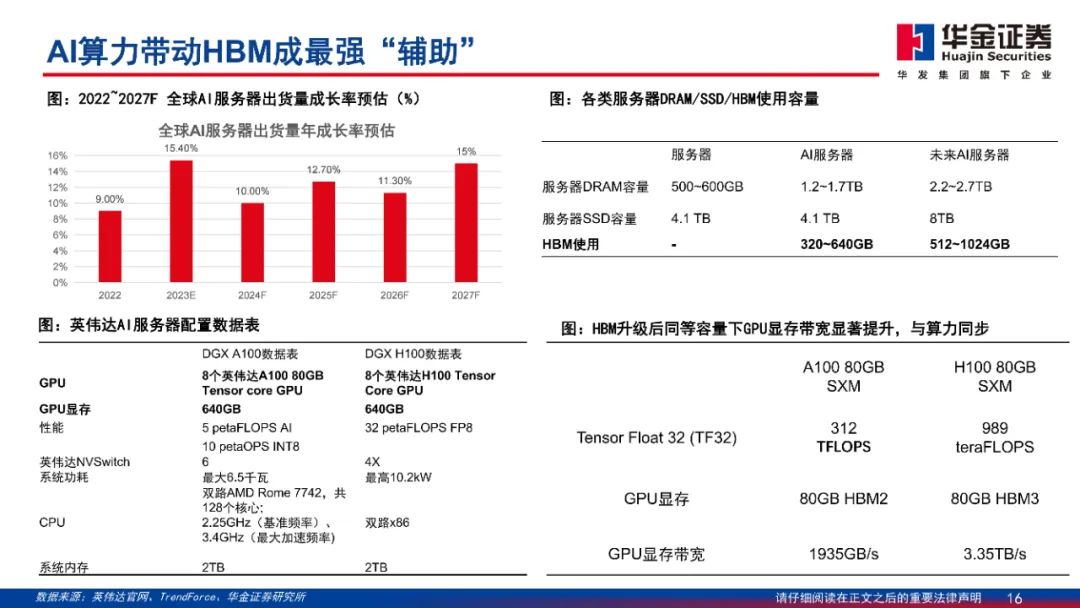

3、HBM核心—“连接”与“堆叠”,3D混合键合成趋势

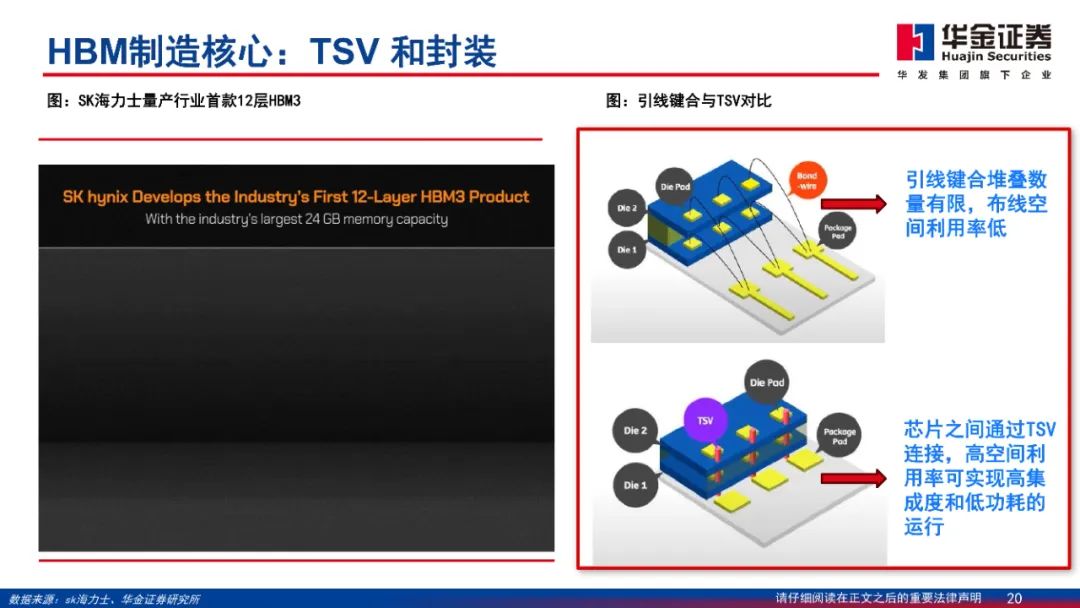
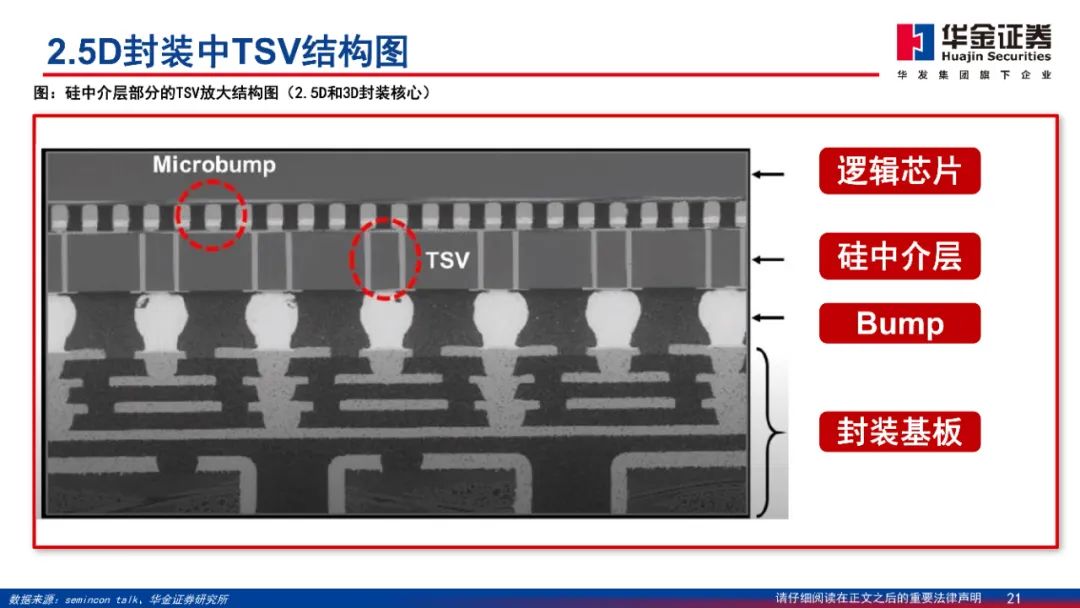
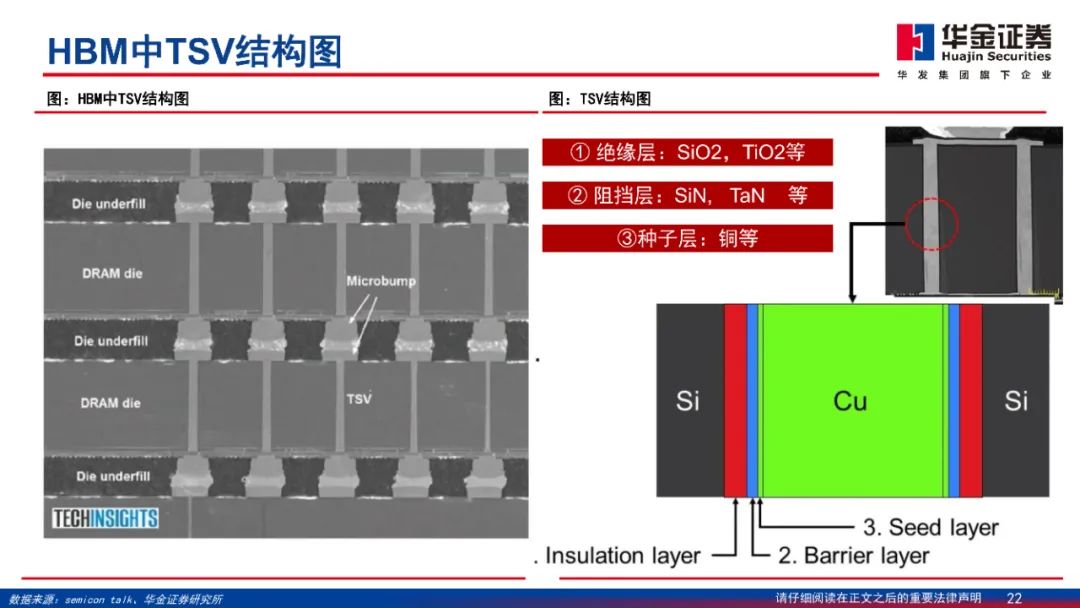
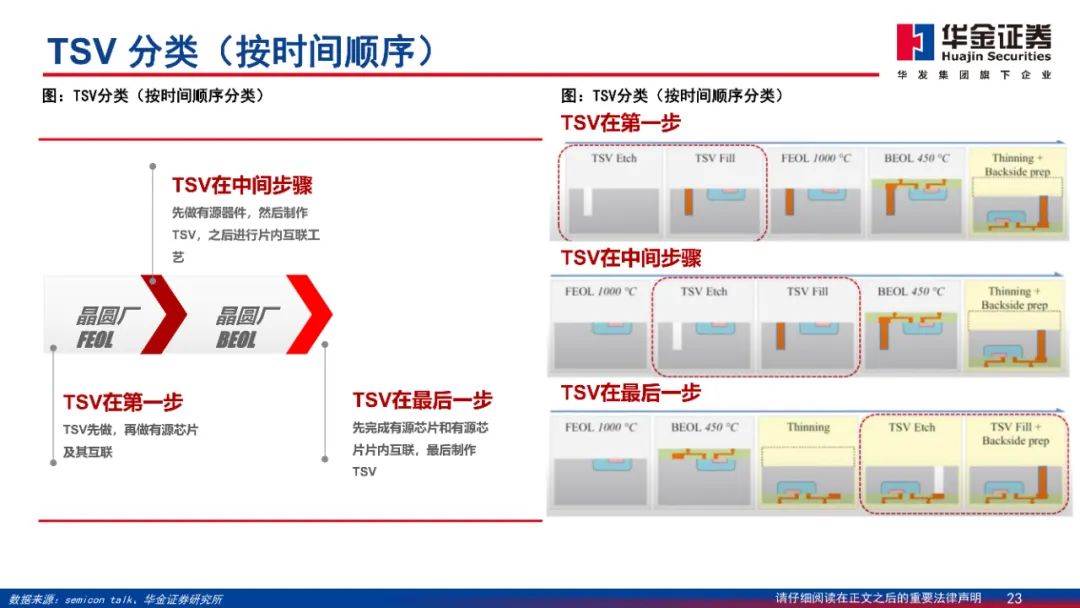
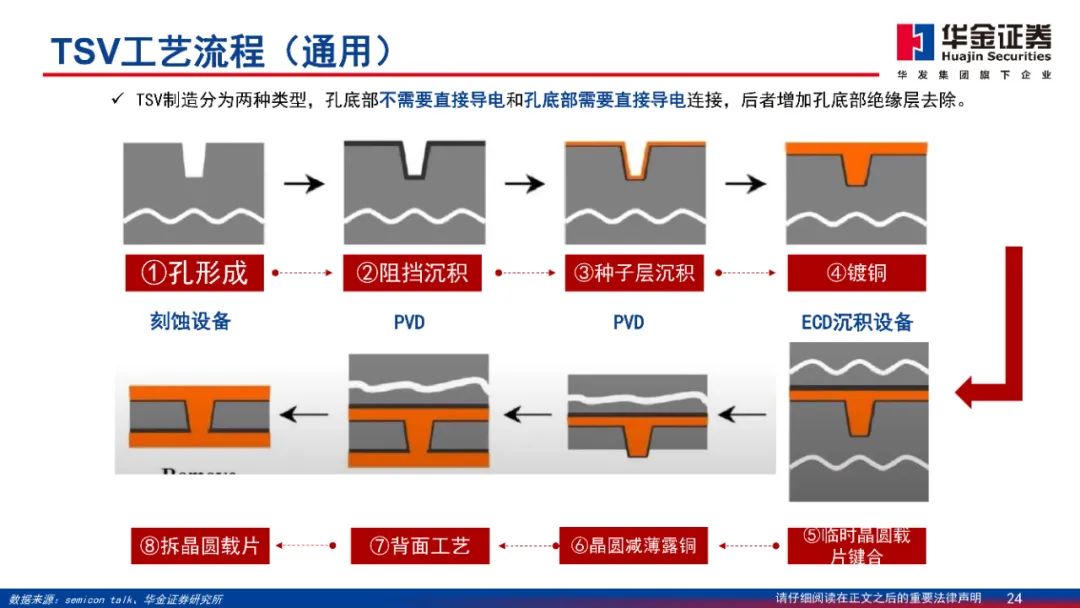
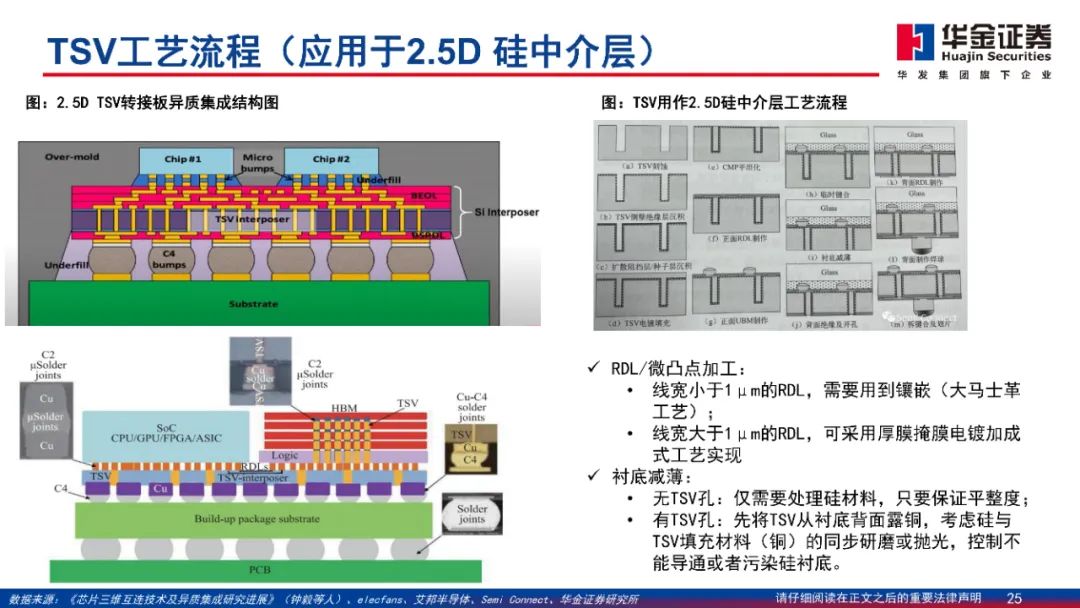

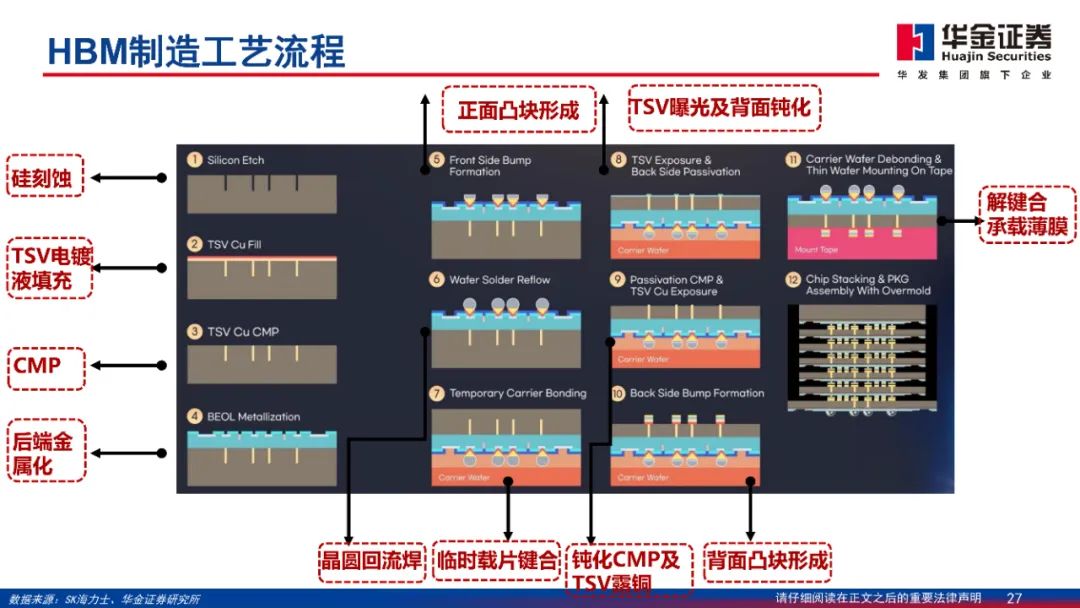

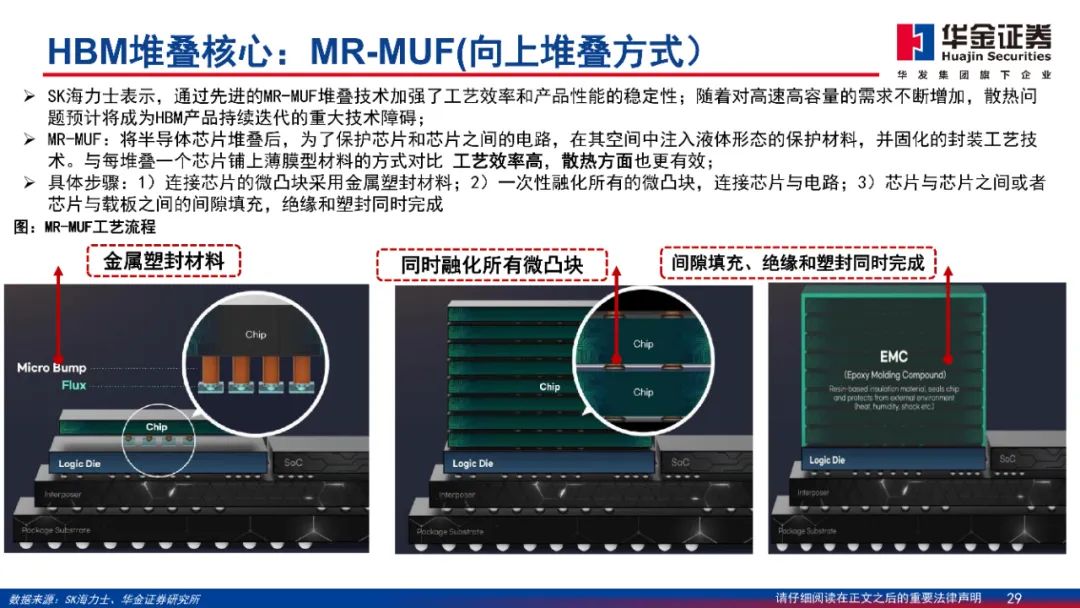
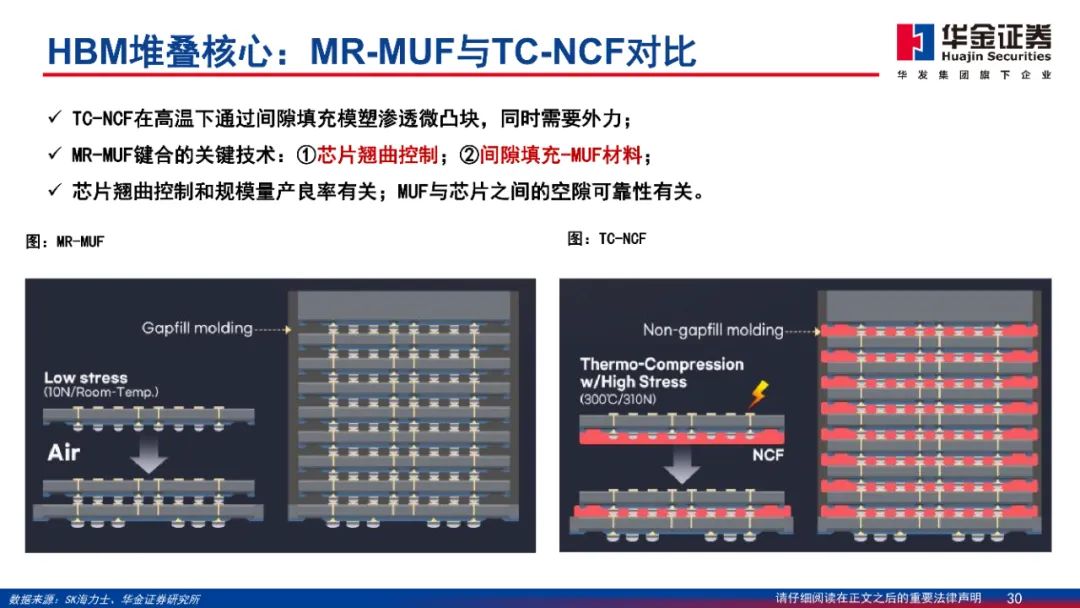
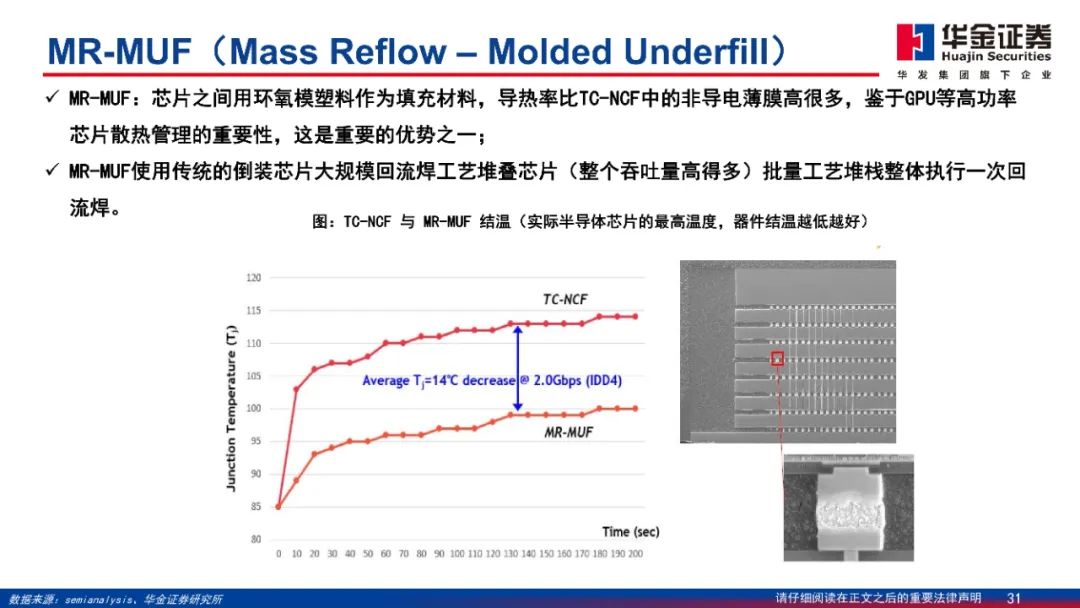
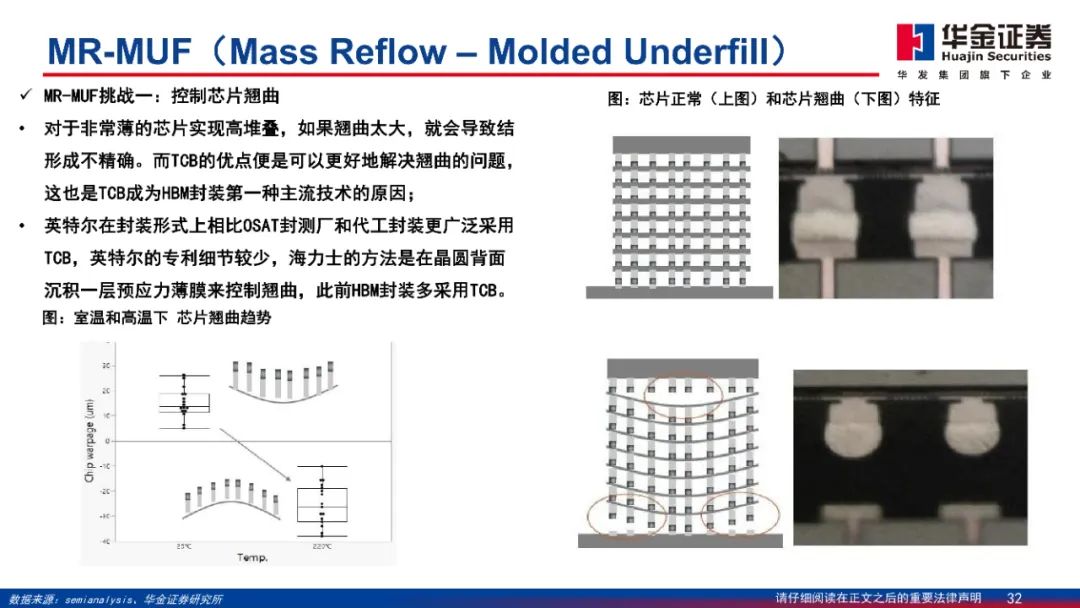
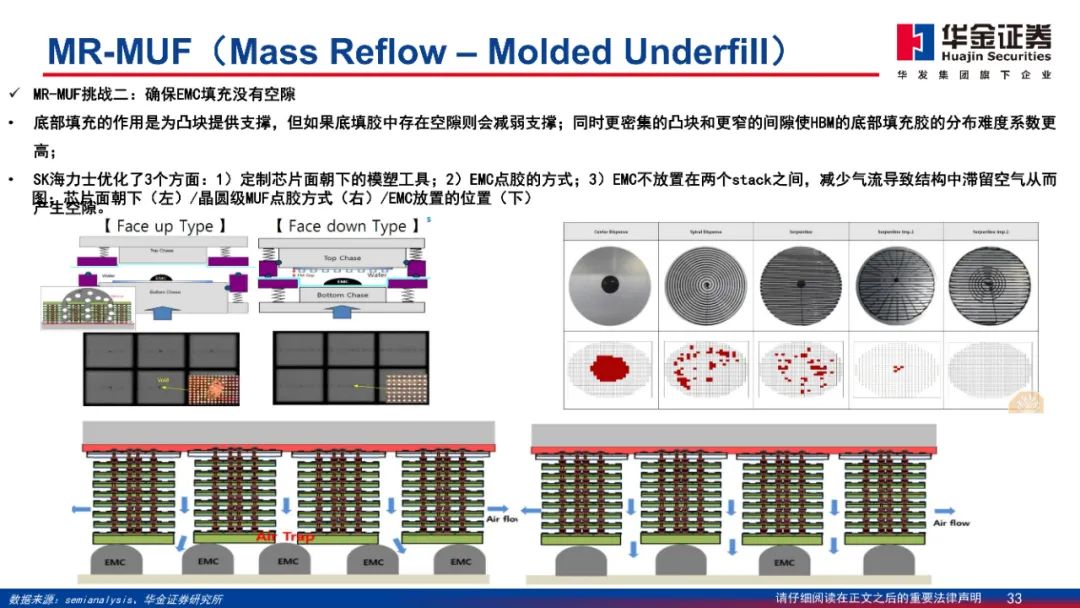
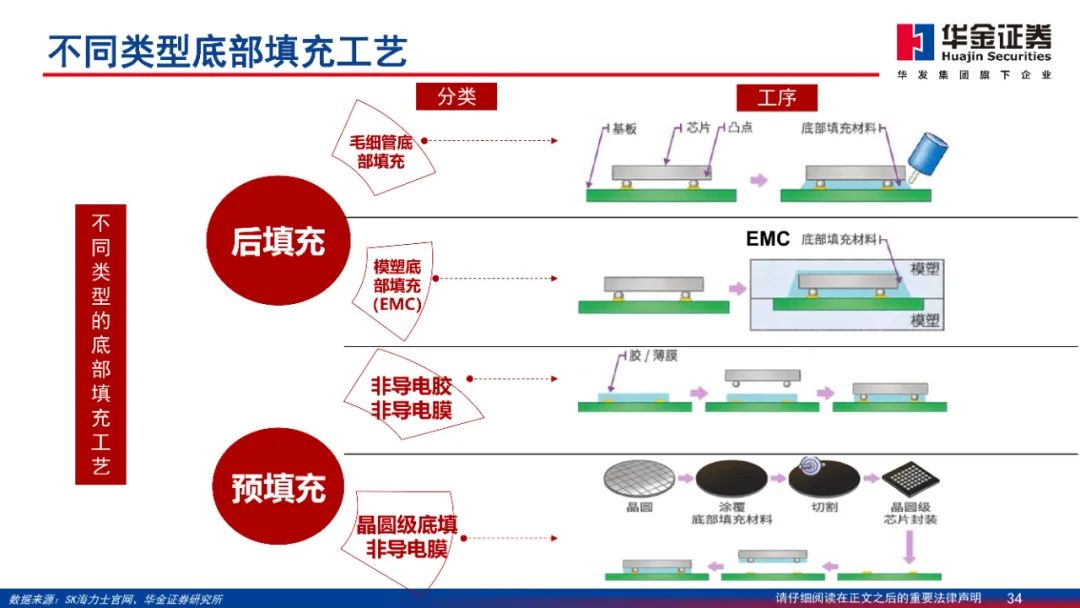
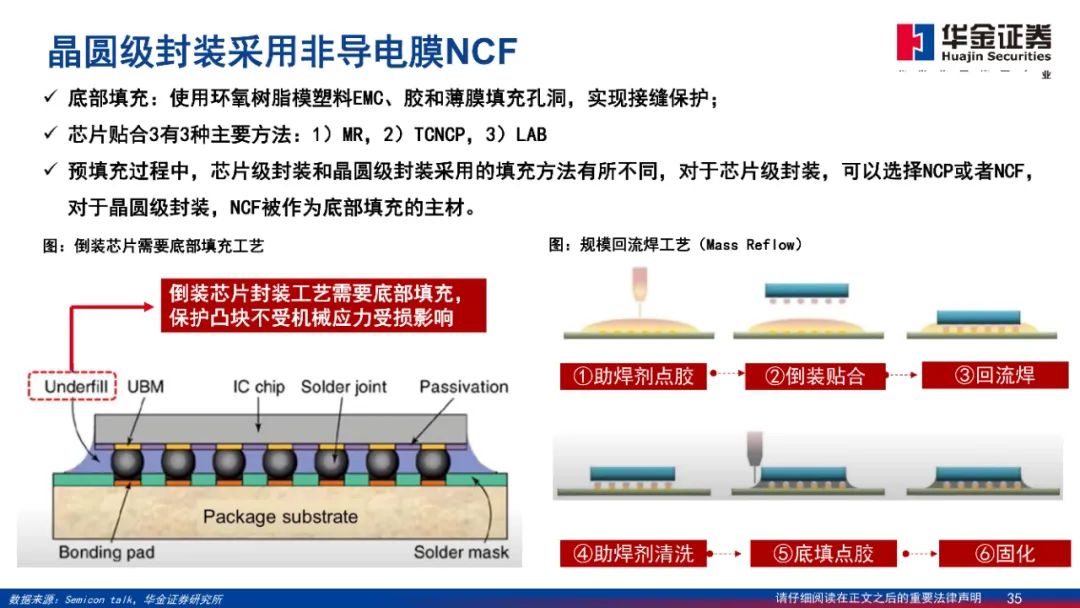

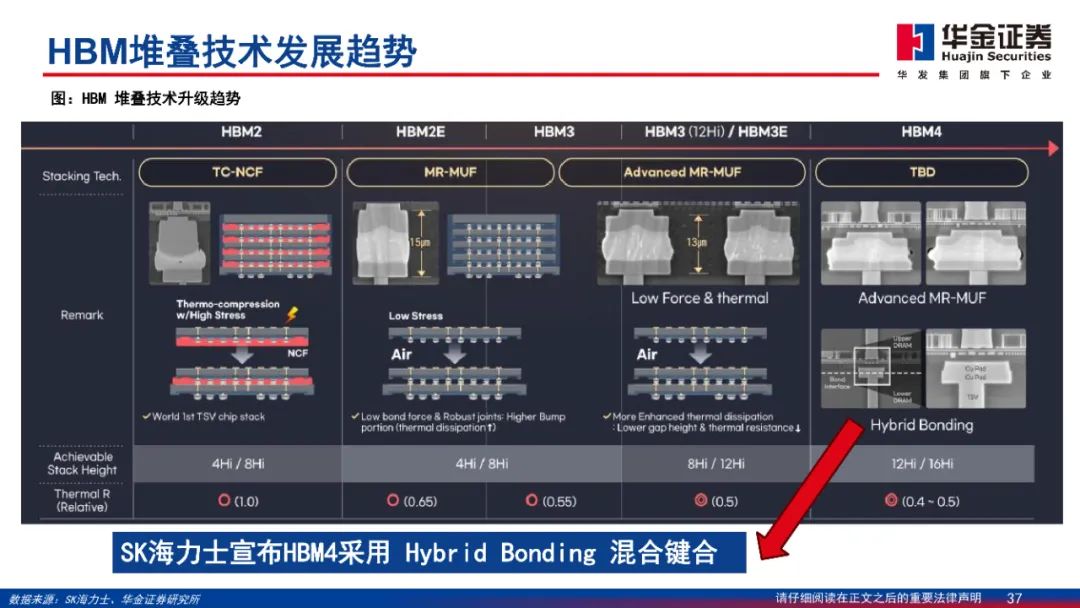
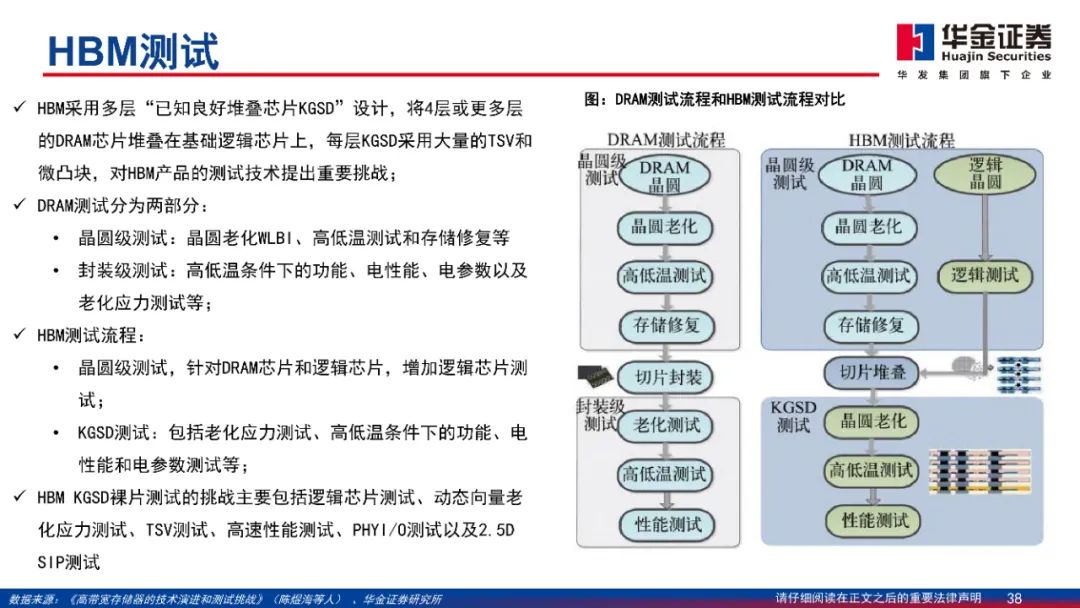
下载链接:暂无
关注博主公众号,获取最新技术博文:

谢谢您的关注

























 1927
1927

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










