
本文是一篇关于p-GaN门AlGaN/GaN高电子迁移率晶体管(HEMTs)的研究文章,发表于《应用物理杂志》(J. Appl. Phys.)2024年4月8日的期刊上。文章的标题为“Analysis and modeling of the influence of gate leakage current on threshold voltage and subthreshold swing in p-GaN gate AlGaN/GaN high electron mobility transistors”,作者为Kai Liu等人,隶属于西安电子科技大学宽带隙半导体技术国家重点实验室。文章的DOI为10.1063/5.0200487。
文章的主旨在于分析和建模栅极漏电流(IGS)对于阈值电压(VTH)和亚阈值摆幅(SS)的影响。通过制造不同栅金属功函数和栅极几何形状的p-GaN门AlGaN/GaN HEMTs,并观察到不同金属对于栅极几何形状的独特依赖性,这与传统的场效应晶体管不同。文章提出了一个新颖的混合物理模型,该模型结合了传统的电容分压模型和空穴注入模型,以解释这一现象,并且实验数据与模型结果吻合良好。研究表明,较高的IGS可以缓解由于光刻重叠误差引起的VTH不稳定性,并同时优化SS。这项工作为检查p-GaN HEMTs的开启机制提供了新的视角,有助于器件设计。
引言(Introduction)
文章首先介绍了GaN基器件在功率电子应用中取得的显著进展,归功于其出色的特性,如高电子迁移率、饱和速度和高击穿电场。为了简化电路并确保安全运行,增强型器件被认为更适合于电路设计。在实现增强型的各种方法中,p型掺杂GaN帽层结构因其在性能、可靠性和成本之间的最佳平衡而成为商业化的主要方法。
在p-GaN HEMTs中,栅极金属接触可以设计为欧姆接触或肖特基接触。肖特基接触因其在器件运行期间形成反向偏置二极管而受到广泛青睐,有效限制栅极漏电流并降低功率损耗。对于肖特基型p-GaN HEMT,栅堆由两个背靠背结构的二极管组成:栅极/p-GaN肖特基二极管和p-GaN/AlGaN/GaN pin二极管。这种结构的复杂性在探索开启机制时带来了挑战。尽管已经进行了广泛的研究并提出了相应的模型,但大多数模型都是从能带图分析中得出的理想化表示,没有考虑到工艺制造的复杂性。制造过程中不可避免的光刻重叠误差需要在设计器件结构时作为一个关键因素考虑。因此,为了防止栅金属偏移p-GaN层,p-GaN HEMT中栅金属的长度通常小于p-GaN层。这种差异已被证明会影响VTH和SS,显示出与传统场效应晶体管不同的独特变化趋势。栅极漏电流(IGS)的概念被认为是这一现象的潜在解释。Bakeroot等人通过TCAD模拟研究了IGS与VTH和SS之间的相关性,并提出IGS可以通过调节p-GaN/AlGaN势垒界面处的二维空穴气(2DHG)的行为来影响两者。Tallarico等人也建议IGS可以通过控制时间依赖的空穴充电/放电过程来影响动态VTH。然而,这一假设仍然需要通过系统的实验数据和相关的物理机制的清晰阐述来验证。栅金属可以通过改变金属功函数来调节IGS。因此,本文通过使用不同金属和几何形状的组合来研究这一现象,并进一步完善p-GaN HEMT的开启机制。
设备制造和测量结果(Devices Fabrication and Measurement Results)
文章展示了p-GaN HEMT的横截面示意图,并详细描述了外延片的生长、掺杂GaN通道、AlGaN势垒层和p-GaN帽层的厚度和掺杂浓度。制造过程包括使用感应耦合等离子体(ICP)系统去除栅极区域外的p-GaN帽层、干法蚀刻、欧姆接触金属的形成、离子注入实现介观隔离以及栅极金属的形成。栅极采用三种金属:Pt/Al/Ni、Ni/Al/Ni和Ti/Al/Ni。最后,在表面沉积了200 nm厚的Si3N4层作为钝化层。文章还详细描述了栅极长度(Lgate)、栅源长度(LGS)、栅漏长度(LGD)、栅宽以及p-GaN层长度(Lp−GaN)和偏移长度(Loffset)的尺寸。
文章通过Keithley 4200半导体参数分析仪测量了电流-电压特性,并定义了VTH为在给定的Loffset下,IDS和Lp−GaN的乘积保持恒定且等于10^−8 A mm的VGS值。文章展示了不同Loffset下,使用Ti、Ni和Pt栅金属的p-GaN HEMT的转移特性。对于Ti和Ni栅极,随着Loffset的增加,VTH表现出明显的正向偏移,而对于Pt栅极,这种偏移不明显。文章还展示了不同栅金属在不同Loffset下测量的10个器件的VTH趋势,以及不同栅金属在不同Loffset下测量的10个器件的SS趋势。此外,文章还展示了不同栅金属在不同Loffset下的IGS与转移特性的关系,并分析了IGS在不同Loffset和不同VGS下的测量值。
模型描述和讨论(Model Description and Discussion)
文章首先从能带图开始分析不同的VTH和SS变化规则,并介绍了在VGS=0 V时栅堆栈的能带图。在p-GaN HEMTs中,栅堆栈由肖特基二极管和pin二极管组成。文章提出了一个基于电容分压模型和空穴注入模型的混合物理模型来解释栅极漏电流对VTH和SS的影响。文章详细描述了模型的参数,包括AlGaN的介电常数、p-GaN的介电常数、AlGaN势垒层的厚度、p-GaN层中Mg的掺杂浓度、电子亲和能、GaN的能隙、金属功函数、空穴密度和价带态密度。文章还讨论了不同栅金属的肖特基势垒高度,并通过C-V曲线提取了不同金属的Vbi值。
文章进一步讨论了栅极几何形状对VTH和SS的影响,并提出了一个包含栅极几何形状的公式来计算Vsch和Vpin。文章还讨论了空穴注入模型对开启机制的影响,并假设一部分注入的空穴可能在p-GaN/AlGaN势垒处积累,导致AlGaN/GaN界面处的电子生成,从而促进通道的开启。文章提出了一个量化表示积累空穴的方法,并使用IGS作为积累空穴的代表性测量。文章还讨论了如何计算Vhole,即积累空穴对VTH的影响。
文章通过实验验证了提出的混合模型,并展示了不同栅金属在不同Loffset下Vpin和IGS/Lp−GaN之间的关系。文章还讨论了如何构建VTH模型,并解释了IGS与VTH和SS的关系。文章指出,较高的IGS可以诱导较低的VTH,但可以缓解由于光刻重叠误差引起的不稳定性,并可以优化SS。文章还讨论了不同栅金属的SS变化趋势,并提出了有效栅极电压VGS_eff的概念,用于评估SS。文章通过计算VGS_eff和VGS在不同Loffset下的变化,解释了不同栅金属的SS变化趋势。
结论(Conclusion)
文章总结了对不同栅金属和几何形状的p-GaN HEMT中VTH和SS变化的调查结果,并提出了一个新颖的混合模型来解释VTH模型。文章指出,一些注入的空穴将在AlGaN/GaN异质结处诱导相应的电子,从而帮助通道的开启。研究结果表明,较高的IGS将诱导较低的VTH,但可以缓解由于光刻重叠误差引起的不稳定性,并可以优化SS。提出的模型阐明了IGS与VTH和SS之间的关系,并为p-GaN HEMTs的设计提供了指导。
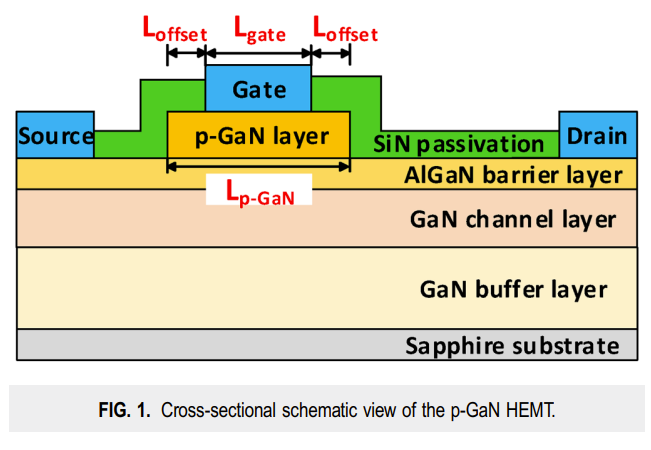
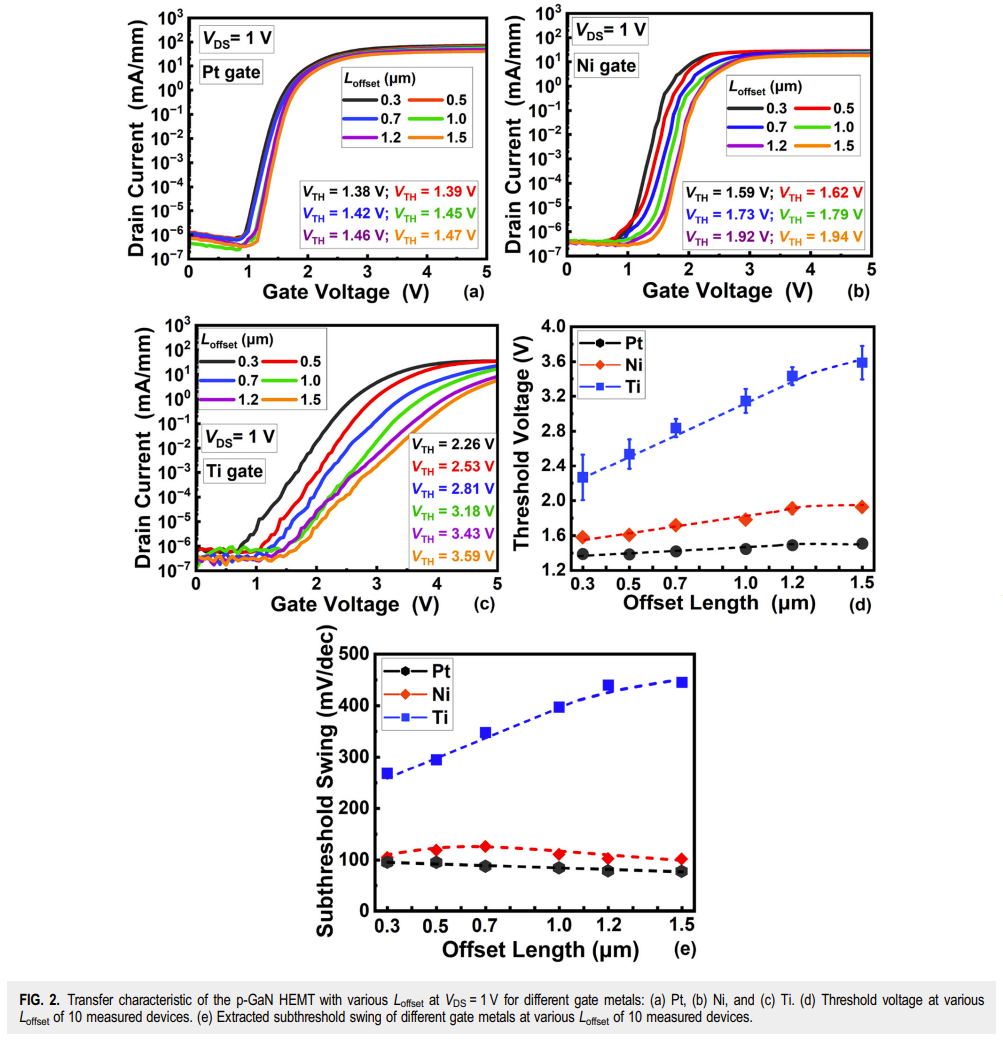
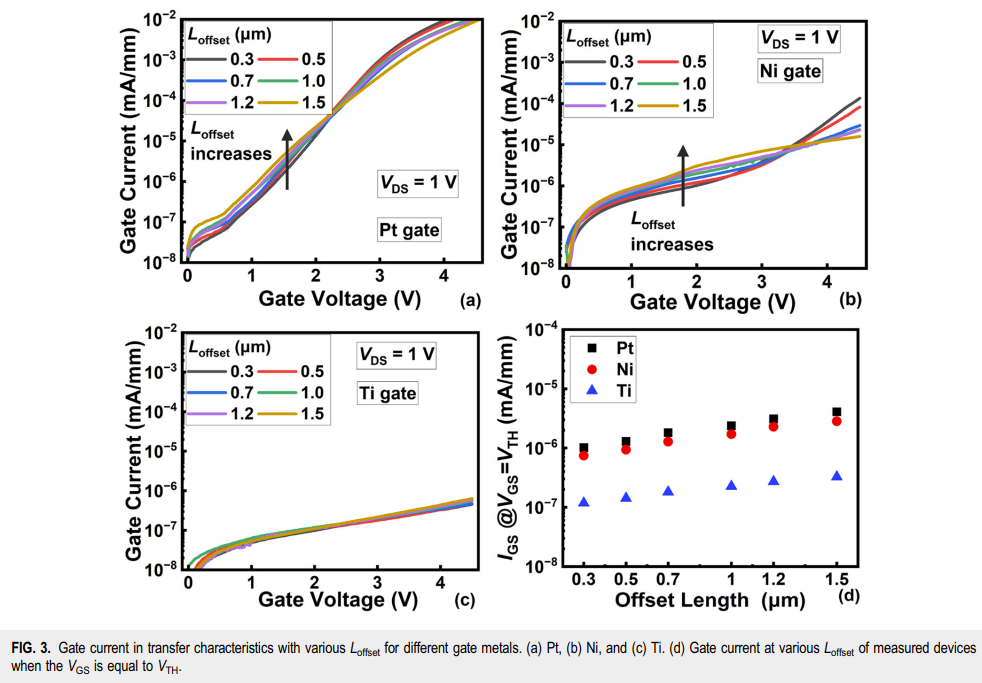
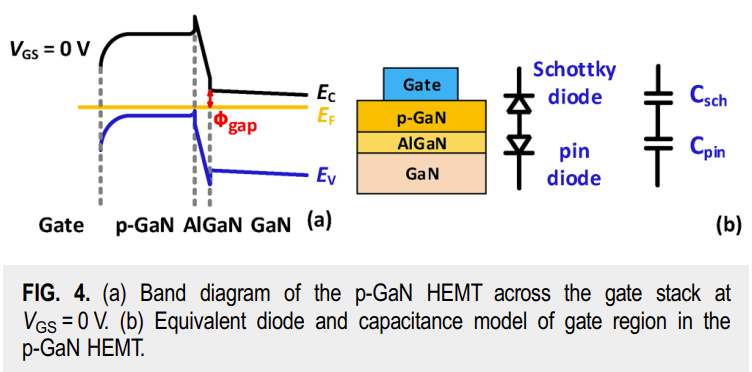
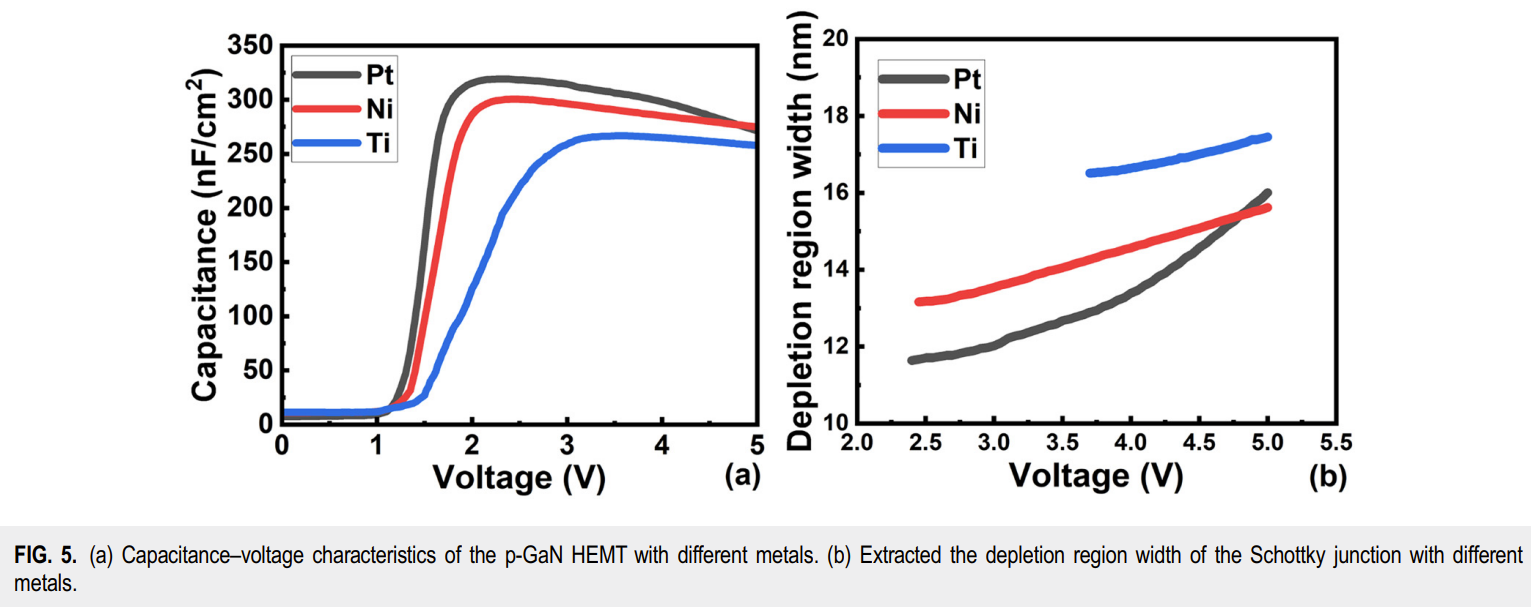


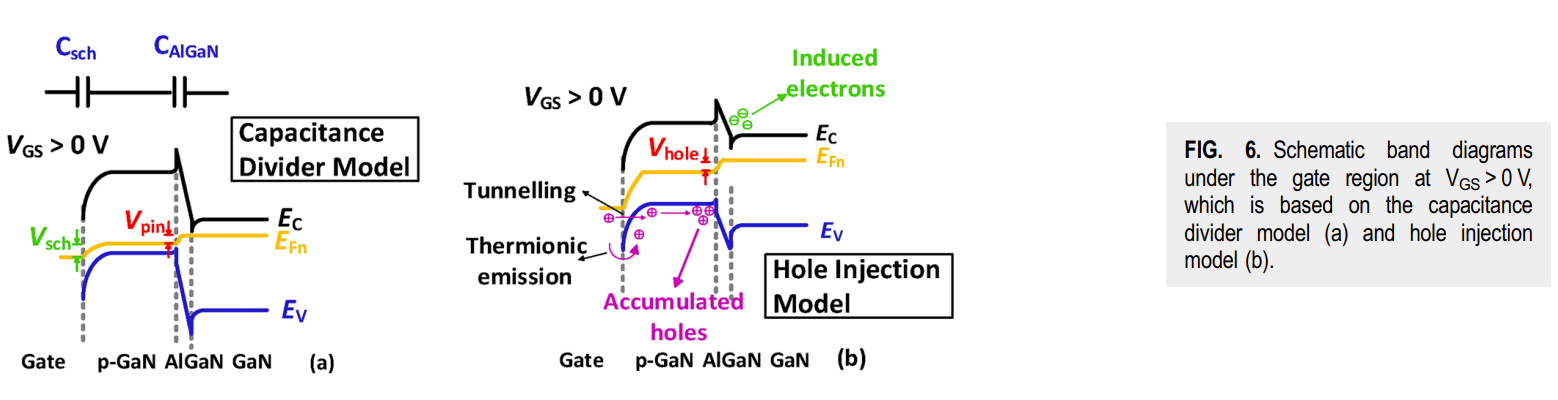
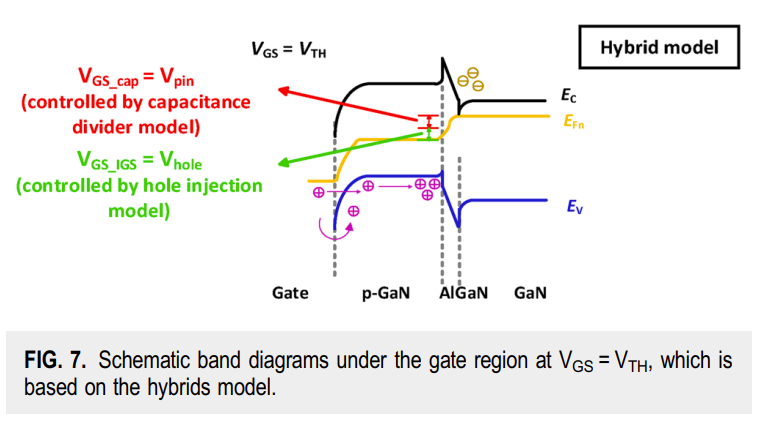
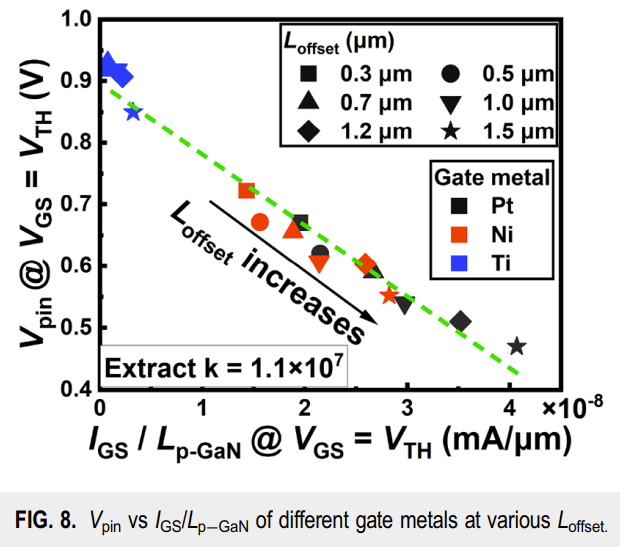
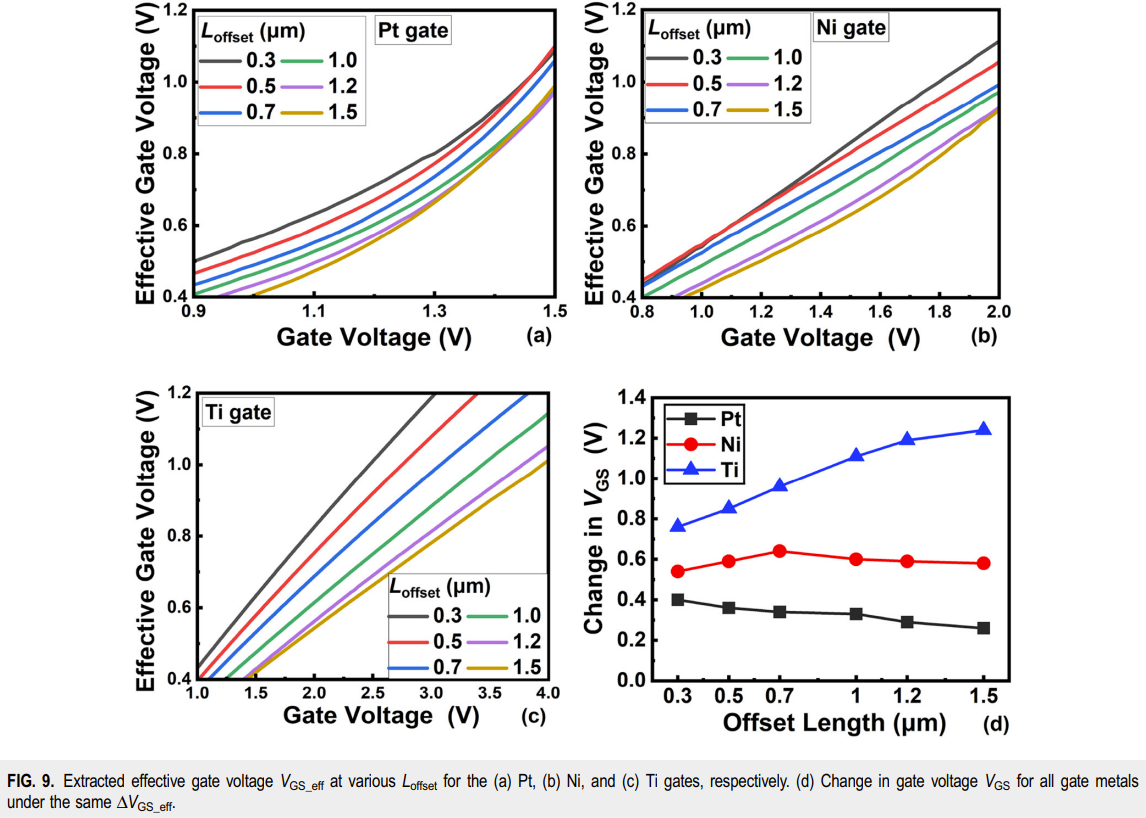
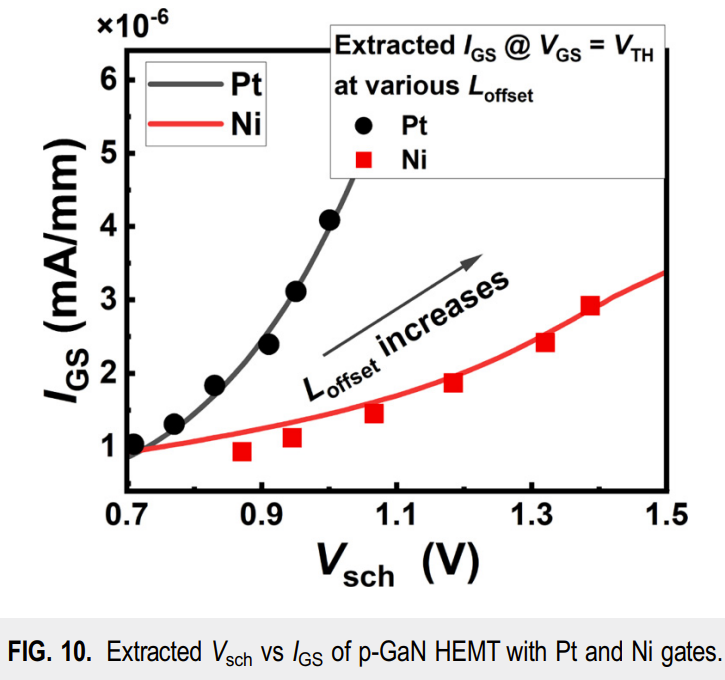























 1054
1054











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








