LOD效应
对于利用STI作隔离的深亚微米CMOS工艺制程技术,STI沟槽中填充的是隔离介质氧化物,由于硅衬底和隔离介质氧化物的热力膨胀系数不同,导致STI会产生压应力挤压邻近MOS的有源区,引起器件的电参数发生变化,这种效应称为STI应力效应,也称LOD效应(Length of Diffusion effect)。LOD效应主要影响器件的饱和电流(Idsat)和阈值电压(Vth)。
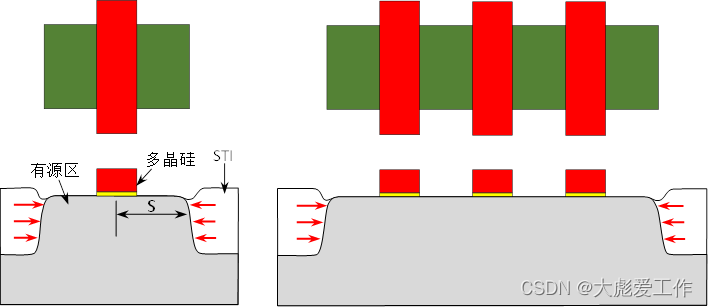
上图所示为MOS受LOD效应影响的剖面图,STI沟槽中填充的隔离介质氧化物会对MOS有源区产生应力挤压。

有源区受LOD效应应力随STI到器件沟道的距离变化,NMOS的速度会随着应力的增大而减小,而PMOS的速度会随着应力的增大而增大。
LOD效应对模拟电路的影响特别大,例如电流镜电路。
电流镜电路
电流镜是模拟集成电路中普遍存在的一种标准部件,它也出现在一些数字电路中。在传统的电压模式运算放大器设计中,电流镜用来产生偏置电流和作为有源负载。在新型电流模式模拟集成电路设计中,电流镜除了用来产生偏置电流外,还被广泛用来实现电流信号的复制或倍乘,极性互补的电流镜还可以实现差动一单端电流信号的变换。电流镜不仅是设计集成电路的基本单元电路,而且它本身就是一种典型的电流模式电路,在一些电流模式系统(例如高频连续时间滤波器、人工神经网络)中得到直接应用。
电流镜是电流控制电流源,下图是其示意图。
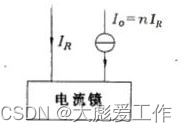
其中IR是由外部给定的基准电流,而Io是它的镜输出电流,n可以大于1、小于1或等于1。电流镜可以有多路输出电流。人们对电流镜所关心的问题是其输出电阻、Io对IR的跟随精度以及它对电源电压和温度的灵敏性等。
由两个N沟增强型MOS管组成的基本电流镜如下图所示。
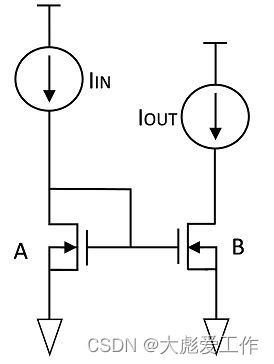
A、B两管的衬底与源短接,所以不存在体效应(对于NMOS器件,当其源端电位高于NMOS管的体(P衬底或地)电位时,阈值电压会增加。这一变化称为体效应。)A作输入管,其栅、漏极短接,VGD=0,所以T1总是工作在饱和区,而且由于栅、漏短接,其交流输人电阻也较低。B作输出管,也需要工作在饱和区,漏极的交流输出电阻很高。管子进入饱和区,iD几乎仅由vGS决定。A、B两个MOS管的vGS相等,可认为iD相等。此处相关基础知识详见《NMOS、PMOS的工作原理及相关内容整理》
伪器件电路
LOD效应对模拟电路影响特别大,例如,上图简单的电流镜电路中,器件B是器件A的器件宽度3倍,下图是增加了伪器件A1和B1的电流镜电路,目的是为了降低LOD效应,获得更好的电路匹配。伪器件的栅都是接地的,所以并没有实际的电路功能。
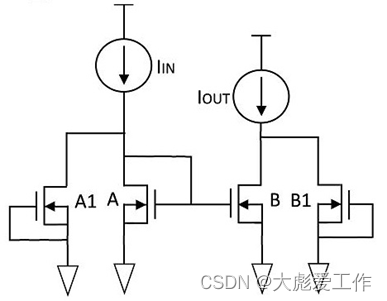
简单的电流镜电路版图如下图,它并没有考虑到电路的匹配。
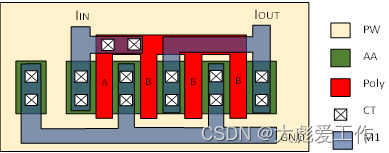
增加了伪器件的电流镜电路版图如下所示,伪器件的存在增加了STI到有效器件栅极的距离,削弱了LOD效应对器件性能的影响,可获得更好的电路匹配。
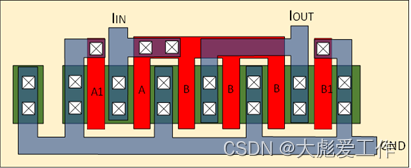





 LOD效应(Length of Diffusion effect)是指在深亚微米CMOS工艺中,由于STI隔离介质与硅衬底热膨胀系数差异导致的压应力影响,从而改变器件电参数的现象。这种效应主要影响MOSFET的饱和电流和阈值电压,尤其是对模拟电路如电流镜电路造成显著影响。电流镜是模拟集成电路中的关键部件,用于产生和复制电流。为减轻LOD效应,可以采用增加伪器件的方法,增加STI到有效器件栅极的距离,从而改善电路匹配和性能。
LOD效应(Length of Diffusion effect)是指在深亚微米CMOS工艺中,由于STI隔离介质与硅衬底热膨胀系数差异导致的压应力影响,从而改变器件电参数的现象。这种效应主要影响MOSFET的饱和电流和阈值电压,尤其是对模拟电路如电流镜电路造成显著影响。电流镜是模拟集成电路中的关键部件,用于产生和复制电流。为减轻LOD效应,可以采用增加伪器件的方法,增加STI到有效器件栅极的距离,从而改善电路匹配和性能。
















 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








