1.CP测试
CP测试,英文全称Circuit Probing、Chip Probing,也称为晶圆测试或中测,测试-个Die都能满足器件对象是整片wafer的每一个Die,目的是确保整片wafer中的每一的特征或者设计规格书,通常包括电压、电流、时序和功能的验证。同时也可以用来检测fab厂制造的工艺水平。

第一个黑色的为晶圆盒 wafer就放在这里面
FLAT(扁平的)和NOTCH(缺口)分辨wafer的方向。
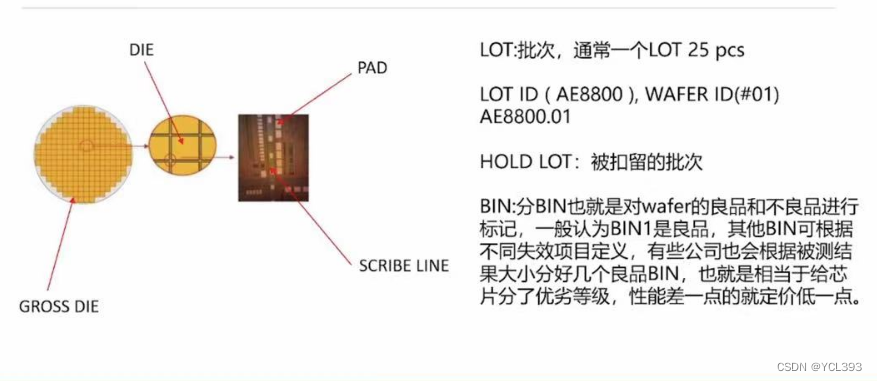
晶圆上由很多DIE组成,DIE与DIE之间有一定的间隙被称为SCRIBE LINE,因为DIE最后会被切割下来进行封装作为单个的芯片使用,DIE上面的白色方块被称为PAD,测试中需要施加或者测量信号的地方,(CP测试中探针就是扎在PAD上来进行测试的)。
CP【Chip Probing】顾名思义就是用探针【Probe】来扎Wafer上晶片的pad,把各类信号输入进晶片,把晶片输出响应抓取并进行比较和计算。需要应用的设备主要是自动测试设备【ATE】+探针台【Prober】+仪器仪表,需要制作的硬件是探针卡【Probe Card】。
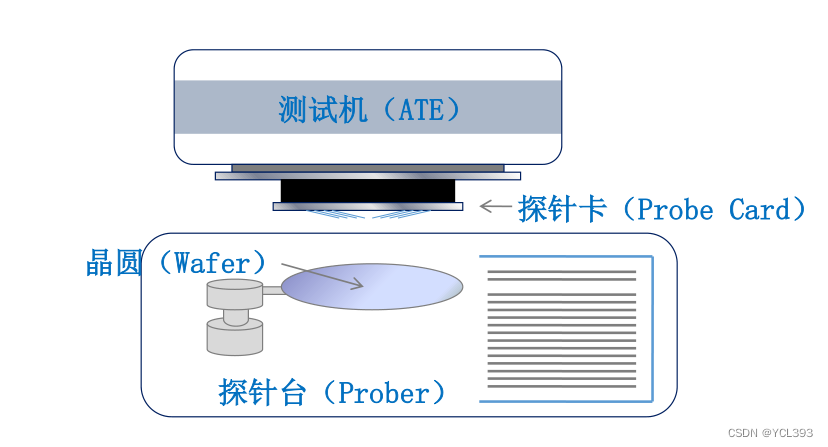
下面对CP的测试器件进行介绍
1、 Probe card(探针卡)负责固定探针和晶圆直接接触,主要是控制卡(PCB)和探针两个部分。目的是将探针卡上的探针直接与晶片上的pad或者bump直接接触,引出晶片信号再配合周边测试仪器与软件控制达到自动化测量读取芯片电信号的目的。3
探针作用:将测试机的信号接入并将其传递到针尖端;通过探针接触PAD,完成电信号的施加和读取。
在测试时针卡不动,wafer每次移动一颗die的距离,直至测完整片。
2、 Probe(CHUCK)任务“精准控制wafer的移动,让那个探针每次都能精准的扎在die上。
CP测试的流程

CP测试完成后,输出包含测试数据(datalog)和MAP
Silicon Wafer Map Analysis
测试数据通常以一颗die为单位统计。主要包含die的位置信息,即XY坐标,测试项及测试结果PASS/FAIL(FAIL品又称REJECT)分BIN信息等。
MAP能够更直观的看出整片wafer的良率情况MAP上呈现的分BIN都是Hard Bin,此外还有SoftBin。同时,MAP也需要提供到封装环节,作为封装选die的依据。

测试数据通常有多种格式,不同厂家的测试机一般都会有自己的格式文件,但是都能同步输出stdfcsv,txt等格式文件。
其中STDF(Standard Test Data Format)(标准测试数据格式)是半导体测试行业的最主要的数据格式,包含了summary信息和所有测试项的测试结果;是半导体行业芯片测试数据的存储规范。
Python支持对stdf的解析,需要可以尝试。

CP测试的具体意义
1.通常在芯片封装阶段时,有些管脚会被封装在芯片内部,
导致有些功能无法在封装后进行测试,因此Wafer中进行CP测试最为合适
2.Wafer制作完成之后,由于工艺偏差、设备等原因引起的制造缺陷,分布在Wafer上的裸DIE中会有一定量的残次品。CP测试的目的就是在封装前将这些残次品找出来(Wafer Sort)同时还可以避免被封装后无法测试芯片性能,优化生产流程,简化步骤,同时提高出厂的良品率,缩减后续封装测试的成本。
3.另外,有些公司会根据CP测试的结果,将芯片划分等级,将这些产品投入不同的市场,购买时需要注意这一点。
在下一章再对FT测试进行讲解。























 3177
3177

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








