前言
在许多 IC 工艺辅助配件进行蝴蝶研磨(背面研磨、研磨),使装片薄形化,例如:用巧克力蛋糕及智能封装等。到200~40μm。在珍珠打磨之后,有许多产品需要进行工艺,包括:离子布植(离子实现)、热处理(热处理)和钯金属(背面金属;BM)沉积等。晶移动研磨曲后产生的爆发和翘曲,如果会过大,就会扩展到锐化的区域。工艺之良率例如:胶膜去除(De-tap)、使用持取(Wafer Handling)和封装(Packaging & Assembly)等工艺,必须工艺之能及破坏层。

硅的湿式刻蚀原理及机台设计考虑
在半导体工艺中,硅的腐蚀刻蚀是一种各向同性刻蚀硅的腐蚀腐蚀液,通常由不同的火花产生的硝化腐蚀。酸HNO3)、氢氟酸(HF)及一种缓冲液(例)如:水、三个、三个)所组成。刻蚀的反应机构,包括两个步骤:(1)首先是利用硝子酸(HNO3)来硅硅表面,如式1 及式 2 所示;(2)硅衬底所形成的表面氧化物(SiO2)
扩散反应控制
化学反应控制
反应物反应生成物
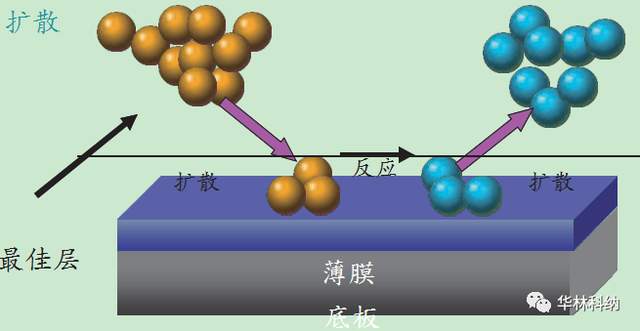
结论
使用硅湿式刻蚀工艺,可以大幅度地删除袖子打磨所产生之激及损伤层,增加了大量针强度。对硅湿式刻蚀工艺原理及设备之设计考虑作一塑一探讨。本研究弘扬科技所设计制造之自动化UFO设备,进行硅湿式刻蚀工艺采用,利用硅设备刻蚀工艺利用,借流流之特殊设计与机构培育。实验结果显示 12 英寸硅片吸附吸收度可达到 5%。弘塑科技 UFO M3-Type 支架可持取曲曲度达±4mm,在薄化吸附上取能力方面,可过滤取一般最大的最薄厚度为150μm,太鼓回收的最薄厚度为50μm。





















 322
322











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








