分享以下整理的一些关于SMT焊接缺陷的中英文对照,供有需要的朋友参考。
常见焊接缺陷及中英文对照
空焊(Solder Skip / Solder Empty)
空焊是指在焊接点上没有任何焊料附着的现象。这种问题常见于焊膏印刷不良、组件引脚或焊盘污染以及炉温配置不当的情况下。根据IPC-A-610的定义,这种缺陷通常归类为「Non-Wetting」,即焊料未能有效润湿焊点。
解决方案:
- 优化焊膏印刷工艺,确保焊膏正确覆盖焊盘。
- 确保焊接前的清洁度,避免氧化或污染影响焊接质量。
- 调整回流焊炉温度设置,保证焊料充分熔化并覆盖焊点。
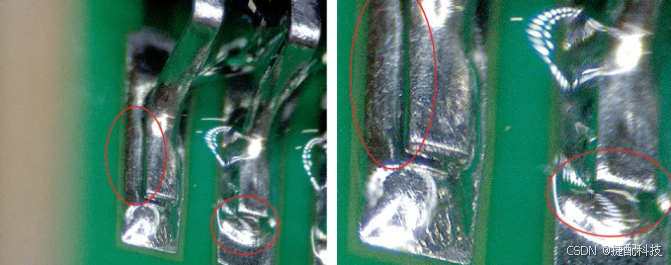
冷焊(Cold Soldering)
冷焊是一种焊点表面呈现灰暗、不均匀和多孔外观的缺陷,通常由于焊接温度不足或焊接时间过短所致。这类缺陷多见于早期使用红外线回流炉的时代,当时热量传递不均容易导致焊接不良。如今,热风对流式回流炉已经普及,使这类问题大幅减少。
解决方案:
- 确保焊接设备达到足够的加热能力,尤其是手工焊接时要选择合适的焊铁功率。
- 调整焊接时间,保证焊点能够充分润湿。
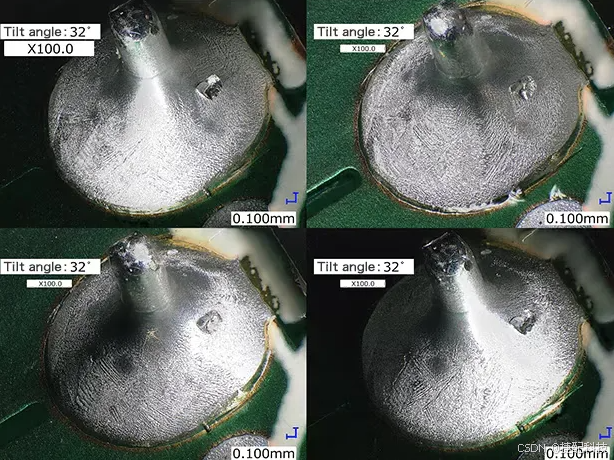
虚焊(Non-Wetting)
虚焊是指焊料未能有效附着于焊点表面,导致焊接强度不足。这通常发生在细间距IC焊接过程中。零件引脚或焊盘氧化是主要原因,此外,焊膏沉积量不足或分布不均也会导致此问题。
检测与解决方案:
使用目视检查和X光检查技术来确保焊接质量。
在焊接前,对组件和焊盘进行表面处理,以去除氧化层。
包焊(Solder Encapsulation)
包焊指的是焊锡包覆了焊点表面,但实际内部焊接不良。这种现象多见于手工焊接,特别是当组件引脚氧化或焊盘连接大面积金属时,焊接过程中的热量无法有效传递,导致内部焊接不完全。
解决方案:
·加强对焊接组件和焊盘的表面处理,确保焊接表面没有氧化物。
·设计电路板时,对大面积金属连接局域进行热隔离处理,以防止焊接热量迅速流失。
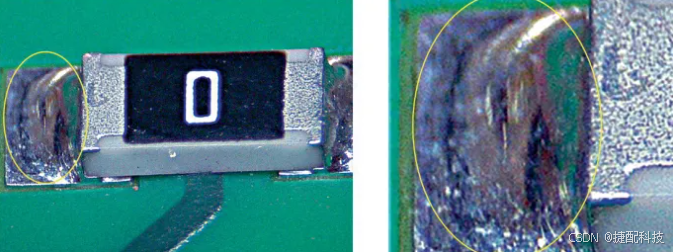
缩锡(De-Wetting)
缩锡是指焊料在润湿表面后回缩,形成不规则的锡堆,并且焊点表面裸露出金属。这种现象通常是由于组件或焊盘氧化、焊接材料不兼容导致的。
预防措施:
- 使用质量可靠的组件,并在焊接前进行适当的清洁处理。
- 确保使用的焊料和助焊剂与基材兼容。
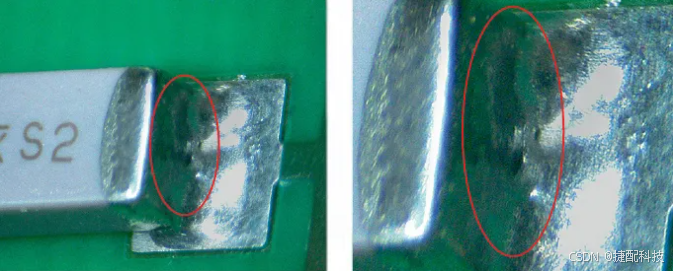
锡桥(Solder Bridge)
锡桥是指IC引脚之间因焊锡过量而产生的短路现象,属于短路(Solder Short)的表现之一。

短路(Solder Short)
焊锡过量或不当焊接导致的短路现象。
锡少(Solder Insufficient)
焊点锡量不足,可能影响焊接强度。
锡须(Whisker)
无铅制程中,锡须问题尤其突出,因为无铅焊锡更易生成锡须,特别是在纯锡工艺中。
偏移(Component Shifted)
组件在焊接过程中出现偏移,未对准焊盘。
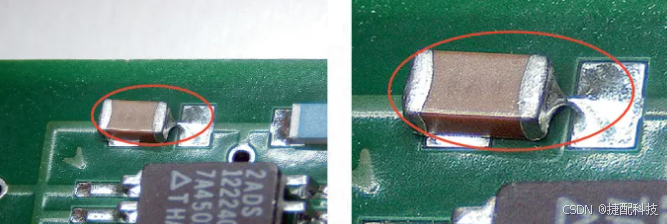
缺件(Component Missed)
组件在组装过程中未能成功放置或遗漏。
墓碑(Tombstone)
墓碑现象指的是组件在回流焊或过锡炉后如墓碑般直立起来。这个用词形象生动,全球通用。
极性反(Wrong Polarity)
电子组件的极性接反,通常发生在极性敏感的组件上,如二极管和电容器。

























 188
188

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








