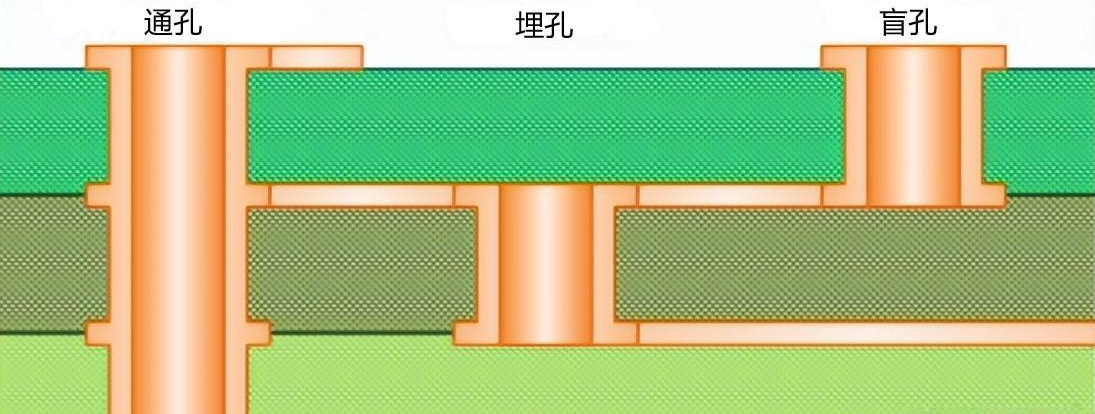
一、现代塞孔工艺的准则
根据电子装配端的实际需求,当前导通孔处理需满足三大核心标准:
1. 导电可靠性:确保孔壁铜层完整,锡铅镀层厚度≥4μm
2. 阻隔防护性:有效防止助焊剂渗透、锡珠残留及真空吸附异常
3. 表面平整度:BGA区域孔位凸凹公差控制在±25μm以内,杜绝虚焊隐患
二、主流工艺方案对比
通过长期生产验证,业界已形成四种典型工艺流程,各具特点:
方案A:后段塞孔处理
工艺流程:阻焊层→HAL整平→导通孔填充→固化定型
优势:避免热风整平导致的油墨脱落
局限:表面平整度不足,BGA区域存在虚焊风险
方案B:前段铝片塞孔
工艺流程:数控钻孔→铝片定位→油墨填充→精密研磨→线路成型
创新点:采用高硬度热固树脂,实现孔壁紧密结合
技术门槛:需配套铜厚控制及精密研磨设备
方案C:同步阻焊处理
工艺流程:导通孔填充→阻焊层同步印刷→曝光显影→双重固化
突破性:将传统7道工序压缩至5道工序
核心控制:丝网目数选择(36T-43T)及压力参数优化
方案D:复合固化工艺
工艺流程:预填充→阶段固化→表面精磨→二次阻焊
平衡点:兼顾生产效率与孔内结构稳定性
注意要点:需防范二次热冲击导致的微孔气爆

三、生产实践中的关键控制
1. 材料适配性:针对不同板材选用匹配的感光/热固油墨
2. 过程监控点:建立塞孔饱满度检测标准(孔口微凸为佳)
3. 设备改造:传统丝印机加装微孔抽气装置,消除气泡残留
4. 失效预防:开发热循环测试方案,模拟验证孔内结构稳定性
值得关注的是,随着IC载板向0.2mm以下孔径发展,传统机械塞孔方式已显现局限性。我们通过改进配方粘度(控制在120-150Pa·s范围)和引入真空辅助填充技术,成功将微孔填充合格率提升至98.6%。这种工艺改良在5G毫米波模块基板生产中表现尤为突出,经实测可承受-55℃~125℃的极端温度冲击。
当前行业正朝着智能化控制方向发展,通过在线光学检测系统实时监控塞孔深度,结合MES系统实现工艺参数动态调整。这种数字化改造不仅将平均处理时间缩短了35%,更重要的是建立了工艺数据库,为不同客户需求提供定制化解决方案。
未来挑战将集中在超微孔(≤50μm)处理领域,需要开发新型纳米填充材料与喷印工艺。我们已开展相关预研工作,初步实验显示,采用压电驱动式微滴喷射技术,配合低介电复合树脂,可在保持信号完整性的同时实现亚微米级平整度,这或将成为下一代HDI板的标准工艺。

























 375
375

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








