【懂得都懂】学弟学妹们理性参考,不要照抄。
一、实验目的与实验仪器(5%)
1.1 实验目的
- 拓展专业知识,了解新型器件发展趋势;
- 深入掌握半导体器件仿真工具的使用方法与器件建模仿真流程;
- 了解锗硅材料以及Si/SiGe异质结的基本特性,以及对晶体管器件特性的影响,提出设计或优化的方法。
1.2 实验仪器
基于silvcao TCAD仿真平台探究SOI技术构建Silicon Germanium Heterojunction Bipolar Transistor(HBT) 的各项指标。
二、实验原理分析(10%)
2.1 锗硅异质结双极晶体管 Silicon Germanium Heterojunction Bipolar Transistor
锗硅异质结双极晶体管(GeSi HBT)是一种高性能射频(RF)器件,具有较高的开关速度、低噪声和高功率增益等特点,广泛应用于通信、射频和微波电子学领域。GeSi HBT的工作原理与传统的双极晶体管类似,但其采用了硅和锗两种材料的异质结构,从而实现了更高的性能和更广泛的应用。
GeSi HBT的结构由三个部分组成:基底、外延层和电极。其中,基底是硅材料,外延层则是锗材料,电极则由金属材料制成。在GeSi HBT中,外延层的锗材料具有高载流子迁移率和高电导率,可以提高电子的速度和流动性能,从而实现更高的开关速度和功率增益。同时,锗材料的热导率也比硅材料高,可以有效地散热,提高器件的可靠性和稳定性。
GeSi HBT的工作原理基于PN结的原理。当电压施加到PN结上时,会形成电场,将电子和空穴分离,形成电流。在GeSi HBT中,当电压施加到基极和发射极之间时,会形成一个电子注,电子注会穿过PN结,进入锗外延层,然后流向集电极。在电子注流动的过程中,会发生电子与空穴的复合,从而释放出能量,这就是GeSi HBT的功率增益。
GeSi HBT的工作原理还涉及到两个重要的参数:电流增益和射频增益。电流增益表示基极电流与集电极电流之间的比率,通常用hFE来表示。射频增益则表示器件在射频频率下的增益,通常用S参数来描述。在实际应用中,GeSi HBT的性能取决于其设计和制造的精度,需要通过优化器件结构和工艺流程,以实现更高的性能和更广泛的应用。
总之,GeSi HBT作为一种高性能射频器件,具有较高的开关速度、低噪声和高功率增益等特点,广泛应用于通信、射频和微波电子学领域。其工作原理基于PN结的原理,通过控制电压和电流来实现信号放大和功率放大的功能。随着射频技术的不断发展和应用需求的不断增加,GeSi HBT的应用前景将越来越广阔。
2.2 SiGe异质结双极晶体管(HBT)的优势
1.高频性能优异:
SiGe HBT具有高迁移率,因此可以获得更高的集电极最大截止频率。同时,由于其高电子迁移率,SiGe HBT也可以显示出更好的热噪声性能。
2.低噪声:
SiGe HBT可以获得更低的基极噪声系数,因为它们具有更高的迁移率和更小的基极电流。这使得它们非常适合在无线通信和微波电路中使用。
3.高集电极电压:
相比较于其他半导体材料,SiGe HBT具有更高的集电极电压。这为高功率应用提供了更多的余地
4.低功耗:
SiGe HBT具有较低的漏电流,从而降低了功耗和热量损失。
2.3 SiGe异质结双极晶体管(HBT)的典型器件结构
1、基底:通常使用硅(Si)作为基底材料。
2、基极:基极是HBT的控制区域,通常由掺杂较少的材料(如纯Ge)构成。基极用于控制电流的流动。
3、发射极:发射极位于基极的一侧,通常由高掺杂的材料(如Si)构成。发射极提供电子注入的源头。
4、集电极:集电极位于基极的另一侧,通常由高掺杂的材料(如Si)构成。集电极用于收集电子流并输出电流信号。
5、硅酸盐层:硅酸盐层是用于隔离不同区域之间的绝缘层。
6、接触层:接触层用于提供电极连接,通常由金属材料(如铝)构成。
2.4 SiGe材料与体Si材料的区别、Si/SiGe异质结的物理机理
1. SiGe材料与体Si材料的区别
(1)组成:SiGe是由硅(Si)和锗(Ge)元素组成的合金材料,其中硅和锗的比例可以根据需要进行调节。而体Si是纯硅的晶体结构。
(2)晶体结构:SiGe和体Si具有相似的晶体结构,都属于立方晶系,但由于锗与硅的原子尺寸略有不同,SiGe中会出现晶格畸变。
(3)物理性质:SiGe具有比体Si更大的晶格常数、热膨胀系数和导热系数。由于锗的加入,SiGe的能带结构发生变化,导致其电学和光学性质也发生了改变。
(4)带隙:体Si的能带隙为间接带隙,约为1.12电子伏特 (eV),而SiGe材料的能带隙可以通过调整Si和Ge的比例来实现从直接带隙到间接带隙的变化
2. Si/SiGe异质结的物理机理
(1)晶格匹配:SiGe合金与单晶Si材料之间存在晶格常数差异,导致晶格畸变。在Si/SiGe异质结界面上,晶格会产生失配应变,即晶体的原子排列出现微小的畸变。这种畸变会引起介电常数和晶格常数的变化,从而影响电子和光子的传输性质。
(2)能带偏移:由于Si和Ge具有不同的能带结构,SiGe合金的能带结构也会发生变化。当Si和SiGe相接触形成异质结时,它们的能带会发生对齐或偏移。这种能带对齐或偏移会导致电子能级或空穴能级在界面处形成能带弯曲或能带偏移区域,从而影响载流子的传输和能量态密度分布。
在Si/SiGe异质结中,晶格畸变和能带偏移相互作用,共同影响了材料的物理性质。具体来说,晶格畸变可以引起应变效应,改变载流子的迁移率和能带结构,从而影响电子与空穴的输运特性。而能带偏移则影响界面态的分布、载流子的传输以及异质结界面处的能量态密度。
2.5 SiGe HBT的应用场景
1. 通信系统:SiGe HBT可用于射频前端模块、功率放大器和频率合成器等部件,用于移动通信、卫星通信和无线网络设备。
2. 射频识别(RFID):SiGe HBT可用于RFID标签和读写器中的射频前端电路,提高了通信速度和性能。
3. 无线局域网(WiFi):SiGe HBT可用于WiFi路由器、网络接入点和其他无线设备中的射频前端模块,提供稳定的无线连接。
4. 毫米波雷达:SiGe HBT可用于毫米波雷达系统中的低噪声放大器和频率合成器,用于汽
车雷达、无人机和安防系统等。
5. 光通信:SiGe HBT可用于光接收机中的前置放大器,提高了光信号的检测灵敏度。
6. 航空航天电子设备:SiGe HBT可用于航空航天电子设备中的射频前端模块和功率放大器,提供可靠的通信和雷达功能。
7. 医疗设备:SiGe HBT可用于医疗设备中的射频信号处理和传感器接口,用于医疗成像、无线监测和诊断设备。
8. 军事应用:SiGe HBT可用于军事雷达、通信系统和无线电频谱监测设备,提供高性能的射频功能和信号处理能力。
三、实验步骤(20%)
根据实验代码构建SiGe HBT,并理解工艺实现过程
1. 建立网格,定义衬底浓度
2. 在材料上做phos重掺杂区域方便形成欧姆接触(离子注入做预扩散,热扩散做再扩散)
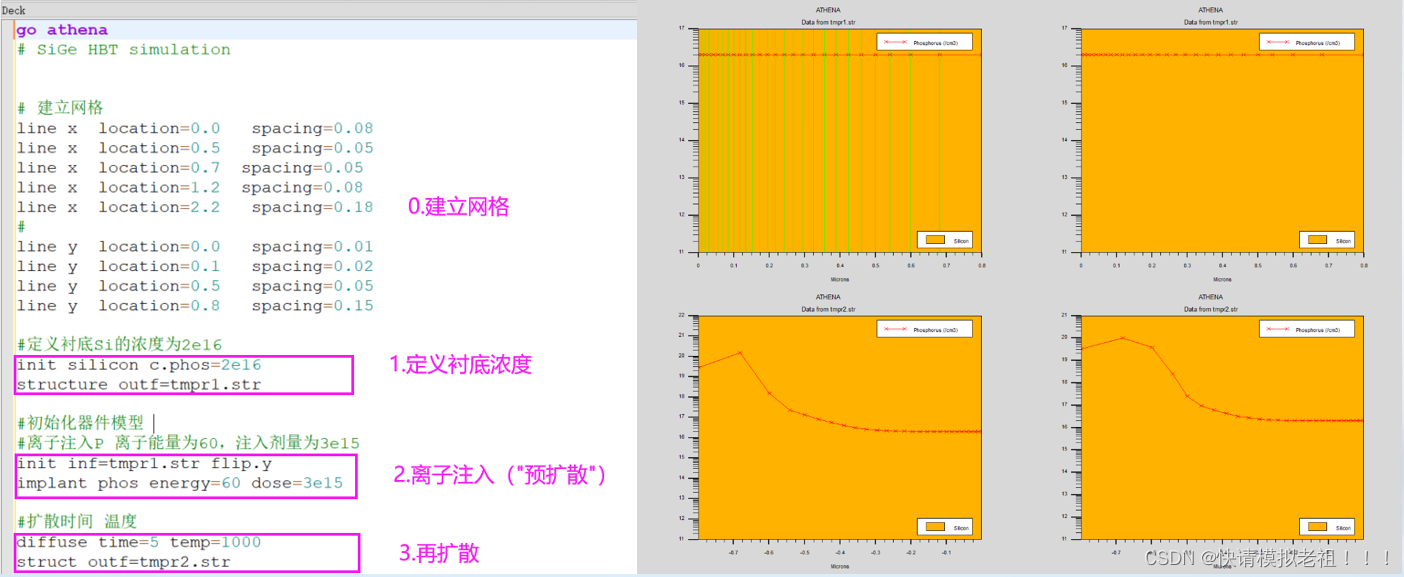
3. 在器件的另一侧淀积SiGe,离子注入Boron(改善其导电性方便与基极构成良好接触)
4. 在SiGe上淀积Si,离子注入+热扩散改善导电性
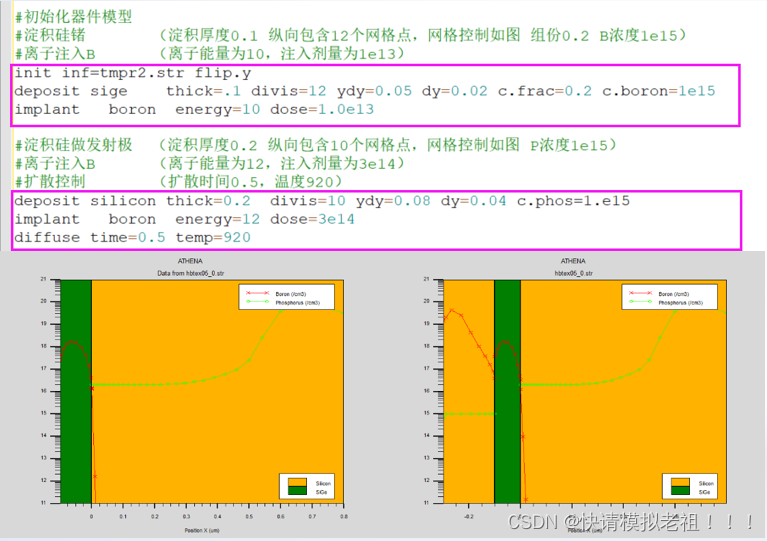
5. 制作发射极(涂胶à光刻à光刻区离子注入à扩散)
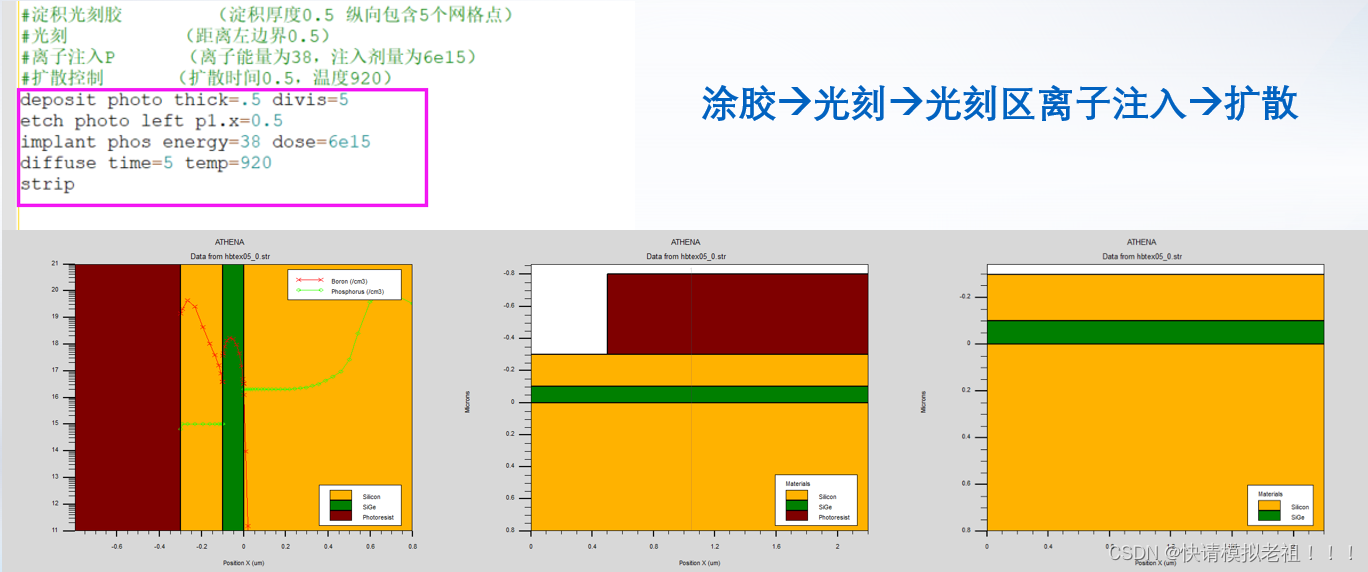
6. 制作电极(淀积AI,光刻)

由刚才工艺过程得到器件模型,对器件模型进行讨论
1. 平衡状态下的器件模型(区域材料浓度,能带结构)
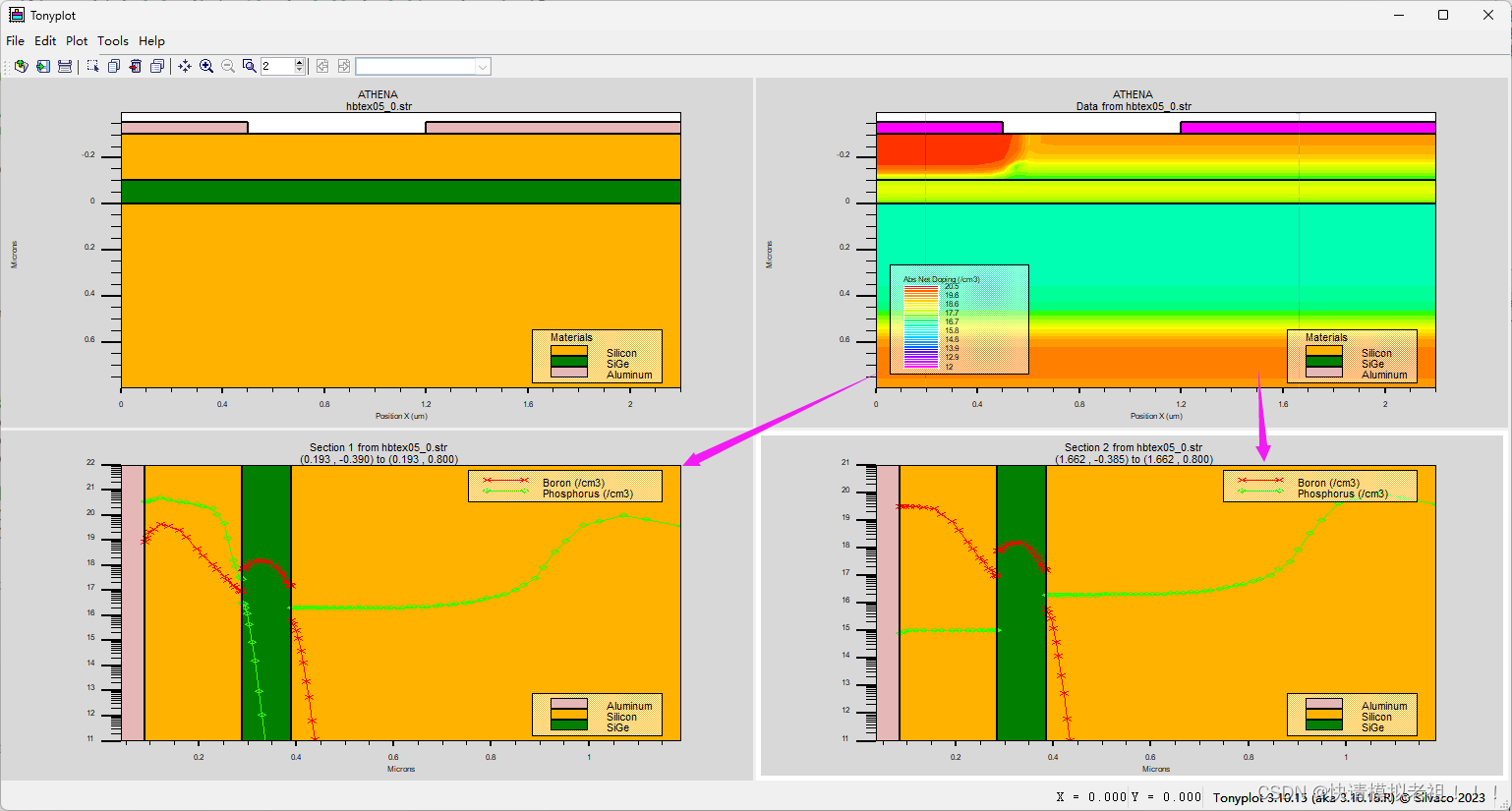
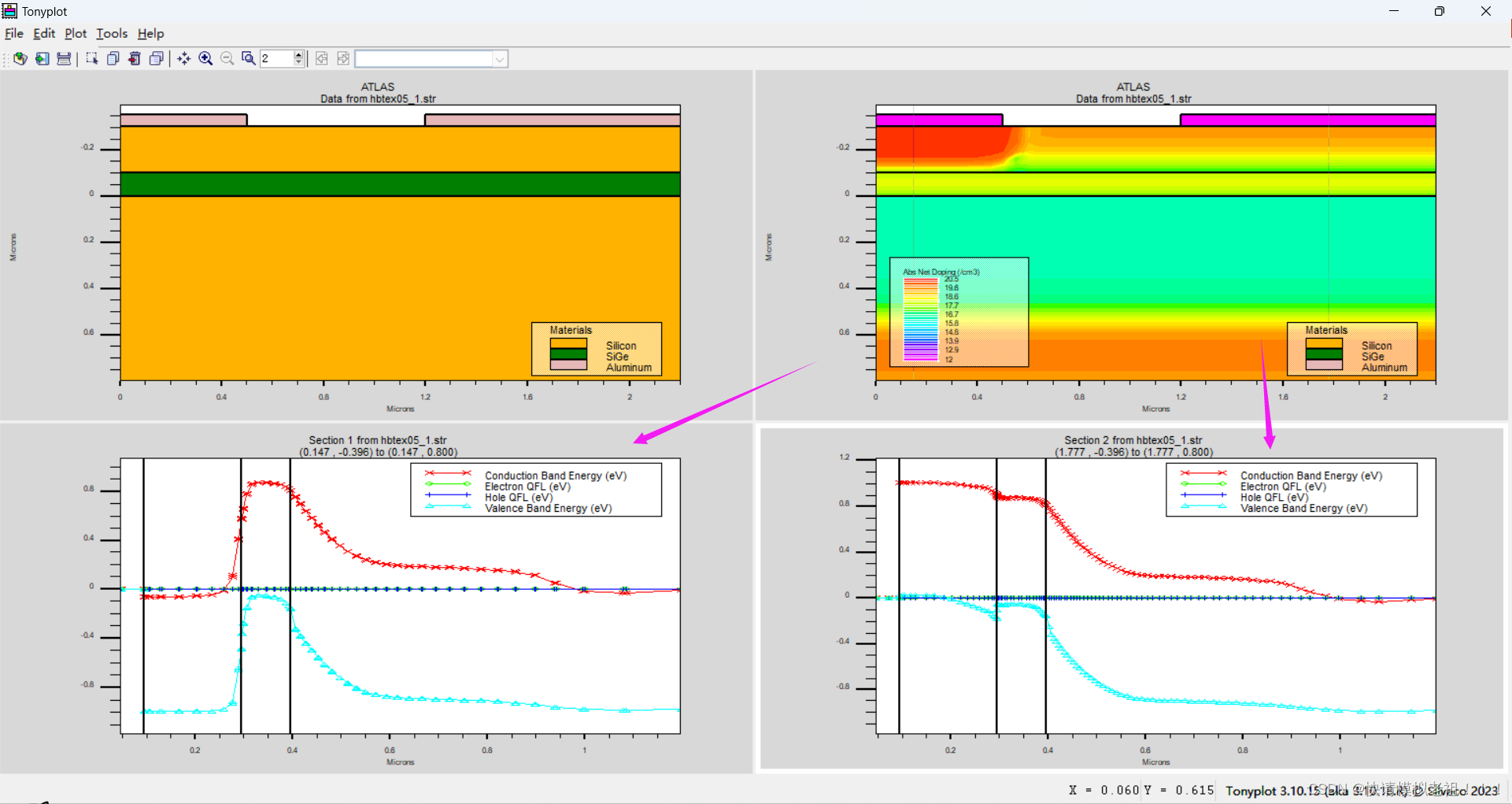
2. 当外加集电极电压为2V条件下的器件模型(载流子浓度,能带结构)
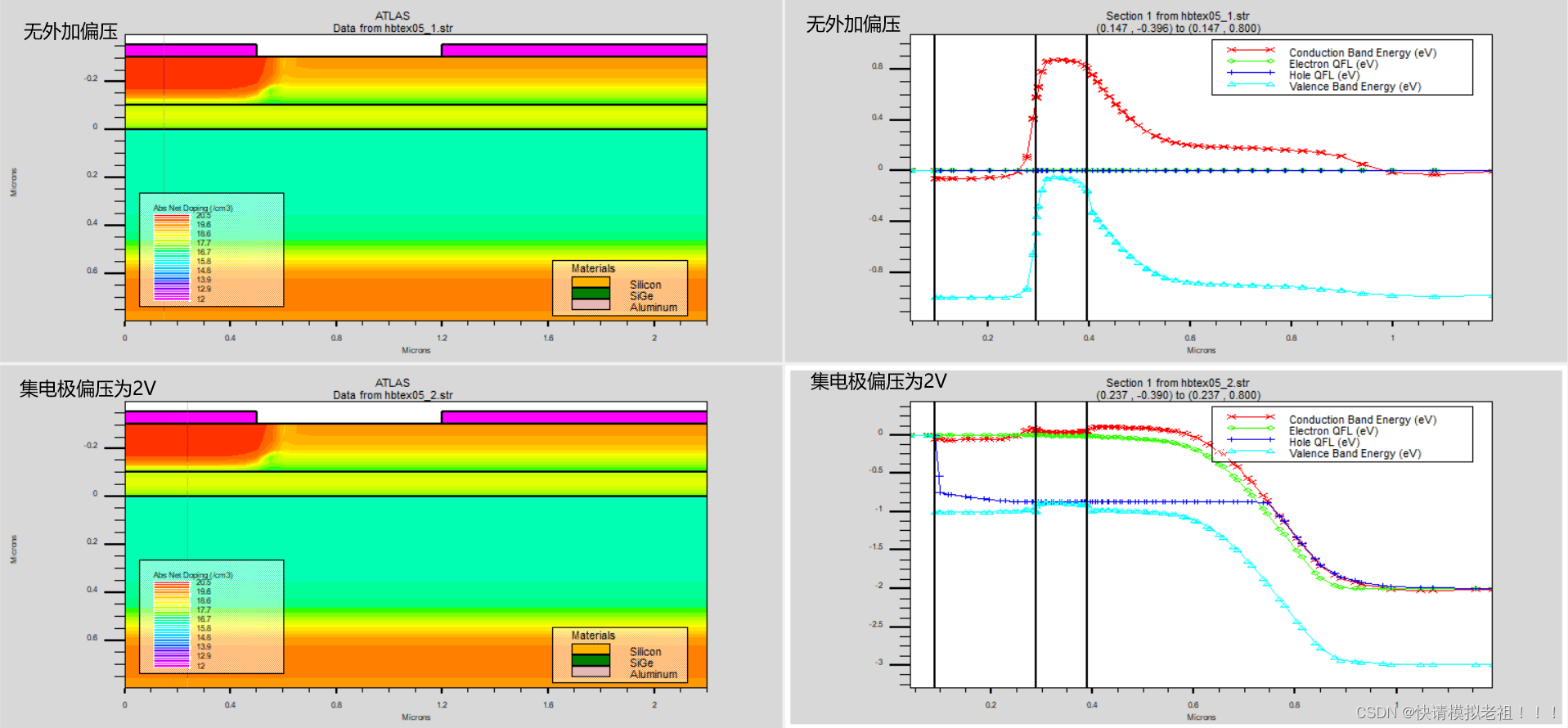
3. 对器件的电气特性进行讨论(放大倍数,Gummel曲线,厄利电压I-V特性曲线),数据见原始记录
四、实验过程原始记录(数据、图表、相关计算等)(40%)
1. 对器件的电气特性进行讨论(放大倍数,Gummel曲线,厄利电压I-V特性曲线)
(1) 放大倍数

(2)Gummel曲线
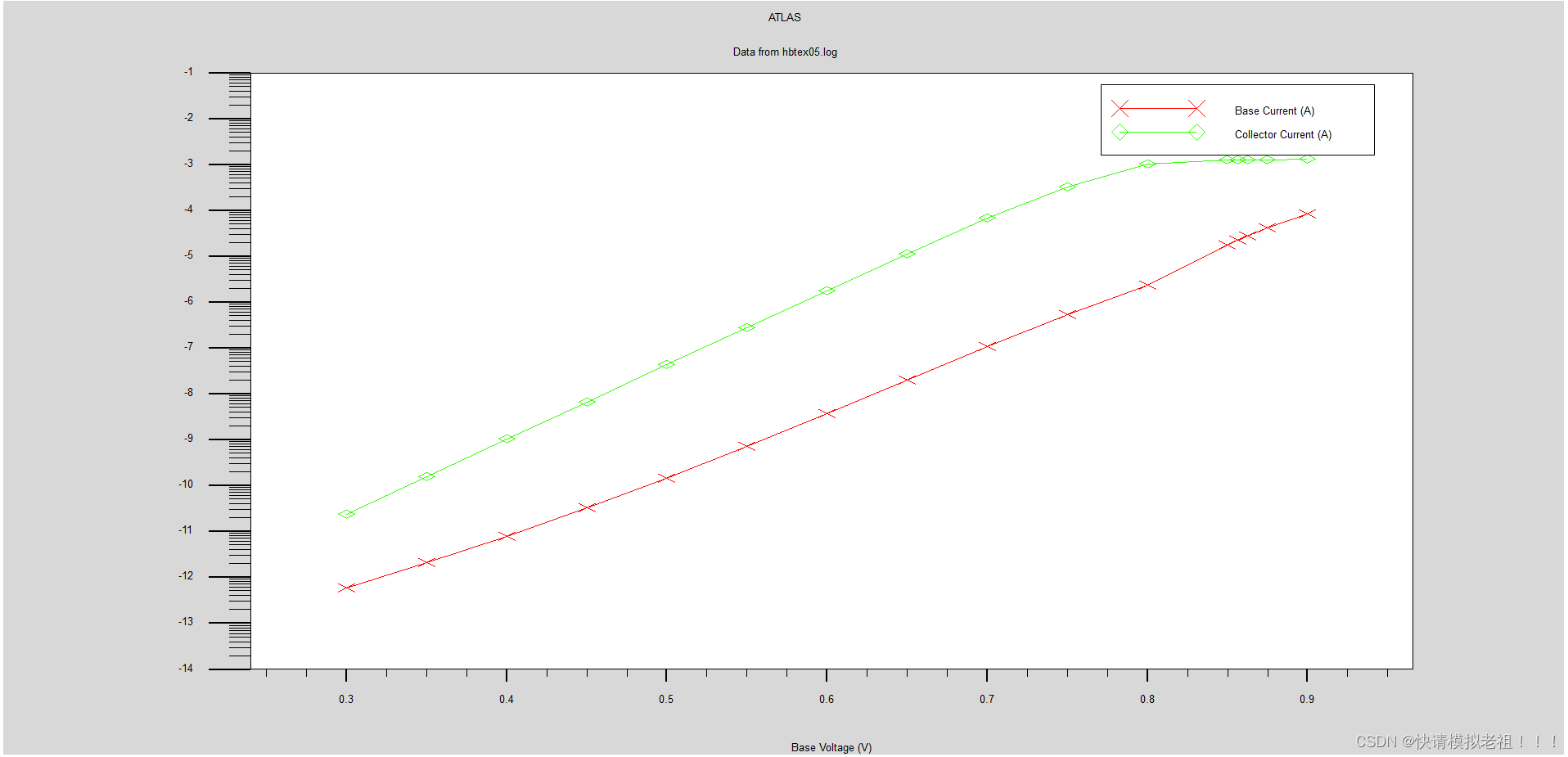
(3)厄利电压
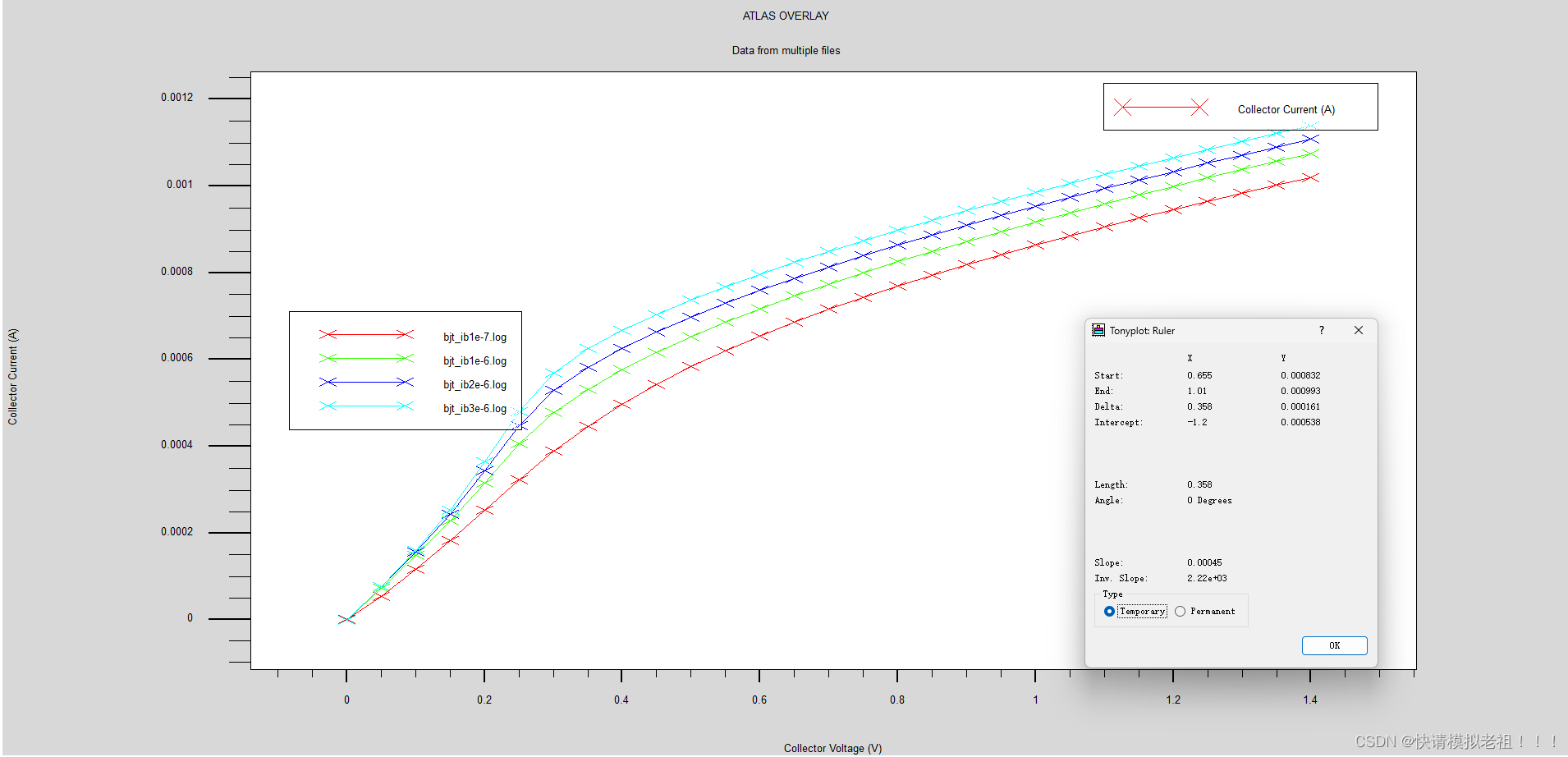
2. 调整基区的Ge摩尔组分,观察Ge组分对器件参数的影响

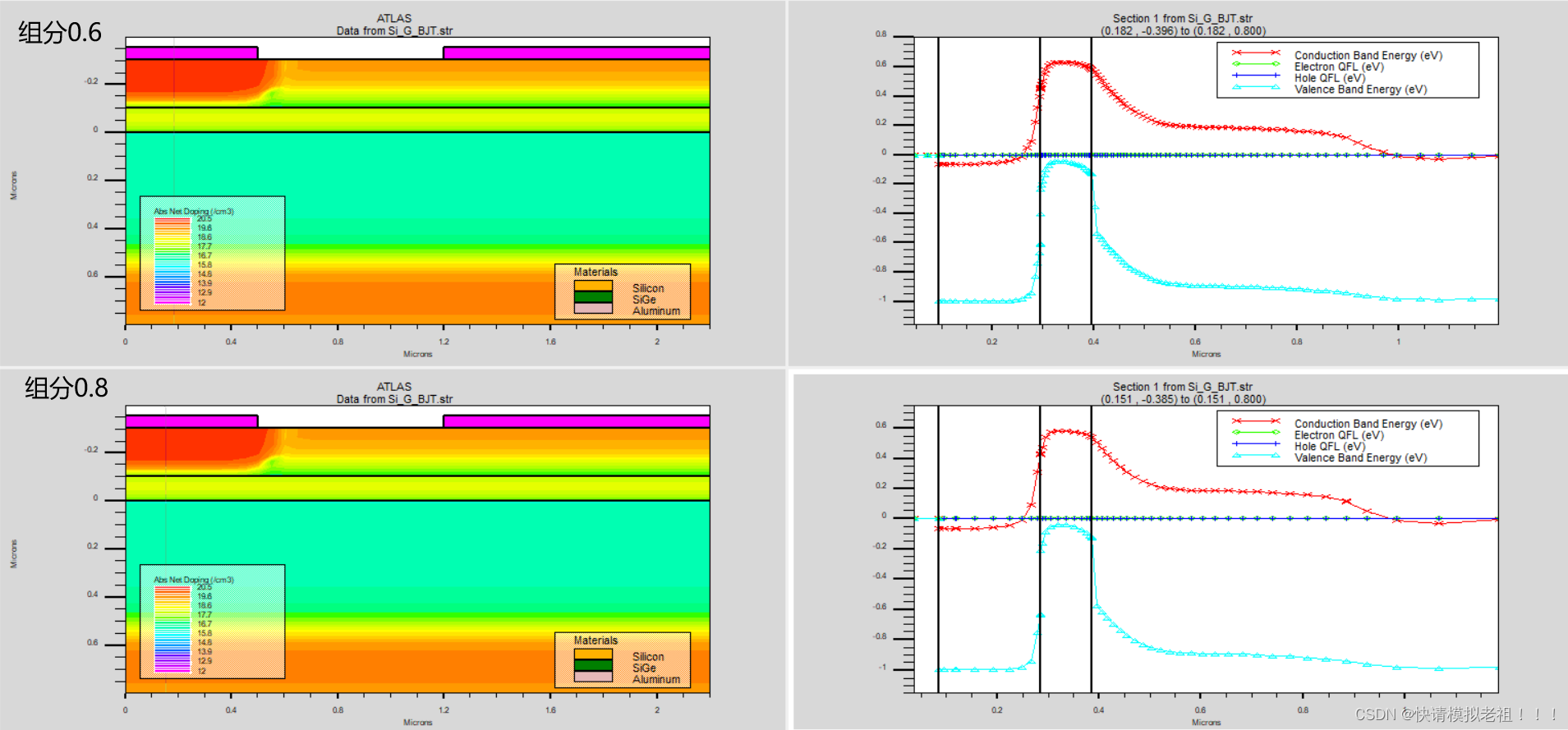
3. 当器件的掺杂浓度以及外加偏压均不变时,结合仿真曲线,分别定性探索Ge组分大概为多少时,放大系数最大?并给出分析
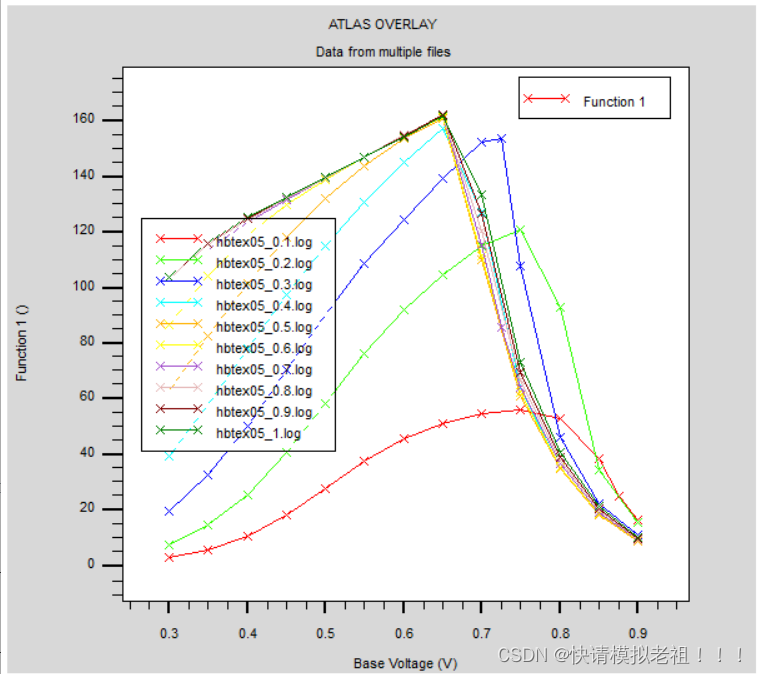
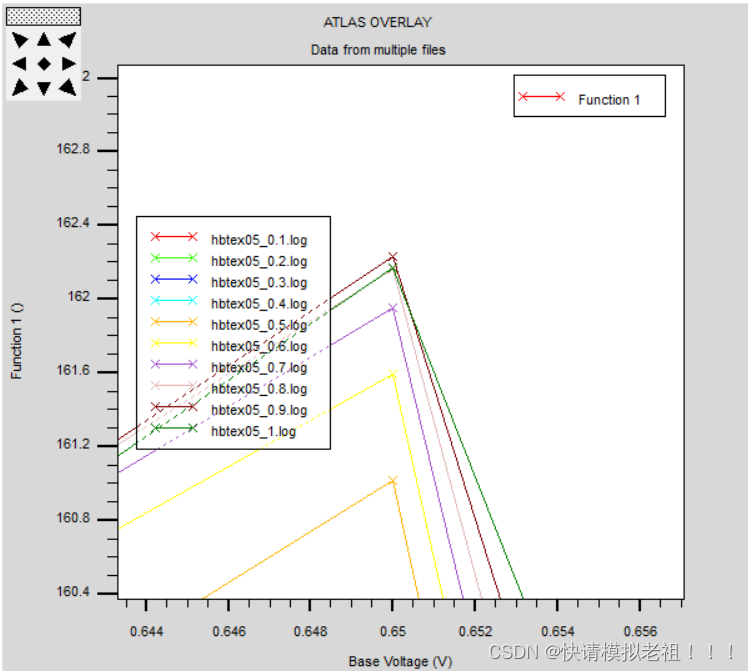
现象:
通过改变Ge的组分大小发现,随着Ge组分的增大,SiGe HBT的放大倍数β先增大到一定值(组分为0.5)后就基本保持不变。当Ge组分约为0.9时,最大β值约为162。通过提高基区Ge的组分,提高了载流子迁移率,增大了放大系数β值
分析与总结:
一般来说,SiGe合金的晶格常数比纯Si小,因此在SiGe合金中添加Ge会导致晶格结构的变形。这种变形可以影响载流子的迁移特性,因为载流子在晶格中的运动受到晶格畸变的影响。此外,Ge的电子亲和能比Si大,这可能会导致在SiGe合金中形成额外的能级,从而影响能带结构和载流子的有效质量。
在某些情况下,增加Ge组分可以改善半导体材料的载流子迁移率,从而提高器件的放大系数。例如,在SiGe HBT中,SiGe材料的增加可以提高基区的迁移率,从而增加晶体管的放大系数。此外,SiGe合金中的Ge原子可以作为掺杂剂,从而增加材料的载流子浓度,从而提高器件的导电性能。
但是,增加Ge组分也可能会带来一些负面影响。例如,SiGe合金的缺陷密度可能会增加,这可能会降低材料的载流子迁移率,从而降低器件的性能。此外,SiGe合金的热传导性能可能会降低,这可能会导致器件的热稳定性下降。因此,在实际设计中,需要进行详细的材料建模和仿真分析,以确定Ge组分对器件性能的影响,并找到最佳的设计参数。
4. 当器件的掺杂浓度以及外加偏压均不变时,结合仿真曲线,分别定性探索Ge组分大概为多少时,厄利电压最小?并给出分析

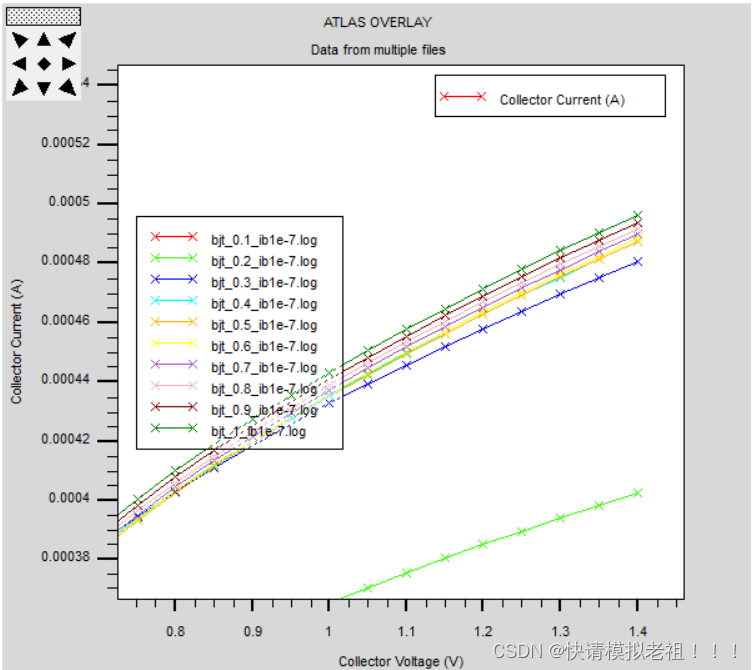
现象:
通过仿真lnI-v特性曲线观察厄尔利电压发现,随着Ge组分的增大,SiGe HBT的厄尔利电压也随之增大,增大到一定值(组分为0.3)后基本保持不变。
Ge组分约为1时,取得最小值约为-0.961。通过提高基区Ge的组分,提高了载流子迁移率,降低了厄尔利电压。
分析与总结:
1. 能带结构:Ge组分的增加会改变SiGe合金的能带结构,可能会影响载流子的有效质量和密度。这对器件的载流子注入和输运过程具有重要影响,从而影响器件的厄利电压。
2. 载流子迁移率:Ge组分的增加可能会影响SiGe合金中的载流子迁移率,因为晶格畸变和杂质散射等因素会对载流子的迁移产生影响。载流子迁移率越高通常厄利电压越低。
3. 缺陷密度:增加Ge组分可能会引入更多的晶格缺陷,这可能会影响载流子的迁移和复合过程。缺陷密度越低,厄利电压越高。
5. 当器件的掺杂浓度以及外加偏压均不变时,结合仿真曲线,分别定性探索Ge组分大概为多少时,集电极电流最大?并给出分析
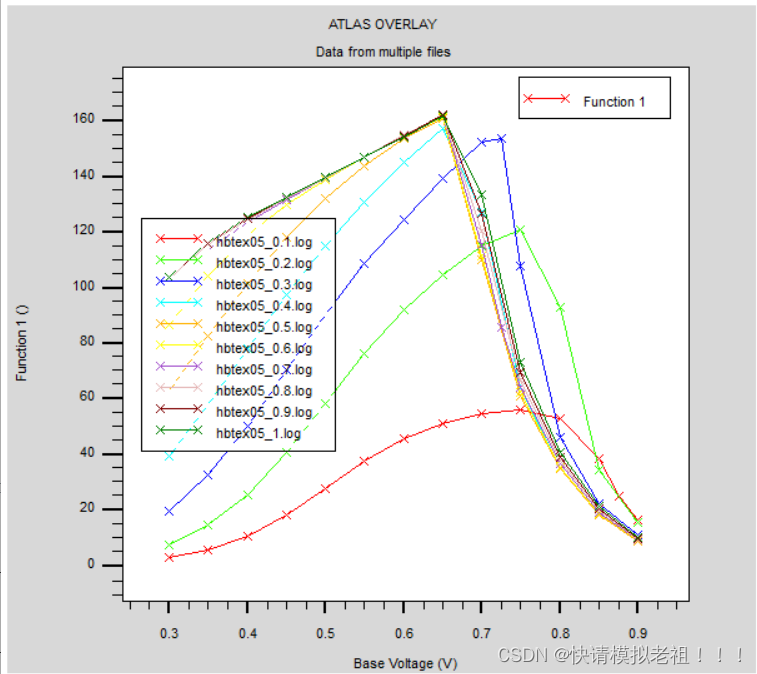
现象:
由公式可知:Ic=βIb
集电极电流取决于放大系数的大小,所以在Ge组分约为0.9时,β值为最大值,此时集电极电流也最大。
分析与总结:
增加Ge组分可能会导致SiGe合金的晶格结构略微扭曲,这可能会改变半导体的能带结构。这些变化可能会影响载流子的生成和传输。一般来说,增加Ge组分会降低SiGe合金的带隙,这意味着更多的载流子可以被激发到导带中,从而增加了载流子的浓度。
此外,Ge通常具有比Si更高的电子和空穴迁移率。因此,增加Ge组分可能会提高载流子的迁移率,这意味着载流子在半导体中的移动速度更快,从而增加了集电极电流。
另外,增加Ge组分可能会改变半导体材料中的缺陷密度和表面态。较低的缺陷密度和表面态可以减少载流子的散射和复合,从而提高了载流子的传输效率和集电极电流。
6. 仿真实现SiGe HBT缓变基区,实验数据原始记录如下:
(1)器件模型
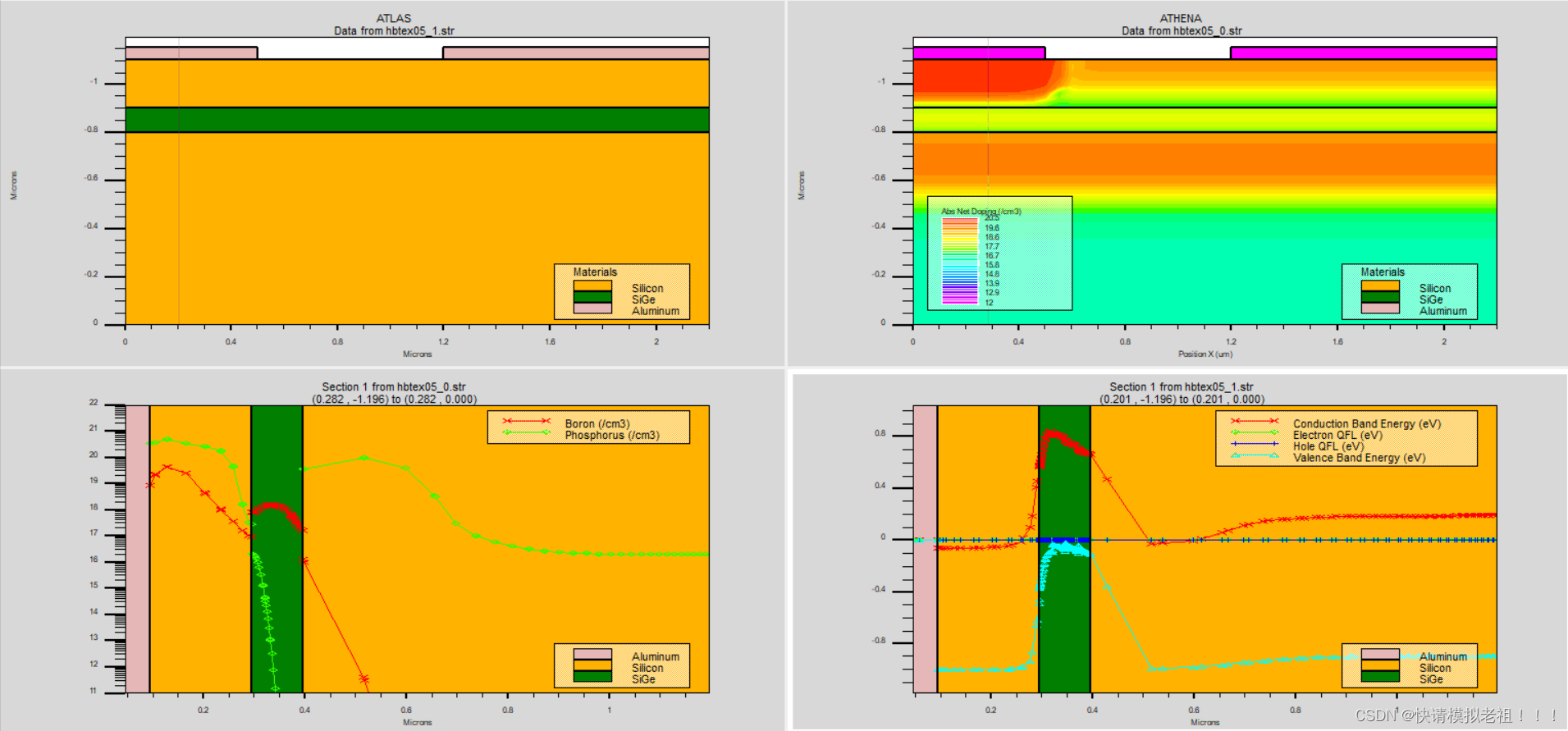
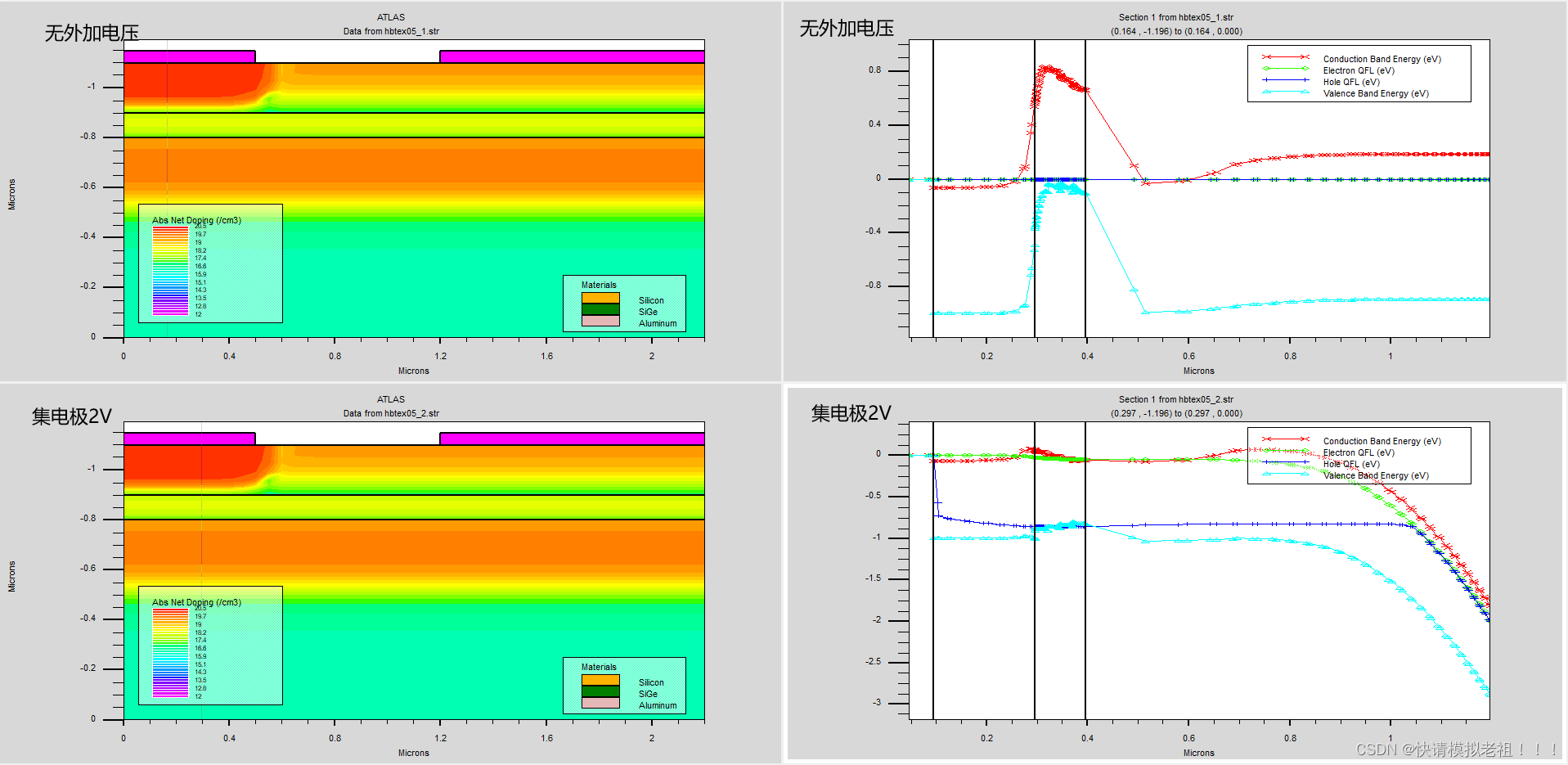
(2)放大倍数
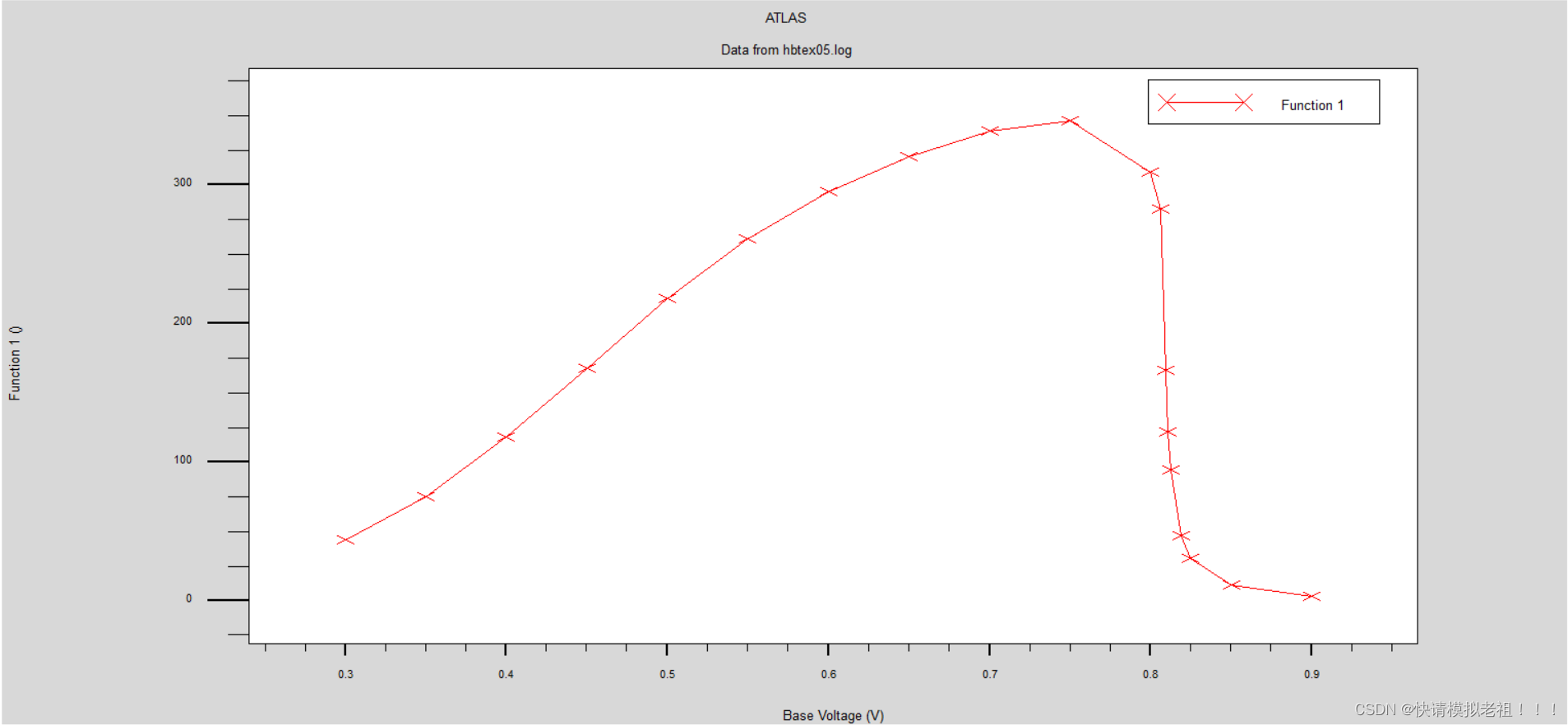
(3)Gummel曲线
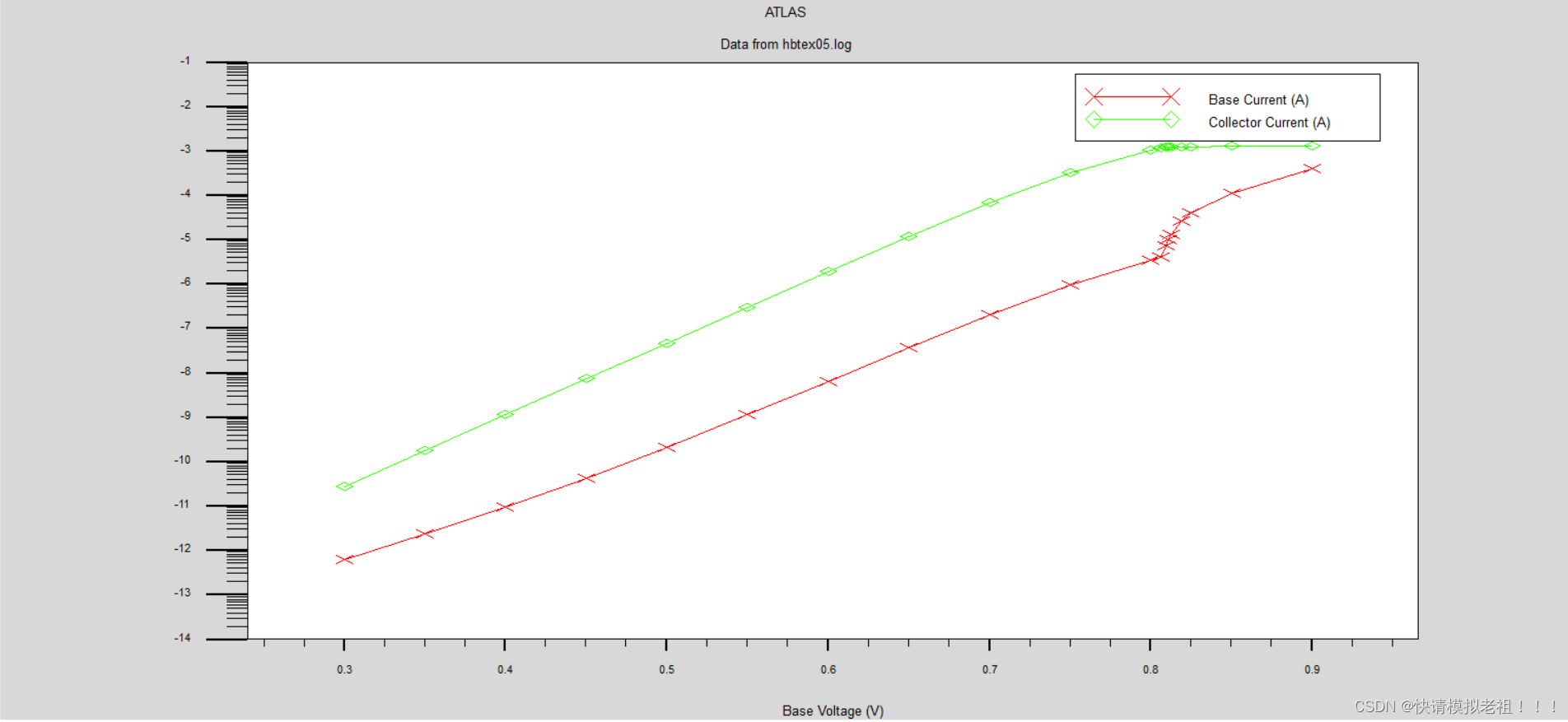
(4)I-V特性曲线求解厄利电压
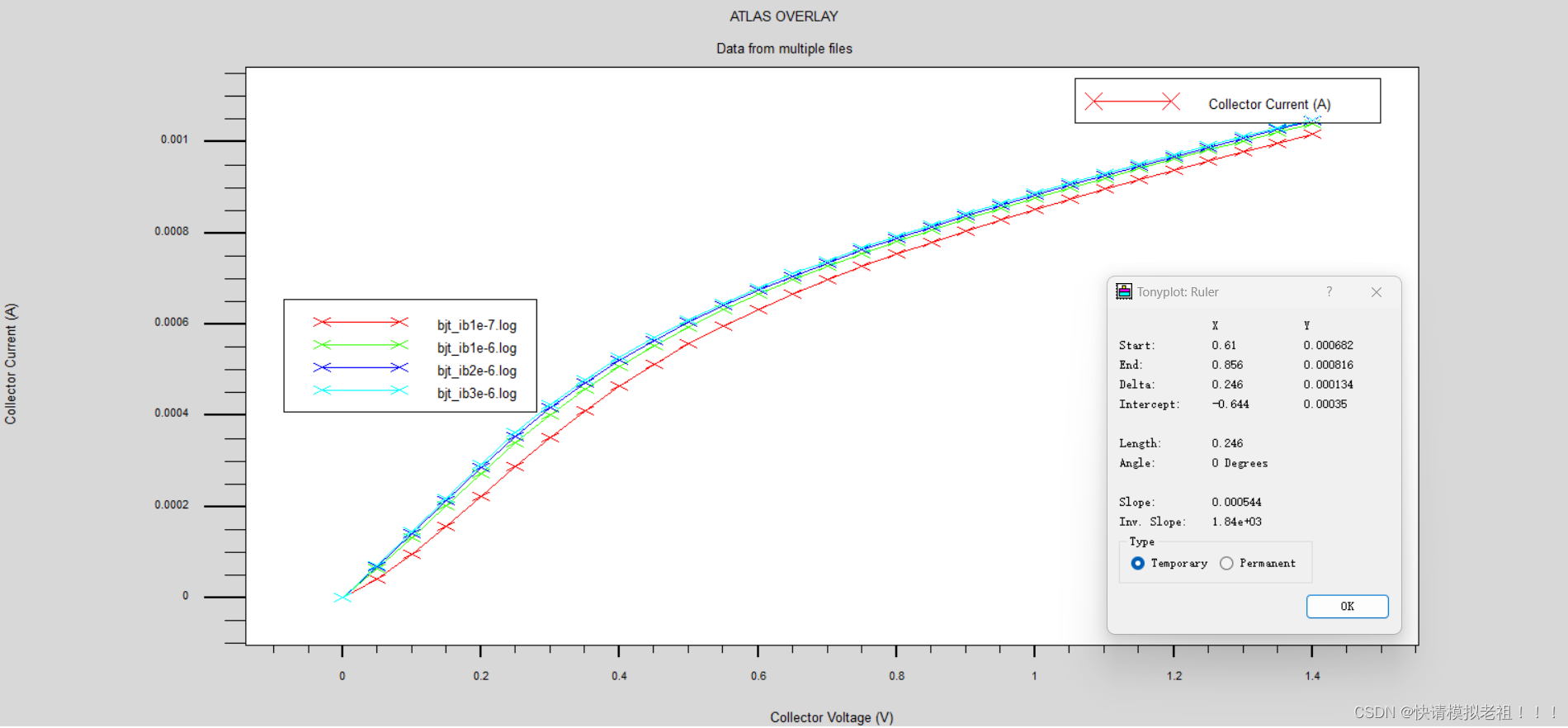
五,思考题分析(20%)
1. 分析上述代码,得到参数曲线,给出主要的工艺流程图。

2. 调整基区的Ge摩尔组分,观察Ge组分对器件参数和电学特性曲线的影响,并结合Si/SiGe异质结的物理特点进行分析(数据见原始记录)
在SiGe应变异质结中。应变的存在使得能带结构发生变化,并引起有效质量和迁移率的改变。SiGe所受的应力可分解为轴向应力和流体静应力两部分。轴向应力使简并的导带边和价带边发生退简并分裂,而流体静应力则使得能带移动并使带隙大小发生变化,结果是应变层的带隙要比相同合金组分的体材料的带隙要小,对于Si衬底上的压应变,SiGe的带隙可以用下列式子来表示
Eg(X)=Eg-0.96X+0.43x2-0.13x3 (eV)
根据公式可得,基区的禁带宽度越小,注入效率越高,注入效率越高,则放大倍数也随之增加。
3. 当器件的掺杂浓度以及外加偏压均不变时,结合仿真曲线,分别定性探索Ge组分大概为多少时,放大系数最大?厄利电压最小?集电极电流最大?能否从物理的角度给与解释?
答:SiGe HBT的电流增益如下

与常规BJT相比,SiGe HBT多了一项关于禁带宽度的指数项,在常规的BJT中,发射区和基区的掺杂浓度比对提高电流增益起着决定性的因素。然而SiGe HBT的电流增益主要与指数项有关,在维持相同的发射区和基区的掺杂浓度下,SiGe的电流增益要大一些,实际应用中使用电流增益比,如下所示:

一般来说,SiGe合金的晶格常数比纯Si小,因此在SiGe合金中添加Ge会导致晶格结构的变形。这种变形可以影响载流子的迁移特性,因为载流子在晶格中的运动受到晶格畸变的影响。此外,Ge的电子亲和能比Si大,这可能会导致在SiGe合金中形成额外的能级,从而影响能带结构和载流子的有效质量。
在某些情况下,增加Ge组分可以改善半导体材料的载流子迁移率,从而提高器件的放大系数。例如,在SiGe HBT中,SiGe材料的增加可以提高基区的迁移率,从而增加晶体管的放大系数。此外,SiGe合金中的Ge原子可以作为掺杂剂,从而增加材料的载流子浓度,从而提高器件的导电性能。
但是,增加Ge组分也可能会带来一些负面影响。例如,SiGe合金的缺陷密度可能会增加,这可能会降低材料的载流子迁移率,从而降低器件的性能。此外,SiGe合金的热传导性能可能会降低,这可能会导致器件的热稳定性下降。因此,在实际设计中,需要进行详细的材料建模和仿真分析,以确定Ge组分对器件性能的影响,并找到最佳的设计参数。
4. 从理论上给出SiGe HBT实现缓变基区的方式,若能从仿真来实现尤佳
实现缓变基区(graded base)是指在SiGe HBT(硅锗异质结双极晶体管)的基区中逐渐改变锗的组分。这种设计有以下好处:
1. 减小晶格失配:SiGe HBT中,硅和锗的晶格常数不同,因此在SiGe异质结中会出现晶格失配。通过实现缓变基区,可以逐渐调整晶格常数,减小晶格失配,降低晶格应变,减少晶格缺陷的产生,提高材料质量。
2. 改善载流子传输:缓变基区可以改善载流子的传输特性。由于锗具有更高的电子和空穴迁移率,通过逐渐增加锗的含量,可以提高载流子的迁移率,从而提高晶体管的性能。
3. 减小基区电阻:SiGe HBT的基区电阻对其性能有很大影响。通过实现缓变基区,可以减小基区电阻,提高晶体管的工作速度和性能。
综上所述,实现缓变基区可以改善SiGe HBT的材料质量,提高载流子传输特性,减小基区电阻,从而提高晶体管的性能和工作稳定性。
修改后的代码如下:

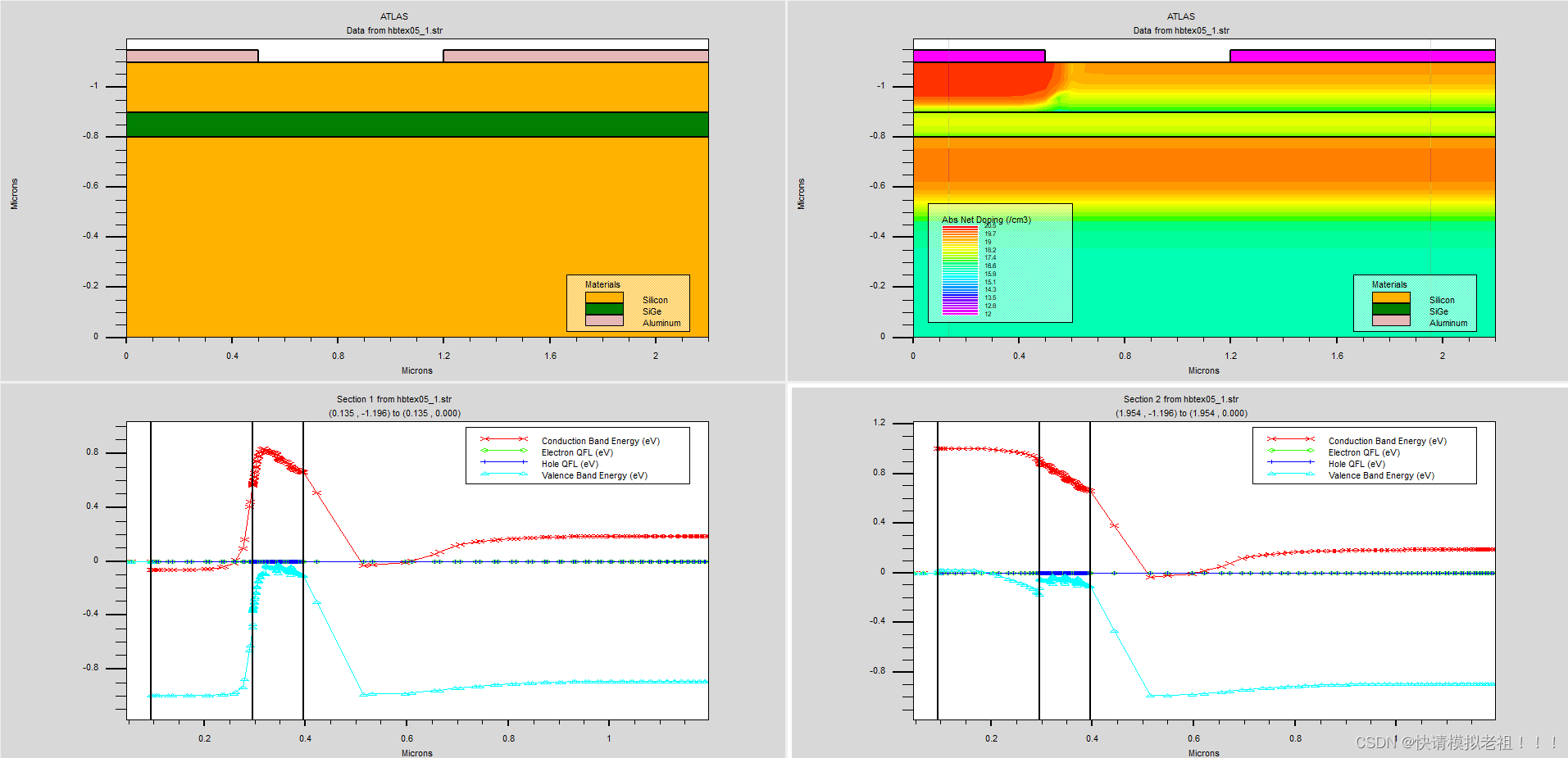
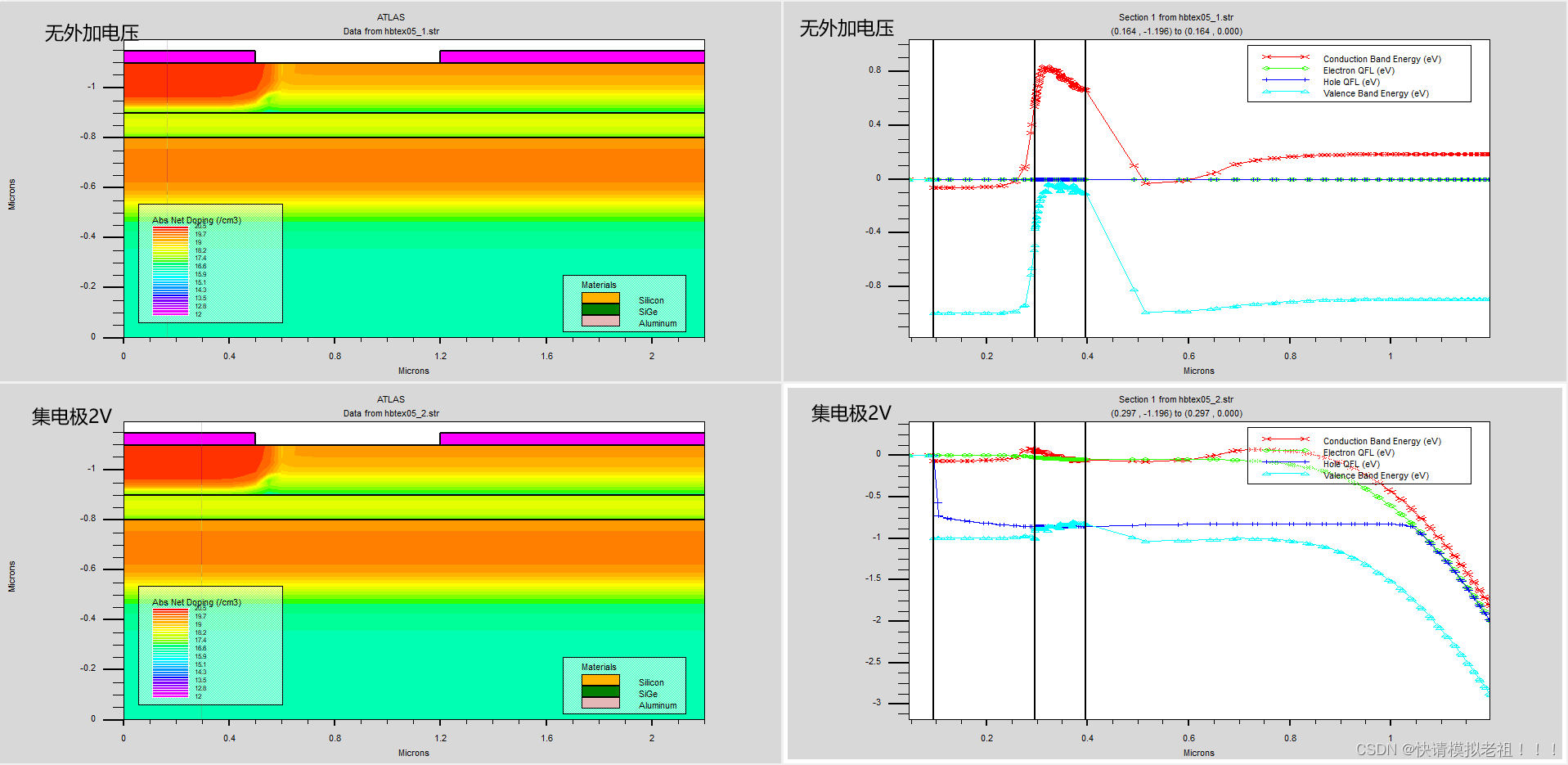
六、实验心得(5%)
在本次实验中,我们小组深入学习了SiGe异质结双极晶体管(HBT)的工艺仿真方法,并成功地构建了SiGe异质结双极晶体管。通过深入了解SiGe异质结双极晶体管的工作原理和性能指标,我们能够更好地理解器件的内部结构和工作原理,为我们的工艺仿真实验提供了坚实的理论基础。
通过仿真改变Ge的组分,我们成功地获得了SiGe异质结双极晶体管的最大放大系数、最小厄尔利电压以及最大集电极电流等参数,这不仅验证了我们的理论知识,也让我们更加深入地了解了器件的性能表现。这些参数的变化对器件的性能有着重要的影响,而我们能够通过仿真实验来直观地观察到这些变化,从而更好地理解和掌握SiGe异质结双极晶体管的性能特点。
在实验中,我们还发现了优化器件性能的多种方法,比如改变材料的组分、结构和尺寸等参数,以及优化器件的结构和工艺流程。这些方法都可以对器件的性能产生积极的影响,让我们的器件更加优越和适用于更广泛的应用场景。通过实验,我们学会了如何运用仿真软件来验证理论知识的正确性,这为我们未来的学习和研究提供了宝贵的经验和启示。
总的来说,本次实验不仅让我们学会了SiGe异质结双极晶体管的工艺仿真方法,还让我们认识到了优化器件性能的重要性,以及如何运用仿真软件来验证和完善理论知识。这些对于我们未来使用和应用SiGe HBT器件去构建自己的微电子大厦具有非同寻常的意义。再次感谢王老师在课上对我们提出的问题和细心指导,万分感谢!
附录一: silvcao仿真代码
| go athena # SiGe HBT simulation # 建立网格 line x location=0.0 spacing=0.08 line x location=0.5 spacing=0.05 line x location=0.7 spacing=0.05 line x location=1.2 spacing=0.08 line x location=2.2 spacing=0.18 # line y location=0.0 spacing=0.01 line y location=0.1 spacing=0.02 line y location=0.5 spacing=0.05 line y location=0.8 spacing=0.15 #定义衬底Si的浓度为2e16 init silicon c.phos=2e16 structure outf=tmpr1.str #初始化器件模型 #离子注入P 离子能量为60,注入剂量为3e15 init inf=tmpr1.str flip.y implant phos energy=60 dose=3e15 #扩散时间 温度 diffuse time=5 temp=1000 struct outf=tmpr2.str #初始化器件模型 #淀积硅锗 (淀积厚度0.1 纵向包含12个网格点,网格控制如图 组份0.2 B浓度1e15) #离子注入B (离子能量为10,注入剂量为1e13) deposit sige thick=0.025 divis=12 ydy=0.05 dy=0.02 c.frac=0.2 c.boron=1e15 implant boron energy=10 dose=1.0e13 #淀积硅做发射极 (淀积厚度0.2 纵向包含10个网格点,网格控制如图 P浓度1e15) #离子注入B (离子能量为12,注入剂量为3e14) #扩散控制 (扩散时间0.5,温度920) deposit silicon thick=0.2 divis=10 ydy=0.08 dy=0.04 c.phos=1.e15 implant boron energy=12 dose=3e14 diffuse time=0.5 temp=920 #淀积光刻胶 (淀积厚度0.5 纵向包含5个网格点) #光刻 (距离左边界0.5) #离子注入P (离子能量为38,注入剂量为6e15) #扩散控制 (扩散时间0.5,温度920) deposit photo thick=.5 divis=5 etch photo left p1.x=0.5 implant phos energy=38 dose=6e15 diffuse time=5 temp=920 strip #淀积AI (淀积厚度0.05 纵向包含1个网格点) #刻蚀 (区域定义) deposit aluminum thick=0.05 div=1 etch aluminum start x=0.5 y=10. etch cont x=0.5 y=-10. etch cont x=1.2 y=-10. etch done x=1.2 y=10. #定义电极 electrode name=emitter x=0.0 electrode name=base x=2.0 electrode name=collector backside #定义每种材料的杂质特征 impurity i.boron acceptor sige impurity i.phos donor sige structure outfile=hbtex05_0.str go atlas # 材料参数和模型规格 material material=Si taun0=1e-7 taup0=1e-7 material material=SiGe taun0=1e-8 taup0=1e-8 model bgn consrh auger fldmob conmob # Initial solution solve init output con.band val.band save outf=hbtex05_1.str tonyplot hbtex05_1.str -set hbtex05_0.set # Bias collector to 2 volts output con.band val.band method gummel newton trap autonr solve prev solve local vcollector=2.0 # Bias base for Gummel plot output con.band val.band method newton trap solve vbase=0.01 solve vbase=0.05 solve vbase=0.2 log outfile=hbtex05.log master solve vbase=0.3 vstep=0.05 name=base vfinal=0.9 save outfile=hbtex05_2.str # plot the logfile tonyplot hbtex05.log -set hbtex05.set go atlas init infile=hbtex05_0.str method trap maxtrap=10 models fldmob srh bgn auger fermidirac stress klasrh conmob print solve init solve vbase=0.01 solve vbase=0.05 solve vbase=0.7 contact name=base current solve ibase=1.0e-7 outfile= bjt_ib1e-7 solve ibase=1.0e-6 outfile= bjt_ib1e-6 solve ibase=2.0e-6 outfile= bjt_ib2e-6 solve ibase=3.0e-6 outfile= bjt_ib3e-6 load infile=bjt_ib1e-7 log outf=bjt_ib1e-7.log solve name=collector vcollector=0.0 vstep=0.05 vfinal=1.4 log off load infile=bjt_ib1e-6 log outf=bjt_ib1e-6.log solve name=collector vcollector=0.0 vstep=0.05 vfinal=1.4 log off load infile=bjt_ib2e-6 log outf=bjt_ib2e-6.log solve name=collector vcollector=0.0 vstep=0.05 vfinal=1.4 log off load infile=bjt_ib3e-6 log outf=bjt_ib3e-6.log solve name=collector vcollector=0.0 vstep=0.05 vfinal=1.4 log off tonyplot -overlay bjt_ib1e-7.log bjt_ib1e-6.log bjt_ib2e-6.log bjt_ib3e-6.log |

























 1260
1260

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








