本篇为西安交通大学本科课程《电气材料基础》的笔记。
本篇为这一单元的第三篇笔记,上一篇传送门。
p-n结和金属-半导体接触
p-n结
无偏压开路状态
如图a所示,左边是n型掺杂,右边是p型掺杂,在n区和p区之间形成了一个不连续的突变,叫做冶金结M。p比n有更高的空穴浓度,空穴向右扩散与n区电子复合;n比p有更高的电子浓度,电子向左扩散与p区空穴复合。当电子和空穴的扩散达到平衡状态,结附近的自由载流子耗尽,在结附近的n区一侧,留下带正电的施主离子,p区一侧,留下带浮点的受主离子,冶金结附近区域称为空间电荷层或耗尽层。
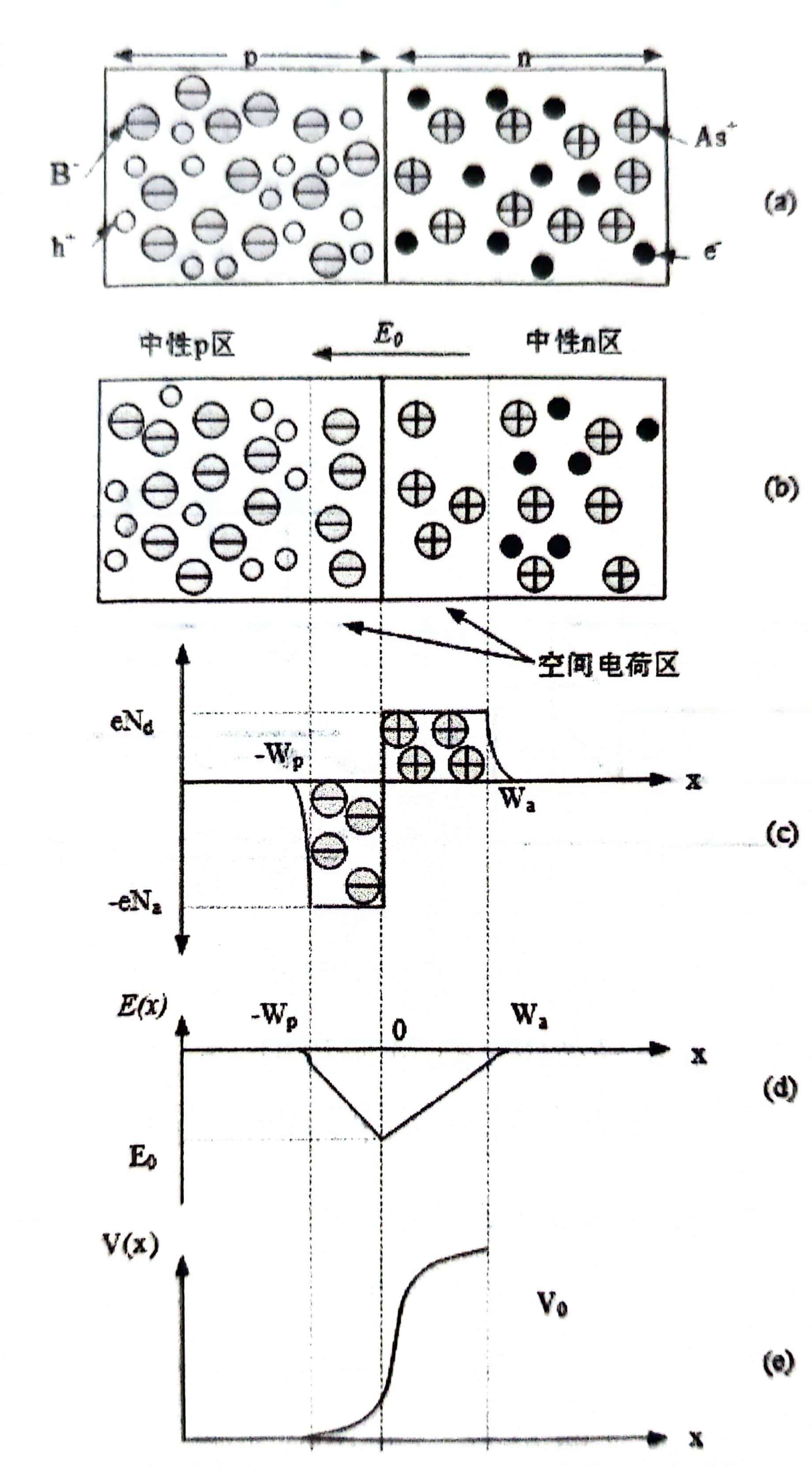
上图就是pn结的性质,图a是p型和n型接触,图b是pn结的形成,图c是空间电荷分布,d是电场分布,e是电势分布。
如图b所示,因为受主和施主掺杂离子的存在,结附近产生一个从右向左即从n区向p区的电场,在其中的电荷将受到电场力的作用。同时,由于浓度差一,也存在扩散驱动力。平衡时空穴向右的扩散速率等于向左漂移速率,扩散电流等于漂移电流。图c是结附近的净空间电荷浓度,因为半导体是电中性,所以有:
N
a
W
p
=
N
d
W
n
N_aW_p=N_dW_n
NaWp=NdWn
其中,
N
a
N_a
Na和
N
d
N_d
Nd分别是P区(受主)和N区(施主)的杂质浓度,
W
n
W_n
Wn和
W
p
W_p
Wp分别是PN结中的n区和p区的耗尽层宽度。
假设有浓度关系:
N
d
<
N
a
N_d<N_a
Nd<Na,那么有
W
p
<
W
n
W_p<W_n
Wp<Wn,即耗尽区进入到轻掺杂一侧的半导体,根据电荷密度和电场的关系,可求得电场,如图d所示:
E
x
=
1
ε
∫
−
W
p
x
ρ
n
e
t
(
x
)
d
x
E_x=\frac{1}{\varepsilon}\int_{-W_p}^{x}\rho_{net}(x)\mathrm{d}x
Ex=ε1∫−Wpxρnet(x)dx
设远离结的p区域边缘为零电势,则根据电场分布可以求出电势的分布,如图e所示。如图中V_0为内建电势。内建电势和掺杂和材料的性质关系有以下关系式:
V
0
=
k
T
e
ln
N
a
N
d
n
i
2
V_0=\frac{kT}{e}\ln\frac{N_aN_d}{n^2_i}
V0=ekTlnni2NaNd
耗尽区的宽度
W
0
W_0
W0为:
W
0
=
2
ε
(
N
a
+
N
d
)
V
0
e
N
a
N
d
W_0=\sqrt{\frac{2\varepsilon(N_a+N_d)V_0}{eN_aN_d}}
W0=eNaNd2ε(Na+Nd)V0
可见: W 0 ∝ V 1 2 W_0\propto V^{\frac{1}{2}} W0∝V21,说明耗尽层的电容是依赖于电压的。
热平衡系统的费米能级 E F E_F EF必须是连续的,所以n区、p区和M区的 E F E_F EF必须一样。为了保证 E F n = E F p E_{Fn}=E_{Fp} EFn=EFp且 E c − E v E_c-E_v Ec−Ev保持不变,必须在M区附近将能级 E c , E v E_c,E_v Ec,Ev弯曲。如下图可见,导带上的n区电子必须越过能量为 e V 0 eV_0 eV0的势垒才能达到p区,其中 V 0 V_0 V0是内建电势。

正向偏压扩散电流和复合电流
当pn结外施加一个电压,让正极和p边相接,负极和n边相连,外施加电压和内建电势的方向相反,有效减少了内建电势,所以更多的空穴可以扩散越过耗尽区进入n区,而过剩的电子也可以扩散进入p边,电压对于扩散到n边的过剩空穴数目通过下式表达:
p n ( 0 ) = p n 0 e e V k T p_n(0)=p_{n0}e^{\frac{eV}{kT}} pn(0)=pn0ekTeV
上面公式叫做结定律,扩散到n区的空穴与电子复合,扩散到p区的电子和空穴复合,电源可以补充n区的电子和p区的空穴,以保证连续的扩散电流。
下图是器件在正向偏压条件下的载流子浓度曲线。

除了少子扩散引起的扩散电流外,少子迁移一会产生电流。如n区,总电流为少子空穴和多子电子的电流之和,与位置无关,这是因为中性区的电场不是零,足够区驱动多子的迁移。
正向偏压时总扩散电流用理想二极管(肖克利)公式来描述:
J
=
J
s
0
(
e
e
V
k
T
−
1
)
J=J_{s0}(e^{\frac{eV}{kT}}-1)
J=Js0(ekTeV−1)
其中, J s 0 = ( e D h L h N d + e D e L e N a ) n i 2 J_{s0}=\left(\frac{eD_h}{L_hN_d}+\frac{eD_e}{L_eN_a}\right)n^2_i Js0=(LhNdeDh+LeNaeDe)ni2, L h , L e L_h,L_e Lh,Le是反向饱和电流密度,分别是空穴和电子的扩散长度。
除了扩散电流外,少子在耗尽区的复合也会产生电流,这个电流叫做复合电流。总电流就是扩散电流和复合电流之和。在
V
>
k
T
e
V>\frac{kT}{e}
V>ekT的情况下,少子就能被激发跃迁,产生复合电流,有:
J
=
J
s
0
e
e
V
k
T
+
J
r
0
e
e
V
2
k
T
≈
J
0
e
e
V
η
k
T
J=J_{s0}e^{\frac{eV}{kT}}+J_{r0}e^{\frac{eV}{2kT}}\approx J_0e^{\frac{eV}{\eta kT}}
J=Js0ekTeV+Jr0e2kTeV≈J0eηkTeV
下图就是正偏压的时候的能带图,这个时候外加的电压基本都降落在耗尽层,n区导带电子容易越过势垒到达p区,空穴也能从p区到n区,形成电回路。

反向偏压电流
反向加压,外加电压高于内建电势,空间电荷层的电场大于内建电场,n区电子和p区空穴均无法向着对方引动。这个时候的反向电流主要由两部分组成:
- 少子扩散电流:当反向偏压 V r > k T e = 25 m V V_r>\frac{kT}{e}=25\mathrm{mV} Vr>ekT=25mV时,耗尽层外 p − n ( 0 ) ≈ 0 p-n(0)\approx0 p−n(0)≈0,而靠近负极的空穴平衡浓度 p − n 0 p-n_0 p−n0虽然小,但不是零,所以存在一个浓度梯度,产生了一个从n区流向p区的空穴扩散电流。同理可得,p区存在一个电子的扩散电流。在耗尽区,这些载流子在电场的驱动下迁移。这个少子扩散电流时反向饱和电流,它不仅取决于材料的参数,还依赖于外加电压,尤其是大大依赖于温度。
- 热生电子-空穴对:如图所示为反向偏压时候的能带图,在耗尽层由热产生电子-空穴对在电场的作用下会分离,电子会沿着下降的势能坡前往n区,空穴会前往p区。这就是因为热产生的少子而造成的反偏电流。
下图是少数流子分布和反向的电流起源。
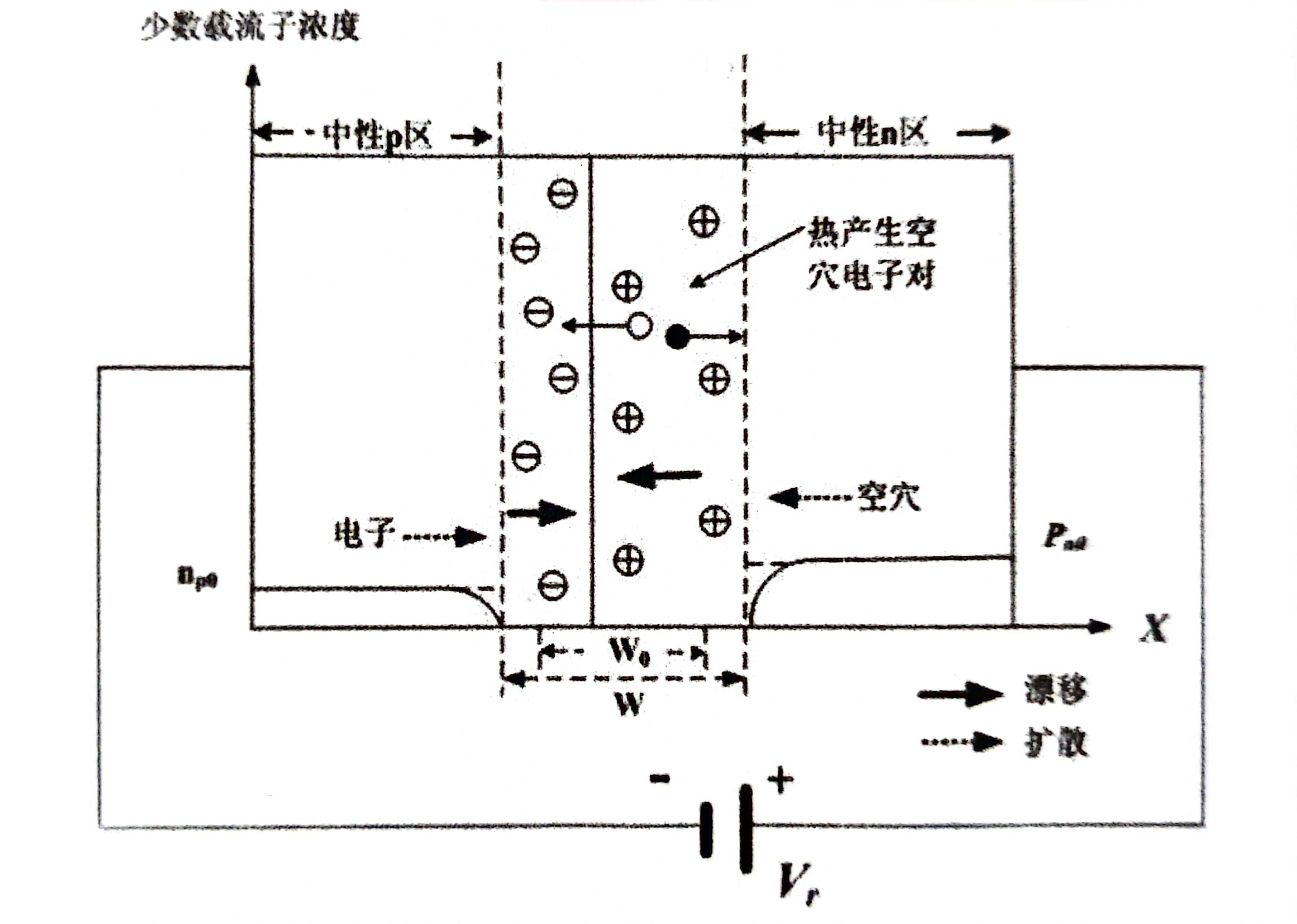
耗尽层电容、扩散电容和动态电阻
耗尽层电容
p-n结的耗尽层宽度可写作:
W
0
=
2
ε
(
N
a
+
N
d
)
(
V
0
−
V
)
e
N
a
N
d
W_0=\sqrt{\frac{2\varepsilon(N_a+N_d)(V_0-V)}{eN_aN_d}}
W0=eNaNd2ε(Na+Nd)(V0−V)
当外加电压V变化到V+dV的时候,W同时会发生变化,耗尽层的电荷变为Q+dQ。耗尽层的电容定义成
C
d
q
p
=
∣
d
Q
d
V
∣
C_{dqp}=|\frac{\mathrm{d}Q}{\mathrm{d}V}|
Cdqp=∣dVdQ∣,因为电荷量
∣
Q
∣
=
e
N
d
W
n
A
=
e
N
a
W
p
A
|Q|=eN_dW_nA=eN_aW_pA
∣Q∣=eNdWnA=eNaWpA,且耗尽层宽度
W
=
W
n
+
W
p
W=W_n+W_p
W=Wn+Wp,可以推出耗尽层电容的表达式:
C
d
e
p
=
ε
A
W
=
A
V
0
−
V
e
ε
N
a
N
d
2
(
N
a
+
N
d
)
C_{dep}=\frac{\varepsilon A}{W}=\frac{A}{\sqrt{V_0-V}}\sqrt{\frac{e\varepsilon N_aN_d}{2(N_a+N_d)}}
Cdep=WεA=V0−VA2(Na+Nd)eεNaNd
可见,电容值随着反向偏电压的增加而减少,且在反向偏压和正向偏压下都是存在的。
扩散电容
只在正偏电压下存在。n区会通过少子的注入和扩散存储正电荷。当电压的微小变化dV时,会引起附加的少子电荷dQ注入n区,则得扩散电容为:
C
d
i
f
f
=
d
Q
d
V
=
τ
h
I
25
C_{diff}=\frac{\mathrm{d}Q}{\mathrm{d}V}=\frac{\tau_h I}{25}
Cdiff=dVdQ=25τhI
其中,
τ
h
\tau_h
τh是少子空穴的寿命,I是二极管的电流,单位是mA。通常扩散电容的大小在nF级别,比其耗尽电容要大得多。
动态电阻
定义为:
r
d
=
d
V
d
I
=
k
T
e
I
=
25
I
r_d=\frac{\mathrm{d}V}{\mathrm{d} I}=\frac{kT}{eI}=\frac{25}{I}
rd=dIdV=eIkT=I25
这个动态电阻在模拟电路中已经详尽说明过。
室温下,且正向偏电压小于热电压 k T e \frac{kT}{e} ekT或25mV时,可以认为在交流小信号下,一个正偏二极管就是 r d r_d rd和 C d i f f C_{diff} Cdiff的并联。
反向击穿
- 雪崩击穿:反向电压升高使得耗尽层的电场大幅提高,在耗尽层中迁移的电子可以从电场获得足够的能量,并撞击其他的原子发生碰撞电离,这会产生额外的电子空穴对,而且被加速的电子必须获得了大于等于禁带宽度 E g E_g Eg的能量。此外,额外产生的电子空穴对也可能会被加速然后进一步引起更多的碰撞电离,这样就产生了雪崩现象。
- 齐纳击穿:重掺杂的pn结耗尽层较窄,而其中电场强度加大。一定的反偏电压下,n区的导带底部能量 E c E_c Ec可能会低于p区的导带顶部能量 E v E_v Ev,说明p区价带顶的电子和n区导带在一个相同的能级。如果价带和导带间隔a很窄,那么电子很容易从p区的价带通过隧道效应,到达n区,同时产生大的电流,这个过程叫做齐纳效应。
下图是反偏pn结钱击穿物理机制。

下图是单边轻掺杂突变pn结耗尽层反向击穿场强与掺杂浓度的关系。
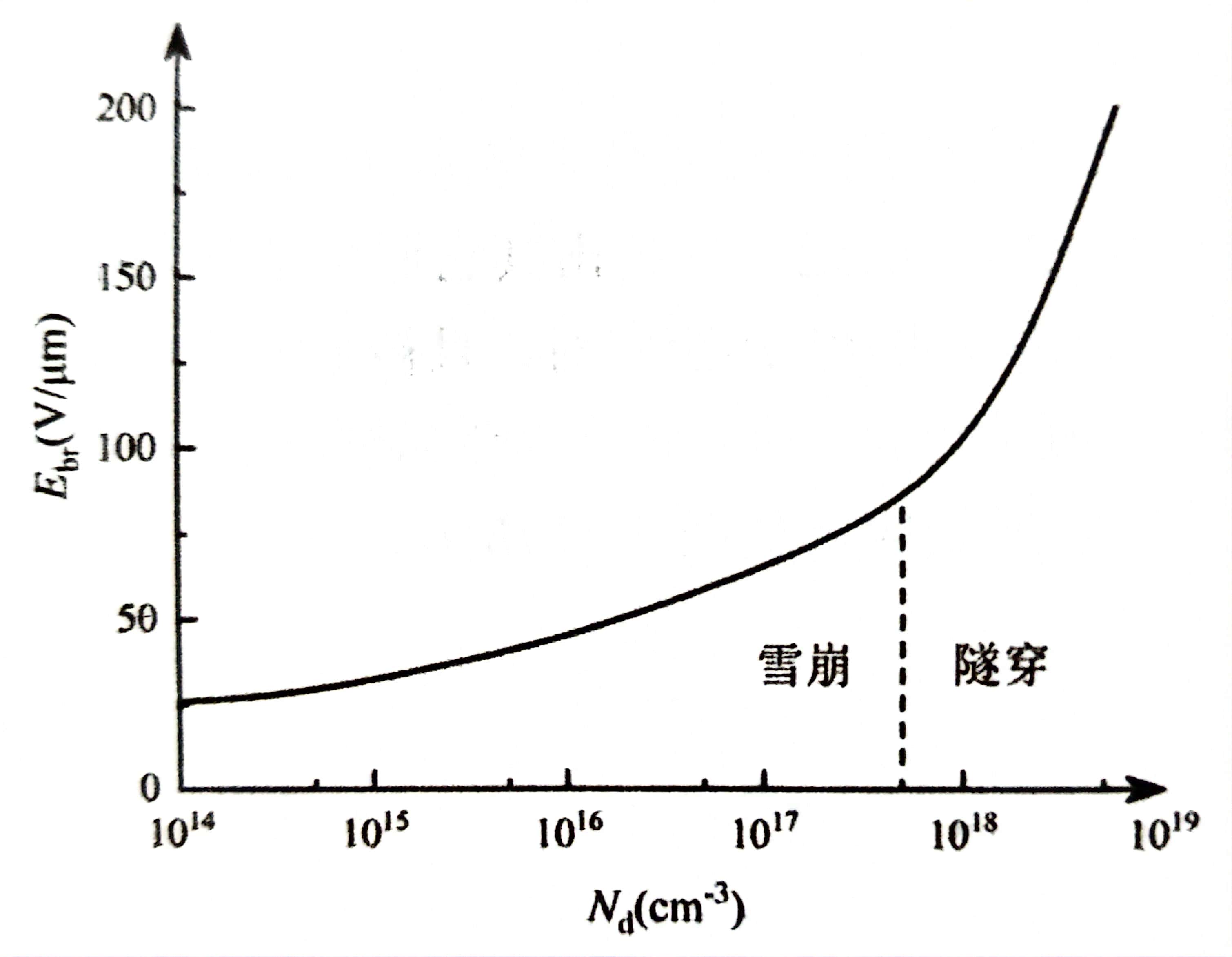
金属-半导体接触
pn结是一种半导体材料制成的,叫做同质结。如果二极管使用两种不同的材料来制造,就叫做异质结。其中一种材料可以不使用半导体而使用金属,即金属-半导体接触制造成的具有整流接触的二极管。

上图是金属半导体接触能带图,a图是接触前的金属半导体能带,b图是理想金属与n型半导体结,c图是反偏电压时理想金属半导体结,d图是正偏电压时理想金属半导体结。
金属和n型半导体接触前的理想能带如图a所示,其中真空能级是参考能级, Φ m \Phi_m Φm和 Φ s \Phi_s Φs分别是金属和半导体功函数, χ \chi χ是电子亲和能,在接触前, Φ m > Φ s \Phi_m>\Phi_s Φm>Φs,半导体的费米能级大于金属的费米能级,接触之后半导体的电子流到金属内,直到两边的能级达到一样,半导体中形成了带正电的空穴和耗尽区。
-
图中, Φ B O = Φ m − χ \Phi_{BO}=\Phi_m-\chi ΦBO=Φm−χ是金属中的电子向半导体中流动所需要克服的势垒,这就是肖特基势垒。
-
V b i = Φ B O − Φ n V_{bi}=\Phi_{BO}-\Phi_n Vbi=ΦBO−Φn是半导体导带中电子移动到金属所形成的势垒,这就是内建电势差。
-
给其外加一个直流电压,如果半导体是连在正极,那么就是反偏,半导体和金属的势垒变大, Φ B O \Phi_{BO} ΦBO不发生变化。
-
如果金属连在正极,那么就是正偏,那么势垒高度 V b i V_{bi} Vbi减少, Φ B O \Phi_{BO} ΦBO依然不发生变化,此时因为内奸电势差变小,电子从半导体移动到金属内。
肖特基势垒二极管的电流主要取决于多子电子的移动,正偏电流方向是从金属向半导体,数值大小为正偏电压 V a V_a Va的指数函数。
可以求得其耗尽层的宽度,
V
R
V_R
VR就是外加电压:
W
=
x
n
=
2
ε
s
(
V
b
i
+
V
R
)
e
N
d
W=x_n=\sqrt{\frac{2\varepsilon_s(V_{bi}+V_R)}{eN_d}}
W=xn=eNd2εs(Vbi+VR)
结电容是:
C
′
=
e
N
d
d
x
n
d
V
R
=
e
ε
s
N
d
2
(
V
b
i
+
V
R
)
C'=eN_d\frac{\mathrm{d}x_n}{\mathrm{d}V_R}=\sqrt{\frac{e\varepsilon_s N_d}{2(V_{bi}+V_R)}}
C′=eNddVRdxn=2(Vbi+VR)eεsNd
其中,C’为单位体积的电容量,对其做变形可得:
(
1
C
′
)
2
=
2
(
V
b
i
+
V
R
)
e
ε
s
N
d
\left(\frac{1}{C'}\right)^2=\frac{2(V_{bi}+V_R)}{e\varepsilon_s N_d}
(C′1)2=eεsNd2(Vbi+VR)
可见, ( 1 C ′ ) 2 \left(\frac{1}{C'}\right)^2 (C′1)2与 V R V_R VR呈现出线性关系,可通过关系曲线求出掺杂浓度 N d N_d Nd。
在电场下,势垒下降,产生肖特基效应,降低的势垒高度是 Δ Φ = e E 4 π ε s \Delta\Phi=\sqrt{\frac{eE}{4\pi\varepsilon_s}} ΔΦ=4πεseE,同时势垒高度还受到表面态的影响。
pn结中的电路取决于少子,而金属半导体的电路取决于多子。电子运动通过势垒,可以使用热电子发生理论解释,其电流密度可以写为:
J
=
J
s
T
(
e
e
V
a
k
T
−
1
)
J=J_{sT}(e^{\frac{eV_a}{kT}}-1)
J=JsT(ekTeVa−1)
J
s
T
J_{sT}
JsT就是反向饱和电流密度:
J
s
T
=
A
∗
T
2
e
−
e
Φ
B
n
k
T
=
A
∗
T
2
e
−
e
Φ
B
0
k
T
e
e
Δ
Φ
k
T
J_{sT}=A^*T^2e^{-\frac{e\Phi_{Bn}}{kT}}=A^*T^2e^{-\frac{e\Phi_{B0}}{kT}}e^{\frac{e\Delta\Phi}{kT}}
JsT=A∗T2e−kTeΦBn=A∗T2e−kTeΦB0ekTeΔΦ
上式变化的原因是
Φ
B
n
=
Φ
B
0
−
Δ
Φ
\Phi_{Bn}=\Phi_{B0}-\Delta\Phi
ΦBn=ΦB0−ΔΦ
肖特基二极管为多子导电器件,加正偏电压不会产生扩散电容。从正偏转向反偏,不存在pn结中的少子存储效应。所以肖特基二极管是高频器件。
半导体材料应用
半导体材料的分类
分为有机半导体和无机半导体。无机半导体分为元素和化合物型;从晶态可分为多晶、单晶和非晶半导体等。
元素半导体材料
90%以上的半导体器件和电路由硅制成。
分为本征半导体和掺杂半导体。
化合物半导体材料
- III-V族化合物半导体:由III族和V族元素构成的金属间化合物半导体,大部分属于闪锌矿结构。禁带宽度大,高温性能、热稳定性、耐辐射性好。适用于高频高速开关,可制成禁带宽度、点阵常数和迁移率等连续变化的半导体材料。砷化镓等有明显的光电效应,可以应用于太阳能电池和光电器件。
- II-VI族化合物半导体:由II族和VI族元素构成的金属间化合物半导体。有直接跃迁型能带结构,禁带范围宽,发光色彩较为丰富。导电率变化广,温度升高禁带减小。可以应用于激光器、发光二极管、荧光管等。
- IV-IV族化合物半导体:例如SiC是宽禁带半导体,晶体结构复杂,一般以 α \alpha α-SiC和 β \beta β-SiC为主,可以制成高温工作的面接触型整流器和场效应管。
半导体薄膜
厚度仅有几个微米,主要分为超晶格薄膜和非晶态薄膜半导体材料。
- 超晶格材料是两种不同掺杂的半导体薄膜或不同成分的薄膜交替生长而成的周期性多层结构材料,可以作差调制掺杂超晶格和组分超晶格晶体。其载流子迁移率和寿命较高,可产生隧道效应和独特的光学特性等。可以制成光电器件例如平面型掺杂势垒光探测器、量子阱激光器等;电子器件例如高电子迁移率晶体管、超晶格雪崩二极管等。
- 非晶态物质是原子排列上的长程无序短程有序的一种状态。其对杂质不敏感,电阻率与掺杂无关。其非结构敏感性主要来源于掺杂杂质的正常化合物都被饱和,即全部价电子都处于键合状态。
半导体材料应用
除了用于二极管、三极管、大规模集成电路和各类传感器等电子元件领域,还可用于高压电机、电缆、避雷器、电力电子器件等。
电压电阻效应及其应用
电压电阻效应,即压阻效应,指的是因为电压引起电阻辩护的现象,是非线性特性元件。电压和电流特性,有对两电极表现出对称的对称形压敏电阻和对两电极表现出非对称的非对称形压敏电阻。前者是使用ZnO等材料,后者使用Si二极管。
非线性原因是:结晶粒界存在由高电阻层形成的势垒,在某一个电压下,由于电子隧道效应和电子雪崩而引起电流急剧增加所导致。
SiC可以在高压电机的防电晕中使用。有良好的非线性导电特性,其电阻可以随电场的增加而自动降低,所以可以自动调节场强。
ZnO压敏陶瓷可以在金属氧化物避雷器中使用。
热电阻效应及其应用
热电阻效应,即热阻效应,指的是随温度变化电阻发生很大变化的现象。
- NTC热敏电阻指的是负电阻温度系数的电阻。用来制造温度敏感传感器和红外线辐射测温仪。
- PTC热敏电阻指的是正电阻温度系数的电阻,分为陶瓷PTC和有机高分子PTC。一般用作自控温元件。
- CTR热敏电阻在一个温度下,电阻值随着温度的增加而急剧下降,有着很大的负温度系数,也就是负电阻突变特性。一般用作温度开关,适用于保护电路。
硅半导体在电力电子器件中的应用
电力电子器件一般用作于开关状态,分为不可控元件,例如二极管;半控型元件,例如晶闸管等;全控型器件,例如IGBT、MOSFET和电力二极管等。























 4万+
4万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








