写在前面
器件结构V1已经初见雏形,下面该器件仿真,获取电流电压特性,但是在电极定义中遇到了困难,电极定义:
electrode name=anode x=6 y=-0.5
electrode name=cathode y=5.2报错如下:
ATHENA> electrode name=anode x=6 y=-0.5
**** Warning ****
Cannot find the electrode for this structure. Electrode
statement ignored.
ATHENA> structure outfile=hist_38.str
ATHENA> electrode name=cathode y=5.2
**** Warning ****
Cannot find the electrode for this structure. Electrode
statement ignored.
所以就完整复习工艺仿真流程,重点是电极定义
网格定义也是需要细致完善的,应该是根据器件的特点,调整网格疏密程度,所以网格定义也是复习重点。
如何将表面电极平坦化?
一、工艺仿真流程复习——学习唐龙谷书籍
此部分非原创,仅记录学习过程中的重点,内容来自唐龙谷老师的半导体工艺和器件仿真工具 Silvaco TCAD实用教程书籍。
ATHENA概述
代码中执行了go athena之后,Deckbuild实时输出窗口会给出当前licenses所允许的仿真组件,如下图,包括ATHENA、SSUPREM4(二维核心工艺仿真器)、Monte Carlo Implant(蒙托卡诺离子注入仿真器)、ELITE(先进物理刻蚀和淀积仿真器)、Monte Carlo Deposit/Etch(蒙托卡诺淀积和刻蚀仿真器)、OPTOLITH(二维光刻仿真器)和ATHENA multicore(我这上边没有)
A T H E N A
Version: athena 5.21.2.R (Fri Jul 12 14:21:19 PDT 2013)
Copyright ?1984 - 2013
Silvaco Inc. All rights reserved
We acknowledge the contribution of the following collaborative partners:
Stanford University
==============================================================
ATHENA : Enabled
SSUPREM4 : Enabled
Monte Carlo Implant : Enabled
ELITE : Enabled
Monte Carlo Etch & Deposit : Enabled
OPTOLITH : Enabled
==============================================================
It is now Thu Mar 02 10:59:27 2023
Executing on host: LAPTOP-1OAUHSR3工艺仿真组件ATHENA有很强的工艺仿真能力,包括单项工艺:离子注入、扩散、淀积、刻蚀、外延、光刻、氧化等。集成工艺从根本上说是单项工艺的组合而来。不具体区分工艺命令是对应哪一个仿真组件的语句,因为这些仿真组件都可以在DeckBuild中灵活调用。

上图为ATHENA的输入输出框架,由工艺步骤、版图和掩膜等的基本工艺条件输入ATHENA,则可以仿真得到相应的结构,内建的计算器还可以计算简单结构的电学信息。输入侧重工艺仿真条件的控制,输出侧重仿真能力。
ATHENA使用了大量默认参数,参数储存在一些仿真程序的文件目录中。
ATHENA生成的标准结构文件可以在其他的仿真器如ATLAS或DevEdit中使用。SSF中含有mesh信息,solution信息,model信息和其他相关的参数。
ATHENA 能仿真的工艺及其具体特性如下:
Bake(烘焙,前烘、后烘)
C语言解释器:允许用户自定义模型
CMP:化学机械抛光。
淀积
开发:五种不同的光刻胶开发模型?
扩散
刻蚀(Etch)
外延生长
曝光
成像(显影?)
氧化
硅化
ATHENA的示例库中含有很多单项工艺的例子,在器件仿真的例子中也有一些是由工艺仿真来生成器件结构的,通过这些例子可以更好的学习和掌握工艺仿真。√。在DeckBuild的Example下拉菜单中选择ATHENA工艺示例库可看到很多代码示例。示例是按照工艺类型分组的,学习时要充分利用这些例子。

下图是工艺仿真流程图。在仿真工艺之前需要先建立网格,这时的网格是指衬底的网格(如果后续工艺带来了新的材料层,则有相应的网格控制的参数:例如div=10等)。仿真初始化是对衬底进行初始化,即定义衬底的材料、掺杂或晶向等。初始化也可以是导入现成的结构(昨天的问题的另一种解决办法:先用ATLAS定义一个背面高掺杂的衬底结构,然后工艺仿真的时候初始化导入该器件!)。工艺步骤即是要仿真的工艺,如淀积、光刻、氧化、刻蚀或扩散等。每一个工艺都有相应的模型以及参数,对于工艺参数的设定需要参考手册或相关文献。经过工艺步骤之后可以提取工艺的结果如结深、材料厚度、浓度分布等。结构操作如导入结构、对结构旋转、做镜像和保存等。Tonyplot可以显示仿真的结果。
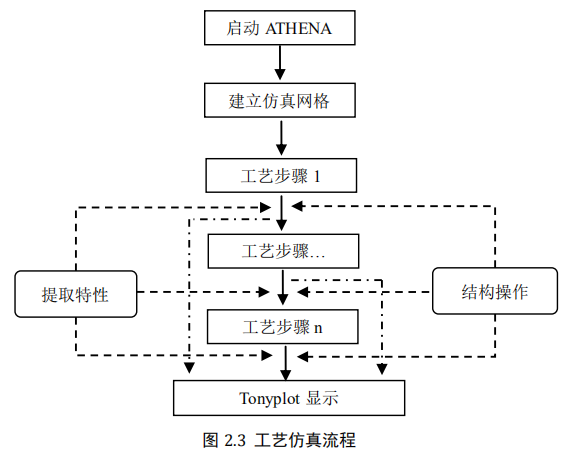
仿真的时候上边的步骤不一定都需要,顺序也可以灵活一些。如导入现成结构的话就可以直接从工艺步骤的仿真开始,要仔细观察变化可以在每一步工艺后存一个结构再用Tonyplot显示出来。提取特性视需要而定。
学习离子注入的例子:从该例子,复习,离子注入会造成器件晶格结构损伤,杂质离子可能也不在正确的位置上,需要热退火(RTP)来激活杂质离子,我自己的pin器件需要在这里完善。
go athena
#调用ATHENA仿真组件
# dimension definition
line x loc = 0.0 spacing=0.1
line x loc = 0.1 spacing=0.1
line y loc = 0 spacing = 0.02
line y loc = 2.0 spacing = 0.20
#网格定义 x方向(0到0.1um)不划分,y方向(0到2um)间距由密变疏
#这是由于离子注入时,器件表层浓度变化明显。
# initialize the mesh 衬底初始化:Si材料,掺入P(N型)浓度为1e14
init silicon c.phos=1.0e14
# perform boron implant 硼(B,P型)离子注入,参数:注入剂量=1e13,能量=70KeV
implant boron dose=1e13 energy=70
# perform diffusion热退火,杂质激活:时间:30min;温度=1000
diffuse time=30 temperature=1000
#提取特性:结深,x值=0时的结深
extract name="xj" xj silicon mat.occno=1 x.val=0.0 junc.occno=1
# save the structure 保存结构 硼注入
structure outfile=boron_implant.str
# plot the final profile画图
tonyplot boron_implant.str
quit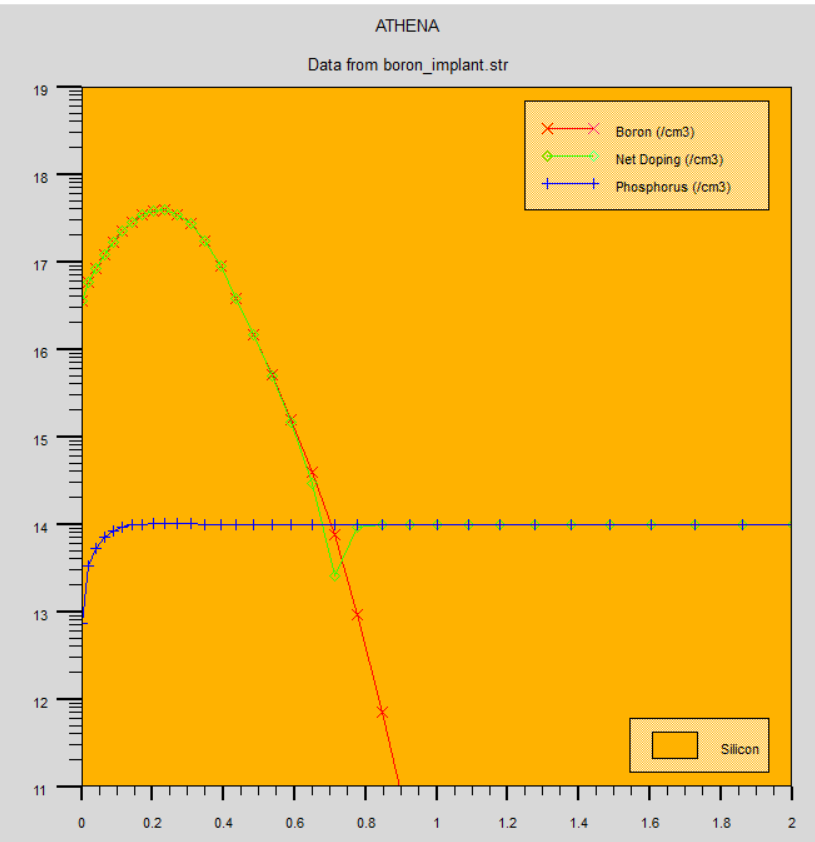
xj=0.700573 um from top of first Silicon layer X.val=0
仿真结果
工艺仿真的结果形式有多种,如保存的结构文件 ,实时输出窗口中显示的信息,提取保存的dat文件。结构文件和dat文件可由tonyplot进行显示。
小tip:init silicon c.phos=1.0e14 two.d
加上two.d的话,哪怕就是一维结构也可以以二维形式展现。如果没加two.d,默认从一维仿真开始。一维仿真:横纵轴不再都是真实的器件,横轴是纵向的深度,纵轴显示杂质浓度等参数。浓度曲线是由网格线处的结果连接起来得到的,所以网格定义对仿真结果的影响很大,有时甚至超过工艺参数或模型的影响。在观察工艺参数对结果的影响时,必须在相同的网格下进行,不然不具有可比性。由于衬底杂质是磷、注入的是硼,所以会形成结,提取到结深为0.70um,显示在实时输出窗口。
仿真流程
开始深入介绍这些流程
2.1 定义网格
工艺仿真之前要先定义衬底,在衬底的基础上经过一系列工艺步骤来生成结构。silvacoTCAD是基于网格计算的仿真工具,也就是在网格点处计算其特性。二维仿真的网格点(node)的总数不能超过20000个。网格点的多少决定了仿真的准确程度和快慢,所以合理的定义网格分布很重要。
参数:X/Y loc= spac= tag=
loc设定网格线在轴上的坐标;spacing设定在该loc处临近网格线间的间距,默认单位都是um。tag参数可在相应的位置加标签,将在以后定义边界和区域的时候提供方便。网格的原点在左上角,y的坐标越往上越小。如果几个loc处的spac大小一样,则网格线均匀分布。如果spac不一样,Silvaco会自动调整,尽量使loc处的spac和设定值一样,这时网格线不均匀。
以上只是定义衬底的网格分布,但后续工艺如氧化,淀积等引入的材料他们的网格如何定义呢?Silvaco对此也给予了充分的考虑,这些工艺都有相应的参数来指定网格的分布。下面从淀积的示例来看怎样实现网格定义:
例 2-12 淀积多晶硅以及定义新增加的多晶硅层的网格。
deposit polysilicon thick=0.50 divisions=10 dy=0.1 ydy=0.25
deposit polysilicon thick=0.50 divisions=10 dy=0.02 ydy=0.25淀积工艺中网格控制的主要参数有:divisions、dy、ydy、min.dy、min.space,各参数的意义如下:
divisions:将新淀积的层划分为divisions份
dy:公称网格间距? 类似spac
ydy:网格间距位置 类似loc ydy是从新淀积层的表面往下的位置
min.dy:最小网格间距
min.space:最小边缘间距
ATHENA的网格“grid”是由连接着三角形的一些点“point”组成的,每一个点有一个或多个节点"node"与之对应。如果“point”在一个材料内部,则对应一个node,如果在几种材料的交界处,则对应多个node。每一个node有代表特定区域特定材料在该point处的一些状态值(solution)如掺杂浓度、迁移率、电场强度等,所以网格定义对仿真结果非常关键。通常是在最需要精确计算其特性的地方就定义得密一些,如样品表面要比衬底底部定义得密一些,异质结界面处,材料厚度很薄的层等。网格越精细仿真的精确性也相应改善,但仿真速度也要变慢,对收敛性也有影响。
由于默认参数tri.left将网格矩形从左下角到右上角划分为两个三角形。之所以将矩形拆分成三角形,是因为在器件编辑器中定义网格时可以由三角形的斜率和夹角来定义网格的容限,使网格不至太过粗糙。另外,第一章在讲解Tonyplot的probe功能时提到了在一个三角形内的物理量都是相同的,这是网格离散化的必然结果。
2.2 衬底初始化
网格定义了之后就是对衬底进行初始化,初始化的命令是“initialize”,initialize可简写为“init”
常用参数:衬底材料、衬底晶向、浓度所含杂质的种类及浓度(均匀掺杂atom/cm3);电阻率;ONE.D,TWO.D,AUTO(仿真的初始维度,默认是AUTO,即一开始采用一维计算直到需要采用二维计算,通常从etch开始);x.locat:2DMesh结构中指明进行一维仿真的位置;space.mult:指定全局的spacing的乘数;scale:输入网格线的最大比率,默认为1;flip.y 设定mesh对x轴做镜像,即将衬底的底部置为最表面……
初始化,导入已有的结构文件:init infile=pre.str
2.3 工艺步骤
ATHENA 工艺仿真器可以对很多工艺进行仿真,这些工艺包括外延,扩散, 氧化,刻蚀,化学机械平坦,淀积,烘烤,曝光,develepment,显影 和 硅化 等。工艺仿真组件有 ATHENA,SSUPREM3,SSUPREM4,parallel monte carlo implant,ELITE, monte carlo deposit/etch,OPTOLITH 等
2.4 提取特性
工艺仿真得到的结果形式有结构文件.str,或是提取的特性如材料厚度、结深、表面浓度、浓度分布、某杂质的总浓度、方块电阻等。Extract有内建的一维QUICKMOS和QUICKBIP,可以在工艺仿真器中提取得到器件结构的信息,如一维电容(1djinc.cap)、一维电导(1dn.conduct)和阈值电压等。
2.5结构操作
结构操作的命令是structure。structure可以保存和导入结构,也可以对结构做镜像或上下翻转,镜像用mirror,参数有left right top bottom;上下翻转是flip.y
例 2-18 保存当前结构到结构文件。
structure outfile=filename.str
例 2-19 对结构做镜像,left 表示现有结构对左边翻转得到新结构的左半部分。
structure mirror left
例 2-20 结构上下翻转,将衬底置于表面(这样可以对衬底进行操作)。
structure flip.y
例 2-21 导入结构文件。
structure infile=filename.str导入结构也可用init,即在启动仿真器ATHENA时由初始化导入结构。在器件仿真中如果不关心结构怎么生成,只需要得到它的器件特性时由init导入结构会很方便。
2.6 Tonyplot显示
Tonyplot可视化工具用来显示当前的结构或是已经保存的结构文件的结构或掺杂等信息。工艺仿真中各个步骤得到的结构可用Tonyplot的动画功能做成动画(格式为.gif文件)。Tonyplot提供简单的函数计算功能如积分,还有PoissonSolver的功能可以在工艺生成的结构中计算一些电学特性。
3.单项工艺
3.1离子注入
离子注入用于工艺仿真时进行注入掺杂,注入的杂质可以是硼、磷、砷、BF2\锑、硅、锌、硒、镁铝钾碳铟等
语法:
主要参数:离子注入模型(GAUSS BCA PEARSON FULL.LAT MONTECARLO等);注入的杂质种类、粒子能量、注入剂量、纵向角度……
几个重要的平面:样品表面(晶向);仿真面(器件剖面);离子注入面(由rotation和Y轴决定)
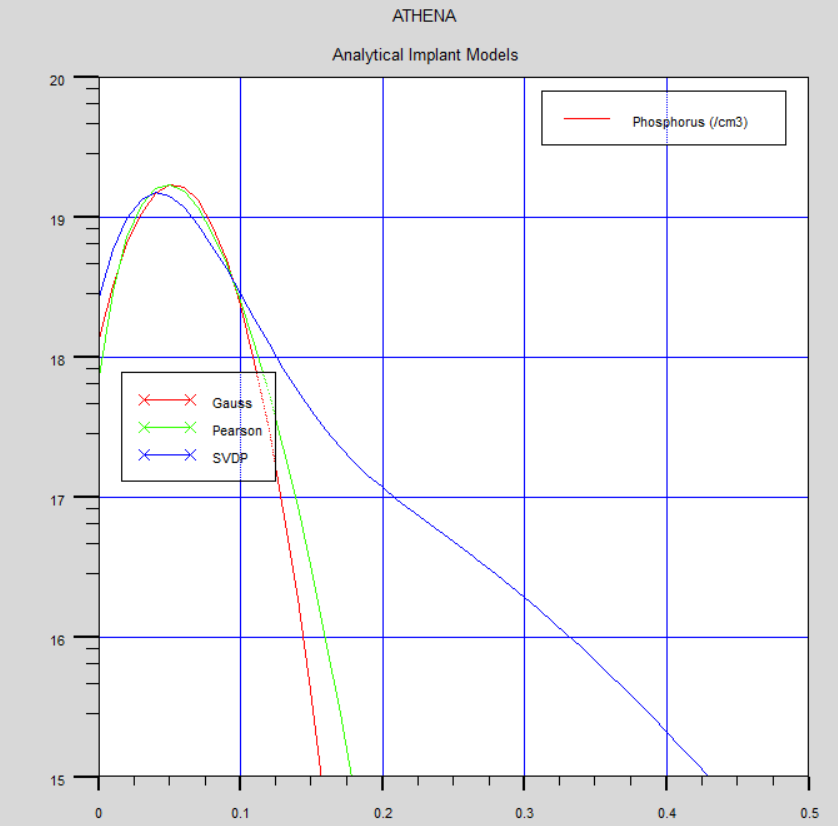
Gauss Pearson SVDP(应该是默认)三者对比
语法:
#Gauss (symmetrical) implant (parameters are in std_tables)
moments std_tables
implant phos dose=1e14 energy=40 gauss
#Use single Pearson (parameters are in std_tables)
moments std_tables
implant phos dose=1e14 energy=40 pearson print.mom
#Use SVDP method (default)
moments svdp_tables
implant phos dose=1e14 energy=40 print.mom
#print.mom :输出所有离子或材料的动量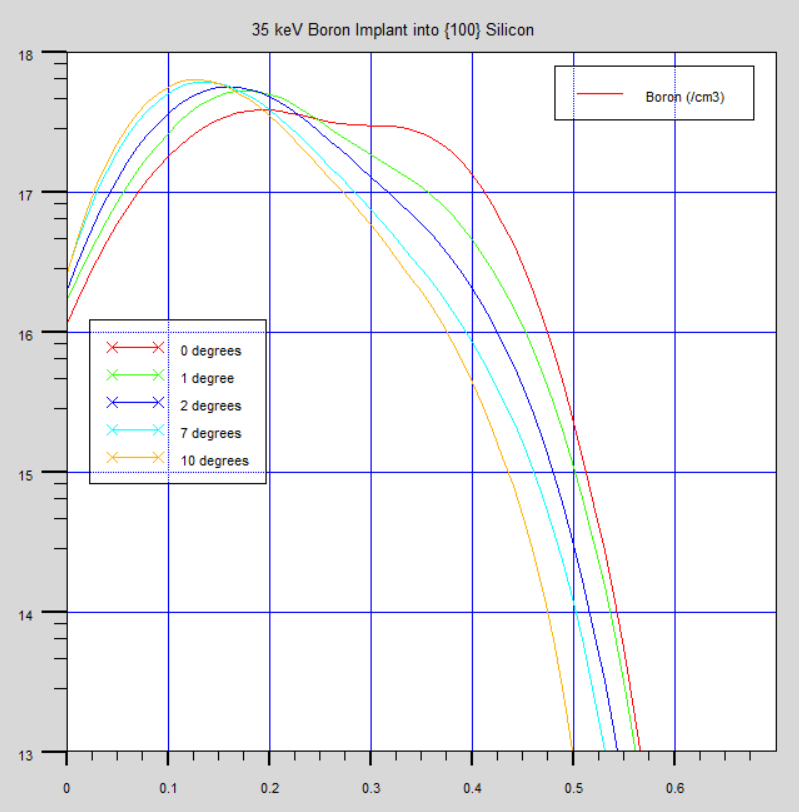
不同注入角度分布
代码:
implant boron energy=35 dose=1.e13 tilt=0 rotation=0 print.mom
implant boron energy=35 dose=1.e13 tilt=1 rotation=0 print.mom
implant boron energy=35 dose=1.e13 tilt=2 rotation=0 print.mom
implant boron energy=35 dose=1.e13 tilt=7 rotation=0 print.mom
implant boron energy=35 dose=1.e13 tilt=10 rotation=0 print.mom该实例完整代码每一个条件都从定义网格开始到保存结构的,差别只是注入角度不同。由于注入的参数有print.mom,留意输出窗口会发现下述信息:
The following implant parameters are found in the ** SVDP (UT at Austin) tables ** and used for:
MATERIAL: silicon; ION: Boron; S.OXIDE.THICK- NESS=0.001um. energy=35 dose=1e+013
tilt=10 rotation=0 range=0.1319 std.dev=0.0562 gamma=0.295714 kurtosis=3.08571 srange=0.216829
sstd.dev =0.0687286 sgamma=0.396857 skurtosis=2.79571 dratio=0.808243 lstd.dev =0.056 kurtt=3
lsstd.dev=0.0032 skurtt=1.82
离子注入会导致晶格损伤,损伤是由原子碰撞引起的。损伤的数量和分布由注入的能量、类型、注入离子的剂量决定。BCA或MD仿真器可以详尽的描述点缺陷、团簇和三维缺陷。缺陷的具体类型包括间隙原子、空位、{311}团簇等
3.2 扩散
扩散可用于仿真杂质的扩散,但不同的扩散氛围会有不同的效果,如氧气氛下的扩散实际上可以对表层的硅或多晶硅进行氧化,如果气氛中含有杂质浓度则可以仿真预沉积。
语法及重要参数:扩散时间;扩散时间单位,默认min;温度(恒温变温设置);气体氛围(干氧湿氧氮气inert);分压;HCL百分比;
干氧样化,氧化层也可以用淀积制作;变温扩散;预淀积
3.3 淀积
Deposit 命令可以淀积特定的材料。
语法及重要参数:淀积材料、淀积光刻胶类型、淀积厚度等
Rate.deposit?不是可以精确设定结果的几何仿真,更接近实际,但不好控制,要选机器和时间等参数
3.4 刻蚀
ATHENA提供两种不同的刻蚀方法,一种是几何刻蚀,另一种是物理刻蚀,物理刻蚀组件是ELITE
ETCH:被刻蚀材料;刻蚀光刻胶的类型;指定的材料完全被刻蚀;刻蚀表面形貌不变,整体下降thickness大小;干法刻蚀刻蚀厚度;角度;梯形刻蚀(p1.x等);任意刻蚀,由一些点组成的区域。
ELITE:刻蚀机器、刻蚀时间、刻蚀时间单位
RIE和湿法刻蚀主要参数:刻蚀速率……
等离子体刻蚀主要参数:压强、温度、
当使用更高级的模型时可以采用ELITE组件。
将裸露在表面的所有材料都刻蚀到一定厚度 etch dry thick=1
对材料刻蚀到一定厚度etch silicon thick=1
一些不同的刻蚀:湿法、RIE、等离子体、蒙托卡诺
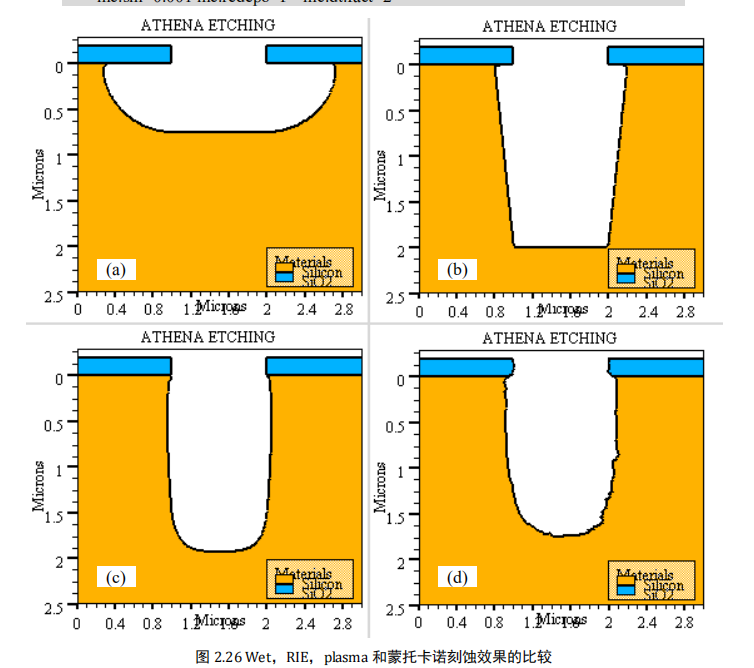
刻蚀是将一定区域中被刻蚀材料去除掉,虽然有刻蚀深度、刻蚀速率、刻蚀方向性等一系列刻蚀参数,但网格定义对结果也至关重要,被刻蚀的区域的网格应尽量定义得精细一些。
3.5 外延
外延是指对硅的外延
外延主要参数:淀积时间、温度、变温、厚度、掺杂等
当表面存在较大起伏时淀积得到的网格有的地方会很粗糙,当粗糙程度超过一定限度时程序就会警告,甚至停止。
3.6 抛光
CMP化学机械平坦化
抛光机器、时间、时间单位、时间步长、时间步长的上限

会报错
3.7 光刻
成像、光阻曝光、光阻烘烤、光阻显影
模块:mask illumination、projection、filter、layout、image、bake、expose 和 develop
3.7.1.mask
可淀积和形成光刻胶图形 。三维工艺仿真是由掩膜驱动的,所以如何得到掩膜文件.lay就很重要了。
3.7.2 illumination
设置OPTOLITH的照明参数:波长、i线等
3.7.3 projection
3.7.4 filter
设定OPTOLITH的发射孔类型和光源形状及其滤波特性,有四种不同的发射孔类型并允许傅里叶转换平面空间滤波。
3.7.5 LAYOUT
LAYOUT描述光刻时输入掩膜的特征
定义掩膜不需要从网格定义开始,因为掩膜所在面是X轴和Z轴的水平面,并不是器件剖面。
3.7.6 IMAGE
IMAGE为计算一维或二维成像的光强分布。
3.7.7 EXPOSE
曝光模块
3.7.8 BAKE
描述对光阻的后曝光和后坚膜时的烘烤
3.7.9 DEVELOP
显影模块
3.7.10 RATE.DEVELOP
3.7.11 完整光刻流程
4.集成工艺
单项工艺。对于BJT MOS CCD LED ESD La'se'r 射频用电容电感等器件或由这些器件组成的小规模电路无非也是由这些基本的工艺组合而来。引发两个疑问:一、有哪些单项工艺组合而来?二、这些工艺的参数如何得到?很复杂
PDK?
5.优化 Optimizer
在工艺仿真时如何得到想要的结果(如希望栅氧长到多厚,离子注入后方块电阻为多少等),这就需要对参数进行优化,Silvaco提供了优化工具Optimizer
启动方式:Commands->Optimizer
5.1 优化设置

优化窗口
优化前需对优化方案进行设置,包括误差范围、寻找次数等,接下来从扩散进行干氧样化的工艺着手讲解优化工具的使用,需对扩散的温度和时间进行优化得到一定厚度的氧化层。
5.2 待优化参数
选择优化参数,在Deckbuild的命令行中选中需要优化的工艺步骤,选中后在Optimizer->mode->Parameters,然后执行Edit->Add,出现参数选择窗口,将time 和temp选上,出现参数设置窗口,参数设置中可设置参数扫描的范围。
SilvacoTCAD可以对多个工艺同时进行优化,优化后的结果也可能有多个组合,怎么选呢?其实可以通过约束参数扫描的范围能较好的进行控制。
5.3 优化目标
优化目标通常是提取的工艺结果,如结深,材料厚度,浓度,方块电阻等。选中相应行,选中后在Optimizer->MODE->Targets,然后执行Edit->Add,即出现优化目标设置框,设置Target Value到目标即可
5.4 优化结果
优化设置、参数和目标设置好后在Optimizer->Mode->Results,然后执行OPtimizer,Deckbuild就会按照设置来回扫描工艺参数,直到提取的结果和目标值在设定的误差范围内。
工艺优化是很好很方便的工具,至此,上一节集成工艺刚开始时提出的两个问题初步给出了解决方法。
哈哈哈就是为了复习电极定义,结果在工艺仿真没提到,不过再看一遍还是有新的收获。
二、二维器件仿真
同1,非原创,仅复习用。
1.ATLAS概述
ATLAS器件仿真框架可以仿真半导体器件的电学、光学、热学行为。ATLAS提供基于物理的模块化的易用的可扩展平台,在此基础上分析二维或三维器件的DC、AC和时域响应,光——电,电——光转换等特性。ATLAS的特性功能很丰富:可以再Deckbuild交互式的运行环境中运行;允许ATHENA、SSUPREM3工艺仿真器输入;DevEdit器件编辑器输入……
主要模块:二维硅器件模拟器、三维硅器件模拟器、半导体激光,二极管模拟器、光电子器件模块……
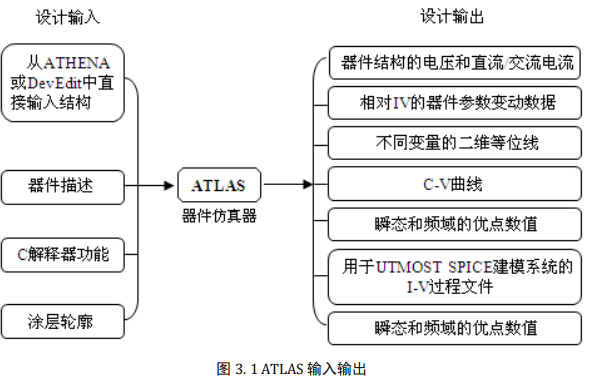
输入输出框架:器件结构由工艺仿真或器件编辑器编辑得到,对器件中材料、物理模型、电接触类型、计算方法等进行描述之后可由ATLAS计算其特性。
ATLAS器件仿真基于全面的物理模型、先进的数值计算方法、
ATLAS可以由用户输入材料的参数,如迁移率参数、寿命参数、能带参数、介电常数等,也可以自定义材料,更改物理模型的参数值。而且材料的界面、结等特性也是可以方便的进行编辑的。
go atlas,Deckbuild的当前可用组件会在实时输出窗口显示出来:
ATLAS语法和ATHENA类似,是由一系列状态及其参数组成的
语法可读性很强,从字面就能理解语句的含义
示例库:bjt ccd diode eprom esd laser……内容很多,只需对自己关心的那一些深入下去就行了
这一章主要提供仿真流程控制方面的学习经验,还有对一些常用器件的直流、交流、瞬态和频率特性的获取方式进行讲解,对光电特性、单粒子翻转效应、晶格自加热效应和噪声特性等也将简要的提及
2.仿真流程
ATLAS的仿真是通过对一系列statement的描述来进行组织的,而这些状态又可以分成一些组:大体是结构生成、设定材料模型、计算方法、器件特性获取和结果分析五种状态

3.定义结构
器件仿真时所采用的结构可由多种方式得到:
直接导入现成的器件结构
由工艺仿真器ATHENA生成器件结构
由ATLAS命令来描述器件结构
由器件编辑器DevEdit生成器件结构
直接导入和工艺生成前边已经讲过,ATLAS命令来描述器件结构是比较简单的,器件剖面占据整个X、Y轴定义的范围,不允许有空的状态。器件编辑器可以灵活的定义器件结构,它的区域边界是由一系列点(x,y)的坐标来决定的,可以得到不规则的边界。器件编辑器也支持导入现成的结构,然后进行更改,如从二维结构扩展到三维结构,网格重新定义,添加电极等。
3.1 ATLAS命令语句生成结构
ATLAS生成结构也是从网格定义开始,主要步骤有四个:初始化网格;定义区域和材料;定义电极;描述掺杂。
3.1.1网格初始化
和ATHENA定义方式相近,ATLAS是由状态x.mesh,y.mesh及其对应的参数location和spacing来定义网格。状态mesh声明网格生成开始,参数space.mult定义网格间距的比例因子,即在spacing的基础上倍乘,默认值1,大于1会让网格变粗糙,但仿真也会相应变快。参数width可以定义器件在Z轴方向的长度。
网格要考虑疏密分布。材料界面、很薄的材料层都需要定义得密一些。有的地方可以定义的稀疏些,如衬底。密的原则就是在某个location附近参数变化显著,分段线性化时应该考虑降分的段的长度小一些,这样才能得到精确的结果。网格也不是越密越好,过于密集会使仿真速度慢很多,网格点数限制在20000内。
命令eliminate可在已有的网络基础上删除掉指定矩形区域内的一些网格线,删除的方式是定义某范围内沿横向或纵向网格线隔一条删除一条。
ATLAS需要将mesh中定义的仿真剖面划分成不同的区域(region),并定义相应的区域参数之后保存结构才能由tonyplot显示网格。
3.1.2 区域和材料
ATHENA的网格定义好后,初始化即得到衬底,在衬底上经过一系列的工艺生成结构。ATLAS的网格定义是对整个器件的二维剖面(二维器件仿真)进行描述的,且剖面一定是矩形(验证了之前的想法一定是错的)
ATLAS器件剖面可以按照需要分成不同的区域,然后定义区域的特性。定义区域需要指明位置(X和Y的范围),材料以及序号。在后续定义掺杂等特性时就可以按区域定义。
应当使mesh范围全部有region进行定义,不提倡没有定义的地方,否则程序会发出警告,如果实在没有材料则可以用material=air
Total grid points: 1066 总的网格点数
Total triangles: 2000三角形数
Obtuse triangles: 0 (0 %)粗糙的三角形比例
ATLAS也可以定义区域中材料组分的渐变
3.1.3 电极
Elctrode定义电极,位置可以是x.min,x.max,y.min,y.max组成的矩形框,也可以是按照剖面的特定位置如top bottom left right substrate等定义,还可以使指定一点和电极在X方向的长度来定义。电极接触类型默认为欧姆接触。
3.1.4掺杂
杂质分布由doping状态设置,doping语法
杂质分布可以是均匀(uniform)、高斯(Gaussian)、误差函数(error function)分布
均匀分布常见的参数有杂质类型、浓度和区域
高斯分布常用的参数可以分成类型和分布参数两类,类型:n p;分布参数又分为三组:①concentration junction②dose characteristic ③concentration characteristic
误差分布和高斯分布参数定义一致
3.2 DevEdit编辑得到结构
器件编辑器得到的区域边界可以多样化。器件编辑器的区域是由一些point连起来的,而ATLAS命令中的区域是定义X和Y边界,所以只能是矩形。这样DevEdit在结构的定义上具有很大的灵活性。
器件编辑之前可以先定义工作面积,由x1 x2 y1 y2来定义
DevEdit的结构是分区域定义的,在不同区域内再指定材料和掺杂,“杂质”是以impurity定义的
Region语法
电极也是由region定义的,包括电极的位置、功函数等
写在最后 今日总结
还是问题驱动型学习软件
今天上午继续写昨天的代码,该电极的定义,但一直报错,说找不到该电极。但是我定义的方法没有错,和昨天仿真的示例mos是一样的,首先考虑是不是得定义区域(region),但是示例也没有定义具体的区域,而且教程和手册也没讲
晚上吃饭的时候和骞说了,他说 那你再写一遍,当时觉得他说的没有帮助,后来实在没办法,就想着一句一句重新敲一下,结果还真解决了问题,感谢我的骞骞宝贝!
问题出在淀积铝,我写的格式不对
depo material=aluminium thick=0.7 div=5
depo后边直接写材料就可以,不用写material=……,这样写类似于自己又定义了新的材料,系统是识别不出来铝的,自然也识别不了那个点所在的电极。
电极定义好了,就开始仿真IV特性。主要关注击穿特性。
我设置的器件结构

仿真结果:
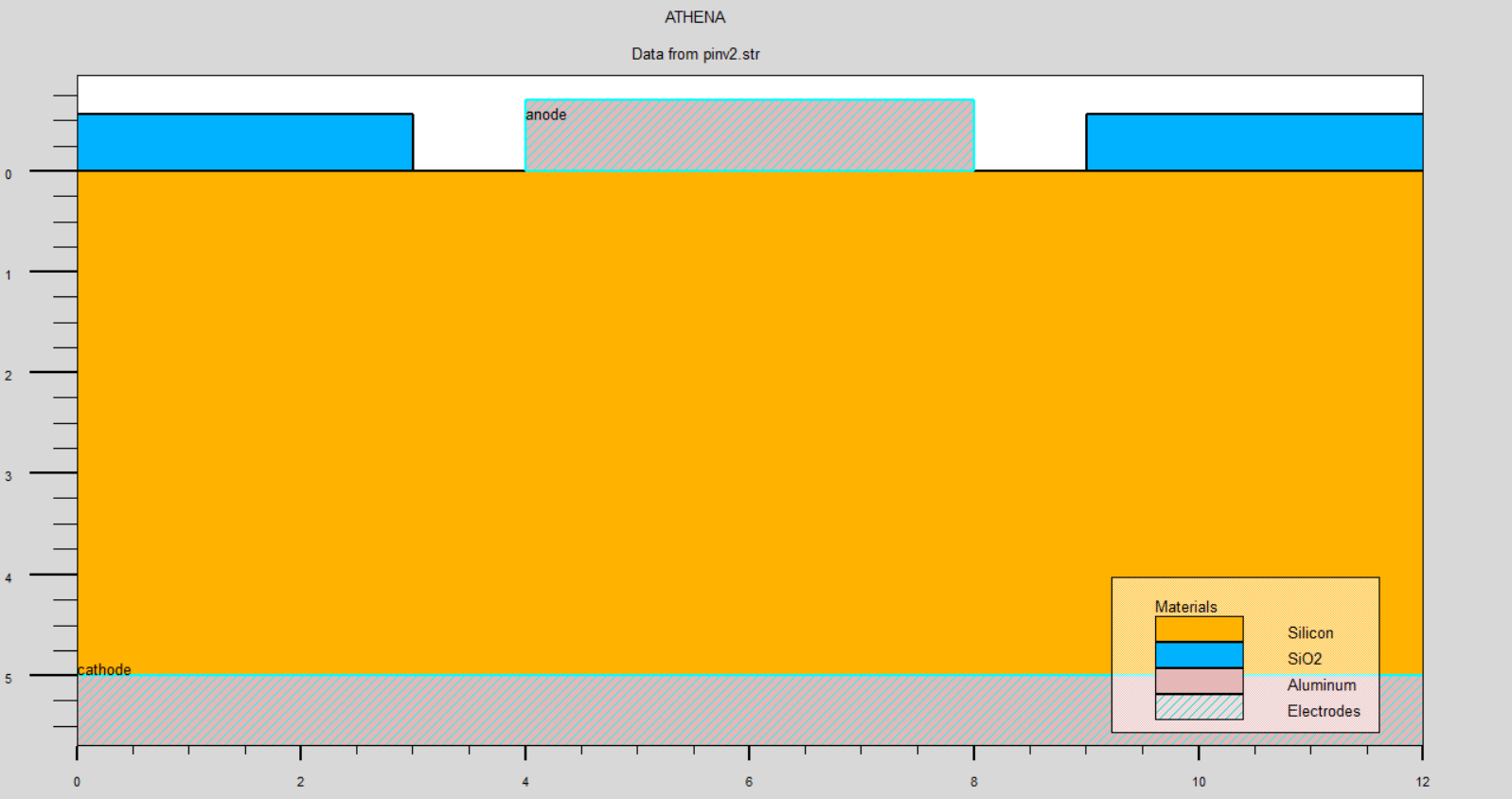
浓度:
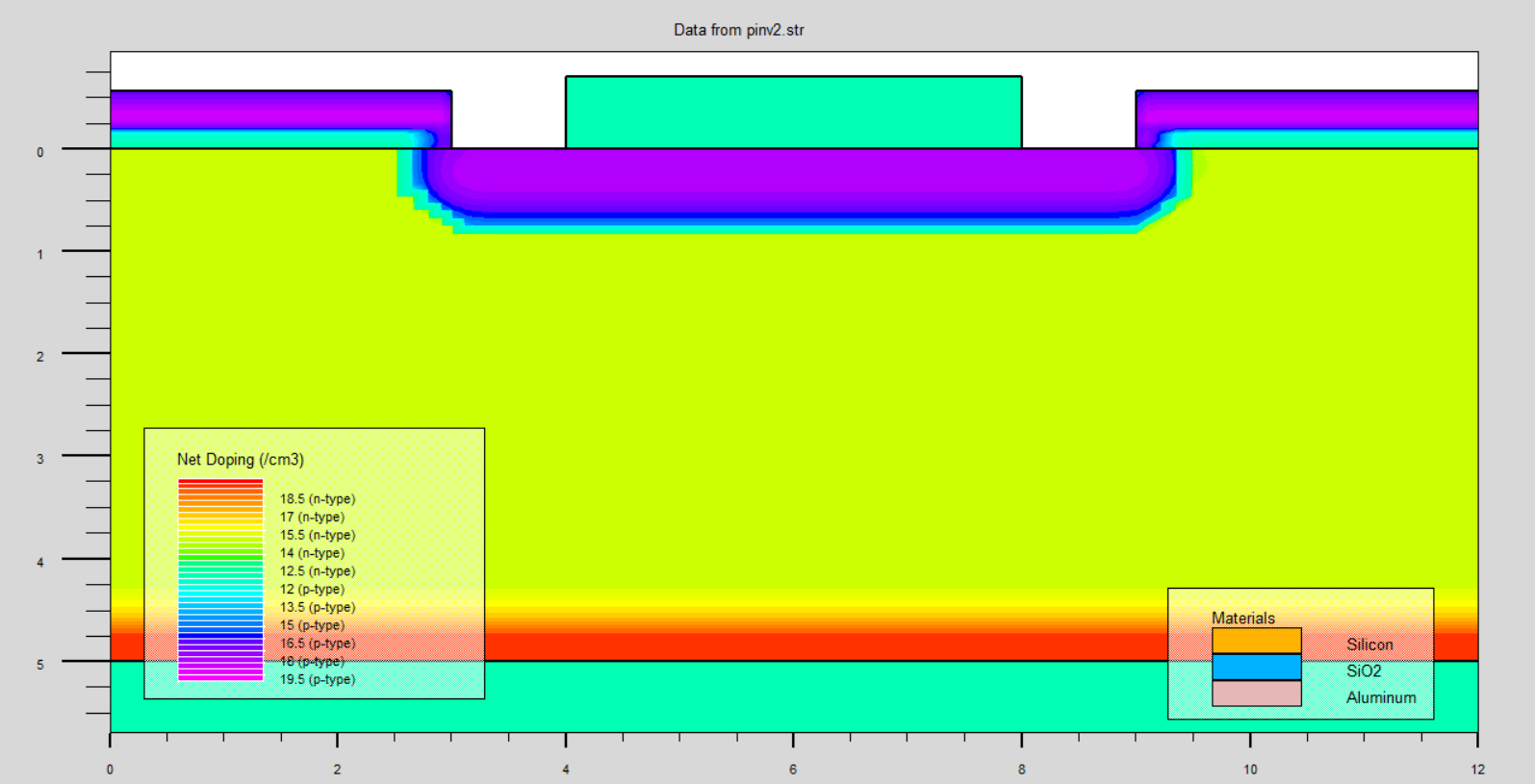
N区是阴极(cathode),P区是阳极(anode)
仿真击穿特性需要在N区加正电压,下图是方针的击穿特性
设置:
solve vcathode=90 vstep=0.1 vfinal=100 name=cathode
击穿特性:
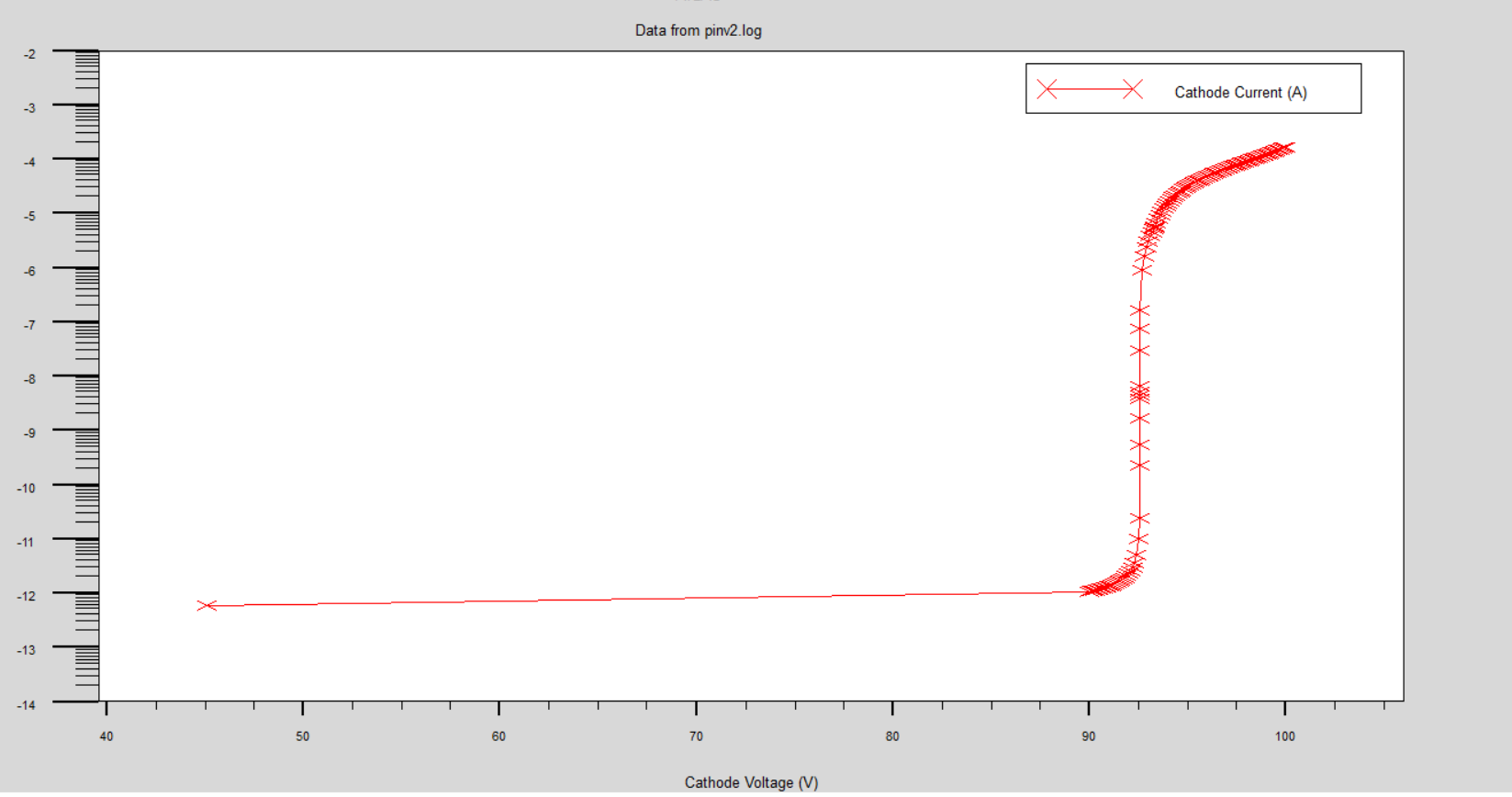
图分析:
可见击穿电压在92.5V附近
感觉器件挺小的,厚度是5um,击穿电压竟然就这么大,是因为中间的高阻衬底作用吗?
那我感觉300um的器件达到200V的击穿电压不是难事,为什么还是毕设其中一个关键指标呢?
可能还是我仿真设置的问题。
不过提高击穿电压也不能单纯降低掺杂浓度,这样的话全耗尽电压也提高了,也会导致器件容易击穿,要找到一个平衡点、中和点,记得之前看过一篇论文,应该有对这个问题的讨论。
首先对于PIN器件的击穿特性不够了解,不然还能计算出击穿电压的一个理论值,对此次仿真结果进行一个大致的评估;这个需要通过调研有关PIN击穿特性的论文或理论知识(图书馆书籍等)或直接搜索别人做过的实验来感悟
其次,需要了解通用性击穿特性仿真的方法,需要仿真示例,来感受器件的击穿特性。
针对现在的pinv2代码,其实可以微调衬底浓度,看击穿电压是否随之改变。
所以还得在已有的论文中着重看二维单像素仿真的部分
对了,今天还重启解决了tonyplot的一个问题,就是显示哪个组件有问题,查看是否需要更新什么的
可能是用久了出现的,看网上有人说重启电脑,真的就好了
An error occured while contacting the Sipc Server.Make sure the sipc.exe ser……

验证衬底浓度和击穿电压关系的时候还老是出现这个错误,需要仿真练习去搞明白
实时输出显示计算到100.几,小于我设置的102,应该是达到我要求的误差条件之类的(
method newton trap maxtrap=10 climit=1e-4
明天复习一下这个
),或者就是都击穿了,还加大电压,本身就不太合理?
初步仿真结果:衬底浓度越小,击穿电压越大

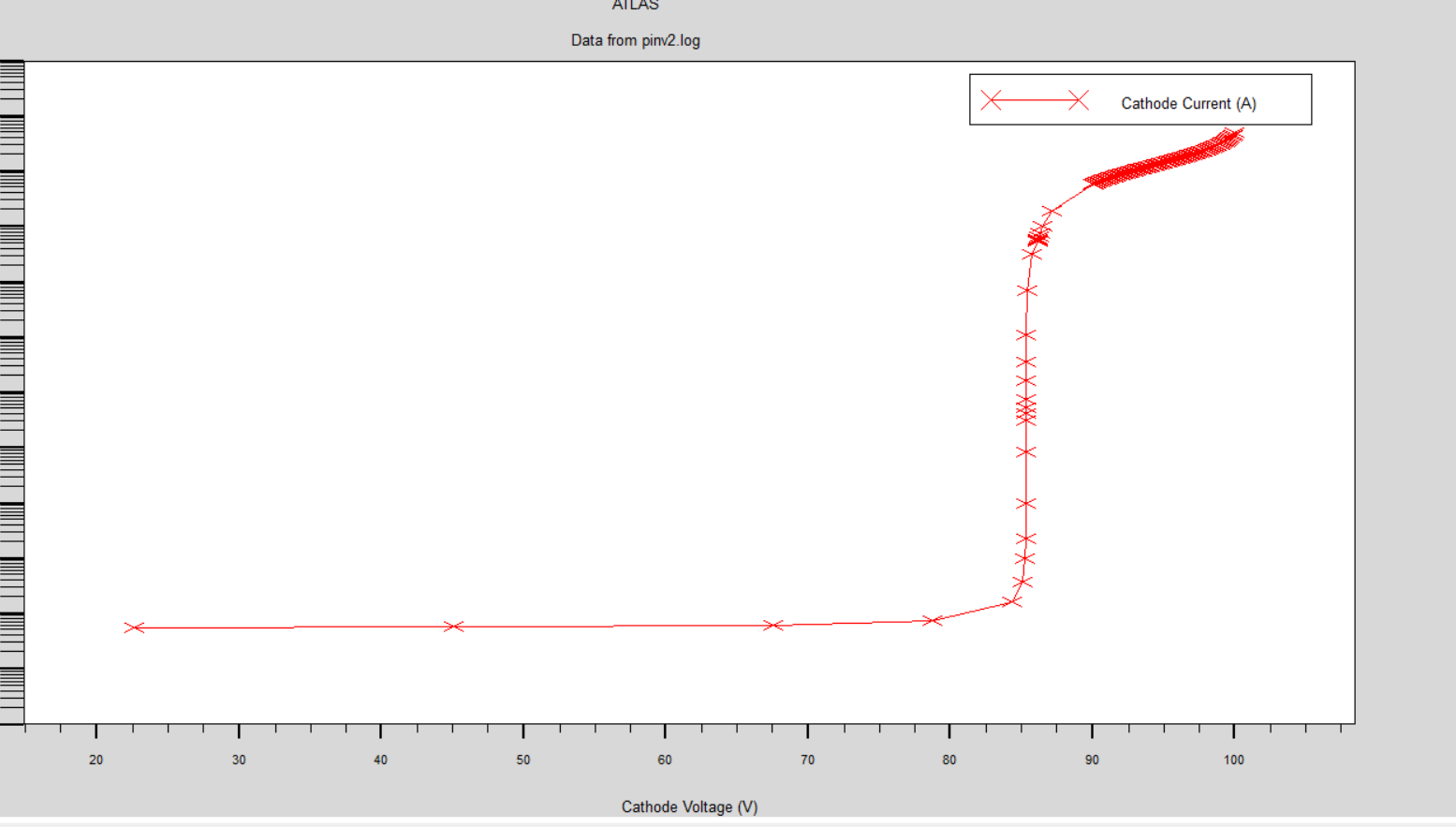
1e15
初步证明验证,算是今天的一些小成果。























 5271
5271

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








