目录
1 引言
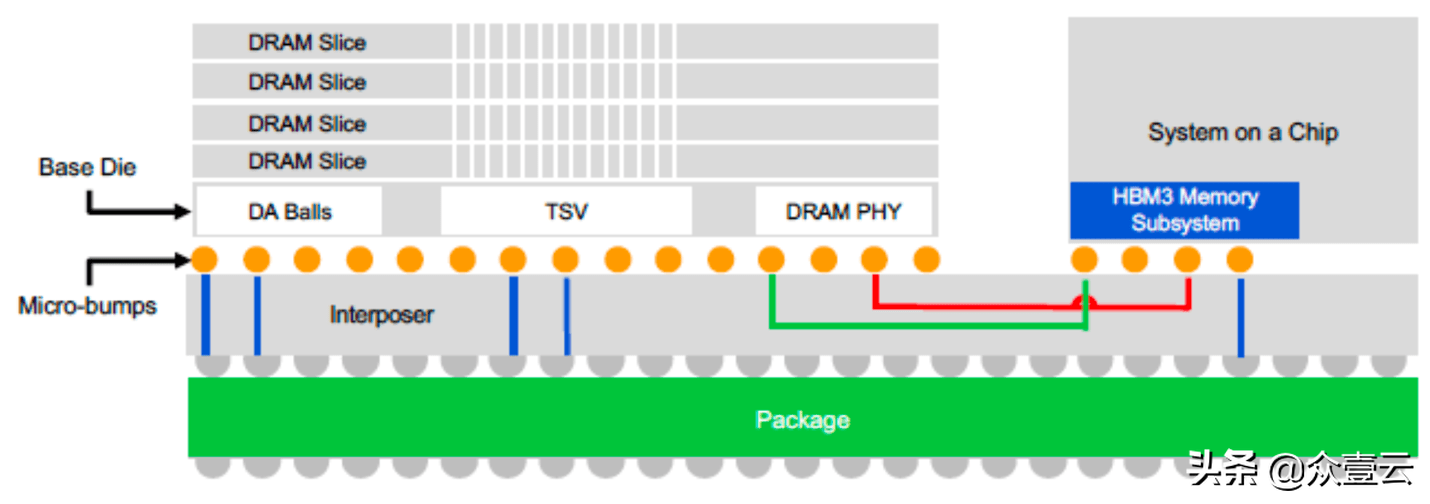
存储技术的创新如同璀璨星辰,而16 层 “混合键合” HBM 内存技术,就像是一位神秘的魔法师,正悄然引领着存储领域的新变革。那么,它究竟有何魅力呢?
传统的内存技术就像是普通的书架,在面对大量信息和高速检索需求时,有些力不从心。而 “混合键合” HBM 内存技术,则以极快的速度将所需的书籍(数据)准确地送到读者(处理器)手中。
16 层 “混合键合” HBM 内存技术,像是为高速行驶的数字列车铺设了一条更加宽阔、平坦的轨道,极大地提高了性能。
2 HBM 内存技术概述
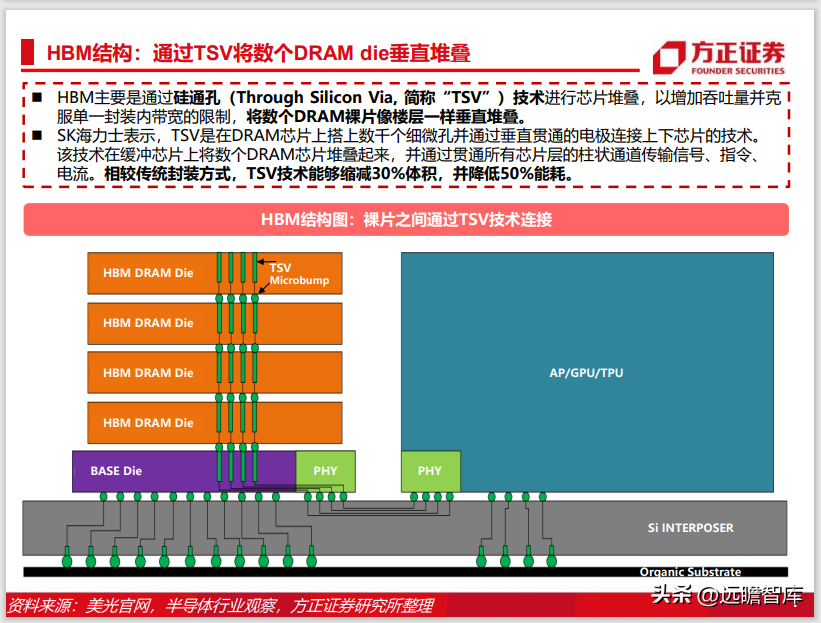
HBM 是通过使用特殊液体或薄膜堆叠 DRAM 制成的高带宽存储器,目前 12 层产品已商业化。随着技术的发展,16 层及以上的 HBM 内存面临新的挑战和机遇。
2.1 HBM 内存的发展历程
从第一代 HBM 诞生以来,经过不断迭代,如今已发展到 HBM3E,甚至 HBM4 也初露头角。
HBM4 比其前身 HBM3 具有显著的性能改进,在使用 16 层堆栈的情况下,单个堆栈可以实现 64 GB 容量,具有四个内存模块的处理器, 可提供高达 256 GB 的内存和 6.56 TB/s 的峰值带宽。
2.2 HBM 内存的应用领域
在数据中心,随着数据密集型工作负载和应用程序的增长,传统数据中心 “CPU + 内存(如 DDR4)+ 存储(如 SSD)” 的数据处理方式已经难以满足需求,转而走进 “异构数据中心” 时代。
像生成式 AI 等大型语言模型需要重复访问数十亿甚至数万亿个参数,,HBM 内存能够存储和快速处理这些数据。
此外,HBM 内存还应用于图形处理器(GPU).
3 “混合键合” HBM 内存技术详解
混合键合(Hybrid Bonding),也称为直接键合互连(Direct Bond Interconnect,DBI),是一种先进的集成电路封装技术。其原理是通过两个芯片覆盖介电材料如二氧化硅(SiO₂),并在介电材料中嵌入与芯片相连的铜接点,然后将两个芯片的接点面对面贴合,再通过热处理使两个芯片的铜接点受热膨胀并对接,从而实现芯片之间的连接。
相比传统的封装技术,混合键合技术具有以下优势:
缩小接点间距
混合键合技术能够将接点间距缩小至 1μm 甚至更低,相比凸块接合技术的最小接点间距约 20μm,混合键合技术可以在相同尺寸的芯片上做出更多的 I/O 接点,甚至能在 1cm² 芯片上做出百万个 I/O 接点,相比传统覆晶焊锡接合,接点数能提升千倍以上。
降低芯片堆叠厚度
混合键合技术只会让芯片增加 1~2μm 的厚度,而微凸块的高度则在 10~30μm 之间,因此采用混合键合技术有助于降低芯片堆叠的厚度,同时省去微凸块间的填充材料。
提高信号传输稳定性和能效
通过混合键合制作铜接点传递讯号,不仅更稳定,耗能也只有微凸块的三分之一甚至更低,有助于节能散热。
减少芯片机械应力
混合键合技术能够减少芯片的机械应力,提升产品的可靠性,同时支持更高的资料传输速度,以及达成更低能耗的表现。
混合键合摒弃了在 DRAM 内存层间添加凸块的繁琐步骤,直接通过铜对铜的连接方式实现上下两层的连接,如同为数据的流通开辟了一条高速公路。
3.2 混合键合技术的优势
提高信号传输速率
就像是一位超级快递员,能够以极快的速度将数据准确无误地送达目的地。
降低 DRAM 层间距
使得 HBM 模块的整体高度得到缩减,如同将高楼大厦变得更加紧凑。
节省了空间,还为轻薄化发展提供了可能。
减少芯片内部的机械应力
如给芯片穿上了一层坚固的铠甲,减少了芯片内部的机械应力。
3.3 混合键合技术的挑战
技术难度高,需要更高的温度和压力,难以确保良率,如同在高温高压下进行一场精细的手术。
混合键合技术的实施就像是在高温高压下进行一场精细的手术,难度极高。它需要更高的温度和压力来实现铜对铜的连接,这就对生产工艺提出了极高的要求。
热控制难度大,需要解决散热问题,避免芯片过热。
传输速率的提高,会产生大量的热量,如不能及时散热,会导致芯片过热,影响性能和寿命。
微粒控制挑战
在芯片的生产过程中,微粒的存在可能会导致芯片的质量和稳定性下降。这近乎达到苛刻的要求。
4 三大内存厂商的布局

三星电子、SK 海力士和美光科技这三大 HBM 内存制造商正在引领 16 层 “混合键合” HBM 内存技术的发展。
5 结论
混合键合技术在,提高了信号传输速率,降低了 DRAM 层间距。
然而,这一技术也面临着诸多挑战。技术难度高,需要更高的温度和压力,确保良率并非易事;热控制难度大,需要解决散热问题。

























 7355
7355

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










