相信很多ICer在Light芯片的过程中无论前端还是后端都听过DFT设计测试,DFT全称Desigh for Test(即可靠性设计),众所周知,测试的目的是为了保证芯片成品的质量以及功能逻辑的可靠性的必须措施,在十年前,芯片的测试还多为板级仿真波形测试,即使用示波器等硬件设备去勘测芯片的逻辑功能是否正常,但是随着芯片复杂性的提升以及逻辑数目的增加,基础的板级测试已经不能保证整体的覆盖率和最后的良率了,芯片测试也逐渐覆盖到设计制造的全流程当中。
本文将从设计流程以及verilog HDL,故障和缺陷模型的建立,故障仿真应用与方法,测试向量生成方法以及算法,确定性测试生成算法,扫描法进行测试电路设计,逻辑内建自测试,测试压缩,Mbist测试存储器等角度出发,从理论以及实际上讲解DFT设计流程以及注意事项。
首先要明白为什么要进行芯片测试,在数字系统中又到底在测试什么?答案是:测试是为了发现成品芯片或者器件的物理缺陷,数字系统测试的为各逻辑单元的功能/PIN的完好性。
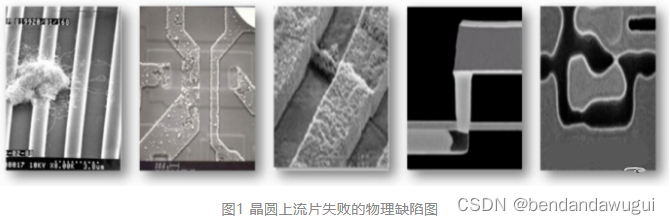 不难看出,从左往右造成缺陷的原因依次为:第一个落了灰造成short,第二个金属线open,第三个也是短路,两根金属搭在一块,第四个下方金属/OD层的 通孔断了,第五个缺陷光刻刻蚀错了,这种的缺陷在TO的过程中是致命的,也是需要DFT工程师提前去排除的,实际上在DFT测试过程中最常用的测试为全扫描测试,即将时序逻辑替换成带SI,SE端的SDFF(等效于在普通移位寄存器DFF的D端连接一个MUX,即最基础的扫描单元SDFF)然后将时序逻辑串起来,以便对组合逻辑进行测试。
不难看出,从左往右造成缺陷的原因依次为:第一个落了灰造成short,第二个金属线open,第三个也是短路,两根金属搭在一块,第四个下方金属/OD层的 通孔断了,第五个缺陷光刻刻蚀错了,这种的缺陷在TO的过程中是致命的,也是需要DFT工程师提前去排除的,实际上在DFT测试过程中最常用的测试为全扫描测试,即将时序逻辑替换成带SI,SE端的SDFF(等效于在普通移位寄存器DFF的D端连接一个MUX,即最基础的扫描单元SDFF)然后将时序逻辑串起来,以便对组合逻辑进行测试。
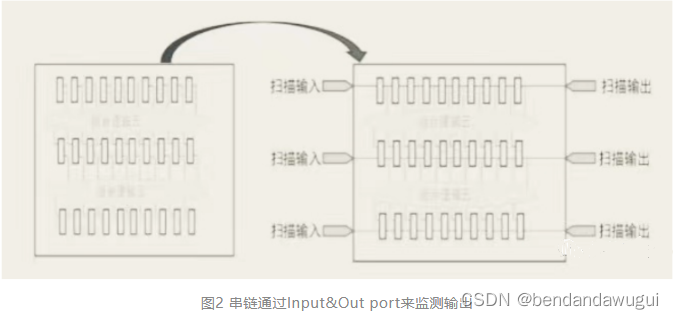
全扫描测试可以显著的增加芯片的可测性,而DFT扫描链测试的基本原理就是可观可控,什么是可观,可控呢?说的通俗一点就是“黑盒子”,在具体的芯片设计中不可能去调整具体logic的PIN的直接输入,也不能直接检测对应logic的直接输出,DFT工程师是通过调整测试/功能模式,在芯片的input PIN控制输入,而在Output Pin控制输出,通过控制输入PIN的信号,检测输出PIN的信号,来达到“可管可控”的目的。

可以看出在给定一串复杂多位二进制信号后,经过内部组合逻辑和时序逻辑的转换,在不同周期可以得到一个对应输出引脚的输出值,在理论上又有一个期望值,若期望值和输出值不符,则可以通过在测试模式下调整输入准确的找到问题的所在。
这么解释可能有点宽泛,下面我们举例来测试XOR的一个module的例子(并行串出结构),DFT扫描链是如何通过控制SI,SO SE端来实现输入可观(SI)输出可测(SO)的,首先在SI第一周期输入信号1,此时第一个周期三拍的转台分别为100,然后这个时候第二拍传递给XOR上方的INPUT PIN的值为1,第一拍传递给下方的INPUT PIN的值为0,按照1^0=1的异或逻辑来说,如果是功能模式状态下,第二个时钟周期应该会输出1,这样第三拍第三周期怎么都会输出1,无论是功能还是测试模式,但是假设XOR的Output PIN floating了的话,在第二周期切换功能模式,则在第三周期第三拍会收到X态信号,和预期的1值不符合,这就完成了一个简单的输入可观,输出可控的DFT扫描测试。

数字系统的制造流程,是以设计使用VHDL/Verilog HDL描述其设计开始,并以制造装运各部件交付 客户为终点,接下来讲解下DFT工程师在整个设计流程当中是如何参与测试,并在不同阶段进行仿真测试的:
RTL设计流程仿真:这一流程主要依赖一些前端工具如VCS,Verdi,MSIM等等,通过对输入的可 综合的顶层verilog互连模型的仿真来检查设计的功能是否正常,为了方便分析设计行为,平台可以 通过注入设计错误即激励来预测该设计在非预期环境下的行为。这一工作在fabless公司通常由验证 工程师来实现完成,在基于Spec进行检查的时候,验证和基于断言的验证方法非常有效,各种验证 方法可以是HDL仿真器的一部分,也可以作为独立程序使用
RTL综合:RTL综合实际上就是在APR之前,将可综合RTL代码转换为门级Netlist网表的过程(此过 程也要插入DFT测试逻辑),在综合完成后,需要对生成的RTL代码进行Formal形式验证,并利用 HDL仿真工具对Netlist进行后仿测试,在仿真的过程中,要检查delay问题,竞争与冒险,时钟速 度以及综合工具对RTL设计错误判断所导致的综合错误。一般来说,需要保证综合过后的网表与综 合前的RTL代码描述一致。
物理版图:后端APR完后吐出的GDS版图通过对IP以及std cell,dummy的merge后,引入spi mod进行DRC,ANT,LVS check,当连线的长度,宽度以及晶体管的大小等DRC rule里规定的内 容都通过仿真检查后,版图GDS就能用于制造芯片了。
芯片制造:相对于图1-1中其他三种形式的测试而言,在生成测试中则有物理器件(要么硬件,要 么测试设备)执行测试。但是,预期响应均全部或部分基于前几个设计阶段已完成测试所获得的经 验。在理想状态下,用于流片后方框上面的三个方框的同一测试平台应转换为运行在测试成品部件 的测试设备上的测试程序。
流片后测试:
这里要重点讲一下CP和FT测试,
CP(chip probing)是把坏的Die挑出来,可以减少封装和测试的成本。可以更直接的知道Wafer 的良率。CP是wafer level的chip probing,是整个wafer工艺,包括backgrinding和backmetal(if need),对一些基本器件参数的测试,如vt(阈值电压),Rdson(导通电阻),BVdss(源漏击穿电压),Igss(栅源漏电流),Idss(漏源漏电流)等,一般测试机台的电压和功率不会很高;
FT(final test)是把坏的chip挑出来;检验封装的良率。 FT是packaged chip level的Final Test,主要是对于这个(CP passed)IC或Device芯片应用方面的测试,有些甚至是待机测试;
现在对于一般的wafer工艺,很多公司多把CP给省了;减少成本。 CP对整片Wafer的每个Die来测试 而FT则对封装好的Chip来测试。 CP Pass 才会去封装,然后FT,确保封装后也Pass。
具体细节见:芯片测试术语介绍CP、FT、WAT - 知乎 (zhihu.com)























 2万+
2万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








