本文研究了氢氧化钾、TMAH(C6H4(OH)2)溶液中氢氧化铵(四甲基铵)和EDP(乙烯二胺(NH2(CH2)2NH2)的浓度和温度对硅表面的影响,制作了光滑的垂直墙和悬吊梳式结构。
在蚀刻研究中,在1100C下热生长1lm二氧化硅掩蔽层,然后通过常规光刻和氧化物图案蚀刻对氧化物层形成图案,对于垂直的侧壁,掩模图案应平行于方向对齐,在将样品浸入蚀刻溶液中之前,在缓冲的高频溶液中去除天然氧化物,然后在去离子(DI)水中冲洗,为了更好地晶片区域的均匀性,我们将样品水平保存在蚀刻溶液中。
将氢氧化钾薄片溶解到去离子水中制备氢氧化钾溶液,在500ml的氢氧化钾溶液中进行了一系列的蚀刻实验,浓度在10~50wt%之间变化,温度在80~120C之间不等,TMAH溶液(500毫升)是通过稀释市售的TMAH溶液制备的。TMAH浓度在5~25wt%之间变化,蚀刻槽的温度在60~90C之间变化。本研究采用500ml乙烯二胺、80g吡氯苯乙烯和水(DI)作为蚀刻溶液,蚀刻溶液中的EDP含量从71~95wt%不等,蚀刻浴的温度从70~125C不等。
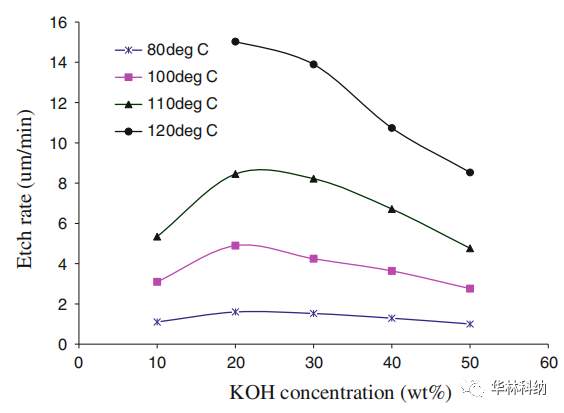
图1
图1显示了不同蚀刻浴温度下不同氢氧化钾浓度下硅蚀刻速率的依赖关系,研究表明,20wt%氢氧化钾溶液在80C下的最大硅蚀刻速率分别为1.52lm/min,在120C下分别为15.06lm/min,10wt%氢氧化钾溶液的沸点为112C,因此在120C曲线处没有相应的数据点。








 本文探讨了KOH、TMAH和EDP在不同浓度和温度下对硅表面蚀刻的影响。研究发现,20wt%的KOH溶液在80°C下有最高蚀刻速率,TMAH溶液中硅蚀刻速率随浓度增加而增加,而EDP在71-95wt%范围内达到最佳蚀刻效果。高温蚀刻能提高表面平滑度,活化能分别为0.6、0.5和0.34eV。该研究为硅垂直梳状壁的制造提供了指导。
本文探讨了KOH、TMAH和EDP在不同浓度和温度下对硅表面蚀刻的影响。研究发现,20wt%的KOH溶液在80°C下有最高蚀刻速率,TMAH溶液中硅蚀刻速率随浓度增加而增加,而EDP在71-95wt%范围内达到最佳蚀刻效果。高温蚀刻能提高表面平滑度,活化能分别为0.6、0.5和0.34eV。该研究为硅垂直梳状壁的制造提供了指导。
 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章

















 984
984

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








