离子注入几何结构
图3-23展示了离子束相对于衬底晶体取向的方向。在晶体材料的离子注入过程中,涉及三个主要平面:
- 注入平面α:初始离子束所在平面,明确决定了入射方向(倾斜角和旋转角)。
- 表面平面Σ:当前二元碰撞近似(BCA)模块(如CRYSTAL参数)中,表面取向固定为{100} 。
- 模拟平面β:用于定义注入过程的参考平面。
当表面平面Σ的取向为[100]时,旋转角(ϕ)的偏移方向为该平面上的<101>晶向。此时:
- 倾斜角ϑ(IMPLANT语句中的TILT参数)为注入平面α的极角;
- 旋转角ϕ(ROTATION参数)为注入平面α与表面平面Σ交线的方位角,与<101>方向的方位角之差 。
注意:目前晶体蒙特卡罗模块中,表面取向(INITIALIZE语句的ORIENT参数)不影响模拟结果,表面始终默认为{100} 。
关键点解析:
-
晶体取向与离子束方向:
- 离子束的入射方向(倾斜与旋转)需结合晶体晶向定义。例如,文献指出离子束方向沿<101>的调整会影响溅射产率,这与通道效应相关 。
- 表面平面Σ的{100}取向限制可能源于BCA模型对称性假设,简化计算复杂度 。
-
参数定义的物理意义:
- 倾斜角ϑ决定了离子束与表面法线的夹角,直接影响离子在晶体中的穿透深度和通道效应 。
- 旋转角ϕ通过调整注入平面α与<101>的相对方位,影响离子在晶体中的横向分布 。
-
实际应用与限制:
- 当前模块仅支持{100}表面取向,可能限制了对其他晶面(如{111})注入行为的模拟,而实验表明晶面取向显著影响刻蚀和损伤分布 。
- 未来扩展需结合三维取向显微技术(如FIB-SEM)以支持多晶面分析 。

图3-23 注入几何结构
模拟(投影)平面
模拟(投影)平面是所有模拟数据投影的载体,最终被导入Athena的结构中。该平面的取向由INITIALIZE语句中的ROT.SUB参数定义 。
- 实验室坐标系(BCA模拟使用)为右手坐标系:
- -Y轴为深度方向,X轴为水平坐标,Z轴指向观察者 。
- 方位角(Azimuth)在X-Z平面内测量 。
- ROT.SUB参数以晶圆主平面(major flat)为基准定义模拟平面的旋转方向,默认为45° 。
模拟平面特性
- 模拟平面(X’-Y平面)始终垂直于晶圆表面,TONYPLOT在此平面上显示结果,Athena亦在此进行计算 。
- 体注入计算为三维,但BCA的光线追踪(离子碰撞、壁面散射及再注入)为2.5维,即结构沿Z轴无限延伸 。所有掺杂与损伤结果均投影到模拟平面并按比例缩放 。
参数关联性
- ROTATION参数以晶圆主平面为基准,且因与模拟平面耦合,默认方向相同 。
- 对于硅等晶体材料,TILT/ROTATION参数定义离子束相对于模拟平面的方向(影响遮蔽效应),而ROT.SUB决定模拟平面如何切割晶体结构 。
- 不同ROT.SUB值会影响沟道效应(channeling),但需注意:
离子传播为三维过程,某些沟道模式可能因TILT/ROTATION/ROT.SUB的组合而增强或减弱 。
关键术语解析:
-
投影平面(Projection Plane):
根据文献,投影平面是连接观察点与物体各点的假想平面,模拟结果在此平面上呈现 。在Athena中,此平面垂直于晶圆表面,与BCA模拟的坐标系绑定 。 -
ROT.SUB参数:
定义模拟平面相对于晶圆主平面的旋转角度,默认45°。此参数通过调整模拟平面的切割方向,影响晶体中离子的沟道行为 。 -
2.5D光线追踪:
结构沿Z轴无限延伸的假设简化了计算,但需通过投影将三维数据映射到二维平面 。此方法与多线激光投影测量技术中的三维模拟系统类似 。 -
坐标系与方位角:
右手坐标系中,方位角在X-Z平面内测量,与投影矩阵的定义一致 。旋转参数的调整需结合极角(TILT)和方位角(ROTATION)以优化注入方向 。
SiC中的离子注入几何结构
Athena的蒙特卡罗模块能够精确模拟4H-SiC和6H-SiC中的离子注入。由于SiC晶格中存在多个宽开放通道(例如4H-SiC的<0001>、<11 2 ‾ \overline{2} 2 0>和<11 2 ‾ \overline{2} 2 3>方向),其沟道效应(channeling effects)非常显著。因此,注入分布高度依赖于晶圆取向和离子束方向。
晶圆偏切的影响
商业化的标准<0001>晶向SiC晶圆通常具有3.5°–8.5°的偏切(miscut),通常朝向<11
2
‾
\overline{2}
2 0>方向。这种偏切主要用于促进外延生长,但同时也会影响离子注入行为——沿晶圆表面法线方向注入等效于在(11
2
‾
\overline{2}
2 0)平面内倾斜离子束。
Athena中的模拟设置
-
模拟平面定义:
Monte Carlo模块通过三维离子轨迹模拟,将最终的停止点及掺杂浓度投影到模拟平面(X’-Y平面)。该平面始终垂直于晶圆表面,其方向由INITIALIZE语句中的ROT.SUB参数定义,以晶圆主平面(major flat)为基准(如图3-24)。- 大多数商用4H-SiC和6H-SiC晶圆的主平面平行于(1 1 ‾ \overline{1} 1 00)晶面。
-
假设条件:
模块假设材料界面在模拟平面法线方向上无变化,即结构沿第三维度(Z轴)无限延伸(2.5D近似)。
关键术语解析:
-
沟道效应(Channeling Effects):
SiC的各向异性晶格结构导致离子沿特定晶向(如<0001>)注入时,穿透深度显著增加。文献表明,沟道效应是优化SiC器件掺杂分布的核心挑战。 -
晶圆偏切(Miscut):
偏切会改变晶格方向与离子束的相对角度,进而影响注入分布和损伤特性。例如,偏切8°的4H-SiC晶圆在垂直注入时可能表现出与倾斜8°注入相似的沟道行为。 -
ROT.SUB参数:
该参数定义模拟平面相对于晶圆主平面的旋转角度,直接影响模拟结果的投影方向。例如,ROT.SUB=45°时,模拟平面切割晶格的方向与主平面成45°夹角。
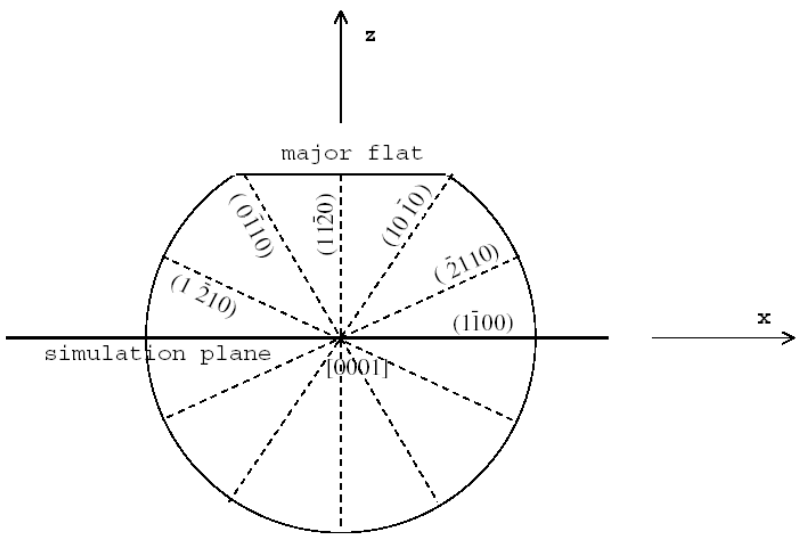
图3-24 展示了Athena BCA模块中SiC晶圆取向与模拟平面的关系,以及晶圆表面主要晶面的投影
模拟平面与晶向的对应关系
若需使Athena的模拟平面与晶圆主平面(<1
1
‾
\overline{1}
1 00>)平行,需设置 ROT.SUB=0;若需模拟平面与<11
2
‾
\overline{2}
2 0>晶向平行,则需设置 ROT.SUB=90 。
离子束方向的参数定义
离子束方向由IMPLANT语句中的 TILT 和 ROTATION 参数共同定义:
- TILT(倾斜角):离子束矢量与晶圆表面法线之间的夹角(单位:度)。
- ROTATION(旋转角):离子束矢量所在平面(垂直于晶圆表面)与模拟平面之间的夹角 。
示例说明:
- 若离子束矢量平面平行于图3-24中的< 2 ‾ \overline{2} 2 110>晶向,需设置 ROTATION=30(参考图3-25)。
- 若离子束矢量平面垂直于模拟平面,则需设置 ROTATION=90 。
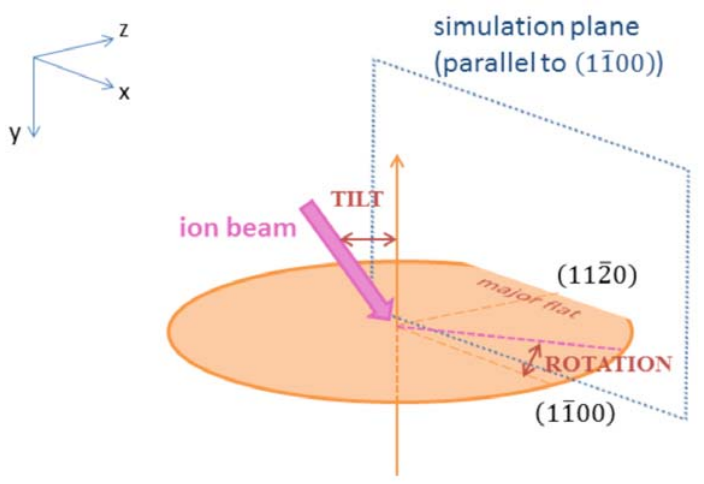
图3-25 三维SiC晶圆与模拟平面方向。当模拟平面与(1 1 ‾ \overline{1} 1 00)晶面平行时,需设置 ROT.SUB=0
晶圆偏切参数定义
晶圆的偏切方向由 MISCUT.TH 和 MISCUT.PH 参数定义:
- MISCUT.TH:晶圆实际表面与XZ平面的夹角(如图1)。
- MISCUT.PH:偏切方向的角度(从主平面方向逆时针测量)。例如:
- 若晶圆沿<1100>方向(图3-24中的X方向)偏切,需设置 MISCUT.PH=0。
- 多数商用晶圆(如文献[16][17])的偏切方向为<11 2 ‾ \overline{2} 2 0>,因此需设置 MISCUT.PH=90,而 MISCUT.TH 根据商用规格设为4°或8°(如“偏离轴向4°±0.5°”)。
典型模拟初始化示例
init sic_4h rot.sub=0
implant aluminum energy=50 dose=1e13 bca n.ion=10000 tilt=4 rotation=90 miscut.th=4 miscut.ph=90
- 参数含义:
- rot.sub=0:模拟平面与主平面(<1 1 ‾ \overline{1} 1 00>)平行。
- tilt=4:离子束沿垂直于模拟平面的方向倾斜4°,对应商用晶圆的“4°偏切”规格。
- miscut.ph=90:偏切方向为<11 2 ‾ \overline{2} 2 0>,符合多数商用晶圆的工艺标准。
这将对应在具有标准小切角的晶圆上进行离子注入,其规格通常在商用晶圆参数中描述为“偏离<110>晶向轴4°±0.5°”。模拟平面将与晶圆主大平面(major flat)保持平行,而离子束将在与模拟平面垂直的平面内倾斜4°。
以下示例详细展示了基于小切角参数(MISCUT.TH/PH)或倾斜/旋转参数(TILT/ROTATION)设置的等效离子注入方向。
SiC离子注入仿真实例
示例1
说明:展示与晶圆主参考面<1
1
‾
\overline{1}
1 00>方向等效的注入方向设置。
标准晶圆(无斜切):
init sic_4h rot.sub=0
implant aluminum n.ion=40000 dose=0.63e13 tilt=0 rot=0 energy=60
bca
等效的斜切晶圆(4°斜切指向<11 2 ‾ \overline{2} 2 0>):
init sic_4h rot.sub=0
implant aluminum n.ion=40000 dose=0.63e13 tilt=4 rot=90 miscut.th=4 miscut.ph=90 energy=60
bca
效果对比:两种注入分布统计等效,但后者因倾斜4°导致投影产生轻微位移(位移量约为cos(4°)比例)。
示例2
说明:展示与晶圆主参考面<11
2
‾
\overline{2}
2 0>方向等效的注入方向设置(注:MISCUT.TH/PH基于晶体学坐标系,而非ROT.SUB定义的实验室坐标系)。
标准晶圆(无斜切):
init sic_4h rot.sub=90
implant aluminum n.ion=40000 dose=0.63e13 tilt=0 rot=0 energy=60
bca
等效的斜切晶圆(4°斜切指向<11 2 ‾ \overline{2} 2 0>):
init sic_4h rot.sub=90
implant aluminum n.ion=40000 dose=0.63e13 tilt=4 rot=0 miscut.th=4 miscut.ph=90 energy=60
bca
效果对比:两种分布统计等效,后者因倾斜4°导致投影位移(位移量由cos(4°)决定)。
示例3
说明:展示理想晶圆与斜切晶圆(4°斜切指向<11
2
‾
\overline{2}
2 0>)在倾斜注入条件下的等效参数设置。
理想晶圆(沿[0001]法线方向倾斜3°注入):
init sic_4h rot.sub=0
implant aluminum n.ion=40000 dose=0.63e13 tilt=3 rot=0 energy=60
bca
等效的斜切晶圆(4°斜切指向<11‒0>):
init sic_4h rot.sub=90
implant aluminum n.ion=40000 dose=0.63e13 tilt=1 rot=0 miscut.th=4 miscut.ph=90 energy=60
bca
效果对比:两种分布统计等效,但由于两者在垂直Y坐标上的投影效应,会存在轻微位移。
通过调整tilt、rot与miscut参数组合,可在仿真中精确复现实际斜切晶圆的离子注入分布特性。

























 7518
7518

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










